Содержание
- 2. Тенденции развития: уменьшение размера элемента (топологической нормы) Lg - длина затвора Xj - толщина легированных областей
- 3. Тенденции развития: увеличение степени интеграции 1 – ранняя стадия выпуска ИС (удвоение количества транзисторов каждые 12
- 4. Проекционная литография Предельное разрешение оптической литографии: где k1 – технологический параметр, λ – длина волны экспонирующего
- 5. Параметр k1 Параметр k1 был уменьшен с 0.8 в 1980 году до 0.4 сегодня. Величина k1
- 6. Фазосдвигающий шаблон Фазосдвигающие шаблоны, в которых сдвиг фазы световой волны на 180 градусов: а - реализуется
- 7. Принцип действия фазосдвигающего шаблона Фазосдвигающий шаблон Обычный шаблон
- 8. Коррекция эффекта близости Для того чтобы в фоторезистивной маске создать необходимый рисунок приходится усложнять рисунок фотошаблона,
- 9. Длина волны экспонирующего излучения Эволюция источников экспонирующего излучения: Ртутные дуговые лампы (λ = 436 (g-line), 405
- 10. Длина волны освещения и топологическая норма По мере уменьшения топологической нормы происходит и уменьшение длины волны
- 11. Иммерсионная литография: увеличение числовой апертуры (NA) NA = n sinθ, где n – коэффициент преломления среды
- 12. Установка иммерсионной литографии Микроскопические изображения резистивных масок, полученных с помощью иммерсионной литографии с полушириной линия-промежуток равной
- 13. Экстремальная ультрафиолетовая литография Длина волны излучения на уровне 10 нм обеспечивает прекрасное разрешение Оптика - отражательная
- 14. Источник импульсной лазерной плазмы CO2 лазер (основной импульс) Nd:YAG лазер (пред-импульс) Камера с мишенью светоделительная пластина
- 15. Импринтинг Импринтинг – это метод литографии, когда трёхмерный рисунок в резисте получается посредством вдавливания в него
- 17. Импринтинг: S-FIL технология
- 18. Импринтинг: технология 2-D рисунок 1-D рисунок Дифракционная микролинза
- 19. Обращенный импринтинг (S-FIL/R process) S-FIL/R процесс: после формирования отпечатка, поверхность покрывается планаризирующим слоем (6), который травится
- 20. Преимущества импринтинга Низкая стоимость оборудования и технологии, так как не используется дорогая оптика, источники излучения и
- 21. Применение наноимпринтинга
- 23. Скачать презентацию
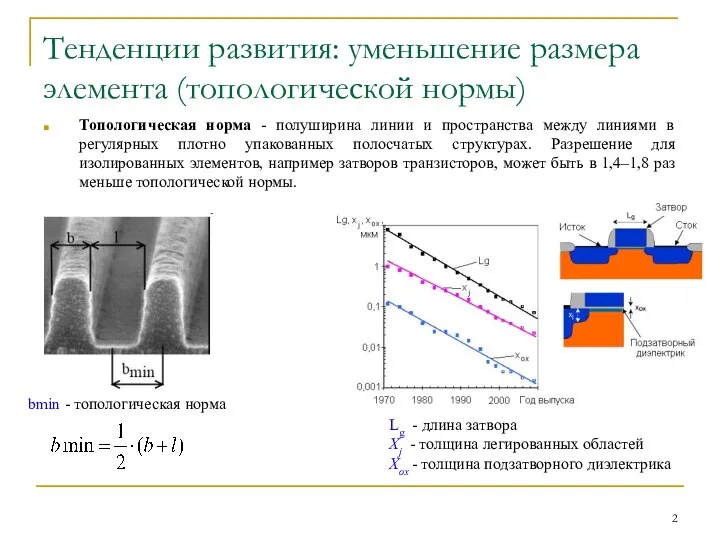





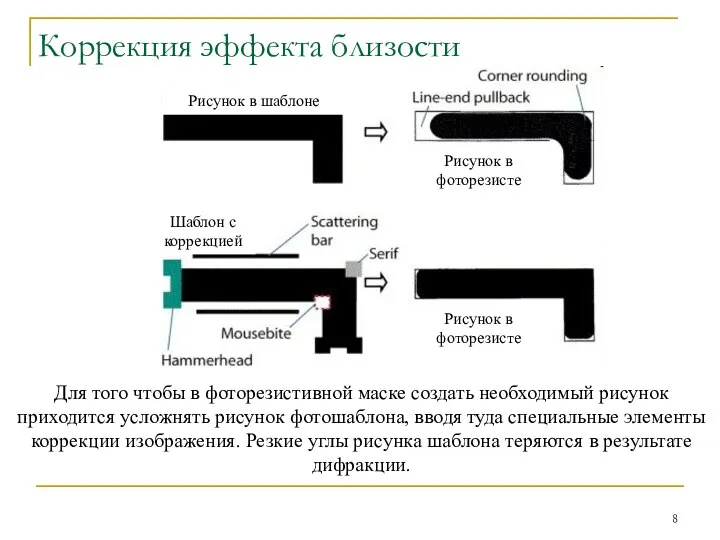

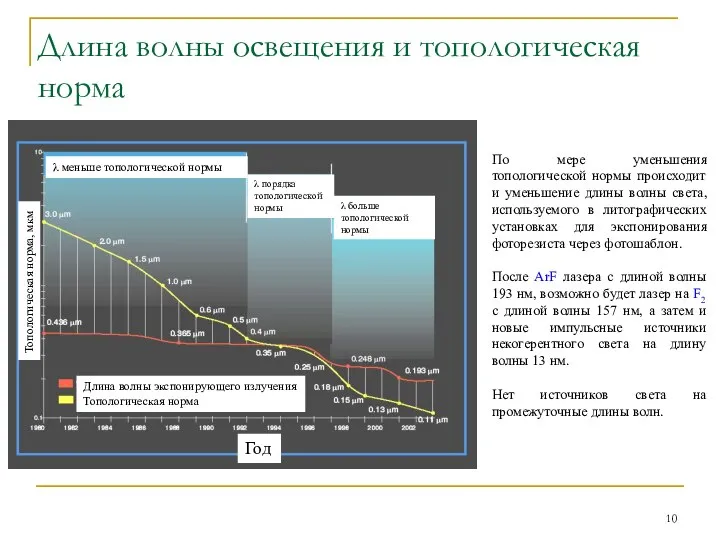

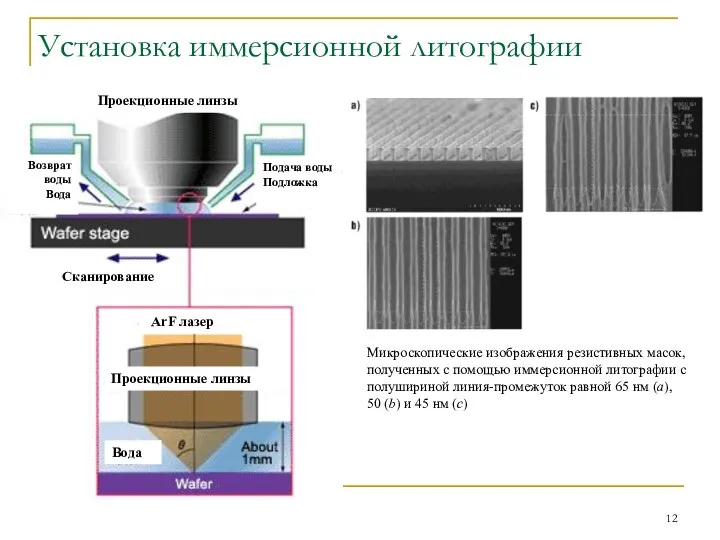

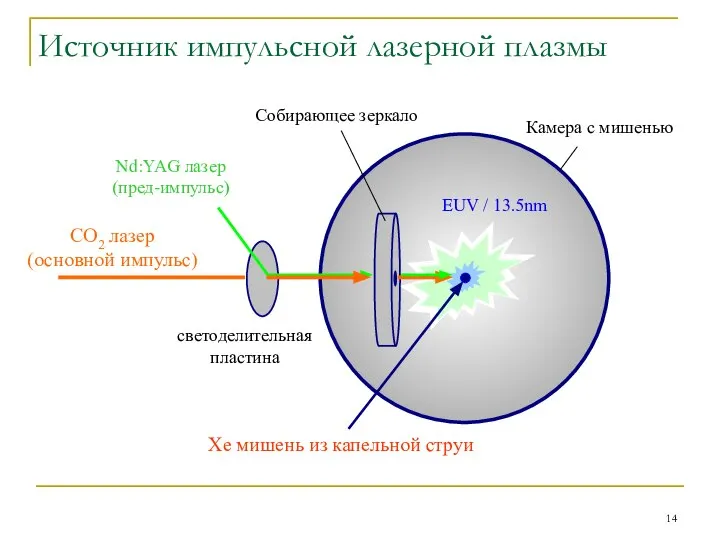


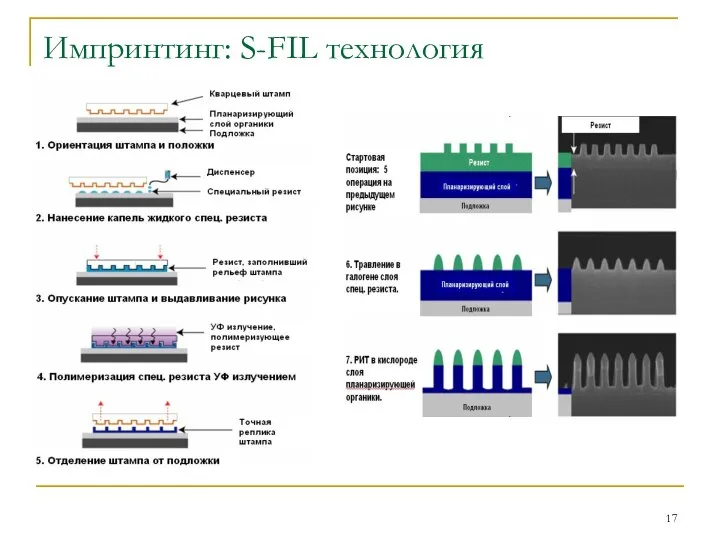
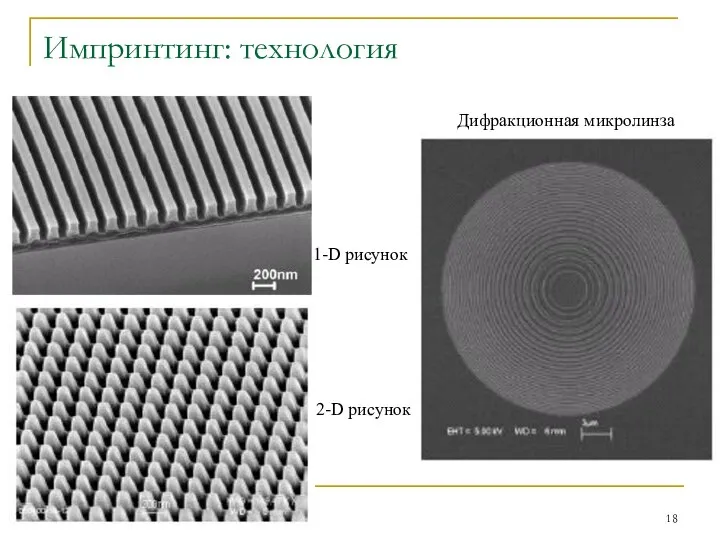
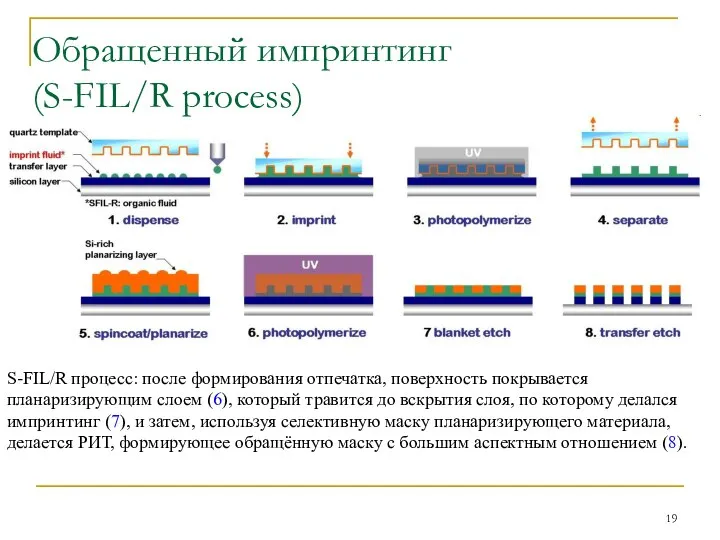


 Шаровая молния. Чем опасна шаровая молния для человека
Шаровая молния. Чем опасна шаровая молния для человека Презентация по физике "презентация к уроку Агрегатные состояния вещества - 8 класс" - скачать бесплатно
Презентация по физике "презентация к уроку Агрегатные состояния вещества - 8 класс" - скачать бесплатно Энергия колебательного движения. (Лекция 7)
Энергия колебательного движения. (Лекция 7) Методика и технологии изучения темы Тепловые машины
Методика и технологии изучения темы Тепловые машины Отношение сигнал-шум на выходе приёмника ЧМ сигнала
Отношение сигнал-шум на выходе приёмника ЧМ сигнала Силы электромагнитной природы
Силы электромагнитной природы Первый закон термодинамики
Первый закон термодинамики Плазмадағы толқын
Плазмадағы толқын Свет в нашей жизни
Свет в нашей жизни ЕГЭ ФИЗИКА
ЕГЭ ФИЗИКА Понятие радиационной защиты. Классификация защит по объекту защиты. Другие классификации защит
Понятие радиационной защиты. Классификация защит по объекту защиты. Другие классификации защит Изучение явления электромагнитной индукции. Лабораторная работа № 4
Изучение явления электромагнитной индукции. Лабораторная работа № 4 Биологические действия радиации Материал к уроку
Биологические действия радиации Материал к уроку Аттестационная работа. Технические инновации Уральского Федерального округа
Аттестационная работа. Технические инновации Уральского Федерального округа Магнитное поле. Взаимодействие токов
Магнитное поле. Взаимодействие токов Колебания и волны (ОГЭ). Решение задач 9 класс
Колебания и волны (ОГЭ). Решение задач 9 класс Квартирный щиток. Презентация по электротехнике
Квартирный щиток. Презентация по электротехнике Урок физики Свободное падение
Урок физики Свободное падение Твердые тела
Твердые тела Шкала электромагнтных излучений
Шкала электромагнтных излучений Электрические цепи постоянного тока. Лекция 1
Электрические цепи постоянного тока. Лекция 1 Измерительные приборы
Измерительные приборы Гидравлика. Относительный покой жидкости
Гидравлика. Относительный покой жидкости Звук. Отражение звука
Звук. Отражение звука Кинематика точки. Лекция 5
Кинематика точки. Лекция 5 Влияние радиации на человека Презентация ученицы 11 класса «Б» ГОУ ЦО №548 «Царицыно» Корсаковой Маргариты
Влияние радиации на человека Презентация ученицы 11 класса «Б» ГОУ ЦО №548 «Царицыно» Корсаковой Маргариты  Использование оборудования центра образования технологической направленностей Точка роста при изучении физики
Использование оборудования центра образования технологической направленностей Точка роста при изучении физики Мирное применение ядерной энергии
Мирное применение ядерной энергии