Содержание
- 2. ТРЕБОВАНИЯ К КОМПАКТНЫМ МОДЕЛЯМ 1. Общие требования 1.1. Возможность настройки модели на широкий спектр геометрических форм
- 3. ТРЕБОВАНИЯ К КОМПАКТНЫМ МОДЕЛЯМ 4. Требования к параметрам 4.1. Общее количество параметров должно быть минимальным. 4.2.
- 4. Модель уровней 1 - 3 Модель первого уровня (Level=1) основана на модели Шихмана-Ходжеса, которая представляет модифицированную
- 5. Полевой транзистор с управляющим p-n переходом Конструкция интегрального транзистора с управляющим p-n переходом Эквивалентная схема транзистора
- 6. Полевой транзистор с управляющим p-n переходом Эквивалентная электрическая схема интегрального p-ПТП с учётом влияния подложки Малосигнальная
- 7. Параметры модели транзистора с управляющим p-n переходом
- 8. Ток стока транзистора с управляющим p-n переходом Ток стока:
- 9. Определение параметров из конструкции транзистора с управляющим p-n переходом Однозатворный транзистор: Многозатворный транзистор: a – половина
- 10. Подвижность электронов
- 11. Выходная вольт-амперная характеристика
- 12. Особенности модели 1. Модель Шихмана–Ходжеса неточна для интегральных ПТП, поскольку не учитывает влияния факторов: подпороговой области
- 13. Полевой транзистор с изолированным затвором параметры модели 1-го уровня
- 14. Полевой транзистор с изолированным затвором параметры модели 1-го уровня
- 15. Полевой транзистор с изолированным затвором Конструкция интегрального полевого транзистора с изолированным затвором Эквивалентная схема транзистора согласно
- 16. Ток стока транзистора с изолированным затвором Ток стока:
- 17. Определение параметров из конструкции транзистора с изолированным затвором
- 18. Определение параметров из конструкции транзистора с изолированным затвором
- 19. Модуляция длины канала
- 20. Модуляция длины канала Область пространственного заряда при нулевом смещении и напряжении питания: Встроенный потенциал:
- 21. Вольт-амперная характеристика
- 22. Модели BSIM BSIM – Berkeley Short-channel IGFET Model Все версии модели BSIM являются открытыми моделями (открытые
- 23. Эволюция моделей BSIM
- 24. Модели BSIM Количество моделей МОП транзисторов, существующих в настоящее время, превысило 100, что затрудняет взаимодействие разработчиков
- 25. МОП-транзистор Модель для большого уровня сигнала Модель для малого уровня сигнала
- 26. BSIM3v3 Модель позволяет учитывать следующие особенности: - эффекты короткого и узкого канала и их влияние на
- 27. BSIM3v3 Пороговое напряжение:
- 28. BSIM3v3 Ток стока:
- 29. BSIM3v3 Особенности моделирования емкостей: - в модели емкостей используется отдельно эффективная длина и ширина канала; для
- 30. BSIM3v3 Количество параметров: DC параметры: 61 C-V параметры: 27 NSQ параметры: 1 Геометрические параметры: 16 Температурные
- 31. МОП-транзистор Модель BSIM3 RF
- 32. LDMOS-транзистор
- 33. Модели для силовых МОП-транзисторов Lg: Индуктивность вывода и разварочной проволоки затвора. Rg; Внутреннее последовательное сопротивление затвора
- 34. Измерения на пластине
- 35. Измерения на пластине Yприбор= Yобщее – Yх.х. Извлечение из схемы на холостом ходе Yприбор/х.х. = Yобщее
- 36. Паразитные параметры
- 37. Полевой транзистор с барьером Шоттки Модель Куртиса
- 38. Полевой транзистор с барьером Шоттки Модель Статса Ток затвора: Ток стока:
- 39. Формальные модели В отличие от физических, формальные модели строятся на основе формального сходства между поведением модели
- 40. Модель Ангелова Транзистор с высокой подвижностью электронов
- 41. Транзистор с высокой подвижностью электронов
- 42. Транзистор с высокой подвижностью электронов
- 43. Транзистор с высокой подвижностью электронов
- 44. Гетеробиполярный транзистор Ток базы: Ток коллектора:
- 46. Скачать презентацию













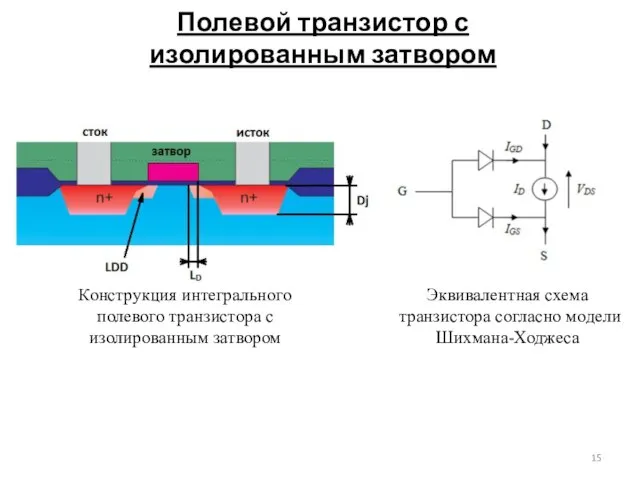



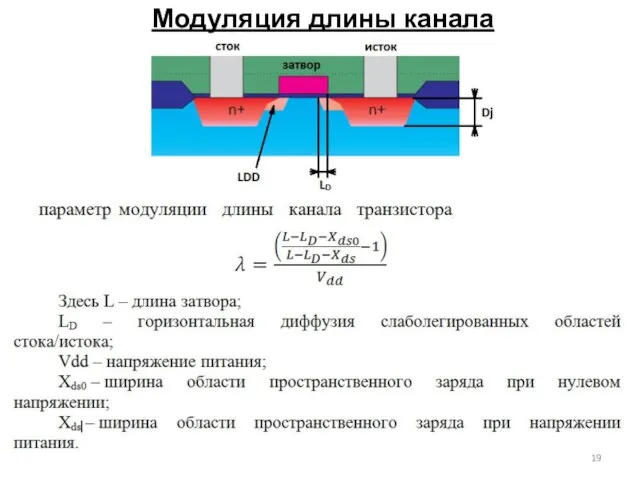



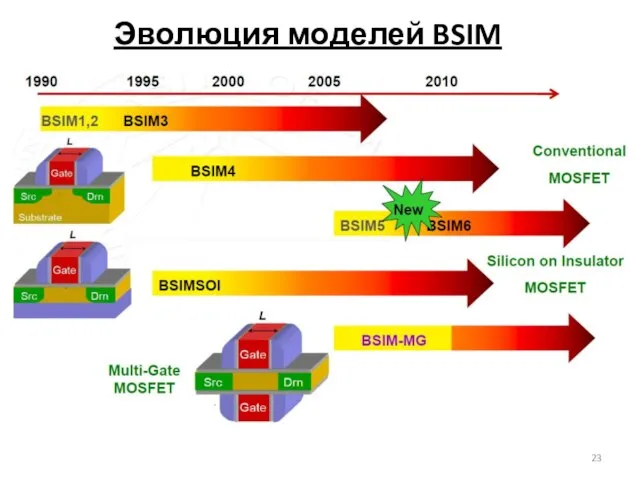

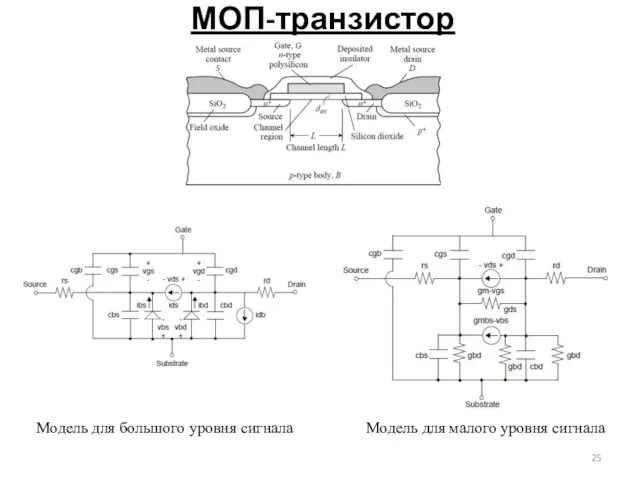





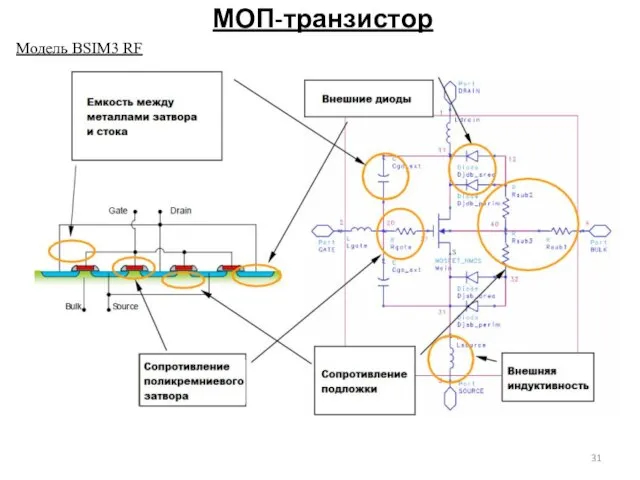
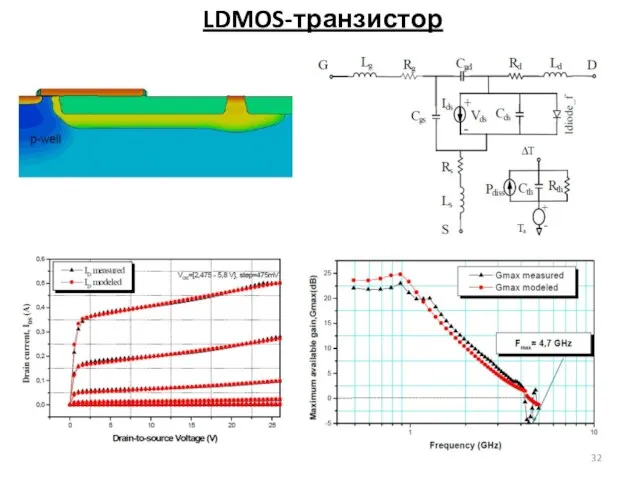




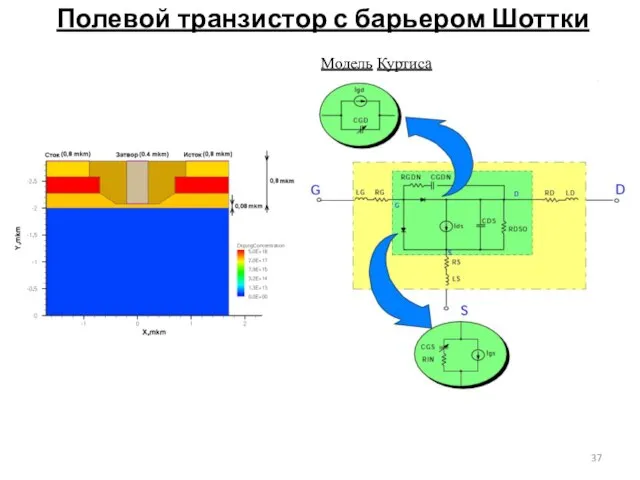







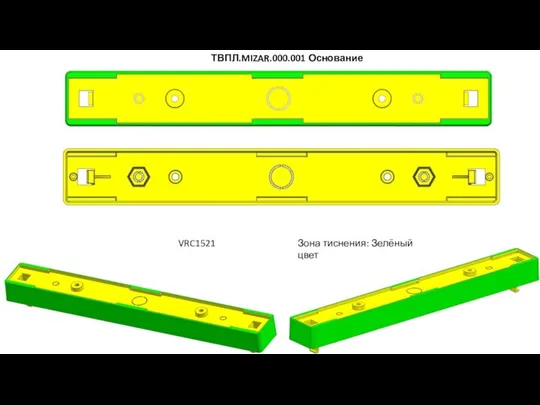 Зоны тиснения
Зоны тиснения Пейзаж родного края
Пейзаж родного края Образец клейма 2 (1)
Образец клейма 2 (1) 20161031_vologodskoe_maslodelanie
20161031_vologodskoe_maslodelanie za-hl-375-degrees-of-comparison-powerpoint_ver_2
za-hl-375-degrees-of-comparison-powerpoint_ver_2 Аддитивные технологии
Аддитивные технологии Железобетон в условиях высоких температур
Железобетон в условиях высоких температур Реконструкция прочностных свойств породы в процессе бурения
Реконструкция прочностных свойств породы в процессе бурения Отчет по производственной практике
Отчет по производственной практике Фото-кастинги. Summer program
Фото-кастинги. Summer program Организация предприятия по возделыванию люпина
Организация предприятия по возделыванию люпина Энергетическое обеспечение нашего дома
Энергетическое обеспечение нашего дома Термография в полиграфии
Термография в полиграфии 20141218_prezentatsiya_k_uroku
20141218_prezentatsiya_k_uroku Uczynki miłosierne względem ciała
Uczynki miłosierne względem ciała Заправка и обнуление картриджа Xerox WC 3119
Заправка и обнуление картриджа Xerox WC 3119 комикс
комикс 20150215_krupin_-_prezentatsiya_finalnaya_chast_2ya
20150215_krupin_-_prezentatsiya_finalnaya_chast_2ya Местоимение
Местоимение Кафедра специального (коррекционного) и инклюзивного образования
Кафедра специального (коррекционного) и инклюзивного образования Презентация август 2022
Презентация август 2022 Планирование, прогнозирование. Организация работ
Планирование, прогнозирование. Организация работ Санаторно-курортный центр ваш курорт
Санаторно-курортный центр ваш курорт Чарльз Дарвин
Чарльз Дарвин Современные методы повышения технических характеристик бетонов
Современные методы повышения технических характеристик бетонов Маршрут №20. Полюстрово
Маршрут №20. Полюстрово 20171114_5
20171114_5 Транспортно-планировочная организация города
Транспортно-планировочная организация города