Содержание
- 2. Общие сведения метода Магнетронное распыление — технология нанесения тонких плёнок на подложку с помощью катодного распыления
- 3. Технологическая установка Вакуумный универсиалный пост ВУП-5 Пленки были получены методом магнетронного распыления. В ходе эксперимента использовались
- 4. Используемые оборудования в ходе экспериментов Блок питания постоянного тока модели ADL-03Z040 Контроллер расхода газа MCV-500SCCM-D Вакуумметр
- 5. Рисунок 1 – Схема технологии двух магнетронной системы 1,12 – магниты; 2,13 – аноды; 3,14 –
- 6. Схема проведения экспериментов по получению углеродных пленок Напыления углерода на кремний Напыления углерода на кремний с
- 7. Процесс напыления углерода на кремниевую подложку
- 8. Напыления углерода на кремний Напыления проводилось в атмосфере Аr+H2(40%) и рабочая давления на камере составило 1*10-2
- 9. Процесс напыления углерода на кремния с буферным слоем меди
- 10. Напыления углерода на кремний с буферным слоем меди Напыления проводилось в атмосфере Аr+H2(40%) и робочие давление
- 11. Молекулалы-сәулелі эпитаксия әдісі Молекулалық-сәулелік эпитаксия (MBE – Molecular Beam Epitaxy) – бұл жоғарғы вакуум жағдайында материалдарды
- 12. MBE қондырғысының бойындағы келесі өсу аймағына кіретінэлементарлық үдерістер (7 суретте): • Адсорбция (жабысқақ) төсенішке атомдар мен
- 13. 1 – төсеніш, 2 –қабыршақ, 3 – қалқалағыштар, 4 – негізгі компонентті эффузиондық ұяшықтар, 5 -
- 15. Скачать презентацию


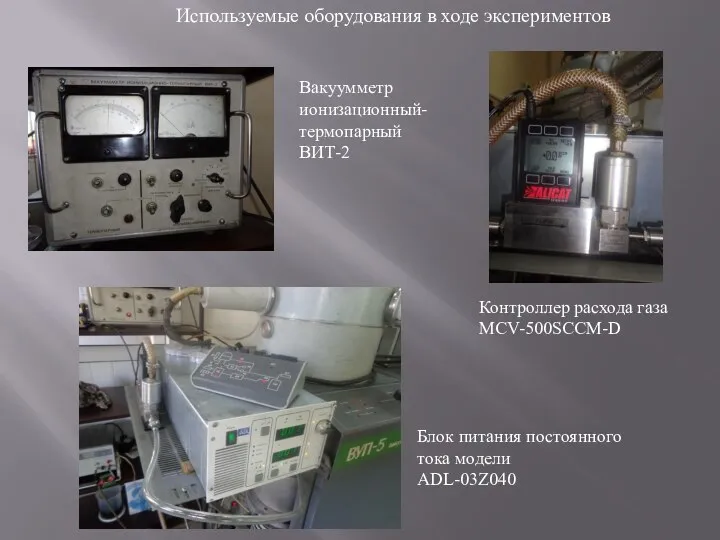








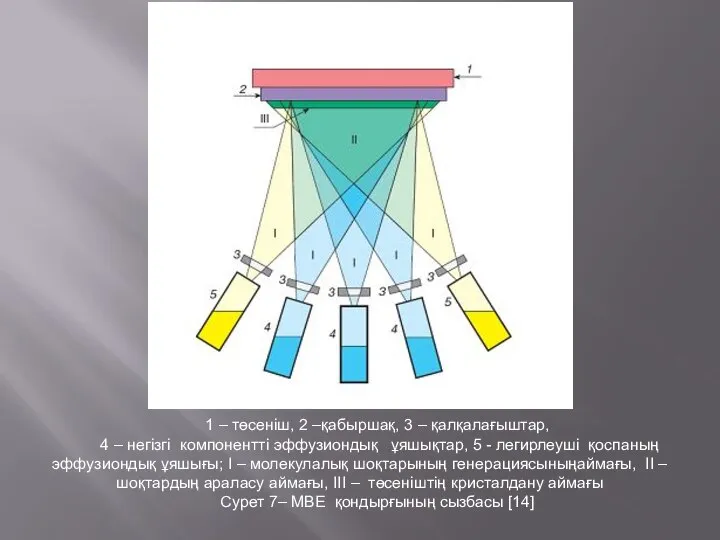
 Поиски и разведка полезных ископаемых
Поиски и разведка полезных ископаемых Певческие голоса
Певческие голоса Белье, его виды и назначение
Белье, его виды и назначение Соединение деталей из древесины клеем
Соединение деталей из древесины клеем Пансионат Ногинский. Фотоотчет о праздничном концерте юных волонтеров
Пансионат Ногинский. Фотоотчет о праздничном концерте юных волонтеров 20150202_rodina
20150202_rodina Первое послание к Коринфянам апостола Павла. Толкование
Первое послание к Коринфянам апостола Павла. Толкование 20120520_otech._voyna_1812__chast2a
20120520_otech._voyna_1812__chast2a New DA
New DA 20140514_khud_kultura_i_byt_rossii_vtoroy_poloviny_19
20140514_khud_kultura_i_byt_rossii_vtoroy_poloviny_19 дворец
дворец Ремонт автомобильной дороги и тротуара
Ремонт автомобильной дороги и тротуара Праздничная игра, посвящённая дню Наума – грамотника
Праздничная игра, посвящённая дню Наума – грамотника Фотоальбом
Фотоальбом Технология обработки деталей лезвием
Технология обработки деталей лезвием Issledovatelskaya
Issledovatelskaya Ватикан
Ватикан шаблон 23 февраля
шаблон 23 февраля Батыс Қазақстан облысы өнеркәсібі
Батыс Қазақстан облысы өнеркәсібі Обо мне. Шарова Надежда Дмитриевна
Обо мне. Шарова Надежда Дмитриевна Сварные соединения (неразьёмные, выполненные сваркой)
Сварные соединения (неразьёмные, выполненные сваркой) Ваш надежный партнер
Ваш надежный партнер С юбилеем! Фотоальбом Мухаметзянов И.В
С юбилеем! Фотоальбом Мухаметзянов И.В Input / Output Devices
Input / Output Devices Базовые логические элементы цифровых микросхем
Базовые логические элементы цифровых микросхем PET, chall 2, p.70, chores, gadgets+will, going to
PET, chall 2, p.70, chores, gadgets+will, going to ООО Группа компании Сокол
ООО Группа компании Сокол КП санузел 1
КП санузел 1