Содержание
- 2. КМОП - структура
- 3. Варианты КМОП структур
- 4. Выбор кармана КМОП - структуры
- 5. Влияние температуры и среды на перераспределение примеси при окислении кремния (N в кремнии/N в оксиде) Коэффициент
- 6. Инверсионный канал по краю кармана р-типа [2] 1018 1017 1016 Латеральная диффузия бора Рабочая область транзистора
- 7. Зависимость подвижности от электрического поля, легирования и температуры
- 8. Зависимость подвижности носителей от концентрации примеси
- 9. Пороговое напряжение МОП-транзистора
- 10. Выбор кармана КМОП - структуры
- 11. Карманы в КМОП структуре Однокарманный вариант Двухкарманный вариант
- 12. Выбор кармана КМОП - структуры
- 13. Подгонка порогового напряжения в двухкарманной КМОП-структуре Uп п-канал +1В +0,5В 0В Uп п-канал +1В +0,5В 0В
- 14. Подгонка порогового напряжения в двухкарманной КМОП-структуре Uп п-канал +1В +0,5В 0В Uп п-канал +1В +0,5В 0В
- 15. Возникает ли инверсный канал по периферии р-кармана в случае двухкарманной технологии? 1018 1017 1016 Латеральная диффузия
- 16. Токи утечки в двухкарманной КМОП структуре
- 18. Преимущества р+- р подложки 1. Улучшение качества полупроводника 2. Уменьшение потока неосновных носителей из подложки в
- 19. Выращивание слитка кремния по методу Чохральского С - 1016 см-3 О – 1018 см-3 SiO +
- 20. Зависимость концентрации кислорода в кремнии от диаметра слитка
- 21. Дефекты кремния, вызванные преципитацией кислорода
- 22. Дефекты слитка кремния, вызванные преципитацией кислорода
- 23. Геттерирование примесей на границе раздела пленка-подложка
- 24. Зависимость подвижности носителей от концентрации носителей и ориентации подложки [4] Подвижность электронов, см2/Вс Подвижность дырок, см2/Вс
- 25. Создание КМОП структуры на гибридно-ориентированной подложке [4] Стадия 1. Окисление рабочего слоя монокремния на КНИ-пластине осаждение
- 26. Механизм гидрофобного сращивания HF (газ)
- 27. Формирование гибридно-ориентированной подложки методом аморфизации и рекристаллизации кремния Эпитаксия кремния + осаждение нитрида + фотолитография Аморфмзация
- 28. Конструкция и проблемы формирования наноразмерной КМОП структуры [1] Составной затвор: - разные величины работы выхода для
- 29. Эффект защелкивания в КМОП структуре [ 1 ]
- 30. Эффект защелкивания в КМОП структуре
- 31. КНИ КМОП структура [2]
- 32. КМОП-структура на основе КНС
- 33. Недостатки КНС - структуры 106 102 Кремний Сапфир ( Al2 O3 Nд см-2 толщина пленки кремния
- 34. Улучшение КНС - структуры Гетероэпитаксия Аморфизация ТО (11000С) - рекристаллизация и окисление кремния Аморфизация лишь дефектного
- 35. РЭМ - фото границы раздела КНС - структуры до и после рекристаллизации До рекристаллизации После рекоисталлизации
- 36. КНИ -структура
- 37. Преимущества КНИ КМОП структуры Резкое уменьшение ёмкостей стока и истока на подложку Уменьшенный эффект подложки при
- 38. Уменьшение емкости сток/исток - подложка
- 39. Уменьшение емкости сток/исток - подложка
- 40. Увеличение быстродействия и уменьшение потребляемой мощности ИС ЗУ в случае КНИ структуры
- 41. Увеличение порогового напряжения МОП-транзистора при последовательном соединении для объёмных КМОП ИС.
- 42. Образование электрон-дырочных пар при облучении полупроводниковой структуры
- 43. Повышение радиационной стойкости КНИ КМОП ИС
- 44. Температурная зависимость тока утечки КНИ и объемного МОП-транзисторов
- 45. Сращивание окисленных кремниевых пластин [2] Исходные структуры Термокомпрессия (бондинг) Утонение рабочего слоя
- 46. Бондинг-метод
- 47. Поверхность окисленной пластины кремния
- 48. Механизм гидрофильного бондинга
- 49. Механизм гидрофильного сращивания 2 H2O Si–OH + OH–Si Si–O–Si+H2O
- 50. Механизм гидрофильного сращивания H2 O
- 51. Метод сращивания со стоп-слоем [2] Vтр n+ = 10 Vтр n Подложка Эпитаксия кремния Бондинг Окисление
- 52. Smart-cut - метод сращивания пластин кремния
- 53. Smart-cut - метод сращивания пластин кремния [2] Окисление кремния Ионная имплантация водорода Бондинг низкотемпературный Образование пузырьков
- 54. Образование пузырьков водорода
- 55. Механизм газового расщепления Оксид кремния
- 56. ПЭМ изображение скрытого дефектного слоя (а) после облучения, (б); после предварительного отжига при 350 9C ;
- 57. Влияние пыли на ионную имплантацию водорода
- 58. ПЭМ –изображение КНИ – структуры перед расщеплением Заглубленный слой окисла (а) и отшелушивание части его в
- 59. Зависимость прочности сращивания от зазора между пластинами при бондинге 1 – предельная прочность кремния на растяжение
- 60. Формирование КНИ структуры методом имплантации кислорода ( SIMOX) [2] Исходная пдастина кремния Ионная имплантацитя кислорода Темообработка
- 61. Микрофотография косого шлифа первой SIMOX структуры (1976 год) Ток ионного пучка - 100 мкА, для облучения
- 62. Факторы, влияющие на параметры КНИ-структуры Доза ионов более 1018 см-2 Температура при облучении более 4000С Плотность
- 63. Изменение распределения кислорода в процессе термообработки после имплантации (шнурование)
- 64. Влияние искусственных центров преципитации на распределение кислорода – «шнурование»
- 65. Поперечное сечение структур КНИ SIMOX, полученное с помощью ПЭМ а) Сразу же после имплантации; б) после
- 66. Структура ITOX–SIMOX подложки на различных стадиях технологии а) ИИ кислорода: 180 кэВ, 3–4,5 1017 ион/см2 ,
- 67. ПЭМ–изображения поперечного сечения КНИ ITOX–SIMOX - структуры а) сразу после имплантации; б) после отжига при 13500C;
- 68. АСМ изображения поверхности кремния и границы раздела КНИ структур ITOX–SIMOX.
- 69. Трехмерная интегральная схема на основе КНИ - структуры Бондинг и SIMOX не применимы из-за высокотемпературных обработок!
- 70. Трехмерная КМОП –структура этажерочного типа
- 71. Трехмерная КМОП – структура мезонинного типа
- 72. ZMR - процесс Поликремний Оксид кремния Кремний Лазерный луч Монокристалл Жидкая зона Монокристалл Поликремний Скорость движения
- 73. Проблемы ZMR Кристаллографические дефекты вследствие взаимодействия лазерного луча с кремнием Изменение оптических свойств кремния в процессе
- 74. Требования к источнику лазерного излучения Мощность излучения - более 20 Вт/см2 Длина волны излучения - менее
- 75. Косвенный лазерный нагрев (КЛН) Антиотражающее покрытие Молибден Оксид кремния Поликремний Оксид кремния Кремниевая монокристаллическая подложка Луч
- 76. Структура пленки кремния после рекристаллизации Крупноблочная структура Поликреминй Направление движения луча лазера
- 77. Конфигурации островков из поликремния
- 78. Влияние направления движения лазера на равномерность толщины пленки кремния
- 79. Результат ZMR обработки пленки поликремния Поликремний Крупноблочная структура Островок монокристалл кремнияа Направление движения луча лазера
- 80. КНИ МОП - транзистор, сформированный ZMR - процессом
- 81. Трехмерная КНИ КМОП ИС преобразователя сигналов (106 транзисторов 2 уровня ,МИЭТ 1987 г )
- 82. Токовые потоки в КНИ МОП транзисторе A- нормальный верхний кана,, B – нижний канал C -
- 83. Биполярный эффект в КНИ МОП транзисторе
- 84. Принцип работы полевого транзистора ( из патента Лилиенфельда, 1926 год )
- 85. Принцип работы беспереходного ( БПТ) КНИ МОП - транзистора
- 86. Изменение области обеднения в БПТ
- 87. Микрофотографии КНИ МОП БПТ
- 88. Области канала в инверсионном и БП транзисторах
- 89. Подвижность носителей в разных областях инверсионного и БП транзисторов
- 90. Зависимость подвижности электронов от концентрации примеси в кремнии
- 91. «Нанопроволочный» КНИ МОП БПТ
- 92. «Нанопроволочный» КНИ МОП БПТ
- 93. Конструкция и проблемы формирования наноразмерной КМОП структуры [1] Составной затвор: - разные величины работы выхода для
- 94. Мелкая щелевая изоляция - ограниченные литографией размеры - независимость ширины от глубины - малая электрическая емкость
- 95. Неоднородно легированный канал - подавление короткоканальных эффектов - гало-области для подавления спада Vп при уменьшении Lк
- 96. Подзатворный диэлектрик - очень тонкий для подавления короткоканальных эффектов и увеличения тока стока - ограничения: плотность
- 97. Составной затвор - разные величины работы выхода для затворов n- или p- типов - низкое поверхностное
- 99. Скачать презентацию




![Инверсионный канал по краю кармана р-типа [2] 1018 1017 1016 Латеральная](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-5.jpg)

















![Зависимость подвижности носителей от концентрации носителей и ориентации подложки [4] Подвижность электронов, см2/Вс Подвижность дырок, см2/Вс](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-23.jpg)
![Создание КМОП структуры на гибридно-ориентированной подложке [4] Стадия 1. Окисление рабочего](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-24.jpg)


![Конструкция и проблемы формирования наноразмерной КМОП структуры [1] Составной затвор: -](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-27.jpg)
![Эффект защелкивания в КМОП структуре [ 1 ]](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-28.jpg)

![КНИ КМОП структура [2]](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-30.jpg)






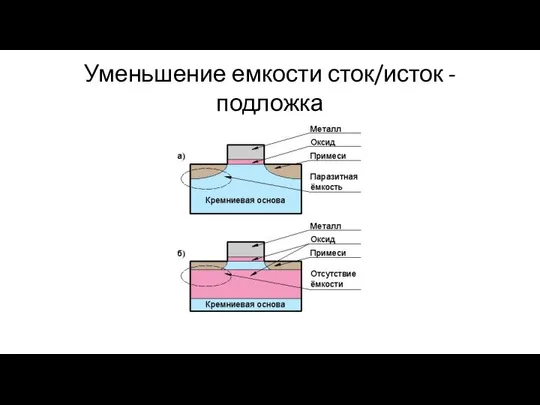






![Сращивание окисленных кремниевых пластин [2] Исходные структуры Термокомпрессия (бондинг) Утонение рабочего слоя](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-44.jpg)





![Метод сращивания со стоп-слоем [2] Vтр n+ = 10 Vтр n](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-50.jpg)

![Smart-cut - метод сращивания пластин кремния [2] Окисление кремния Ионная имплантация](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-52.jpg)






![Формирование КНИ структуры методом имплантации кислорода ( SIMOX) [2] Исходная пдастина](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-59.jpg)






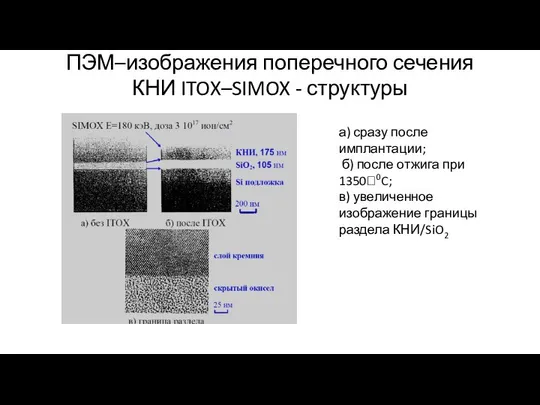











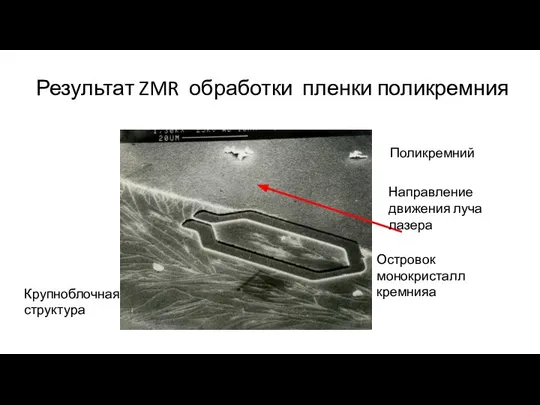








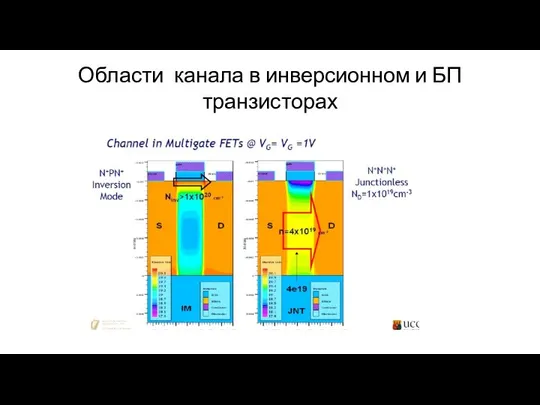
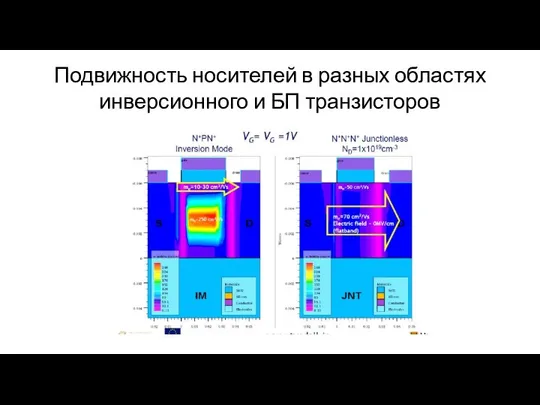


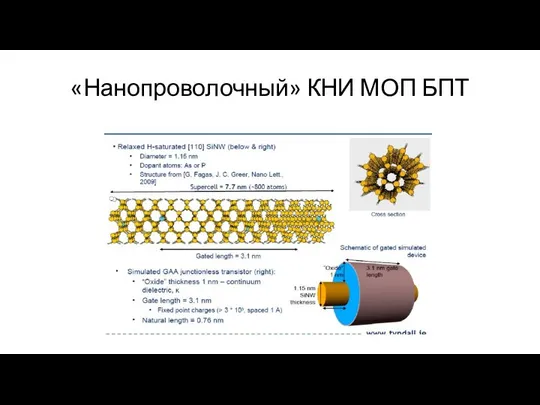
![Конструкция и проблемы формирования наноразмерной КМОП структуры [1] Составной затвор: -](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1473442/slide-92.jpg)




 Студенческий хоккей в США
Студенческий хоккей в США Топ 10 посещаемых мною сайтов
Топ 10 посещаемых мною сайтов эксперимент в исследовании
эксперимент в исследовании  Введение во Храм Пресвятой Богородицы. Гимнография
Введение во Храм Пресвятой Богородицы. Гимнография Йорн Утзон
Йорн Утзон Моделирование
Моделирование Право на труд. Трудовые правоотношения
Право на труд. Трудовые правоотношения Основы распространения радиоволн и антенно- фидерные устройства
Основы распространения радиоволн и антенно- фидерные устройства ТЕМА БИОХИМИЯ ПЕЧЕНИ ЖЕЛТУХИ
ТЕМА БИОХИМИЯ ПЕЧЕНИ ЖЕЛТУХИ Экскурсия в музей «Усадьба средневекового рушанина»
Экскурсия в музей «Усадьба средневекового рушанина» Информационное обеспечение контрактной системы в сфере закупок продукции для государственных и муниципальных нужд
Информационное обеспечение контрактной системы в сфере закупок продукции для государственных и муниципальных нужд Простагландины
Простагландины Модель гостеприимства
Модель гостеприимства Аттестационная работа. Туризм и здоровье. Виды туризма
Аттестационная работа. Туризм и здоровье. Виды туризма Производная функции
Производная функции Қазақстанның халықаралық ұйымдарға мүше болуы
Қазақстанның халықаралық ұйымдарға мүше болуы Разработка конфигурации «Склад стройматериалов»
Разработка конфигурации «Склад стройматериалов» Технологии регистрации заряженных частиц, сбор и анализ данных детекторов в ФВЭ. VMM. (Лекция 5)
Технологии регистрации заряженных частиц, сбор и анализ данных детекторов в ФВЭ. VMM. (Лекция 5) Основы гистологии. Растительная клетка.
Основы гистологии. Растительная клетка. Формирование базисных стратегий продукта. Тема 2
Формирование базисных стратегий продукта. Тема 2 Содержание пушных зверей
Содержание пушных зверей Правила гри в баскетбол
Правила гри в баскетбол Лихорадка Эбола и Марбурга
Лихорадка Эбола и Марбурга Билл Скарсгард
Билл Скарсгард  Антидемпинговые меры Работу выполнили Пустовая Анастасия, Мятлик Елена, Ю103
Антидемпинговые меры Работу выполнили Пустовая Анастасия, Мятлик Елена, Ю103 Франция в XIX-XXвв
Франция в XIX-XXвв  Работы нулевого цикла
Работы нулевого цикла Тема занятия Ожоги и обморожения
Тема занятия Ожоги и обморожения