Содержание
- 2. Барьер на границе металла с полупроводником (барьер Шоттки)
- 3. Работа выхода равна разности между энергией покоящегося электрона в вакууме у поверхности образца полупроводника и уровнем
- 4. Контакт металл-полупроводник
- 5. Контакт металл-полупроводник
- 6. Контакт металл-собственный полупроводник
- 7. Контакт металл-электронный полупроводник
- 8. Контакт металл-дырочный полупроводник
- 9. Без смещения:
- 10. Со смещением:
- 11. Сила изображения
- 12. Сила изображения Если теперь вблизи границы раздела металл – вакуум имеется электрическое поле , то выражение
- 13. Граница металл-полупроводник при приложении электрического поля (барьер для электрона)
- 14. Граница металл-полупроводник при приложении электрического поля (барьер для электрона) Эта функция имеет максимум в точке хm.
- 15. Прямое и обратное смещение перехода металл-полупроводник
- 16. Важно подчеркнуть, что внешнее напряжение может только выпрямить границы разрешенных зон . Другими словами, при приложении
- 18. Расчет ВАХ барьера Шоттки При приложении напряжения: где - Постоянная Ричардсона
- 19. ВАХ диода Шоттки
- 20. Диод Шоттки
- 21. Диод Шоттки
- 22. ДШ характеризуются быстрой рекомбинацией инжектированных носителей (время жизни носителей крайне мало), а значит и высоким быстродействием.
- 25. Контакт электронного и дырочного полупроводников
- 26. Возникновение потенциального барьера. Контактная разность потенциалов
- 27. Контакт электронного и дырочного полупроводников
- 30. Образование p-n-перехода
- 31. Перераспределение носителей, образовавшееся при контакте, и формирование потенциального барьера высотой приводит к тому, что диффузионный поток
- 32. Для того чтобы рассчитать распределения концентраций свободных носителей в приповерхностной области необходимо решить уравнение Пуассона, устанавливающее
- 33. Решение уравнения Пуассона
- 34. Толщина ОПЗ
- 35. Чем выше степень легирования n- и p-областей полупроводника, тем меньше толщина ОПЗ. Если одна из областей
- 36. Определение контактной разности потенциалов
- 37. Потенциальный барьер в pn-переходе тем выше, чем сильнее легированы p- и n-области. По мере роста температуры
- 38. Связь концентрации носителей с
- 39. Рассмотрим теперь pn-переход, к которому приложено прямое смещение Vсм (минус батареи к n-типу, плюс – к
- 40. Понижение потенциального барьера приводит к увеличению потока основных носителей заряда по сравнению с равновесным состоянием. Под
- 41. Распределение носителей заряда вблизи перехода а)
- 42. Введение в полупроводник носителей заряда с помощью pn-перехода при подаче на него прямого смещения в область,
- 43. Для ее нахождения в стационарном случае на границе с ОПЗ (при ) нужно вместо использовать значение
- 44. Распределение неосновных носителей в базе
- 45. Аналогичные явления происходят в p-области: сюда из n- области инжектируются электроны и концентрация избыточных электронов при
- 46. Если к pn-переходу приложено обратное смещение (минус батареи к p-типу, плюс – к n-типу), потенциальный барьер
- 47. Чем сильнее переход смещен в обратном направлении, тем выше потенциальный барьер, и тем меньшее количество основных
- 48. Таким образом, при обратном смещении pn-перехода ток основных носителей заряда будет меньше, чем при равновесном состоянии,
- 49. Прямое смещение p-n-перехода
- 51. Идеальная МДП–структура Если на окисел, покрывающий поверхность кристалла, нанести металлический электрод (затвор), то, изменяя его потенциал
- 52. МДП-структура
- 53. МДП-структура
- 54. На границе металл-диэлектрик, диэлектрик-полупроводник, а в отсутствии диэлектрика на границе металл-полупроводник возникает контактная разность потенциалов:
- 55. Обогащение n-тип
- 56. Обеднение n-тип p-тип
- 57. Инверсия n-тип p-тип
- 58. Допущения для «идеальной» МДП-структуры Разность работ выхода между металлом затвора и диэлектриком, диэлектриком и полупроводником, равна
- 59. МДП-структура
- 60. Для характеристики изгиба будем использовать понятие поверхностного потенциала φs
- 61. Расчет параметров
- 62. К расчету МДП-структуры (4.6) (4.7) (4.8) (4.9) (4.10) (4.11) (4.12)
- 63. Емкость барьера Шоттки
- 64. Емкость p-n–перехода
- 65. Диффузионная емкость pn-перехода
- 66. Емкость МДП-структуры
- 68. С-V-характеристики идеальной МДП-структуры
- 70. Скачать презентацию


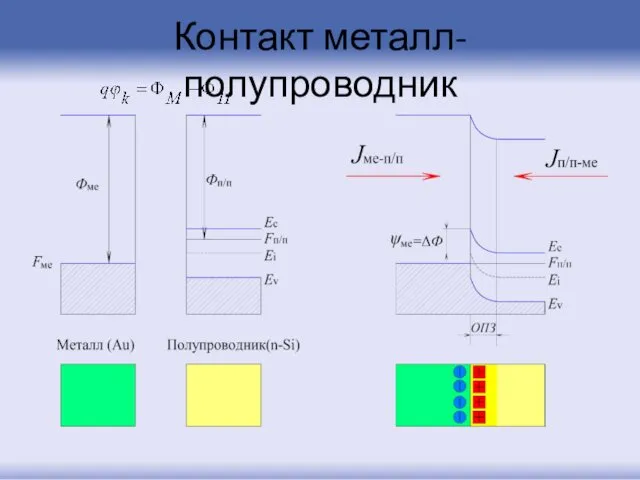
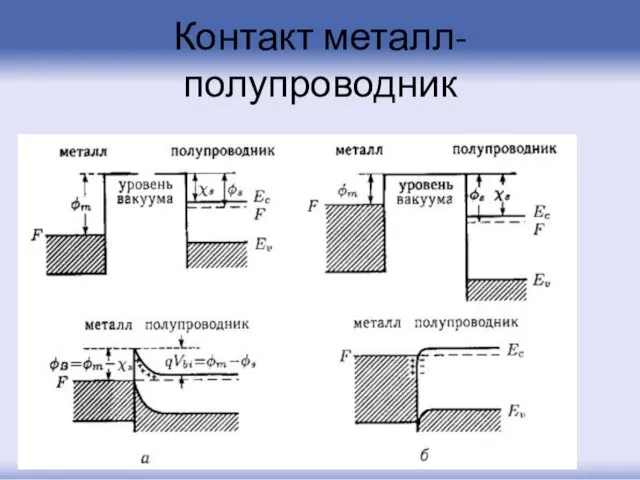


















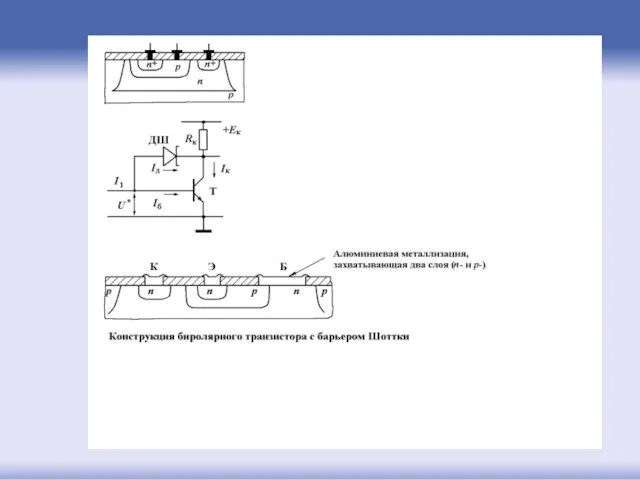

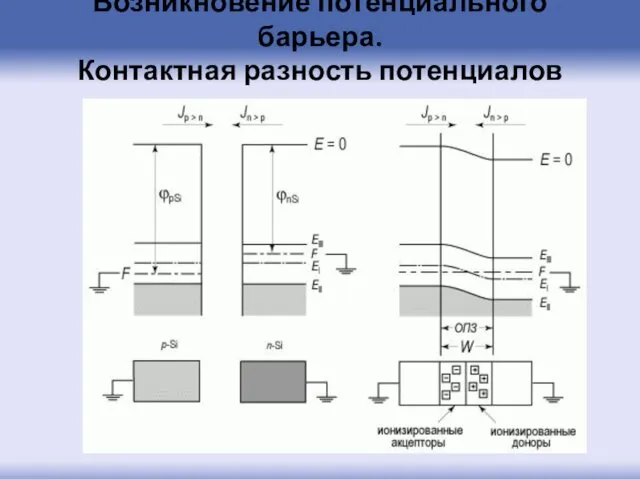


























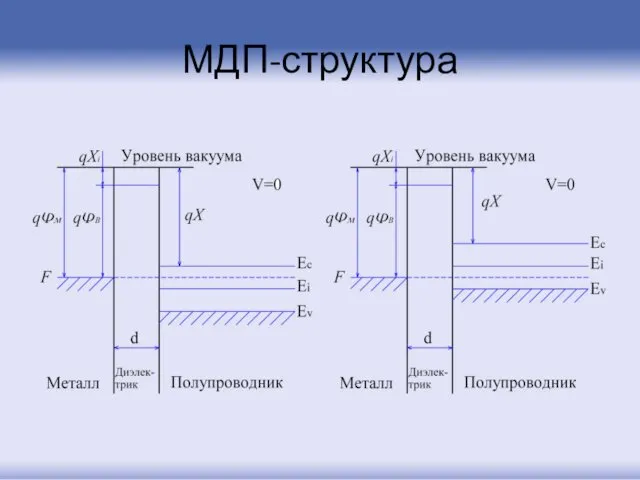

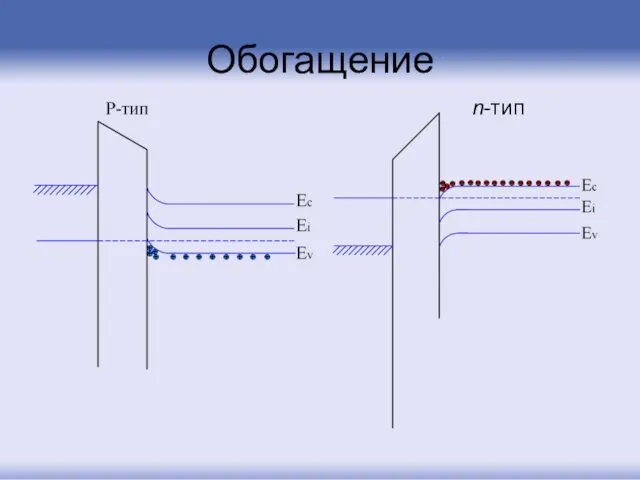
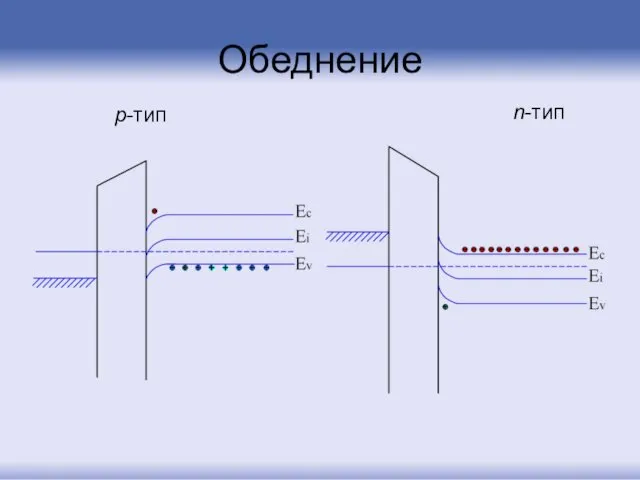


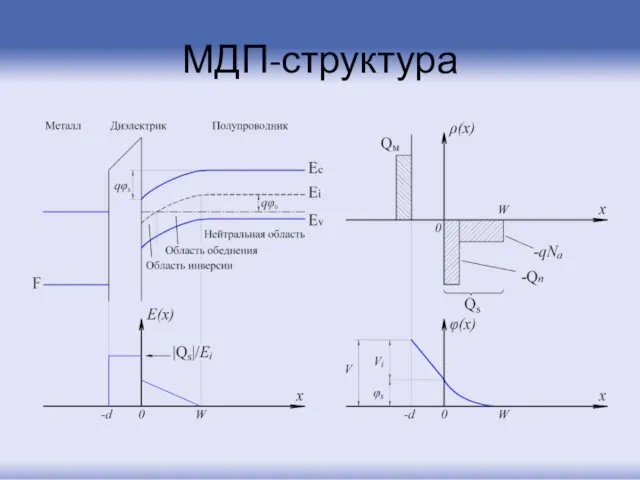






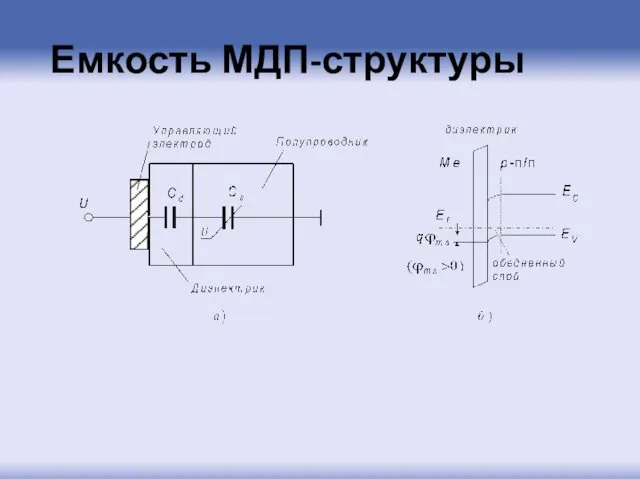


 Мгновенные источники тепла
Мгновенные источники тепла Взаимодействие гамма-излучения с веществом
Взаимодействие гамма-излучения с веществом Оптические приборы
Оптические приборы Радиоактивное загрязнение территории
Радиоактивное загрязнение территории Открытие и применение закона всемирного тяготения
Открытие и применение закона всемирного тяготения Равновесие тел урок физики, 10 класс
Равновесие тел урок физики, 10 класс Структура и спектрально-люминесцентные характеристики керамики Y2O3:Er
Структура и спектрально-люминесцентные характеристики керамики Y2O3:Er Движение по окружности
Движение по окружности Волны Эллиотта
Волны Эллиотта Аттестационная работа. Использование конструктора LEGO. Технология и физика во внеурочной деятельности
Аттестационная работа. Использование конструктора LEGO. Технология и физика во внеурочной деятельности Линзы
Линзы Свойства электромагнитных излучений, спектр излучений, области их применения
Свойства электромагнитных излучений, спектр излучений, области их применения Звук
Звук Использование информационных технологий в школьном лабораторном эксперименте: определение ускорения свободного падения
Использование информационных технологий в школьном лабораторном эксперименте: определение ускорения свободного падения Динаміка матеріальної точки та поступального руху
Динаміка матеріальної точки та поступального руху Транспортные системы ОФ. Расчет пирамидального бункера
Транспортные системы ОФ. Расчет пирамидального бункера Простейшие движения твердых тел
Простейшие движения твердых тел Нейтронно-физические эксперименты в физике ядерных реакторов
Нейтронно-физические эксперименты в физике ядерных реакторов Биофизика и ее место в естествознании. Физическая сущность методов диагностики, применяемых в медицине и ветеринарии
Биофизика и ее место в естествознании. Физическая сущность методов диагностики, применяемых в медицине и ветеринарии Квантовая физика- раздел современной физики, в котором изучаются свойства, строение атомов и молекул, движение и взаимодействи
Квантовая физика- раздел современной физики, в котором изучаются свойства, строение атомов и молекул, движение и взаимодействи Решение задач. Подготовка к контрольной работе №8 по теме «Световые явления»
Решение задач. Подготовка к контрольной работе №8 по теме «Световые явления» Гравиметрия. Гравитационное поле
Гравиметрия. Гравитационное поле Властивості рідин. Поверхневий натяг
Властивості рідин. Поверхневий натяг  Термодинамикалық заң
Термодинамикалық заң Улучшение технико-экономичиских показателей при эксплуатации судовой энергетической установки
Улучшение технико-экономичиских показателей при эксплуатации судовой энергетической установки Принцип действия и КПД тепловых двигателей
Принцип действия и КПД тепловых двигателей Статика. «Дайте мне точку опоры, и я подниму Землю!»
Статика. «Дайте мне точку опоры, и я подниму Землю!» Материя и цвет. Свет
Материя и цвет. Свет