Содержание
- 2. Технология роста монокристаллов SiC 2
- 3. Политипы SiC Структурное упорядочение семейства естественных сверхрешеток SiC: вид упаковок А, В, С в пределах слоя;
- 4. Сублимация синтезированного SiC на затравку 4
- 5. Методы для достижения высокого удельного споротивления монокристаллов SiC: - высокотемпературное химическое осаждение из газовой фазы (метод
- 6. Развитие базовой технологии производства подложек SiC Блок-схема технологического маршрута 6
- 7. Круглая шлифовка монокристаллов 7 Станок круглой шлифовки 3У10 МСМ Диаметры, с которыми работаем: 50.8 мм 76.2
- 8. Установка рентгеновской ориентации 8 MTI EQ-DX 100 Точность ориентации:
- 9. Резка слитка на пластины 9 Станок многопроволочной резки Takatori MWS 45 SN Время процесса: 35 ÷
- 10. Изготовление фаски на подложках 10 Станок изготовления фаски TSK EP-3800 Edge Grinder Время процесса: от 1
- 11. Шлифовка и полировка подложек SiC 11 Станок двусторонней шлифовки/полировки: Peter Wolters AC470L Процесс шлифоки: Макс. загрузка
- 12. Химико-механическая полировка подложек 12 Станок ХМП SpeedFam GPAW 32 Атомарно-гладкая поверхность с шероховатостью 1÷2 Å
- 13. Финишная отмывка и упаковка 13 Каскад УЗ-ванн Центрифуга Вакуумный упаковщик
- 14. Участок метрики подложек SiC 14 Бесконтактное измерение толщины и прогиба Картографирование удельного сопротивления
- 15. Промышленная технология производства подложек SiC 15 Полный цикл изготовления подложек качества «epi-ready»: 1 месяц
- 16. Эпитаксиальный рост гетероструктур GaN на SiC: - метод газофазной эпитаксии из металл-органических соединений (MOCVD) в НТЦ
- 18. Скачать презентацию


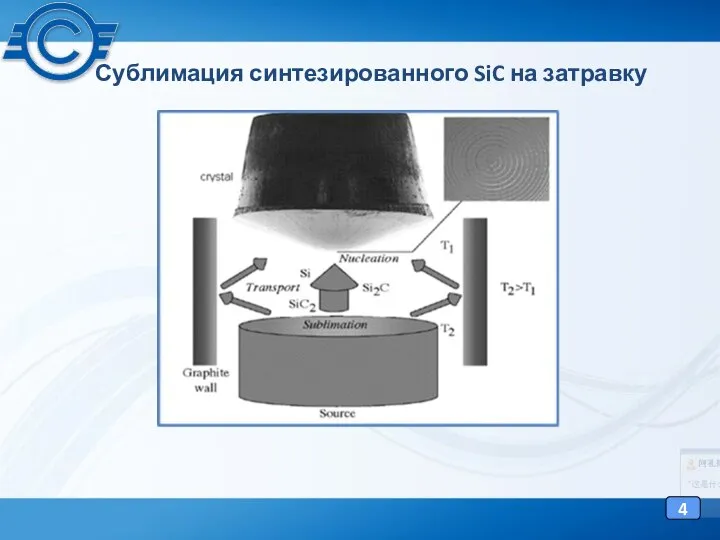





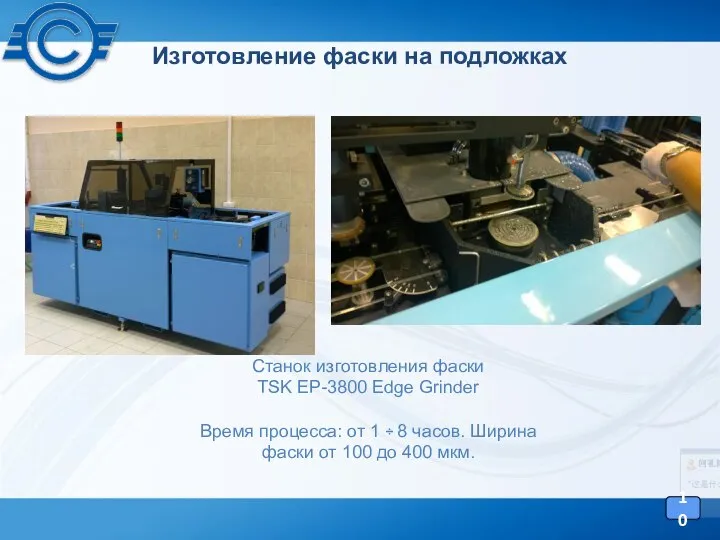


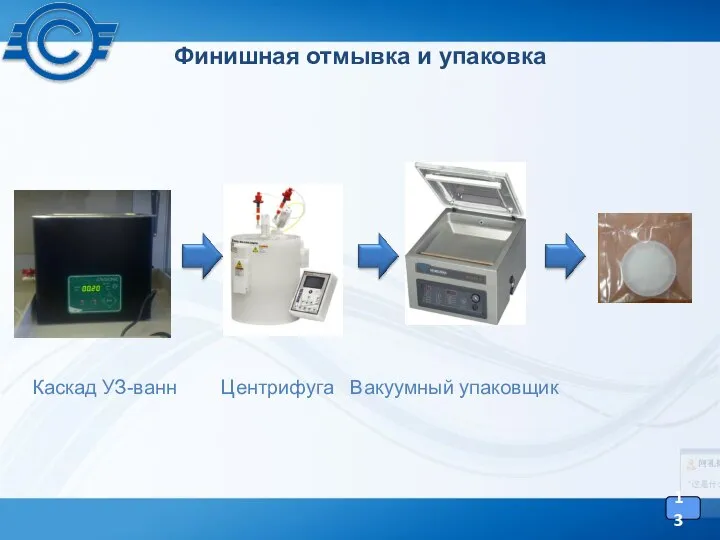



 Схемотехника комбинационных узлов
Схемотехника комбинационных узлов 2022-08-29 (7)
2022-08-29 (7) Дошк группа Инд занятия по ФП и РСЗВ 31.03
Дошк группа Инд занятия по ФП и РСЗВ 31.03 Парус Кёнигсбрег
Парус Кёнигсбрег Зимние загадки
Зимние загадки Шиверское, организация деятельности
Шиверское, организация деятельности Применения термически надежных (от перепада температур ) со скошенными торцами взрыво-вибро-устойчивых компрессоров
Применения термически надежных (от перепада температур ) со скошенными торцами взрыво-вибро-устойчивых компрессоров 20141221_kreshchenie_rusi_-_chast_2_0
20141221_kreshchenie_rusi_-_chast_2_0 Пожарные автомобили
Пожарные автомобили Православные праздники
Православные праздники Роль руководителя для оптимальных коммуникаций в проекте
Роль руководителя для оптимальных коммуникаций в проекте Жизнь в моём городе в прошлые времена (историческая тема в бытовом жанре)
Жизнь в моём городе в прошлые времена (историческая тема в бытовом жанре) Презентація1
Презентація1 Как придумать крутой заголовок (Даша)
Как придумать крутой заголовок (Даша) Шагнувшие в бессмертие…. Улица опаленной юности
Шагнувшие в бессмертие…. Улица опаленной юности Роль и значение стажёров в детском лагере
Роль и значение стажёров в детском лагере Строительство гнезд и их охрана
Строительство гнезд и их охрана 20131225_nenauchnoe_poznanieyusots.poznanie.10kl
20131225_nenauchnoe_poznanieyusots.poznanie.10kl Золотая осень
Золотая осень Уборочное оборудование
Уборочное оборудование Общественный транспорт на Бурнаковке. Итоги работы за 2017 год
Общественный транспорт на Бурнаковке. Итоги работы за 2017 год Выполнение теплотехнического расчета ограждающей конструкции стены
Выполнение теплотехнического расчета ограждающей конструкции стены 20170226_rifma
20170226_rifma Инструкция
Инструкция Резюме. Чайка Срегей Игоревич
Резюме. Чайка Срегей Игоревич Наименование учреждения
Наименование учреждения Cat
Cat Бойлеры Grunhelm
Бойлеры Grunhelm