Содержание
- 2. ЛАЗЕРНАЯ ТЕХНОЛОГИЯ ПОЛУПРОВОДНИКОВ. Уровень основных операций. Лазерное осаждение тонких пленок. Наибольшее развитие как с научной, так
- 3. Уровень основных операций. Лазерное осаждение тонких пленок. Схема установки для ЛВЭ. Лазерное излучение от импульсного лазера
- 4. Уровень основных операций. Лазерное осаждение тонких пленок. Для получения высококачественных лазерных конденсатов n-GaAs и n-InSb на
- 5. Уровень основных операций. Лазерное осаждение тонких пленок. Совмещенная технология GaAs/Si. На рисунке приведен пример реализации процесса
- 6. Уровень основных операций. Лазерное осаждение тонких пленок высокотемпературных сверхпроводников (ВТСП).
- 7. Уровень основных операций. Лазерное осаждение тонких ВТСП- пленок .
- 8. Уровень основных операций. Лазерное осаждение тонких ВТСП- пленок.
- 9. Уровень завершающих операций. Лазерное скрайбирование. Скрайбирование заключается в нанесении рисок на рабочую повepxность полупроводниковой пластины с
- 10. Уровень завершающих операций. Лазерное скрайбирование. Серийная установка для лазерного скрайбирования состоит из лазера, оптической системы для
- 11. Уровень завершающих операций. Маркировка. В настоящее время существуют два способа лазерной маркировки: сфокусированным пучком и широким
- 13. Скачать презентацию
ЛАЗЕРНАЯ ТЕХНОЛОГИЯ ПОЛУПРОВОДНИКОВ.
Уровень основных операций.
Лазерное осаждение тонких пленок.
Наибольшее развитие как с
ЛАЗЕРНАЯ ТЕХНОЛОГИЯ ПОЛУПРОВОДНИКОВ.
Уровень основных операций.
Лазерное осаждение тонких пленок.
Наибольшее развитие как с
при замене подложки из GaAs кремниевой подложкой могут быть преодолены проблемы, связанные с чрезвычайной хрупкостью GaAs;
поскольку теплопроводность кремния примерно в три раза большe теплопроводности GaAs, при выращивании пленок этого материала на кремниевых подложках возможно создание более мощных арсенид-галлиевых ИС, имеющих более высокую плотность размещения элементов;
следует ожидать значительного снижения стоимости полупроводниковых ИС, поскольку тонкие пленки GaAs выращиваются на подложках гораздо большего диаметра, чем диаметр существующих арсенид-галлиевых пластин, а при обработке кремниевых подложек используются целевые и широко распространенные методики;
появляется возможность разработки приборов новых типов, сочетающих структуры, изготовленные в слое арсенида галлия, и структуры, расположенные в кремниевой подложке, например, возможность объединения на единой подложке элементов интегральной оптики (на основе GaAs) и элементов микроэлектроники (на основе Si)..
Уровень основных операций.
Лазерное осаждение тонких пленок.
Схема установки для ЛВЭ. Лазерное излучение
Уровень основных операций.
Лазерное осаждение тонких пленок.
Схема установки для ЛВЭ. Лазерное излучение
Уровень основных операций.
Лазерное осаждение тонких пленок.
Для получения высококачественных лазерных конденсатов n-GaAs
Уровень основных операций.
Лазерное осаждение тонких пленок.
Для получения высококачественных лазерных конденсатов n-GaAs
Высокоэнергетичные ионы из пароплазменного потока осуществляют распыление окисного слоя, создавая в нем окна размером 1-10 нм. Нa участках очищенной поверхности начинается эпитаксиальный рост полупроводников А3В5. После зарастания окон на поверхности окисной пленки образуется система ориентированных зародышей новой фазы. Рост пленки на этих дискретно расположенных зародышах происходит без образования дислокаций несоответствия, поскольку контакт между пленкой и подложкой имеет место только на части поверхности. При этом выходы столбцов полупроводников A3B5 в окнах могут отклоняться на значительные расстояния без существенного напряжения химических связей.
Уровень основных операций.
Лазерное осаждение тонких пленок.
Совмещенная технология GaAs/Si.
На рисунке приведен
Уровень основных операций.
Лазерное осаждение тонких пленок.
Совмещенная технология GaAs/Si.
На рисунке приведен
1 - пленка А3В5, полученная методом ЛВЭ; 2 - слой p-Si; 3 - слой n-Si; 4 - окисел; 5 - металлические контакты; 6 - подложка p-Si.
Уровень основных операций.
Лазерное осаждение тонких пленок высокотемпературных сверхпроводников (ВТСП).
Уровень основных операций.
Лазерное осаждение тонких пленок высокотемпературных сверхпроводников (ВТСП).
Уровень основных операций.
Лазерное осаждение тонких ВТСП- пленок .
Уровень основных операций.
Лазерное осаждение тонких ВТСП- пленок .
Уровень основных операций.
Лазерное осаждение тонких ВТСП- пленок.
Уровень основных операций.
Лазерное осаждение тонких ВТСП- пленок.
Уровень завершающих операций.
Лазерное скрайбирование.
Скрайбирование заключается в нанесении рисок на рабочую повepxность
Уровень завершающих операций.
Лазерное скрайбирование.
Скрайбирование заключается в нанесении рисок на рабочую повepxность
В 70-х годах повсеместно в электронной промышленности применяется лазерное скрайбирование. Особенностью лазерного скрайбирования является то, что оно обеспечивает разламывание пластин с перпендикулярными рабочей поверхности боковыми гранями кристаллов. К достоинствам способа лазерного скрайбирования можно отнести высокую производительность при отсутствии сколов. Лазерное скрайбирование обеспечивает качественное разламывание пластин кремния толщиной до 400-450 мкм. Недостатком метода лазерного скрайбирования является разбрызгивание продуктов обработки - частиц испаряемого и расплавленного полупроводникового материала, из-за чего необходима защита рабочей поверхности пластины.
Для лазерного скрайбирования в настоящее время наиболее широко используется частотный АИГ: Nd-лазер с длиной волны излучения 1,06 мкм в режиме модулированной добротности (tи=100-500 нс). При использовании такого режима обработки реализуют ширину риски 25-40 мкм с глубиной 50-100 мкм. Как правило, скорость скрайбирования выбирают в пределах от 100-200 мм/с. Поскольку для эффективной реализации процесса лазерного скрайбирования необходимо равномерно удалить материал в области лазерного воздействия, плотность потока излучения необходимо выбирать в диапазоне qс3
Уровень завершающих операций.
Лазерное скрайбирование.
Серийная установка для лазерного скрайбирования состоит из лазера,
Уровень завершающих операций.
Лазерное скрайбирование.
Серийная установка для лазерного скрайбирования состоит из лазера,
Для улучшения данной процедуры используется режим многократного скрайбирования. Дня снижения загрязнения рабочей поверхности пластины продуктами лазерного скрайбирования применяется вакуумный отсос и нанесение на рабочую поверхность пластины слоя латекса (водный раствор каучука), поливинилового спирта, поверхностно-активных веществ.
Процесс лазерного скрайбирования определяется набором параметров. Длина волны излучения, мощность излучения, диаметр фокального пятна, частота следования и длительность импульсов являются фиксированными. А скорость скрайбирования, шаг поперечной подачи образца (пластины) и число проходов можно изменять. Выбор последних параметров определяется требуемой глубиной лазерной риски, зависит от толщины пластины и размеров кристаллов (чипов). Пластины диаметром 76 мм и толщиной 380 мкм скрайбируют за два прохода при рабочей скорости стола 120 мм/с. При этом глубина риски долина быть не менее 80 мкм. Пластины диаметром 100 мм, толщиной 460 мкм скрайбируют при той же скорости, но за три прохода, получая риску глубиной 100 мкм.
Уровень завершающих операций.
Маркировка.
В настоящее время существуют два способа лазерной маркировки:
Уровень завершающих операций.
Маркировка.
В настоящее время существуют два способа лазерной маркировки:
Автоматическая система с электромеханическими дефлекторами обеспечивает маркировку сложных буквенно-цифровых шрифтов. Производительность этого способа маркировки 1 деталь/с или 6 млн. деталей в год. При таких скоростях маркерный знак может содержать до 40 меток. Типичное поле маркировки 7,5÷10 см2 на рабочем расстоянии 15÷30 см, глубина маркировочного знака по стали достигает 0,005-0,0075 см. При помощи лазеров на АИГ: Nd в режиме модуляции добротности наносится цифро-буквенная информация в виде непрерывных линий, состоящих из перекрывающихся точек.
Импульсными АИГ: Nd-лазерами при частоте 100 Гц осуществляется штриховая маркировка в виде точечных матриц. При растровом сканировании лучом площади до 7,5x7,5 см компьютер по программе определяет моменты включения лазера. В последнее время разрабатываются универсальные системы для резки и маркировки, пайки и маркировки с использованием до 10 волоконно-оптических кабелей вывода излучения.

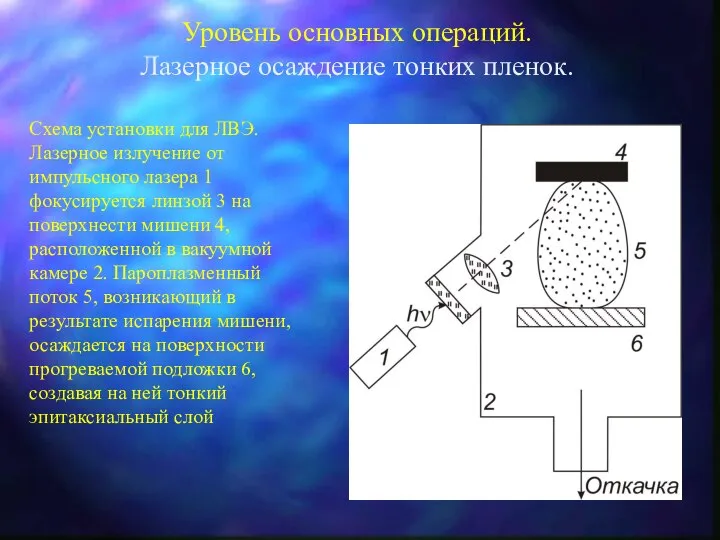

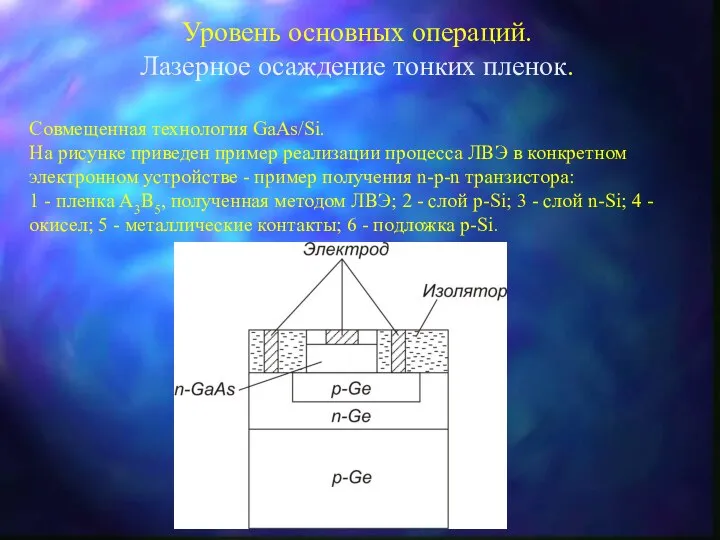

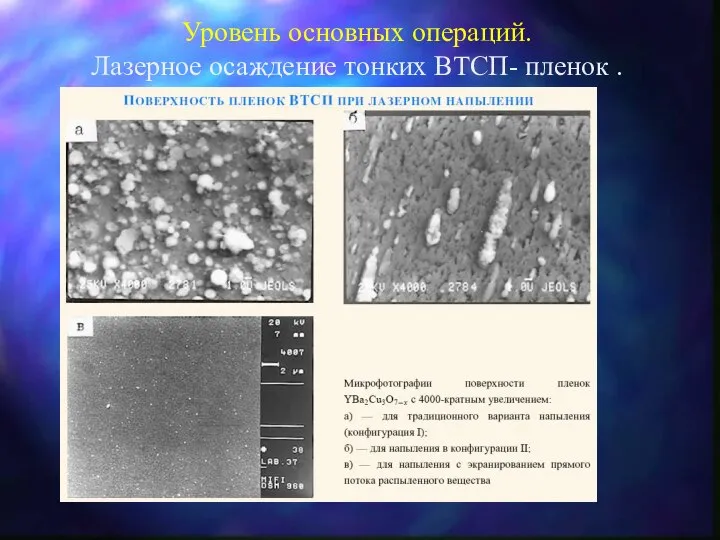




 Основы логики
Основы логики соединение костей
соединение костей Преимущества и недостатки объектно-ориентированного программирования (ООП)
Преимущества и недостатки объектно-ориентированного программирования (ООП) Особенности формирования и использования финансовых ресурсов некоммерческих организаций Подготовила: Бондарева Е. Д., гр. МЭ-101
Особенности формирования и использования финансовых ресурсов некоммерческих организаций Подготовила: Бондарева Е. Д., гр. МЭ-101 Человек-человек Страховой агент
Человек-человек Страховой агент Структури даних. Масиви
Структури даних. Масиви Иридодиагностика-10
Иридодиагностика-10 Биочипы в медицине
Биочипы в медицине Схема тепловых расчетов для конкретной экспериментальной установки
Схема тепловых расчетов для конкретной экспериментальной установки Выход из конфликта
Выход из конфликта Презентацию подготовил ученик 8 класса Ерошенко Григорий
Презентацию подготовил ученик 8 класса Ерошенко Григорий Естественные препятствия и их категорирование
Естественные препятствия и их категорирование Керечан Ганни Іванівни - презентация для начальной школы
Керечан Ганни Іванівни - презентация для начальной школы Коллективный план работ при разработке сайта
Коллективный план работ при разработке сайта Флаги сигнала
Флаги сигнала Eigenes spiel
Eigenes spiel Бытовые электроприборы
Бытовые электроприборы Устройство технических средств перекачки горючего
Устройство технических средств перекачки горючего Теорема Виета (8 класс) - презентация по Алгебре_
Теорема Виета (8 класс) - презентация по Алгебре_ Международные экономические отношения и основные формы их проявления
Международные экономические отношения и основные формы их проявления лекция № 7 для студентов 1 курса, обучающихся по специальности 060101 – Лечебное дело К.п.н., доцент Шилина Н.Г. Красноярск, 2013 Тем
лекция № 7 для студентов 1 курса, обучающихся по специальности 060101 – Лечебное дело К.п.н., доцент Шилина Н.Г. Красноярск, 2013 Тем Globalisation
Globalisation AUGUSTE RENOIR (1841-1919)
AUGUSTE RENOIR (1841-1919)  Электр ортадан тепкіш сораптық қондырғы
Электр ортадан тепкіш сораптық қондырғы Средства и методы физической культуры для формирования правильной осанки детей младшего школьного возраста
Средства и методы физической культуры для формирования правильной осанки детей младшего школьного возраста 8н8па76инпиш
8н8па76инпиш Поток и циркуляция векторного поля
Поток и циркуляция векторного поля Пространственная вертикаль
Пространственная вертикаль