Содержание
- 2. Соединения AIIIBV Соединения AIIIBV являются ближайшими электронными аналогами кремния и германия. Они образуются в результате взаимодействия
- 3. Таблица Менделеева
- 4. Характеристики соединений AIIIBV Eg, эВ
- 5. Твердые растворы на основе соединений AIIIBV Твердые растворы позволяют существенно расширить по сравнению с элементарными полупроводниками
- 6. Твердые растворы на основе соединений AIIIBV Наиболее хорошо изучены тройные твердые растворы, в которых замещение происходит
- 7. Твердые растворы на основе соединений AIIIBV
- 8. Фоновые примеси Нелегированные слои GaAs, выращенные методом МЛЭ с твердотельными источниками, обладают p-типом проводимости с концентрацией
- 9. Энергия связи примесей замещения в GaAs
- 10. Мелкие акцепторы Как правило, в качестве примеси p-типа в GaAs и AlGaAs используется Be, создающий мелкий
- 11. Мелкие доноры Кремний является наиболее распространенной примесью, используемой для GaAs и родственных материалов. Наиболее привлекательными свойствами
- 13. Скачать презентацию
Слайд 2
Соединения AIIIBV
Соединения AIIIBV являются ближайшими электронными аналогами кремния и германия. Они
Соединения AIIIBV
Соединения AIIIBV являются ближайшими электронными аналогами кремния и германия. Они
образуются в результате взаимодействия элементов III-а подгруппы Периодической таблицы (бора, алюминия, галлия, индия) с элементами V-а подгруппы (азотом, фосфором, мышьяком и сурьмой).
Висмут и таллий не образовывают соединений рассматриваемого ряда.
Соединения AIIIBV принято классифицировать по металлоидному элементу V группы.
Соответственно, различают
нитриды
фосфиды
арсениды
антимониды.
Висмут и таллий не образовывают соединений рассматриваемого ряда.
Соединения AIIIBV принято классифицировать по металлоидному элементу V группы.
Соответственно, различают
нитриды
фосфиды
арсениды
антимониды.
Слайд 3
Таблица Менделеева
Таблица Менделеева
Слайд 4
Характеристики соединений AIIIBV
Eg, эВ
Характеристики соединений AIIIBV
Eg, эВ
Слайд 5
Твердые растворы на основе соединений AIIIBV
Твердые растворы позволяют существенно расширить по
Твердые растворы на основе соединений AIIIBV
Твердые растворы позволяют существенно расширить по
сравнению с элементарными полупроводниками и полупроводниковыми соединениями набор электрофизических параметров, определяющих возможности применения материалов в конкретных полупроводниковых приборах.
Среди соединений AIIIBV распространены твердые растворы замещения.
Необходимые условия образования твердых растворов:
кристаллохимическое подобие кристаллических решеток соединений-компонентов
близость их периодов идентичности.
Среди соединений AIIIBV распространены твердые растворы замещения.
Необходимые условия образования твердых растворов:
кристаллохимическое подобие кристаллических решеток соединений-компонентов
близость их периодов идентичности.
Слайд 6
Твердые растворы на основе соединений AIIIBV
Наиболее хорошо изучены тройные твердые растворы,
Твердые растворы на основе соединений AIIIBV
Наиболее хорошо изучены тройные твердые растворы,
в которых замещение происходит лишь по одной из подрешеток бинарного соединения (металлической или металлоидной).
Состав таких твердых растворов принято характеризовать символами
AxB1-xC и ACyD1-y ,
где A и B обозначают элементы III группы,
C и D - элементы V группы.
В формуле AxB1-xC индекс х обозначает мольную долю соединения A в твердом растворе.
Если твердые растворы существуют во всем диапазоне, то х может меняться от 0 до 1.
Состав таких твердых растворов принято характеризовать символами
AxB1-xC и ACyD1-y ,
где A и B обозначают элементы III группы,
C и D - элементы V группы.
В формуле AxB1-xC индекс х обозначает мольную долю соединения A в твердом растворе.
Если твердые растворы существуют во всем диапазоне, то х может меняться от 0 до 1.
Слайд 7
Твердые растворы на основе соединений AIIIBV
Твердые растворы на основе соединений AIIIBV
Слайд 8
Фоновые примеси
Нелегированные слои GaAs, выращенные методом МЛЭ с твердотельными источниками, обладают
Фоновые примеси
Нелегированные слои GaAs, выращенные методом МЛЭ с твердотельными источниками, обладают
p-типом проводимости с концентрацией свободных дырок около 1014 см-3. Общепринято считать, что ответственной за это фоновой примесью является выступающий в роли мелкого акцептора углерод с энергией связи 26 мэВ. Наличие углерода в слоях преимущественно обусловлено взаимодействием CO и CO2, присутствующих в ростовой камере, с Ga и As на поверхности подложки.
Фоновые примеси, такие как Mn и Si, а также другие, не индетифицированные мелкие доноры, в общем, зависят от предыстории системы или могут быть отнесены к загрязнениям, связанным с некоторыми компонентами системы МЛЭ, нагреваемыми в процессе роста до высоких температур. В таких случаях степень загрязнения растущих пленок может быть уменьшена путем тщательного подбора конструктивных материалов, материалов источников и компоновкой ростовой камеры. Наконец, непосредственно исходные твердые полупроводниковые материалы могут иметь плохое качество очистки.
Фоновые примеси, такие как Mn и Si, а также другие, не индетифицированные мелкие доноры, в общем, зависят от предыстории системы или могут быть отнесены к загрязнениям, связанным с некоторыми компонентами системы МЛЭ, нагреваемыми в процессе роста до высоких температур. В таких случаях степень загрязнения растущих пленок может быть уменьшена путем тщательного подбора конструктивных материалов, материалов источников и компоновкой ростовой камеры. Наконец, непосредственно исходные твердые полупроводниковые материалы могут иметь плохое качество очистки.
Слайд 9
Энергия связи примесей замещения в GaAs
Энергия связи примесей замещения в GaAs
Слайд 10
Мелкие акцепторы
Как правило, в качестве примеси p-типа в GaAs и
Мелкие акцепторы
Как правило, в качестве примеси p-типа в GaAs и
AlGaAs используется Be, создающий мелкий уровень (~28 мэВ) вблизи валентной зоны.
Коэффициент прилипания и электрическая активность Be (т.е. соотношение ионизированных и нейтральных атомов Be) близка к единице вплоть до концентраций ~5 1019 см-3. Для повышения концентрации бериллия в материалах необходимо поддерживать температуру подложки ниже 550оС.
Для материалов, растущих при более низких температурах, таких как InP или GaInAs, в качестве альтернативной Be примеси служит Mg, так как он менее токсичен и электрические и оптические свойства получаемых слоев сравнимы со свойствами слоев, легированных Be. Однако с повышением температуры роста коэффициент прилипания магния резко уменьшается и составляет ~10-3 при 600оС. Магний может быть использован как примесь р - типа вплоть до концентраций 1018см-3. Выше этих концентраций морфология поверхности сильно деградирует из-за образования комплексов Mg-As. По этой причине, а также учитывая, что акцепторный уровень, создаваемый Mg, относительно глубок, использование Mg, как легирующей примеси при изготовлении приборных структур не рекомендуется.
Элементы II группы Zn и Сd, которые нашли широкое применение при легировании в жидкофазной или парофазной эпитаксии, обладают давлением насыщенных паров, намного превышающим давление паров Ga при температуре роста пленки. Попытки ввести эти примеси путем термического испарения из эффузионных ячеек в процессе МЛЭ к успеху не привели.
Коэффициент прилипания и электрическая активность Be (т.е. соотношение ионизированных и нейтральных атомов Be) близка к единице вплоть до концентраций ~5 1019 см-3. Для повышения концентрации бериллия в материалах необходимо поддерживать температуру подложки ниже 550оС.
Для материалов, растущих при более низких температурах, таких как InP или GaInAs, в качестве альтернативной Be примеси служит Mg, так как он менее токсичен и электрические и оптические свойства получаемых слоев сравнимы со свойствами слоев, легированных Be. Однако с повышением температуры роста коэффициент прилипания магния резко уменьшается и составляет ~10-3 при 600оС. Магний может быть использован как примесь р - типа вплоть до концентраций 1018см-3. Выше этих концентраций морфология поверхности сильно деградирует из-за образования комплексов Mg-As. По этой причине, а также учитывая, что акцепторный уровень, создаваемый Mg, относительно глубок, использование Mg, как легирующей примеси при изготовлении приборных структур не рекомендуется.
Элементы II группы Zn и Сd, которые нашли широкое применение при легировании в жидкофазной или парофазной эпитаксии, обладают давлением насыщенных паров, намного превышающим давление паров Ga при температуре роста пленки. Попытки ввести эти примеси путем термического испарения из эффузионных ячеек в процессе МЛЭ к успеху не привели.
Слайд 11
Мелкие доноры
Кремний является наиболее распространенной примесью, используемой для GaAs и
Мелкие доноры
Кремний является наиболее распространенной примесью, используемой для GaAs и
родственных материалов. Наиболее привлекательными свойствами Si как примеси n-типа, замещающей в узле атом Ga, является его коэффициент прилипания, близкий к единице, и малый коэффициент диффузии. Предел растворимости Si лежит в области ~5 1018 см-3 при стандартной температуре роста. Выше этого предела наблюдаются выделения второй фазы. Определенная степень компенсации Si проявляется из-за амфортерной природы Si. Кремний может также встраиваться в подрешетку As, замещая узельные атомы As. При стандартных ростовых условиях степень автокомпенсации составляет 10 %.
Преимущественное внедрение Si в подрешетку As происходит при температурах роста выше 600оС и малых соотношениях потоков As4/Ga, т.е. когда поверхность обеднена As. Из-за небольшой степени автокомпенсации в слоях, легированных Si наблюдается высокая подвижность носителей заряда. Наилучший результат, полученный на момент написания данного пособия, составляет 160000 см2/(В с) при Т=77 К.
Преимущественное внедрение Si в подрешетку As происходит при температурах роста выше 600оС и малых соотношениях потоков As4/Ga, т.е. когда поверхность обеднена As. Из-за небольшой степени автокомпенсации в слоях, легированных Si наблюдается высокая подвижность носителей заряда. Наилучший результат, полученный на момент написания данного пособия, составляет 160000 см2/(В с) при Т=77 К.
- Предыдущая
Применения наноструктурСледующая -
МАКРОЭКОНОМИЧЕСКАЯ ПОЛИТИКА ГОСУДАРСТВА

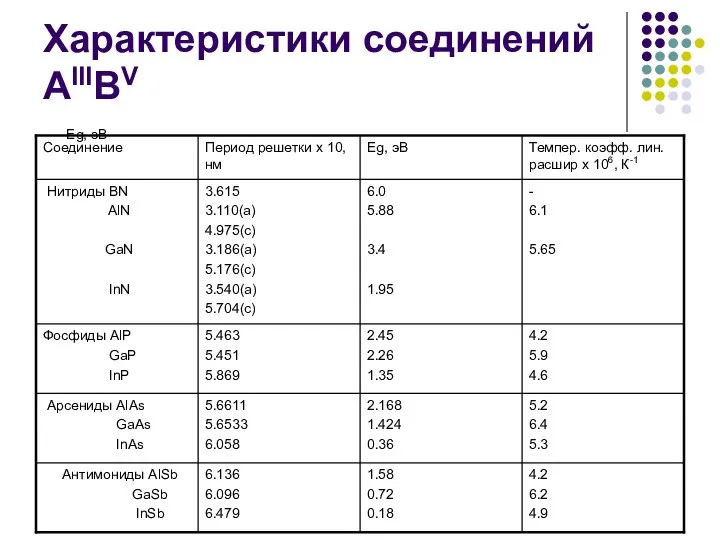







 Синдром дефицита внимания и гиперактивности Выполнила: Mаслова О. И.
Синдром дефицита внимания и гиперактивности Выполнила: Mаслова О. И. Диагностика двигателя легкового автомобиля
Диагностика двигателя легкового автомобиля БАЗЫ ДАННЫХ
БАЗЫ ДАННЫХ Дисфункциональные маточные кровотечения (ДМК
Дисфункциональные маточные кровотечения (ДМК Брейн-ринг «М.В. Ломоносов – великий сын России»
Брейн-ринг «М.В. Ломоносов – великий сын России» Факторы внешней среды, как способ лечебной физической культуры Крымский государственный медицинский университет им. С. И. Георги
Факторы внешней среды, как способ лечебной физической культуры Крымский государственный медицинский университет им. С. И. Георги Великая Отечественная война глазами художников
Великая Отечественная война глазами художников «Души своей открою тайники…» Задачи: Учиться вести дневниковые записи Выражать свое душевное состояние с помощью изобразительных средств Учиться делать выводы Анализировать свои поступки
«Души своей открою тайники…» Задачи: Учиться вести дневниковые записи Выражать свое душевное состояние с помощью изобразительных средств Учиться делать выводы Анализировать свои поступки Презентация на тему «Исследование особенностей налогообложения предприятий-участников внешнеэкономической деятельности»
Презентация на тему «Исследование особенностей налогообложения предприятий-участников внешнеэкономической деятельности» Антикоррупционное мировоззрение как фактор национальной безопасности (09)
Антикоррупционное мировоззрение как фактор национальной безопасности (09) Теоретические основы ноксологии
Теоретические основы ноксологии Патентоведение / защита интеллектуальной собственности
Патентоведение / защита интеллектуальной собственности Конституция РФ
Конституция РФ Социокультурные основы политических предпочтений
Социокультурные основы политических предпочтений Python
Python ООП на Delphi - 1. Знакомство с системой программирования Borland Delphi
ООП на Delphi - 1. Знакомство с системой программирования Borland Delphi Ежен Делакруа
Ежен Делакруа Координационный совет по развитию предпринимательской деятельности
Координационный совет по развитию предпринимательской деятельности  Периодический закон Менделеева
Периодический закон Менделеева  Terrorism. 6 things you should know about the terrorism
Terrorism. 6 things you should know about the terrorism Презентация Валютно -Финансовые условия внешнеторговых контрактов
Презентация Валютно -Финансовые условия внешнеторговых контрактов Программируемое радио. Основные определения
Программируемое радио. Основные определения Требования международно-правовых документов по ограничению или запрещению различных видов оружия
Требования международно-правовых документов по ограничению или запрещению различных видов оружия Алгоритм создания библиографического указателя Поток 86 Группа 1
Алгоритм создания библиографического указателя Поток 86 Группа 1 Разработка обучающих тестов по химии для средней школы
Разработка обучающих тестов по химии для средней школы Образ коня в изобразительном искусстве
Образ коня в изобразительном искусстве Образ современного учителя
Образ современного учителя Принципы международного права
Принципы международного права