ВЛИЯНИЕ ИМПЛАНТАЦИИ ИОНОВ ФОСФОРА НА СТРУКТУРНЫЕ ИЗМЕНЕНИЯ В ПОВЕРХНОСТНЫХ СЛОЯХ МОНОКРИСТАЛЛА КРЕМНИЯ
Содержание
- 2. Цель работы Исследование структурных изменений в приповерхностных слоях монокристаллов Si после имплантации ионов фосфора. Энергия имплантованных
- 3. Для реализации цели: Использовано методы рентгеновской топографии и двухкристального спектрометра; Использовано численные методы решения системы дифференциальных
- 4. 1 исходная 2 имплантация Образец кремния схематично Исходная область Ионная имплантация: фосфор (Е=180кеВ, D=8·1014cм-2)
- 5. КОСОНЕСИММЕТРИЧНАЯ ДИФРАКЦИИ В ГЕОМЕТРИИ НА ОТРАЖЕНИЕ И – источник рентг. излучения Щ – щель П –
- 6. Топография монокристалов Si а) Lext=2,1мкм б) Lext=1,05мкм в) Lext=0,75мкм Х-лучевые топограмы монокристала Si: CuKα-излучение, входящая плоскость
- 7. Атомно-силовая микроскопия образца Si б) а) Объёмное изображение микрорельефа поверхности образца Si а) исходная область б)
- 8. Схема трехосного рентгеновского дифрактометра Високоразрешающий трехосный рентгеновский дифрактометр PANalytical X’Pert MRD PRO. используется для измерения кривых
- 9. Кривые дифракционного отражения монокристалла Si -800 -600 -400 -200 0 200 400 600 800 ∆θ lg(I/I0)
- 10. Кривые дифракционного отражения монокристалла Si: сопоставление теоретической и экспериментальных кривых -600 -400 -200 0 200 400
- 12. Скачать презентацию


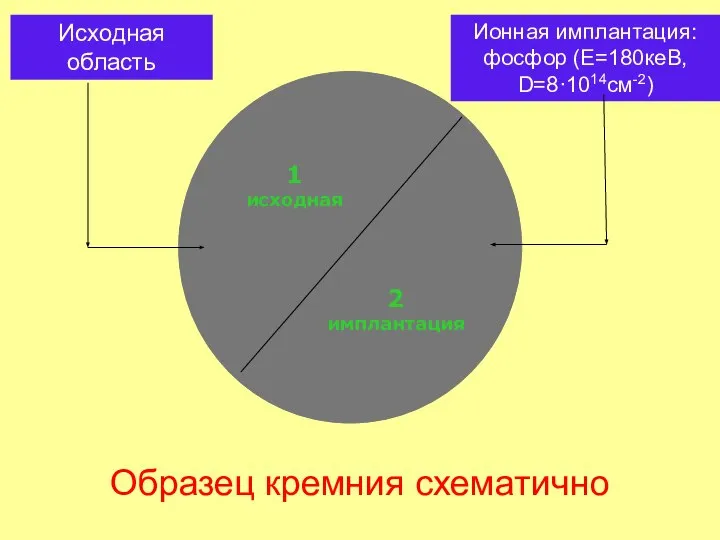



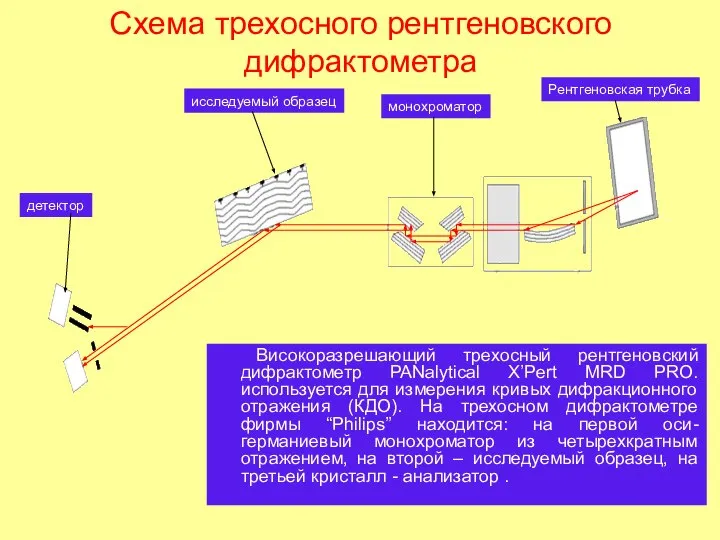


 Уравнения распространения волн
Уравнения распространения волн Презентация по физике на тему: «Термоядерная реакция»
Презентация по физике на тему: «Термоядерная реакция»  Определение разрешающей способности оптических систем. Контроль качества изображения точки
Определение разрешающей способности оптических систем. Контроль качества изображения точки Аттестационная работа. Методическая разработка по выполнению учебного проекта Тепловые явления вокруг нас
Аттестационная работа. Методическая разработка по выполнению учебного проекта Тепловые явления вокруг нас Презентация по физике "ВИДЫ излучений" - скачать бесплатно
Презентация по физике "ВИДЫ излучений" - скачать бесплатно Трёхфазные электрические цепи
Трёхфазные электрические цепи Инфракрасное излучение
Инфракрасное излучение Таинственный мир электричества
Таинственный мир электричества Термодинамика газовых потоков
Термодинамика газовых потоков Презентація з фізики на тему «Кварки» Підготувала учениця 11-В класу Трикіша В.
Презентація з фізики на тему «Кварки» Підготувала учениця 11-В класу Трикіша В.  Плоскопараллельное движение твердого тела. Тема 6
Плоскопараллельное движение твердого тела. Тема 6 Мария Кюри
Мария Кюри Исследование радиационного фона
Исследование радиационного фона Распространение волн в упругих средах (11 класс)
Распространение волн в упругих средах (11 класс) Инфразвук Звуки, издаваемые камнями. Ультразвук
Инфразвук Звуки, издаваемые камнями. Ультразвук  УРОК ФИЗИКИ В 10 КЛАССЕ Основные положения МКТ
УРОК ФИЗИКИ В 10 КЛАССЕ Основные положения МКТ  Разработка макета триодной рентгеновской трубки с линейным фокусом
Разработка макета триодной рентгеновской трубки с линейным фокусом Причины возникновения ураганов на территории южных районов Томской области.
Причины возникновения ураганов на территории южных районов Томской области. Кинетика биологических процессов
Кинетика биологических процессов Особенности водно-химического режима в контурах ЯЭУ
Особенности водно-химического режима в контурах ЯЭУ Система электроснабжения постоянного тока
Система электроснабжения постоянного тока РАДИОАКТИВНОСТЬ урок физики 11 класс
РАДИОАКТИВНОСТЬ урок физики 11 класс Открытие и применение закона всемирного тяготения
Открытие и применение закона всемирного тяготения Смеси идеальных газов. I закон термодинамики. Внутренняя энергия и работа
Смеси идеальных газов. I закон термодинамики. Внутренняя энергия и работа Электромагнитная индукция. Явление электромагнитной индукции (ЭМИ)
Электромагнитная индукция. Явление электромагнитной индукции (ЭМИ) Конденсатор. Электромагнитные явления
Конденсатор. Электромагнитные явления Понятие объемного резонатора. Возбуждение резонатора
Понятие объемного резонатора. Возбуждение резонатора Кинематические характеристики движения
Кинематические характеристики движения