База транзистора
Минимальное расстояние от края эмиттера до края базы две длины
базы 2(Lб - Lэ)
Минимальное расстояние от эмиттера до контакта к базе 2(Lб - Lэ) Минимальное расстояние между двумя эмиттерами 2(Lб - Lэ)
Минимальное расстояние от эмиттера до пассивной базы (Lб - Lэ)
Wб min = Wэ max + 4Δ + 4(Lб - Lэ) + W max +4Δ (если пассивной базы нет)
Wба min = Wэ max + 4Δ + 3(Lб - Lэ)+ Wпб max
в поперечном направлении Wб2 min = Wэ max + 4Δ + 4(Lб - Lэ)
Wб = W б min + 2×0.2∙Lб + 2 δ сл тр + δсл фл
W б max = W б + 2×0.2∙Lб + 2 δ сл тр + δсл фл
Wб ФШ = W б - 2 δ тр - 2 δ фл. - 2×0.7∙Lб
Wпб ФШ = N
Wпб = N + 2 δ тр + 2 δ фл + 2×0.7∙Lпб
W пб max = W пб + 2×0.2∙Lпб + 2 δ сл тр + δсл фл






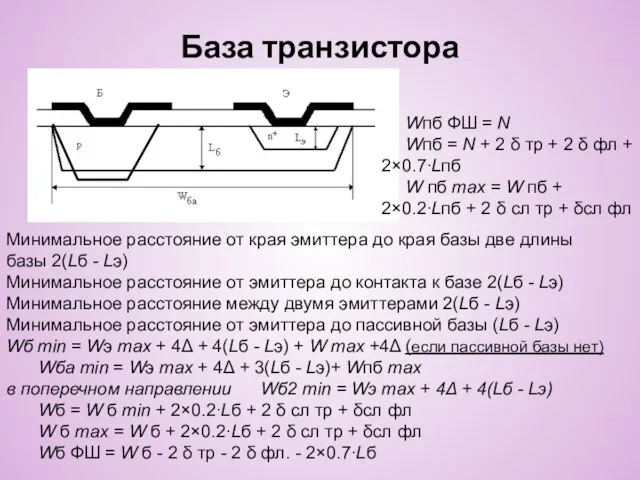







 Оценка качества условий оказания социальных услуг на территории Ямало-Ненецкого автономного округа
Оценка качества условий оказания социальных услуг на территории Ямало-Ненецкого автономного округа Программное обеспечение.Персональный компьютер
Программное обеспечение.Персональный компьютер Eselta - gate интегрированное решение
Eselta - gate интегрированное решение Структуры Структура как и массив, относится к составным типам данных. Это объект, состоящий из нескольких элементов (в Паскале — з
Структуры Структура как и массив, относится к составным типам данных. Это объект, состоящий из нескольких элементов (в Паскале — з Решение логических задач табличным способом
Решение логических задач табличным способом Обобщения. Часть 3
Обобщения. Часть 3 Измерение информации 10 класс
Измерение информации 10 класс Основы алгоритмизации и программирования
Основы алгоритмизации и программирования Итоговый проект курса Годнокод
Итоговый проект курса Годнокод Файлдық жүйелер мен ДҚБЖ арасындағы негізгі айырмашылық
Файлдық жүйелер мен ДҚБЖ арасындағы негізгі айырмашылық ЗЛП и Word
ЗЛП и Word Введение в WINDOWS Файл, каталог, работа с объектами Смирнова Ирина Евгеньевна 20 сентября 2000 г.
Введение в WINDOWS Файл, каталог, работа с объектами Смирнова Ирина Евгеньевна 20 сентября 2000 г. Сроки документооборота
Сроки документооборота Презентация к теме 15 лит-ра для 78,79 групп
Презентация к теме 15 лит-ра для 78,79 групп Як публікуватися в рецензованих виданнях (Scopus). Підготовка рукопису
Як публікуватися в рецензованих виданнях (Scopus). Підготовка рукопису Sissejuhatus informaatikasse. 14. Loeng: Tehisintellekt
Sissejuhatus informaatikasse. 14. Loeng: Tehisintellekt Створення структури таблиці (бази даних) i введення даних у таблицю
Створення структури таблиці (бази даних) i введення даних у таблицю ТП MS EXCEL. Технологии использования функций рабочего листа
ТП MS EXCEL. Технологии использования функций рабочего листа Безопасное общение в социальных сетях
Безопасное общение в социальных сетях Создать таблицу Производство овощей
Создать таблицу Производство овощей Технические приемы записи звуковой и видеоинформации
Технические приемы записи звуковой и видеоинформации Презентация "Графы. Моделирование" - скачать презентации по Информатике
Презентация "Графы. Моделирование" - скачать презентации по Информатике Galileo basic course
Galileo basic course OSI Network Layer
OSI Network Layer Проектирование реляционной базы данных
Проектирование реляционной базы данных Протоколы сети Internet
Протоколы сети Internet Признаки объектов. Понятие как форма мышления
Признаки объектов. Понятие как форма мышления Летняя школа инженера
Летняя школа инженера