Содержание
- 2. Целью данной работы было выполнение анализа влияния операционных параметров режима плазмохимического травления GaAs в плазме смеси
- 3. Операционные параметры режима ПХТ GaAs Соотношение расхода реакционных газов, стандартные см3/мин (sccm); Мощность ICP источника, Вт;
- 4. Установка травления в индуктивно-связанной плазме SI 500 производства SENTECH Instruments GmbH Установка Sentech SI 500 Схема
- 5. Подбор материала маски Используемые варианты масок
- 6. Подбор материала маски В качестве маскирующего материала была применена двухслойная фоторезистивная (ФР) маска на основе фоторезиста
- 7. Подбор оптимальных параметров Травление проводилось в газовой среде Cl2/BCl3/Ar. Соотношение расхода газов составило (40:20:5) sccm. Оптимальные
- 8. Результаты исследования Зависимость средней скорости ПХТ GaAs от давления
- 9. Результаты исследования Зависимость средней скорости ПХТ ФР маски от давления
- 10. Применение Лицевая (а) и обратная сторона (б) рНЕМТ транзистора Полученные результаты с успехом были использованы при
- 11. Заключение По результатам проведенных исследований, можно оценить скорость травления при изменении давления в камере. Было показано,
- 13. Скачать презентацию








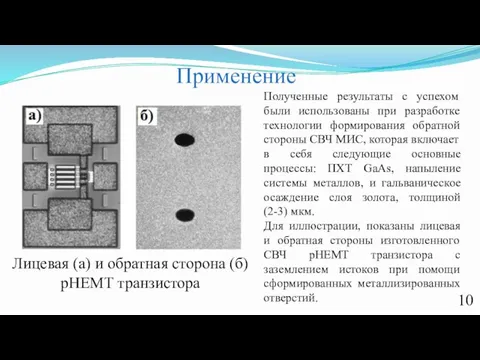

 Комплексные системы: отделка потолков помещений (КНАУФ)
Комплексные системы: отделка потолков помещений (КНАУФ) Основные термины и понятия физической культуры
Основные термины и понятия физической культуры Организация движения поездов
Организация движения поездов Год Российской науки
Год Российской науки Отопительные приборы
Отопительные приборы Системы жизнеобеспечения городов. Газоснабжение
Системы жизнеобеспечения городов. Газоснабжение Сценирвание как инструсент проектной деятельности
Сценирвание как инструсент проектной деятельности Организация учебного процесса в 1-ом классе
Организация учебного процесса в 1-ом классе Директора школы №3
Директора школы №3 Порядок оформления письменной корреспонденции. Почта России
Порядок оформления письменной корреспонденции. Почта России Универсальный солдат Великой Отечественной
Универсальный солдат Великой Отечественной Актуальные аспекты профилактики инфекций, связанных с оказанием медицинской помощи в работе медицинской сестры
Актуальные аспекты профилактики инфекций, связанных с оказанием медицинской помощи в работе медицинской сестры Организация монтажа, наладки, технического обслуживания и определение возможностей оптимизации
Организация монтажа, наладки, технического обслуживания и определение возможностей оптимизации Пугач Євгенія Олександрівна вчитель-логопед Ватутінського ДНЗ №7 Сонечко
Пугач Євгенія Олександрівна вчитель-логопед Ватутінського ДНЗ №7 Сонечко Аттестационная работа. Образовательная программа общеинтеллектуального направления В мире математики
Аттестационная работа. Образовательная программа общеинтеллектуального направления В мире математики Разработка охранного устройства на базе датчика движения
Разработка охранного устройства на базе датчика движения зимние виды спорта3
зимние виды спорта3 Энергосбережение в электротехнических системах
Энергосбережение в электротехнических системах 19 декабря - День Святого Николая
19 декабря - День Святого Николая Технологическая оснастка обсадных колонн
Технологическая оснастка обсадных колонн Верстачная крышка
Верстачная крышка Виды обработки металлов
Виды обработки металлов Классификация роботов
Классификация роботов Они ковали победу
Они ковали победу Преимущества членства в Ассоциации
Преимущества членства в Ассоциации Подъемно-транспортное оборудование в сфере торговли
Подъемно-транспортное оборудование в сфере торговли Переживание и стратегии преодоления (coping) психологической травмы
Переживание и стратегии преодоления (coping) психологической травмы Подготовка заявки на умник-2020
Подготовка заявки на умник-2020