Содержание
- 5. FEOL (front-end-of-line). Означает первую часть производственного цикла изготовления ИС, в котором отдельные элементы (транзисторы, емкости, резисторы
- 6. Литография - технологический метод, предназначенный для формирования на подложке топологического рисунка микросхемы с помощью чувствительных к
- 7. Задача фотолитографии — обеспечить качественное формирование топологических решений на всем поле кремниевой пластины с соблюдением допускаемых
- 10. Материалы, чувствительные к излучению, называют соответственно фото-, рентгено- и электронорезистами. Это в основном полимерные материалы, устойчивые
- 11. Фоторезисты - сложные полимерные композиции, в состав которых входят светочувствительные и пленкообразующие компоненты, растворители, некоторые добавки,
- 12. Операции фотолитографии Нанесение слоя резиста. Наиболее распространенным методом нанесения фоторезиста на подложки является центрифугирование: при включении
- 16. «Lift –off» процесс, основанный на применении двухслойного резиста. используется для получения металлических линий нанометрового масштаба.
- 20. Основные свойства фоторезистов Светочувствительность S = 1/H - величина, обратная экспозиции (Выражается в лквеличина, обратная экспозиции
- 21. Необходимо различать разрешающую способность фоторезиста и процесса фотолитографии в целом. Так, при разрешающей способности резиста до
- 23. Кривые на рисунке показывают сколько ф/р остается на подложке после экспонирования и проявления в зависисмости от
- 25. Для больших θ NA ≡ n ・ sin θ, где n — коэффициент преломления среды между
- 27. В идеальном линейном литографическом процессе любое изменение параметров маски должно приводить к идентичным изменениям размеров на
- 32. Сдвиг фазы зависит от толщины и типа используемого материала, необходимую толщину материала для сдвига по фазе
- 35. Схематическое изображение безхромного PSM (слева) и тонкие линии, которые он формирует на поверхности фоторезиста (справа).
- 36. Поскольку все фазосдвигающие границы формируют узкие темные линии на фоторезисте, только замкнутые области могут обрабатываться с
- 37. Варианты коррекции оптического эффекта близости. (a) — без OPC; (b) — простое OPC (коррекция размеров элементов);
- 40. Перед нанесением фоточувствительного резистивного слоя на подложку наносится тем или иным способом специальное антиотражающее покрытие. Этот
- 41. Схемы литографического процесса с двойным резистом разной полярности. На первом этапе на подложку с ранее организованным
- 43. Hexamethyldisilazane
- 45. Для получения структур с разрешением знгачительно ниже 100 нм становится обоснованным использование принципильно новых способов экспонирования.
- 46. ЭУФ-литография Преимущества: - ЭУФЛ является оптической и проекционной, используются стеклянные заготовки для шаблонов; - может быть
- 61. Эффект близости
- 63. Расчетные данные объема обрабатываемой информации при проектировании фотошаблонов для уровня технологии 130-65 нм.
- 65. трековая линия нанесения ФР
- 66. Установки контактной печати
- 67. Модуль нанесения центрифугированием
- 68. оборудование для ультрафиолетовой вакуумной фотолитографии (Extreme Ultraviolet Light Photolithography Tool).
- 69. Схема линейного кластерного производственного участка с технологическим оборудованием.
- 71. Скачать презентацию


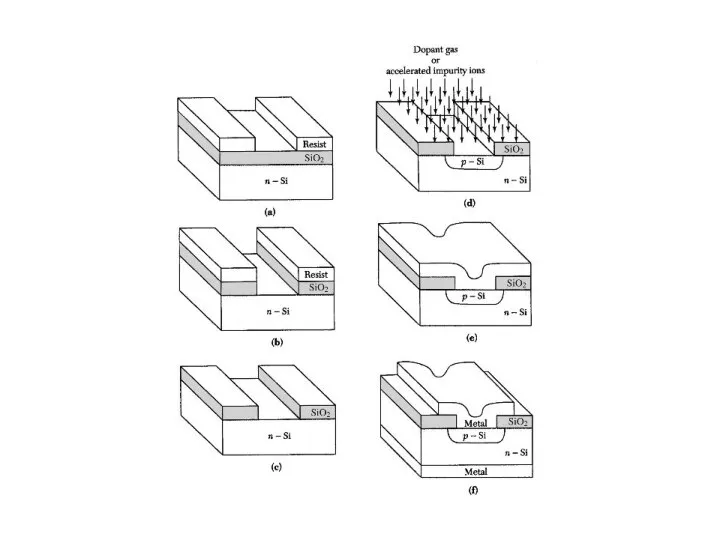



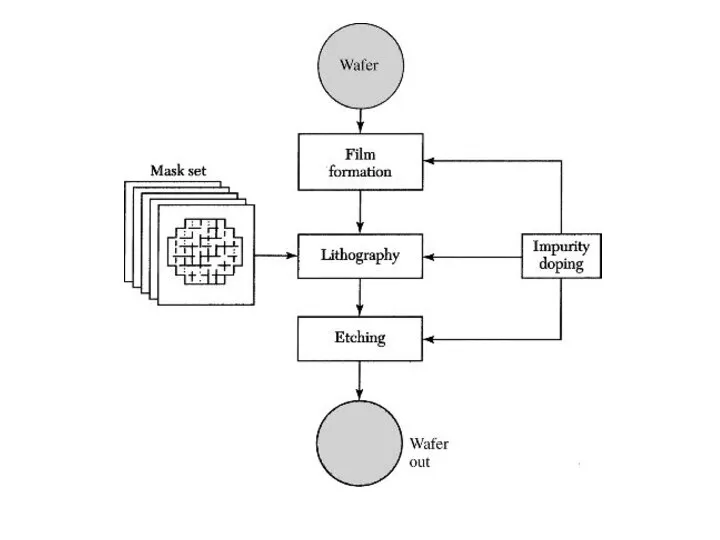
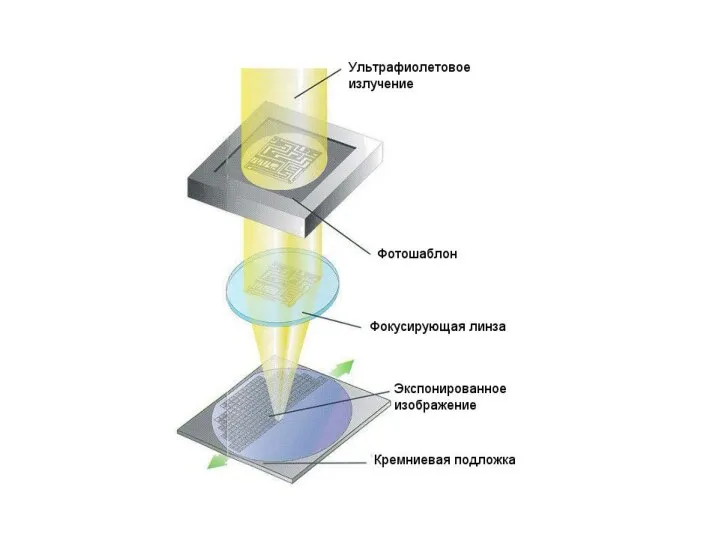



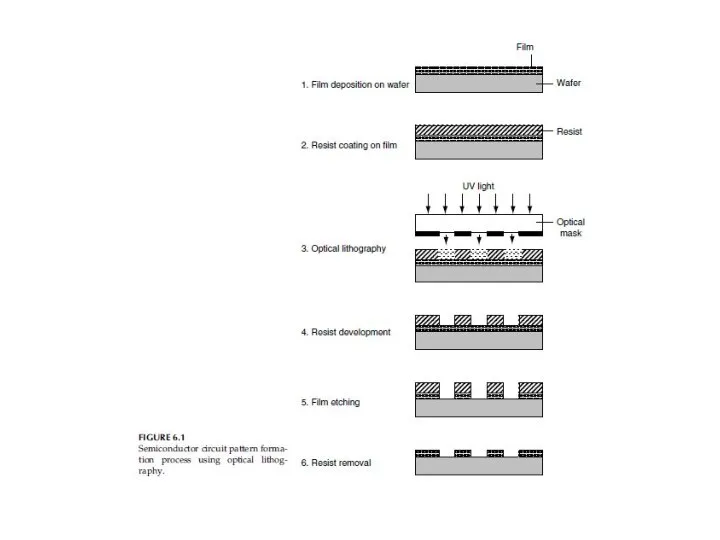

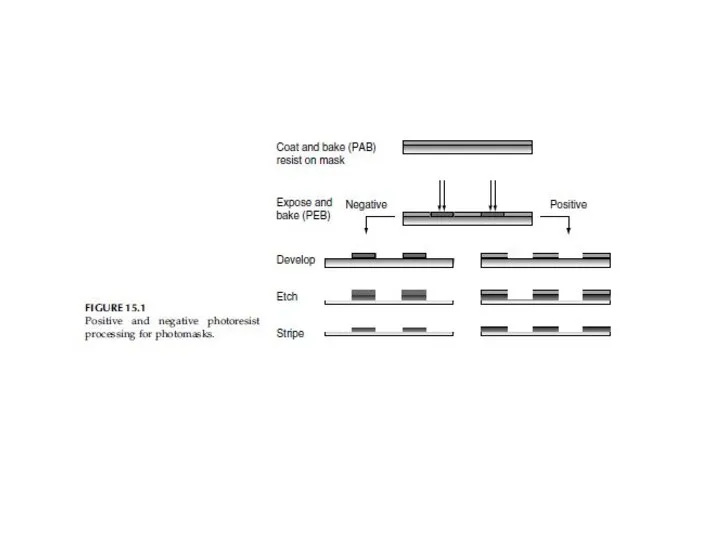
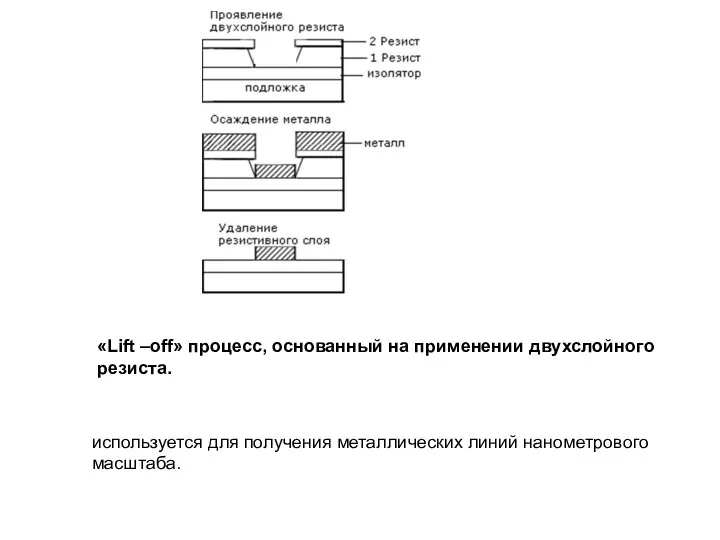


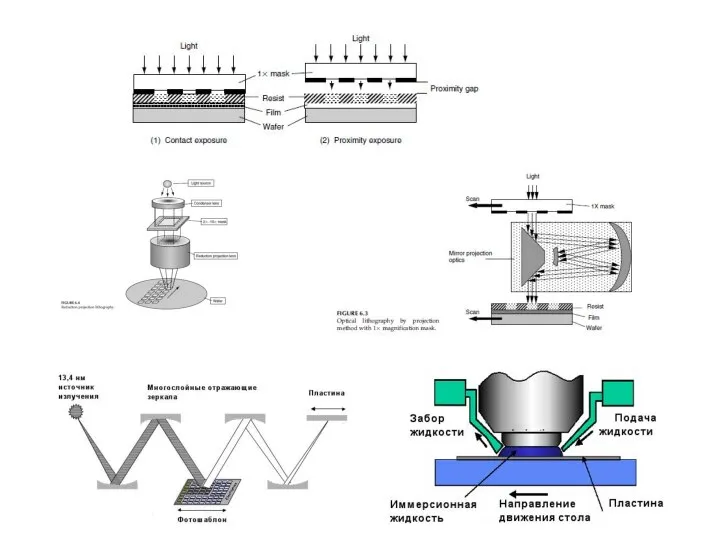


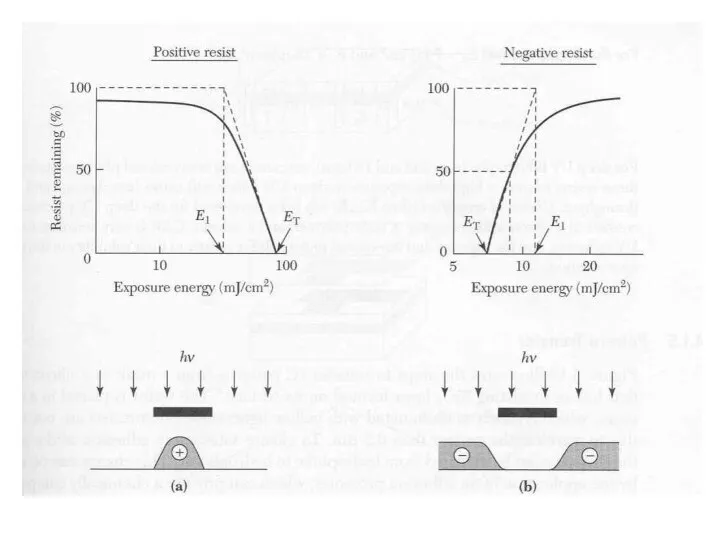





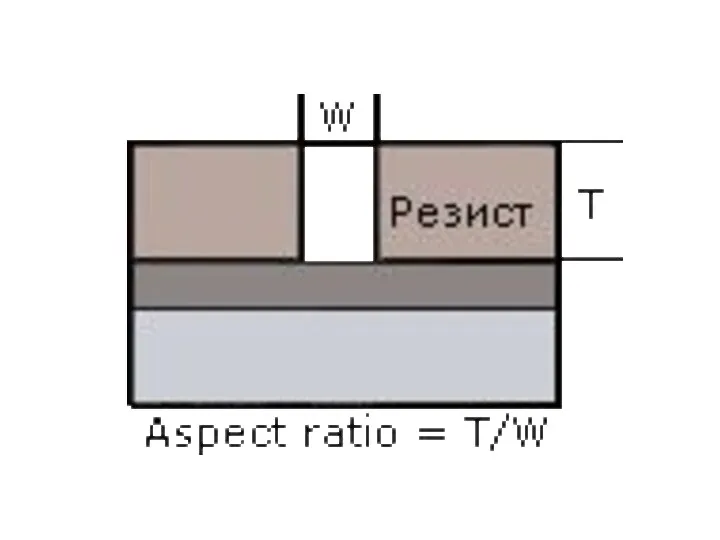
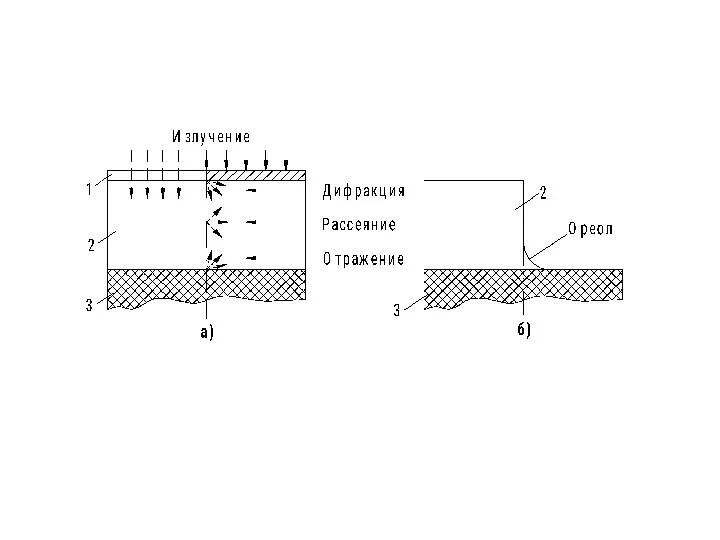

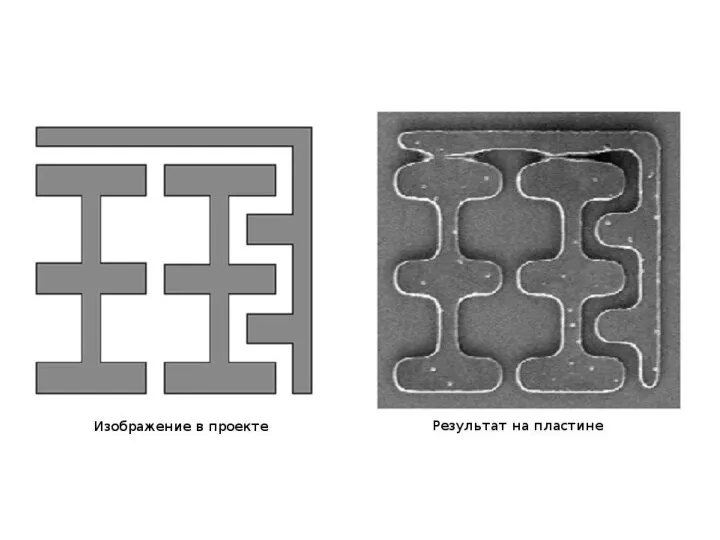

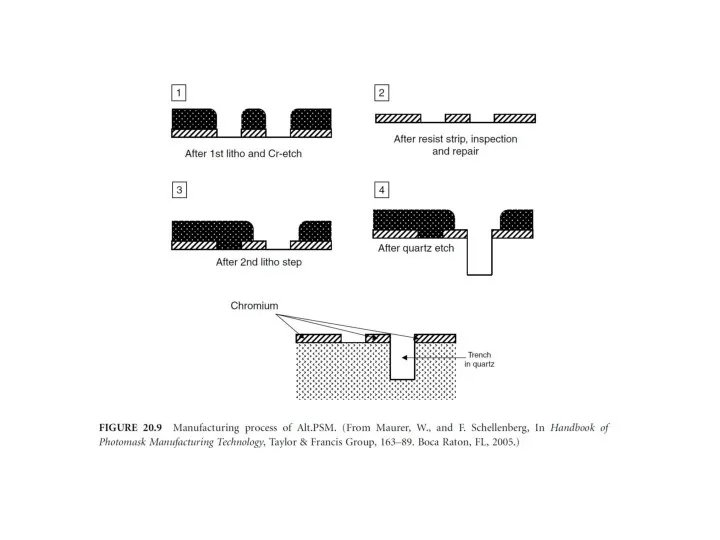
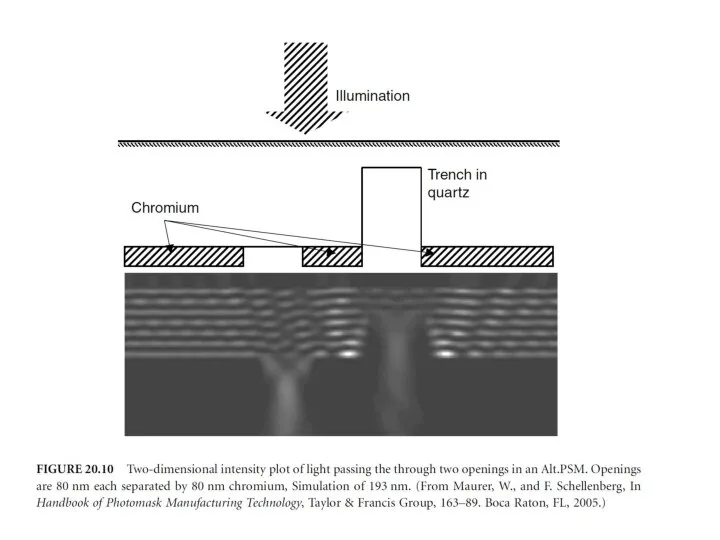
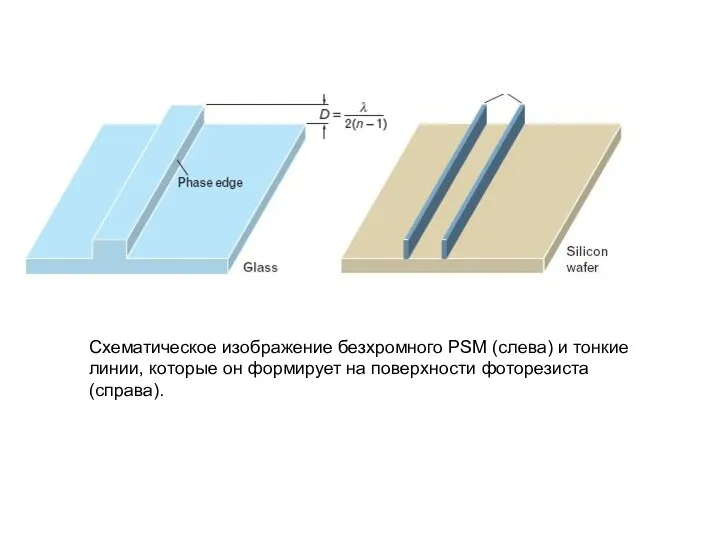




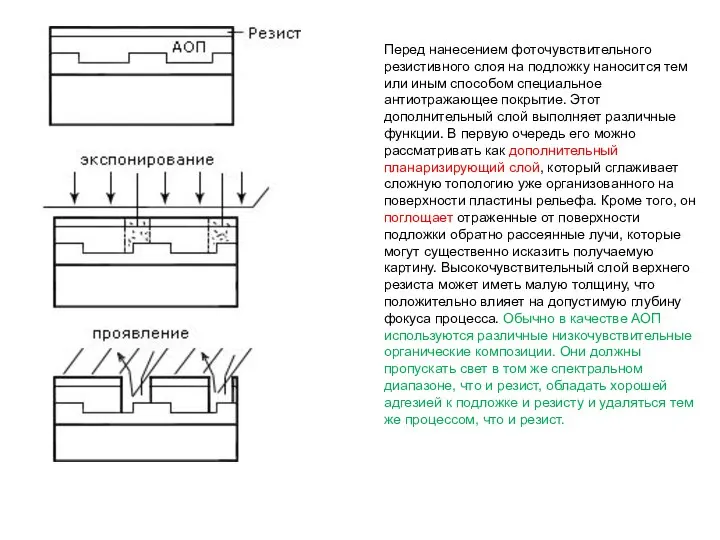
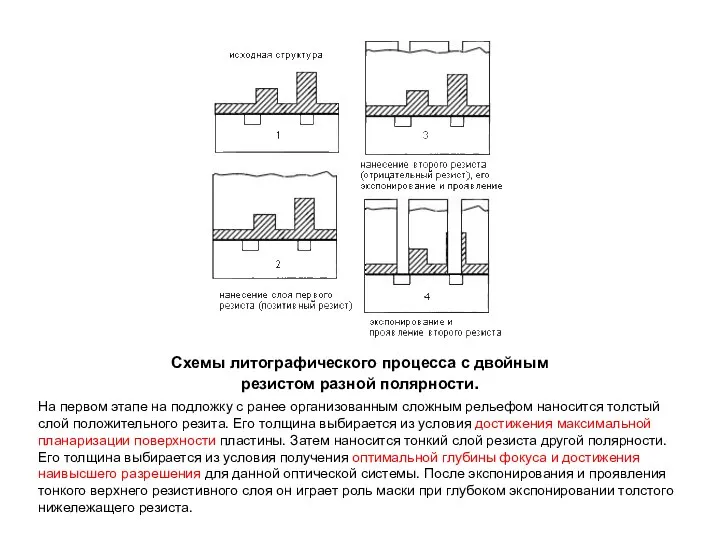

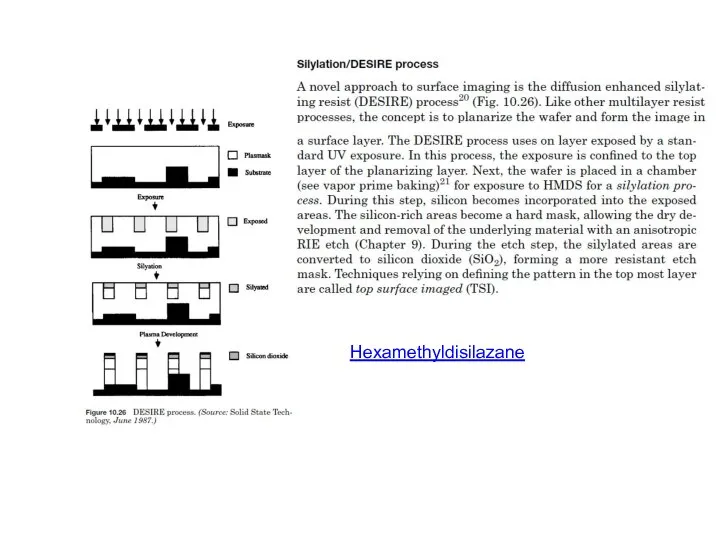



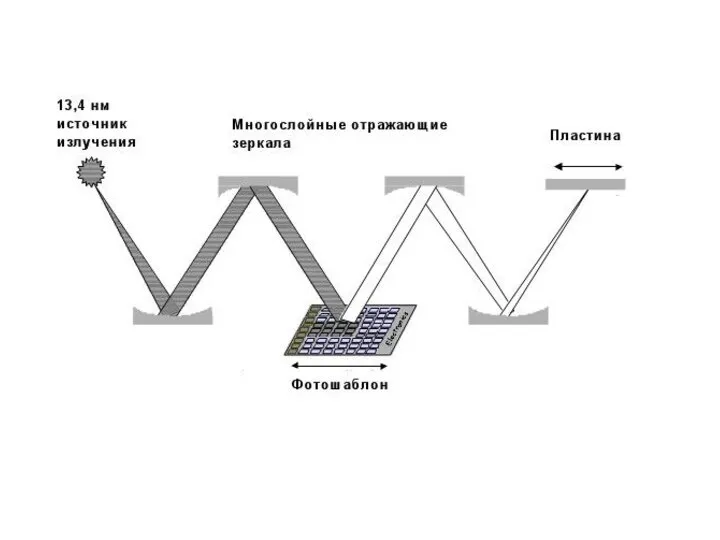
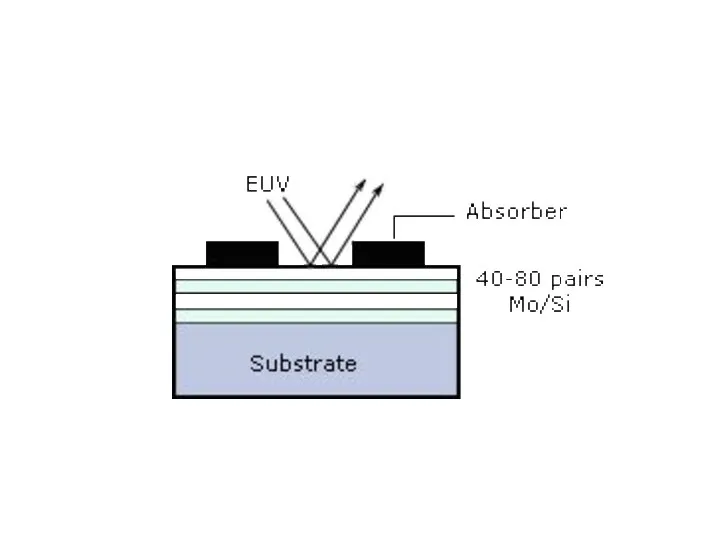



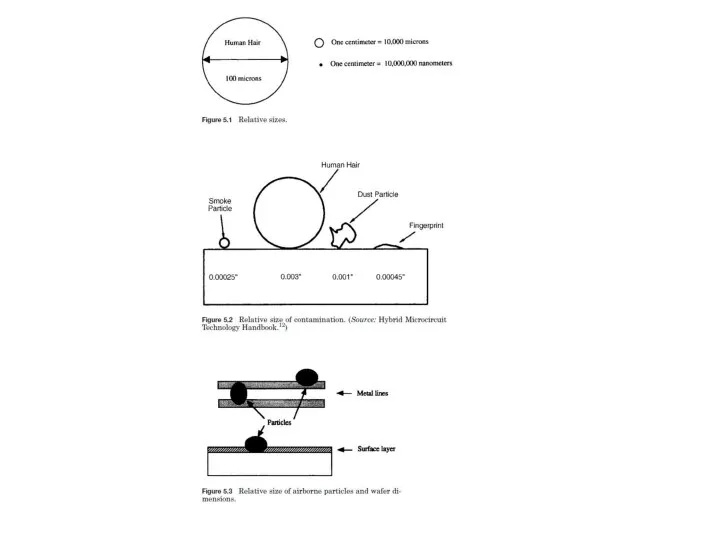
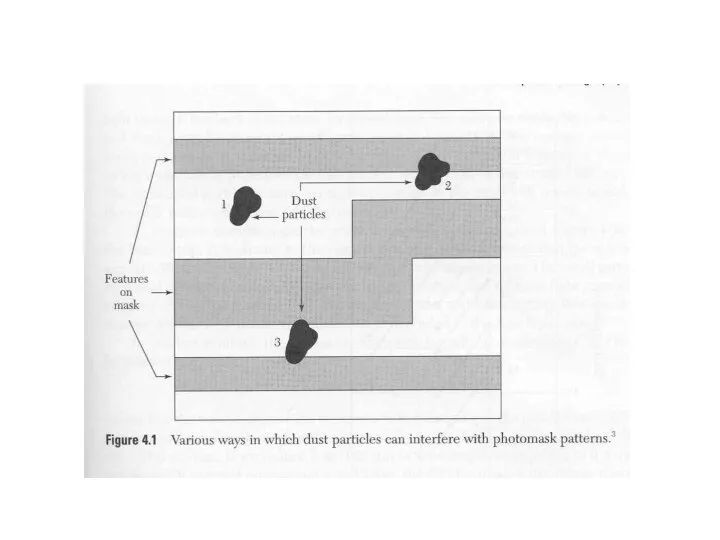
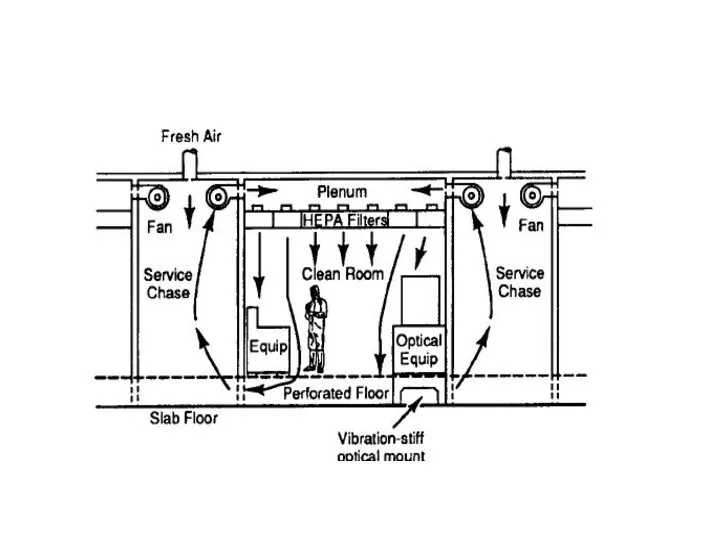
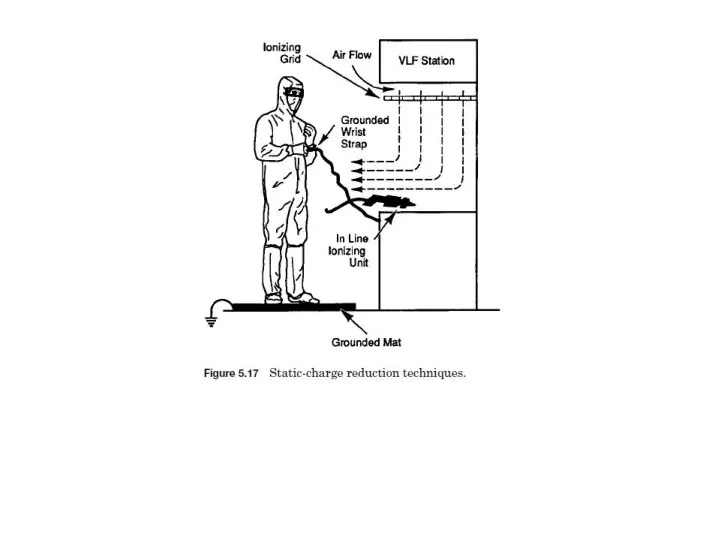

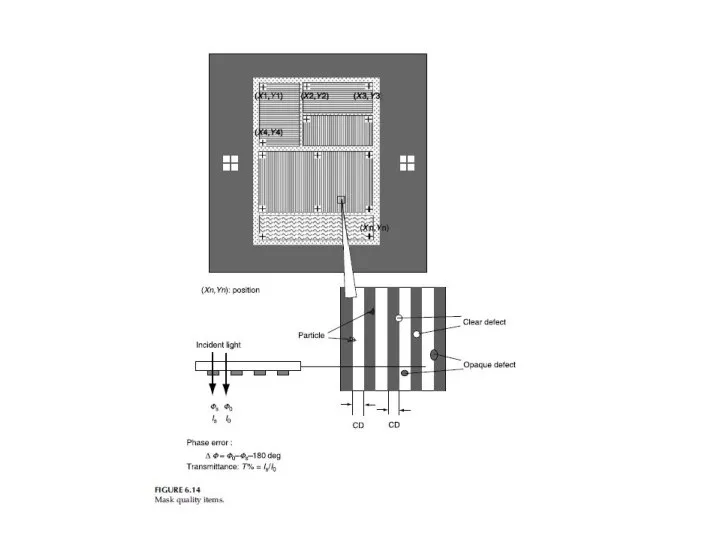
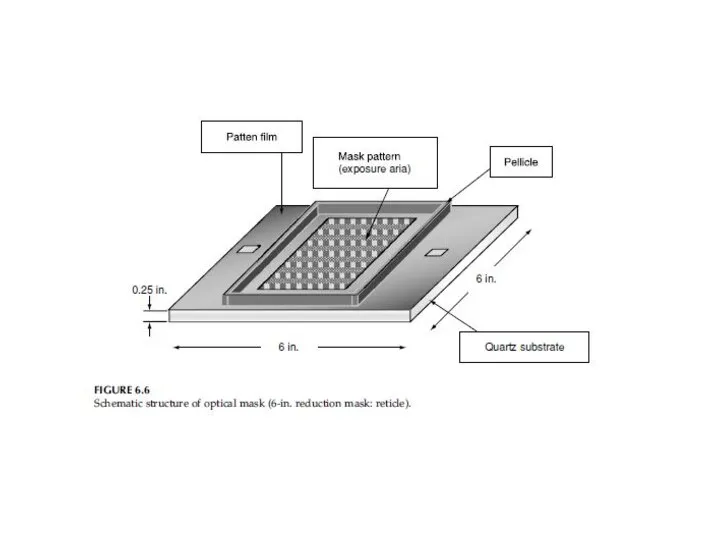
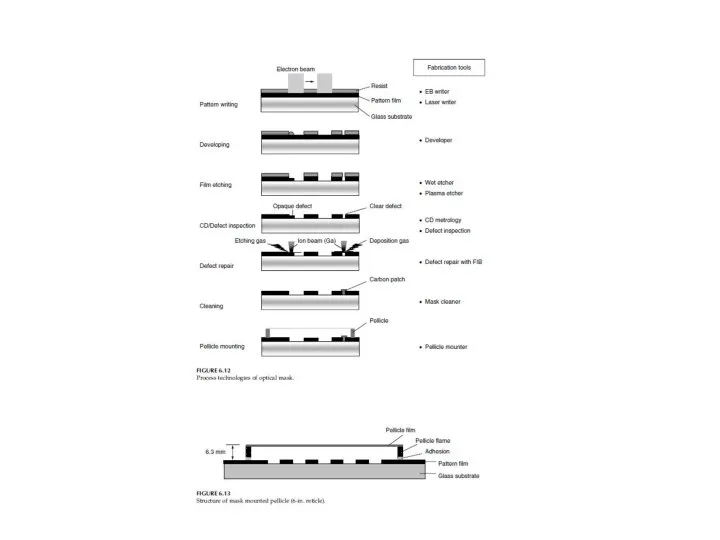

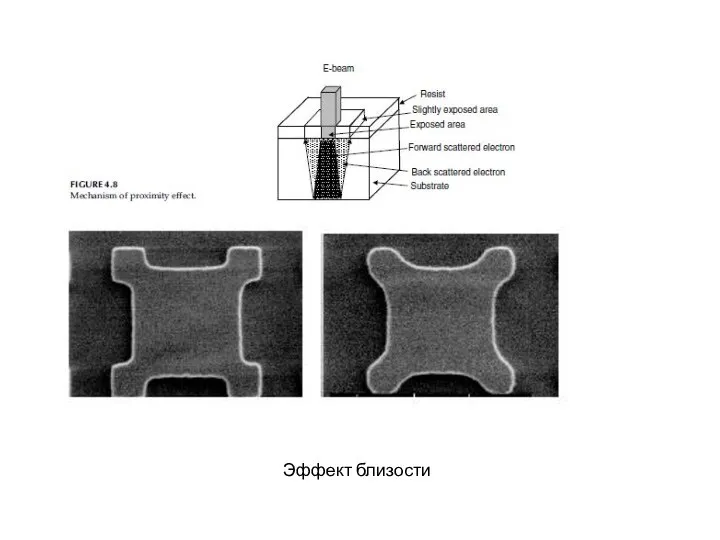


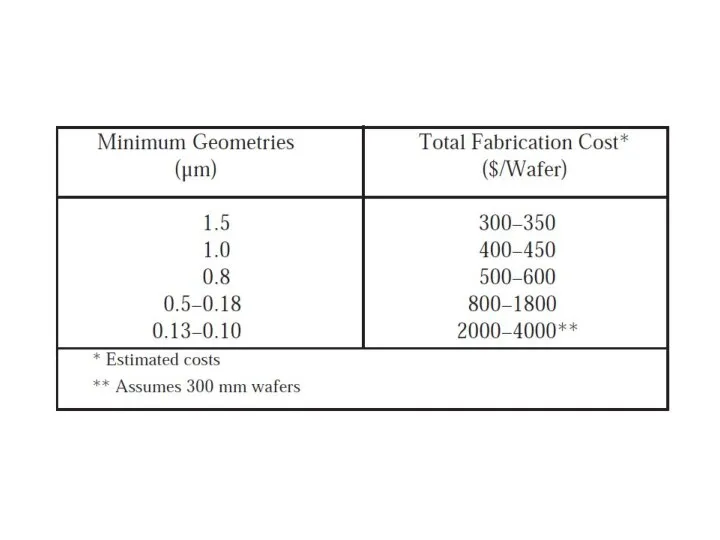





 азбука - презентация для начальной школы
азбука - презентация для начальной школы Презентация на тему "Часть 3 (С2.2). Сочинение-рассуждение (собственное высказывание на основе прочитанного текста)" - скачать пр
Презентация на тему "Часть 3 (С2.2). Сочинение-рассуждение (собственное высказывание на основе прочитанного текста)" - скачать пр Презентация «Предмет квантовой механики. Место квантовой механики среди наук о движении.»
Презентация «Предмет квантовой механики. Место квантовой механики среди наук о движении.» Робер Дуано – ироничный наблюдатель, лиричный и великий фотограф-гуманист
Робер Дуано – ироничный наблюдатель, лиричный и великий фотограф-гуманист Преза Шашихин
Преза Шашихин Вентильді және интегральды сұлбалар. Биттік байланыстар логикасы. Блоктарға интеграцияланатын сұлба деңгейлері
Вентильді және интегральды сұлбалар. Биттік байланыстар логикасы. Блоктарға интеграцияланатын сұлба деңгейлері Историческая трансформация пылесоса
Историческая трансформация пылесоса Магические числа» и кЛАССИЧЕСКОЕ использования констант
Магические числа» и кЛАССИЧЕСКОЕ использования констант Читаем. Вспомним местоимения. Спряжение глаголов. Познакомимся с числами от 1 до 12
Читаем. Вспомним местоимения. Спряжение глаголов. Познакомимся с числами от 1 до 12 Презентация Виски
Презентация Виски Хорошее настроение - презентация для начальной школы_
Хорошее настроение - презентация для начальной школы_ Иконопись
Иконопись Военизированная спортивно-экстремальная игра «Зарница»
Военизированная спортивно-экстремальная игра «Зарница» Оборудование МС производства и ср-ва автоматизации
Оборудование МС производства и ср-ва автоматизации Подбор номенклатуры полупроводниковых приборов в поисковой системе «Дейтрон»
Подбор номенклатуры полупроводниковых приборов в поисковой системе «Дейтрон» Построение третьего вида по двум данным
Построение третьего вида по двум данным КИСЛОТА – вещество, принимающее электроны в пары при образовании химической связи. ОСНОВАНИЕ – вещество, предоставляющее электро
КИСЛОТА – вещество, принимающее электроны в пары при образовании химической связи. ОСНОВАНИЕ – вещество, предоставляющее электро Подростковый возраст Родительское собрание
Подростковый возраст Родительское собрание Переходные процессы приводящие к потере устойчивости ЭТС. Промежуточно-устойчивые режимы
Переходные процессы приводящие к потере устойчивости ЭТС. Промежуточно-устойчивые режимы Fashion and function
Fashion and function Етика мовної комунікації
Етика мовної комунікації Бауэрсокс Д.ДЖ., Клосс Д.ДЖ. Логистика. Интегрированная цепь поставок. - М : ЗАО "ОЛИМП-БИЗНЕС", 2001. Бауэрсокс Д.ДЖ., Клосс Д.
Бауэрсокс Д.ДЖ., Клосс Д.ДЖ. Логистика. Интегрированная цепь поставок. - М : ЗАО "ОЛИМП-БИЗНЕС", 2001. Бауэрсокс Д.ДЖ., Клосс Д. Дисциплина Информатики
Дисциплина Информатики  Преступления в сфере служебной деятельности
Преступления в сфере служебной деятельности Метрологическое обеспечение строительства. (Лекция 1)
Метрологическое обеспечение строительства. (Лекция 1) Женские образы в поэмах Гомера. Живопись и скульптура
Женские образы в поэмах Гомера. Живопись и скульптура Религия античного мира
Религия античного мира Attractions Kushchyovsky District
Attractions Kushchyovsky District