Содержание
- 2. Линии шириной 22 нм протравленные в кремнии через электронно-лучевой резист. Аспектное отношение 7:1
- 3. SF6/O2 крио процесс с использованием наноимпринт литографии. Суб-20 нм область.
- 4. 26 нм элемент поликремния, протравленный с высокой селективностью по отношению к подзатворному окислу. 3 стадии травления:
- 5. 27 нм линии в кремнии глубиной 450 нм.
- 6. 1 мкм переходные контактные отверстия в окисле кремния
- 7. 110 нм линии хрома.
- 8. 100 нм линии. Аспектное отношение 10:1.
- 9. 50 мкм элемент кремния.
- 10. 50 мкм травление кремния с использованием Bosch Process при изготовлении микромеханических устройств
- 11. Травление кремния по РИТ технологии в анизотропно-изотропном процессе для формирования кантиливеров АСМ
- 12. 75 мкм травление кремния
- 13. 400 мкм отверстие в кремнии, полученное по технологии криогенного РИТ
- 18. Плазмой называют квазинейтральный газ заряженных и нейтральных частиц, концентрация которых достаточна для того, чтобы создаваемый ими
- 19. Низкотемпературная газоразрядная плазма (НГП). НГП – это слабо ионизированный газ при давлении 13·10-2 - 13·102 Па
- 20. В зависимости от вида плазмообразующего газа и природы поверхности твёрдого тела в каждом из трёх случаев
- 22. Под процессом травления понимается удаление с поверхности атомов и молекул материала верхнего слоя. По физико-химическому механизму
- 23. ПТ и РИПТ происходят в плазме химически активных газов, и в них поверхность обрабатываемого материала подвергается
- 24. Процессы травления должны обеспечивать воспроизводимость, скорость, селективность, степень анизотропии, равномерность и высокую производительность. Указанные характеристики зависят
- 25. В системах вакуумного плазменного травления (ВПТ) диапазон давлений рабочего газа определяется условиями существования рабочих разрядов. В
- 28. Основные параметры процесса травления: Скорость травления Селективность травления Анизотропия травления Профиль травления Уровень внесенных радиационных нарушений
- 36. Изображение ICP системы для травления. Электростатический экран между катушкой и диэлектрическим окном (кварцевая труба) обеспечивает индуктивное
- 40. Схема форвакуумного насоса
- 41. Диффузионный насос
- 42. Турбомолекулярный насос
- 43. Схема криогенного насоса
- 46. Схема РИТ
- 59. Транспорт частиц в микроструктуре
- 61. Номенклатура специальных газов
- 64. Основные факторы при травлении в плазме элементов с малыми размерами и высоким аспектным соотношением: зарядка диэлектрических
- 65. Четыре основных механизма снижения анизотропии и задержки РИТ Ионное затенение. Рассеивание и зарядовый обмен в ОПЗ
- 71. Зависимости скоростей травления Si*, SiO2 и Si3N4 от операционных параметров процесса: а) - от ВЧ-мощности; б)
- 72. Зависимости селективностей травления Si*/SiO2 и Si*/Si3N4 от операционных параметров процесса: а) от ВЧ-мощности; б) – от
- 73. Микрофотографии изотропных профилей травления Si*: а) - W = 90 Вт, P = 45 Па, QSF6
- 74. Микрофотографии нанопроволочной кремниевой структуры (а) и чувствительного виброрезонансного наноэлемента для атомных весов (б).
- 75. Изготовление кремневого штампа: a) профили резистов, сформированные с помощью проекционной и электронно-лучевой литографий, б) металлизация, использующая
- 78. Transmission electron microscopy cross-sections of nanowire structure. (Reprinted from Yang, F.-L., Lee, D.-H., Chen, H.-Y., Chang,
- 79. Фотография кремниевого штампа, полученная с помощью сканирующего электронного микроскопа. Из рисунка видно, что ширина линии составляет
- 80. Микрофотография профиля щелевой структуры с осажденными тонкими слоями TaN/Ta/Cu.
- 81. Возможные поврежденияструктур, присущие плазменным процессам.
- 85. Поперечное сечение нижней части канавки с подтравом, вызванным переотражением ионов от заряженных стенок.
- 92. Селективное плазменное травление нитрида для формирования нитридного спейсера.
- 93. Микрофотография самосовмещенного контакта, вытравленного в системе высокоплотной плазмы, иллюстрирующая низкую селективность на углах структуры при понижении
- 94. Микроснимок поперечного сечения щелей различной ширины, протравленных в DRM системе в течение восьми минут. Наблюдается снижение
- 96. Схематичное изображение щелевого конденсатора, используемого в 256 Мгб ДОЗУ.
- 97. Вариации формы канавки для различных поколений ДОЗУ, приводящие к 10% изменениям площади конденсатора, вызываемым отклонением параметров
- 98. Микрофотография поперечного сечения с трансмиссионного электронного микроскопа (TEM) Al(Cu) проводника после травления Cl2/HCl плазмой, сопровождаемой удалением
- 99. Фотография полости в проводнике ("укус мыши") вызванной коррозией проводника из Al(Cu).
- 100. Темы для рефератов: Физико-химические свойства низкотемпературной плазмы. Методы диагностики. Физико-химическое воздействие НГП на обрабатываемую поверхность. Методы
- 102. Скачать презентацию
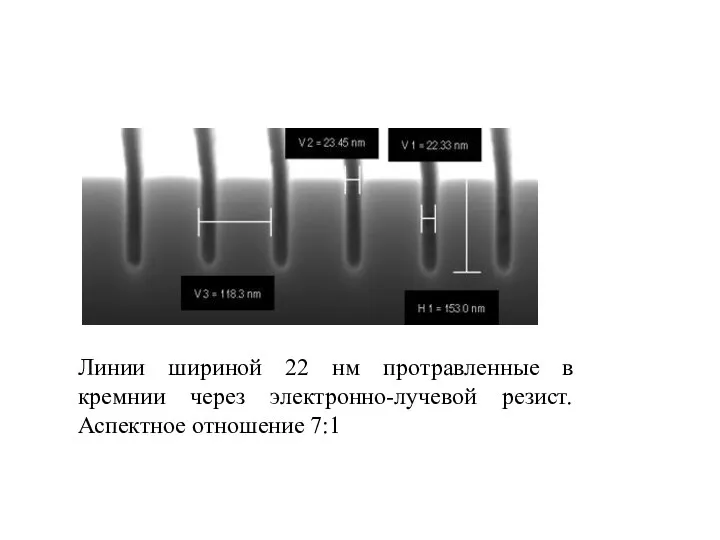

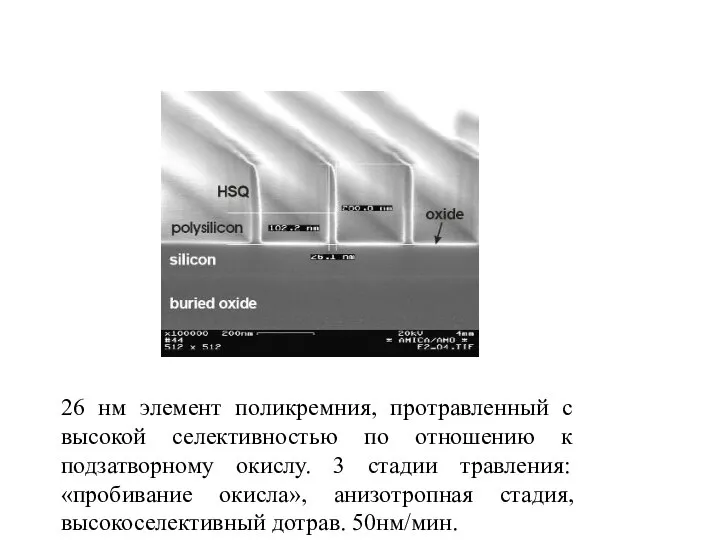

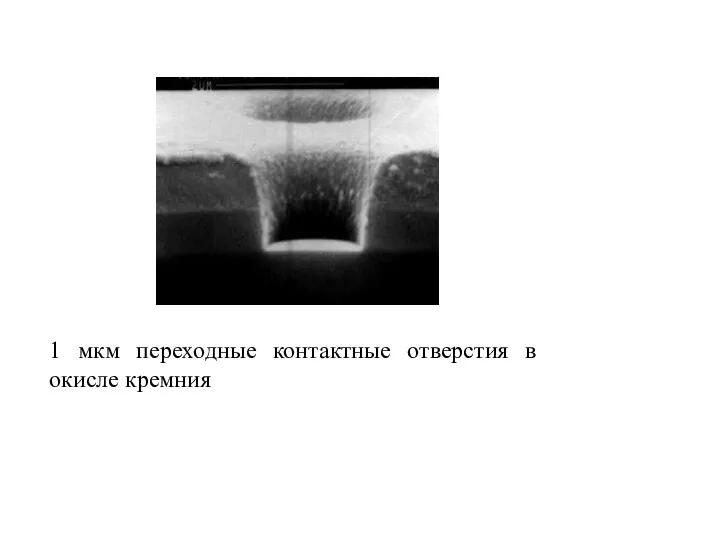
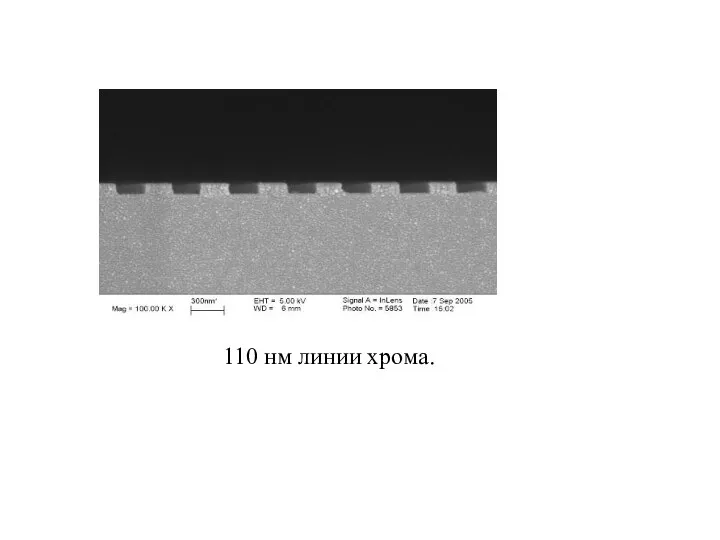


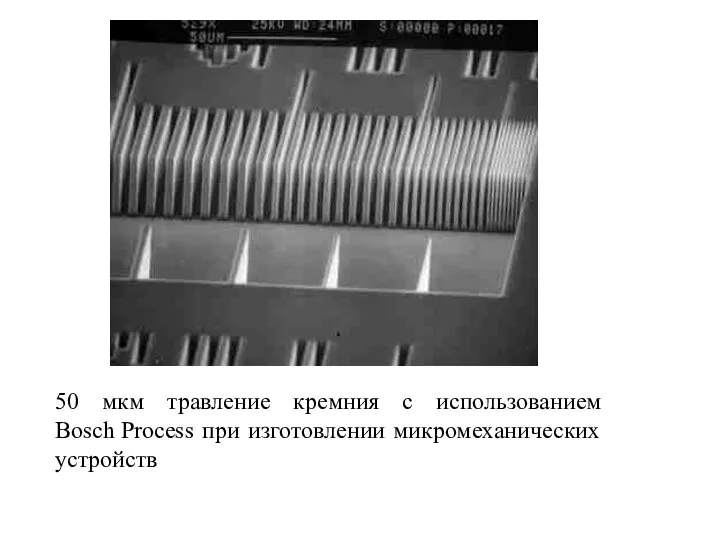
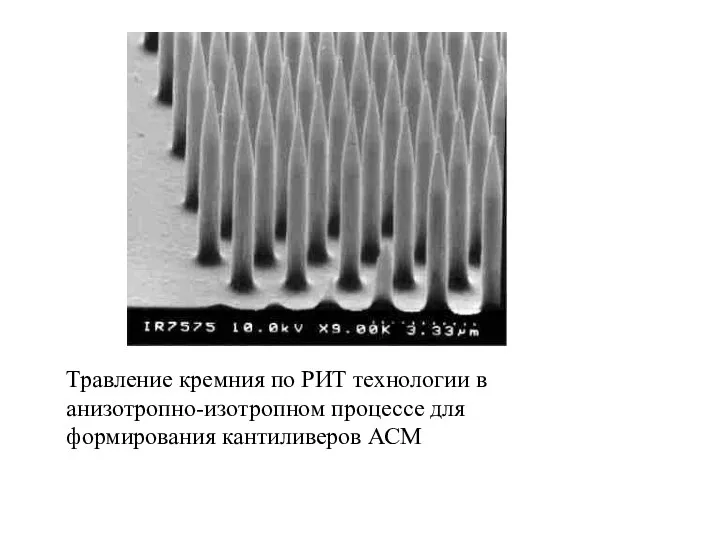




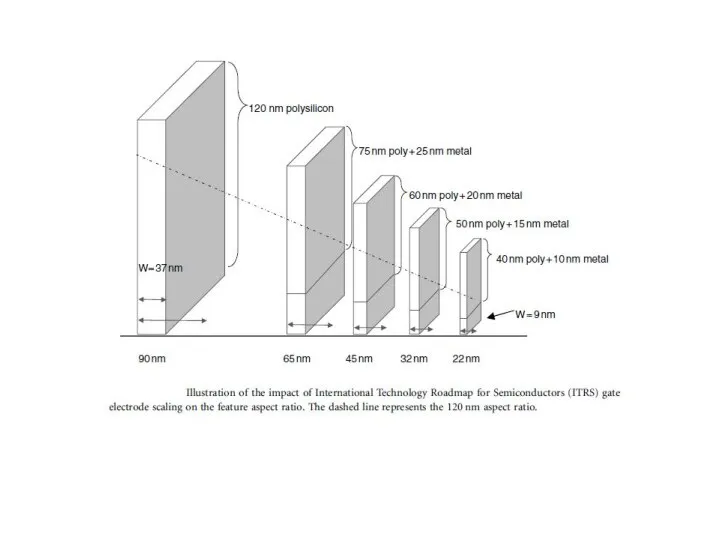












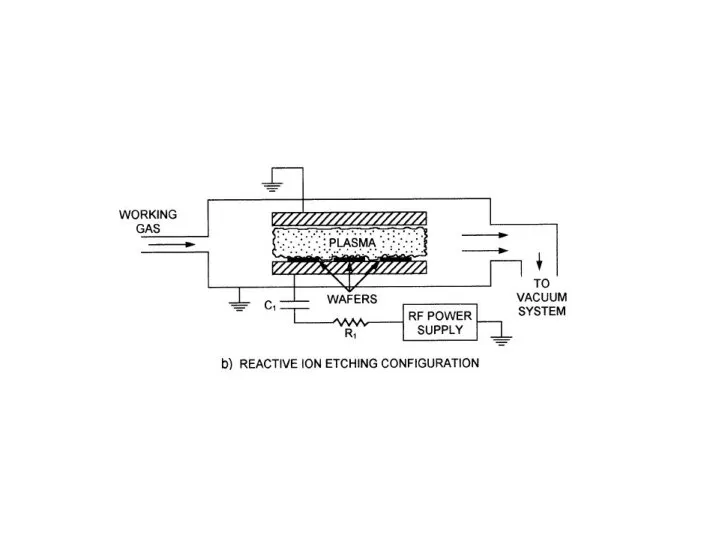
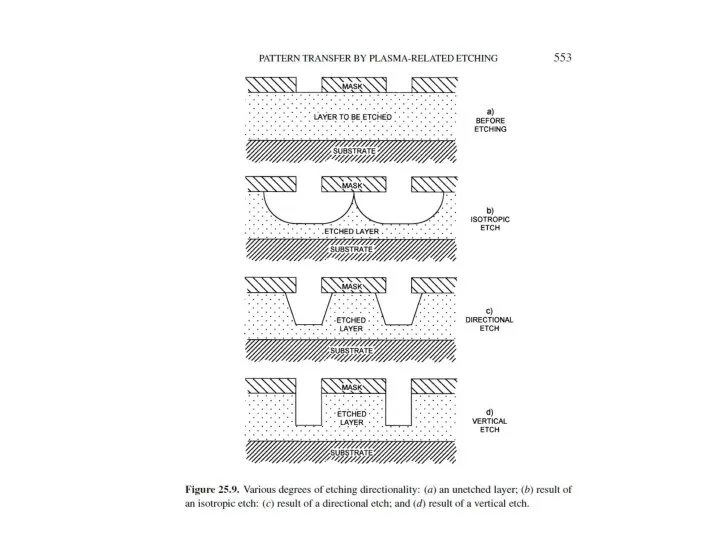


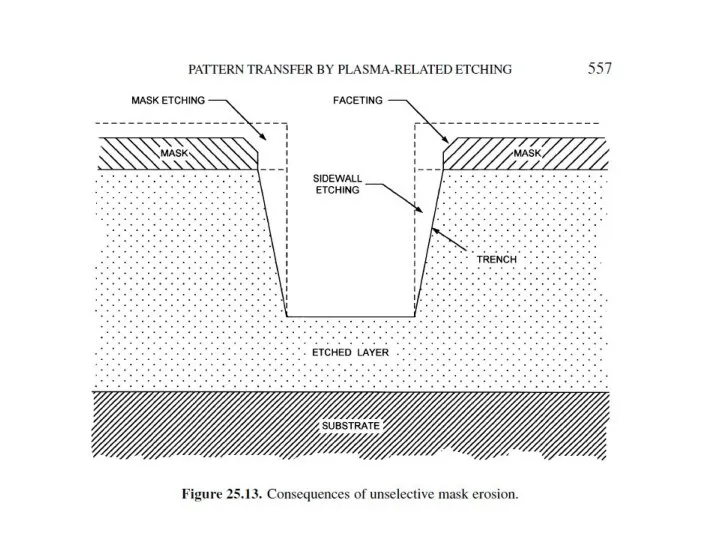
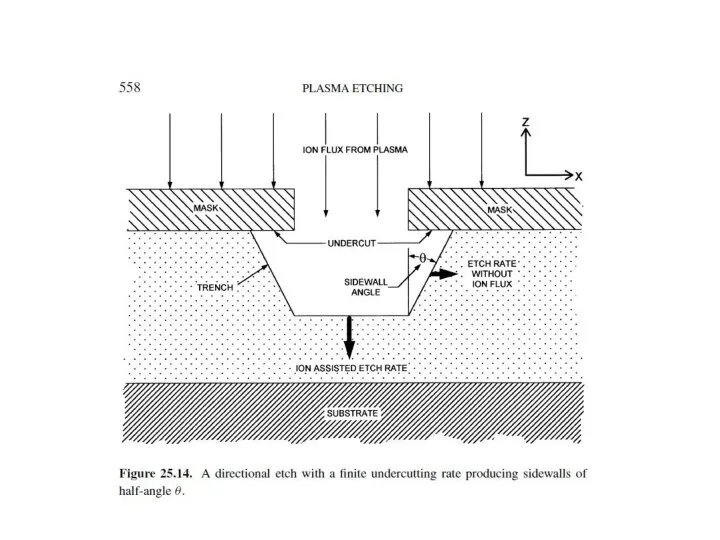
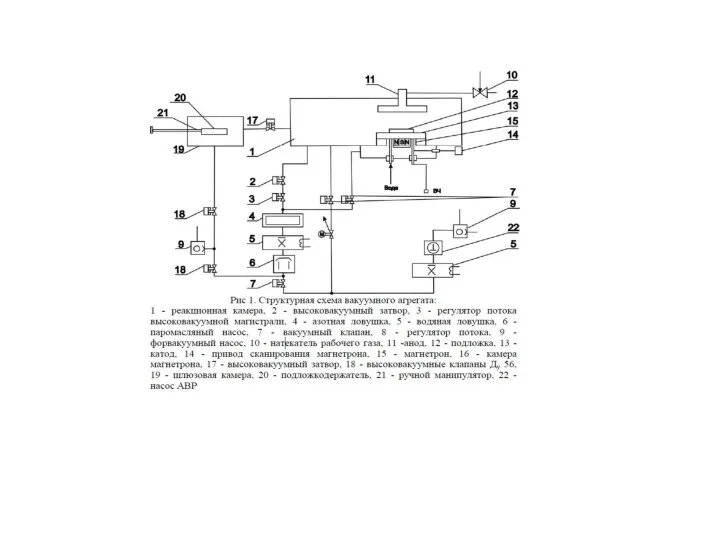
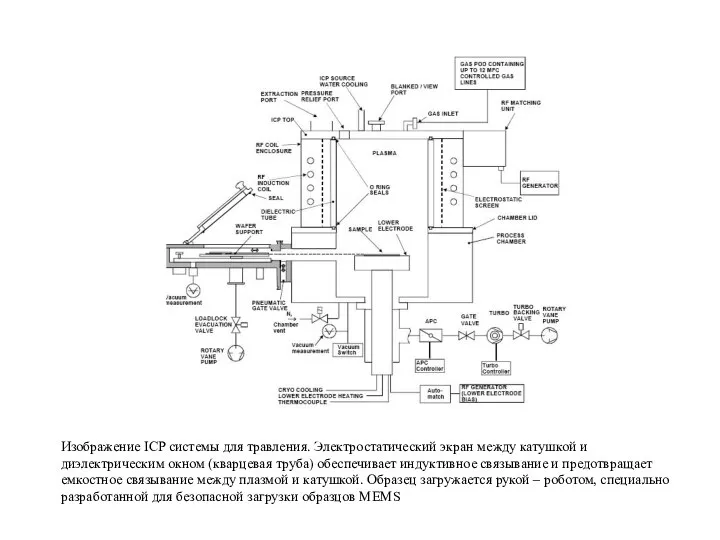
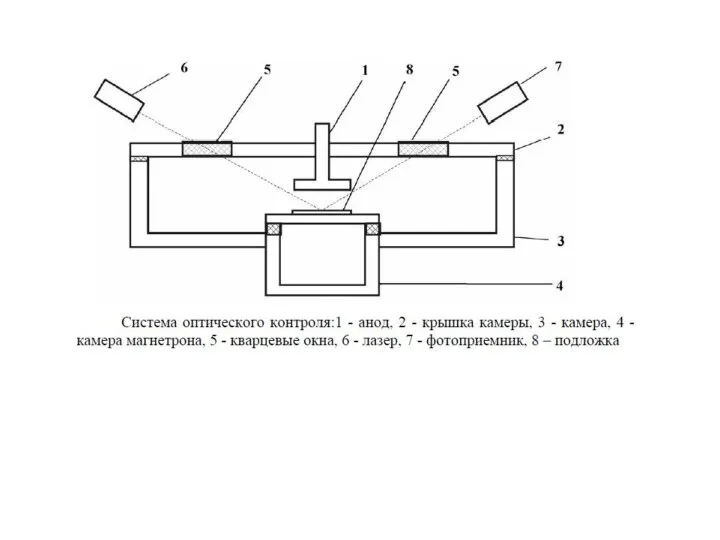
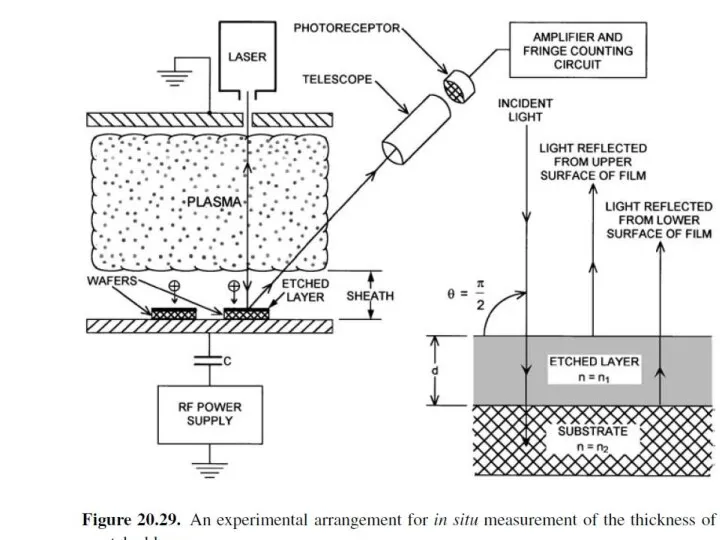
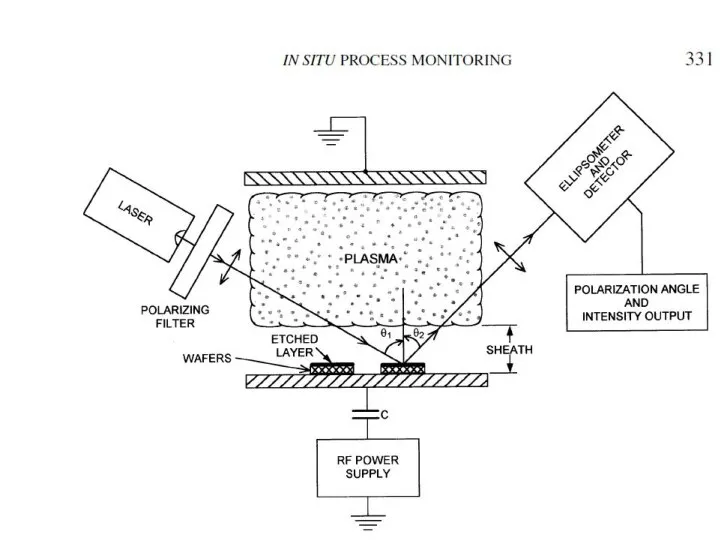




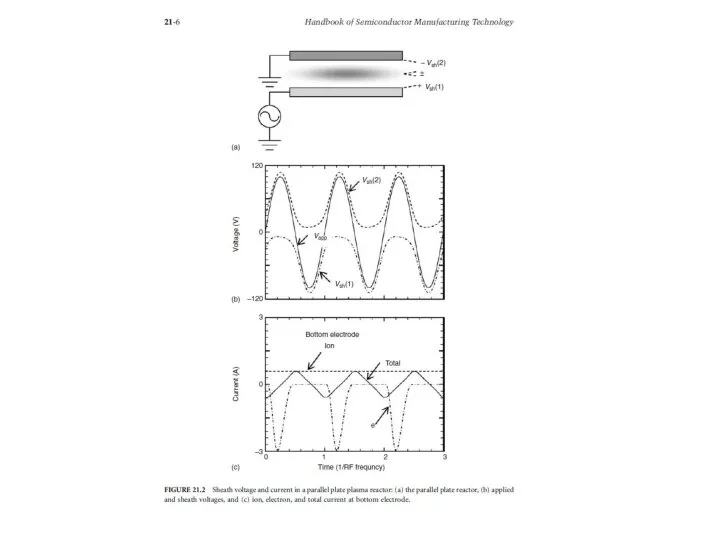
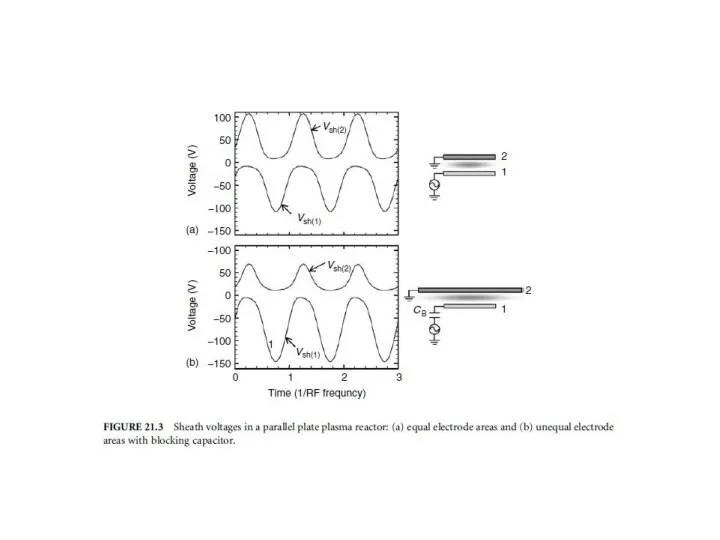
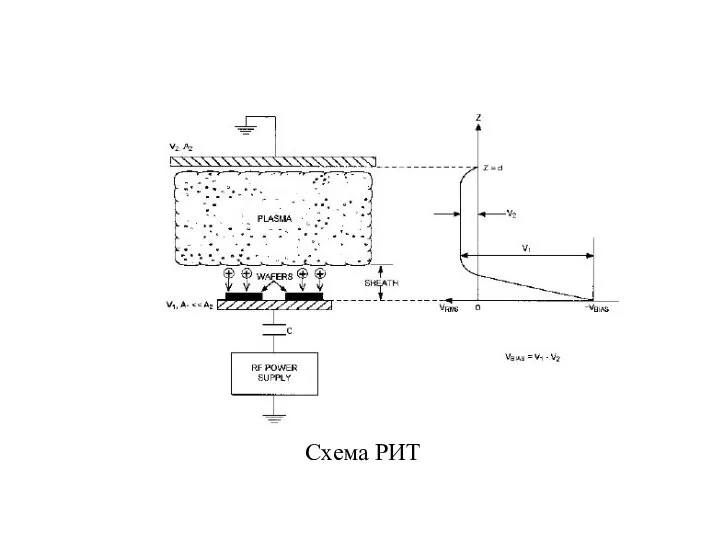
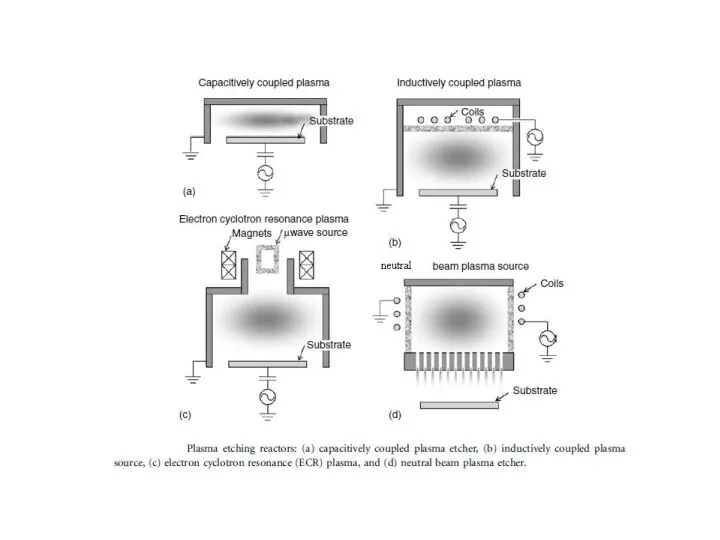
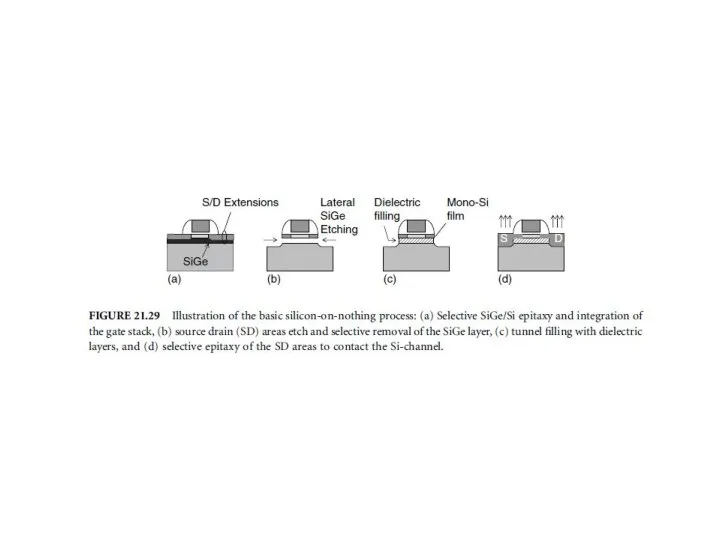



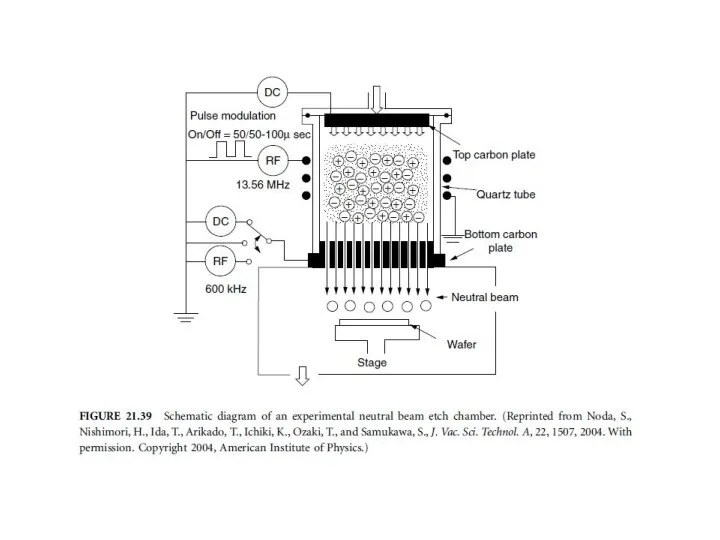
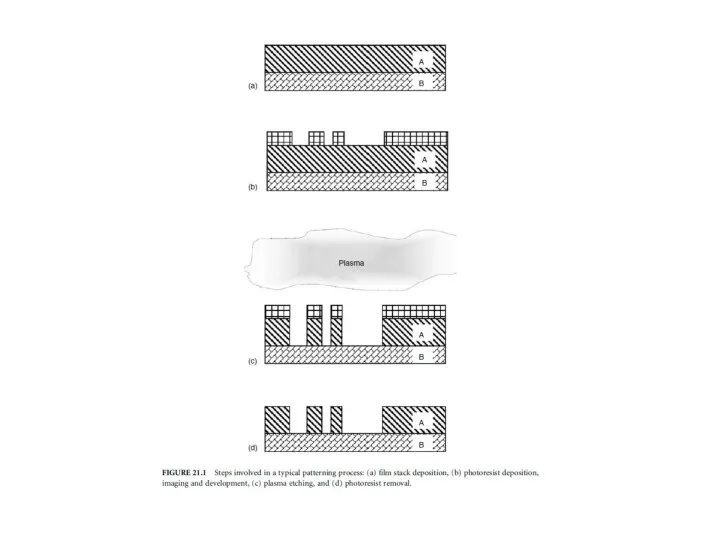
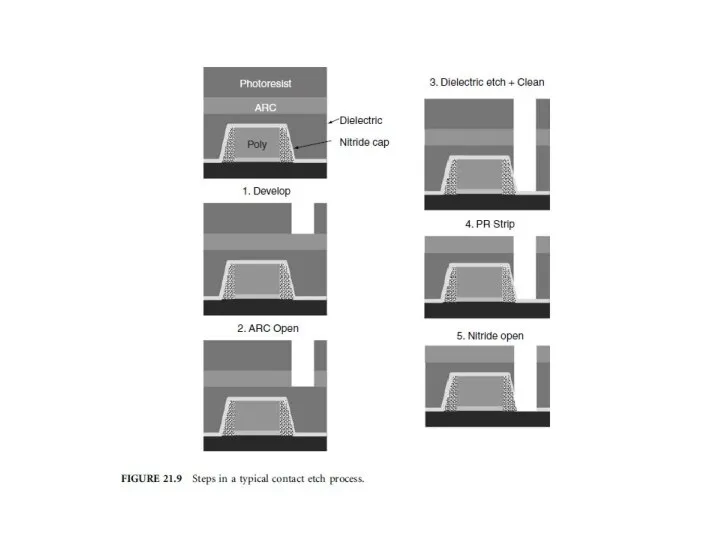


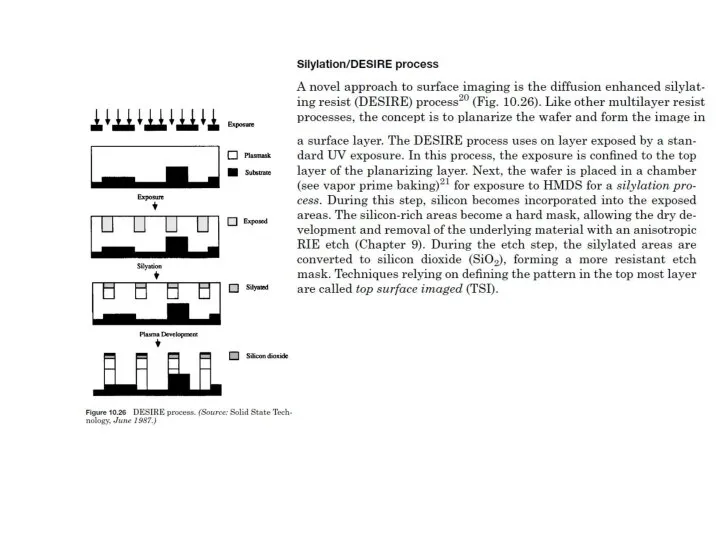


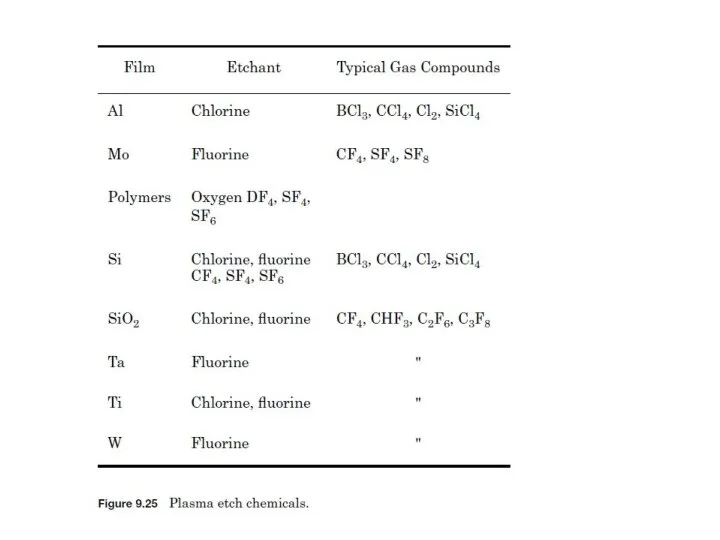








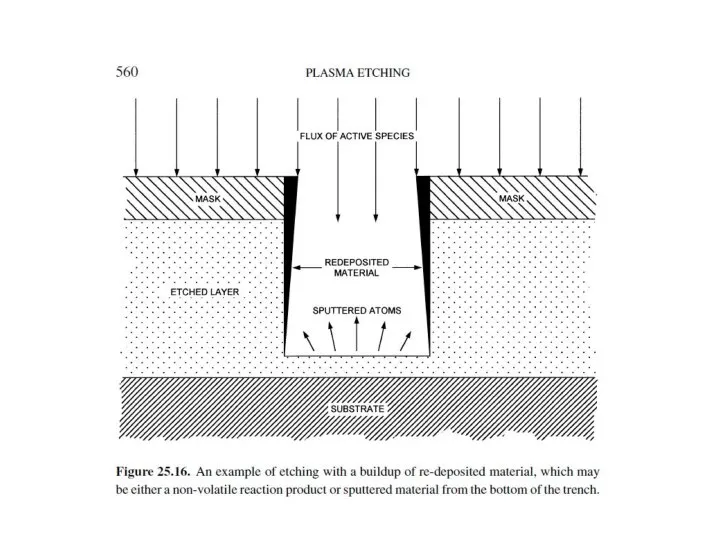


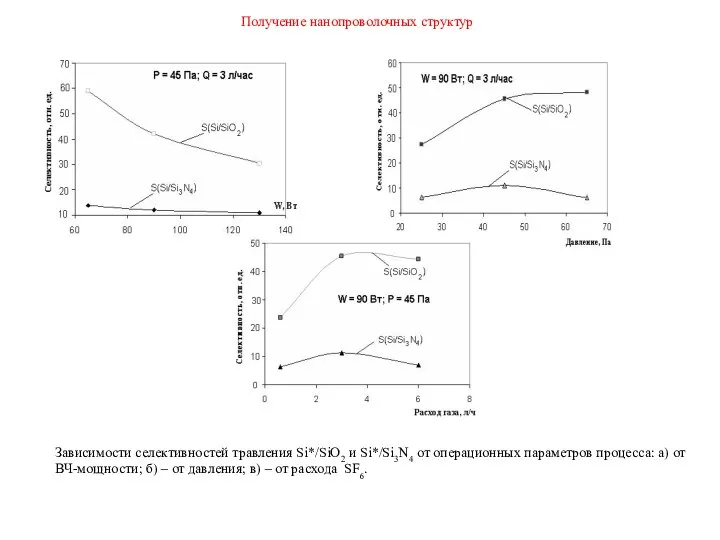
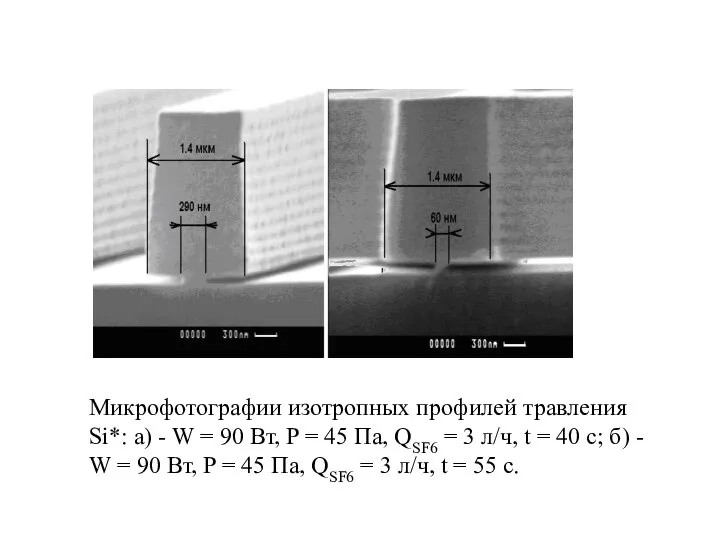
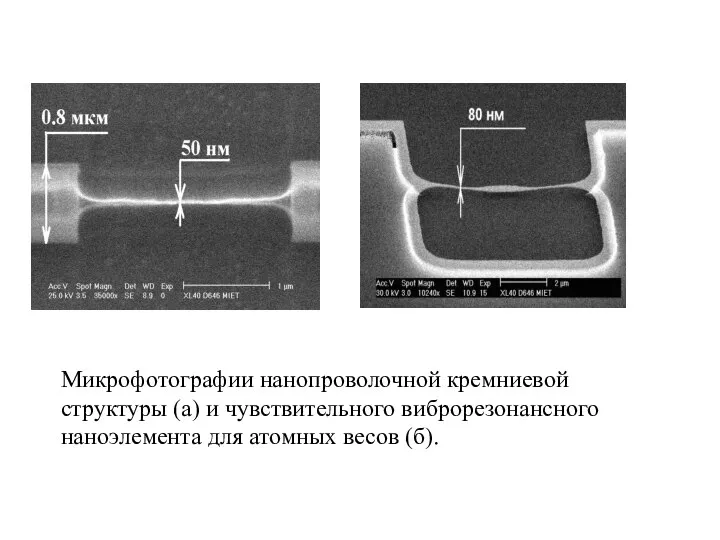
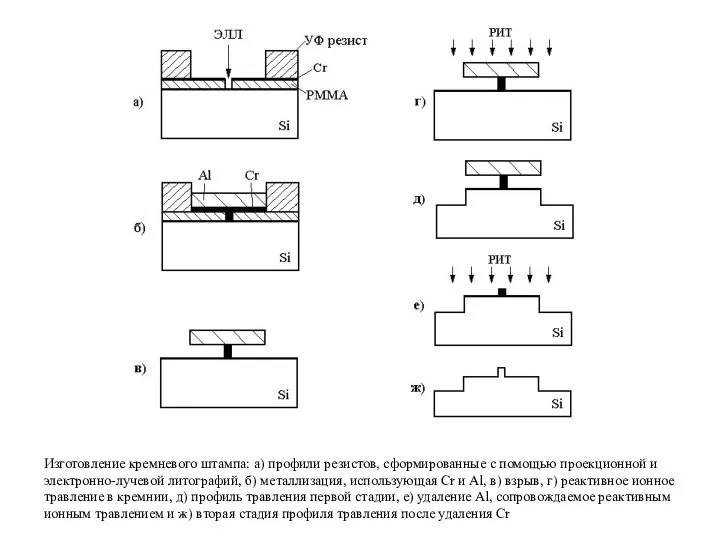

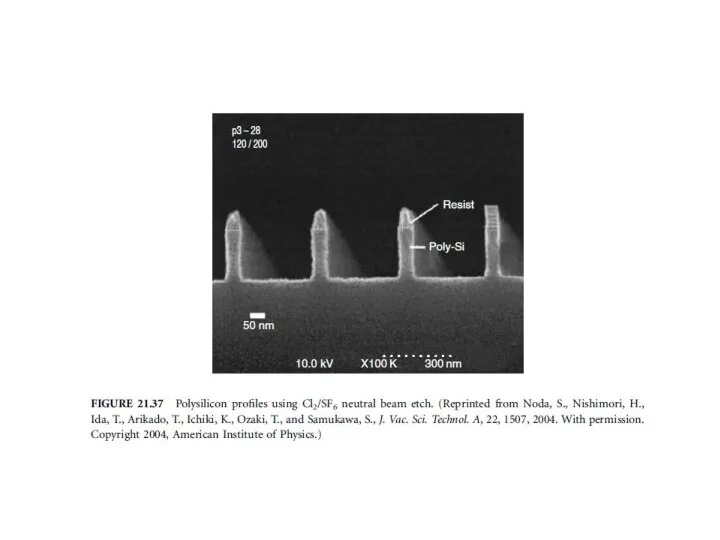
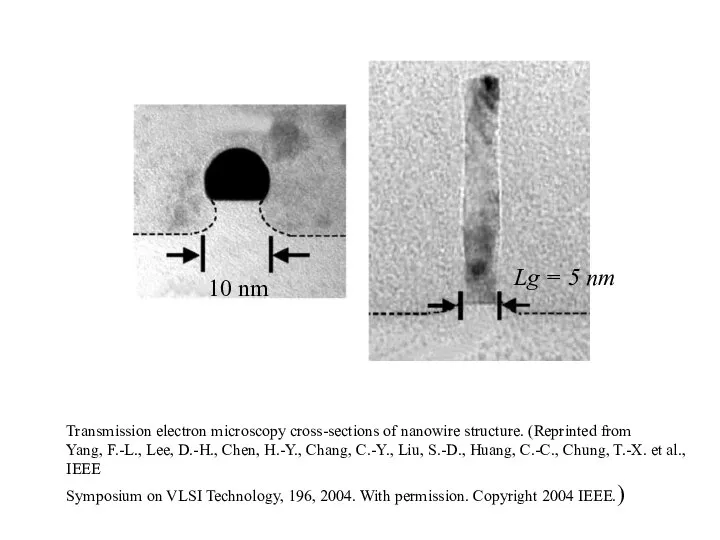








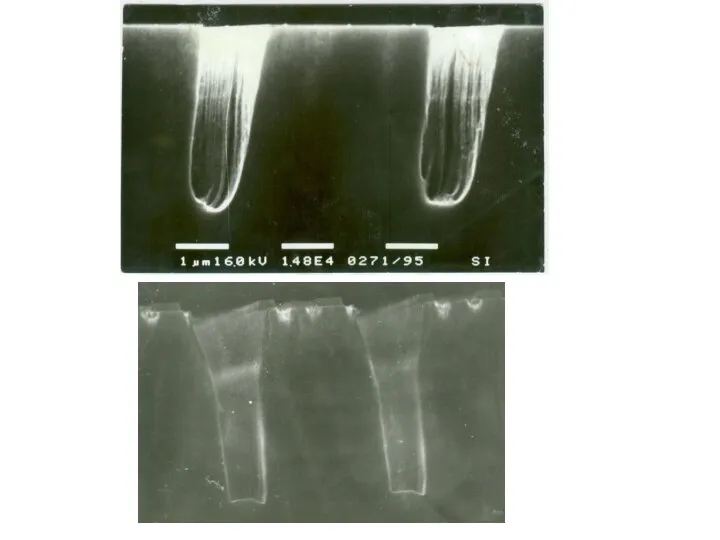

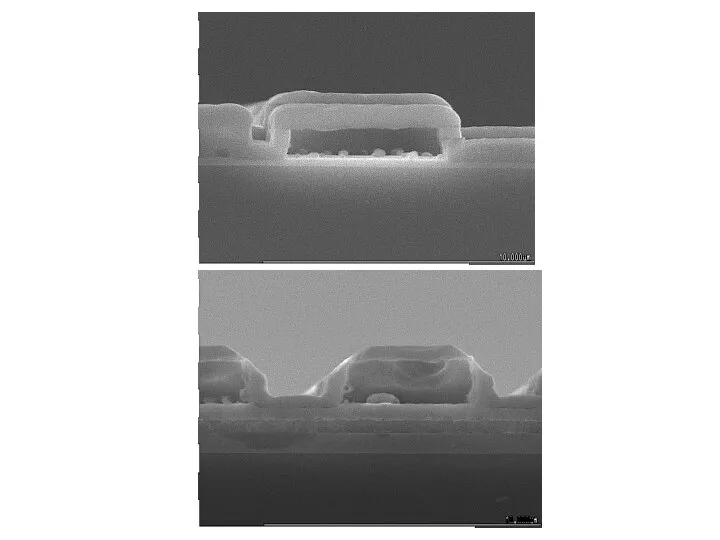
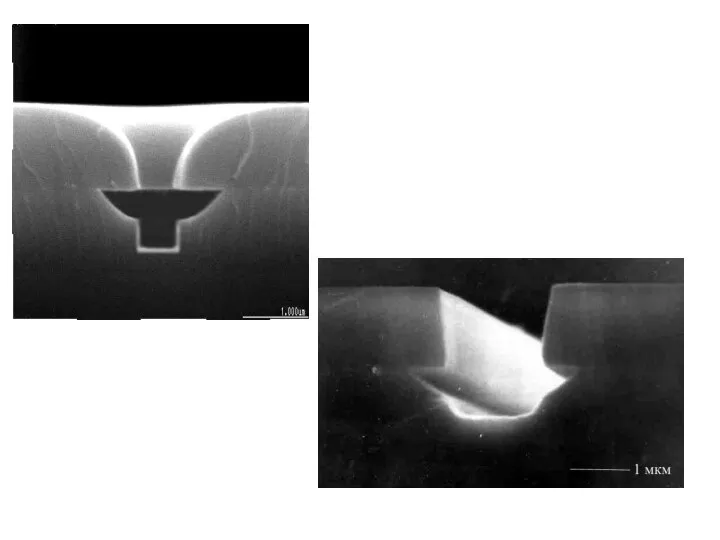



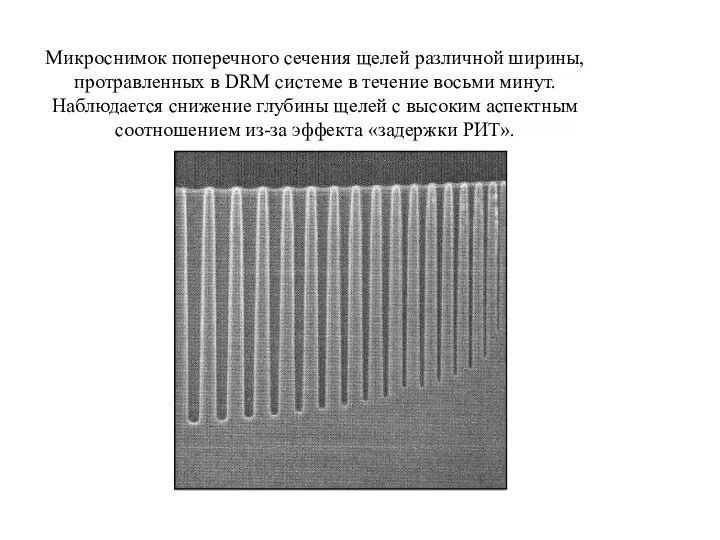
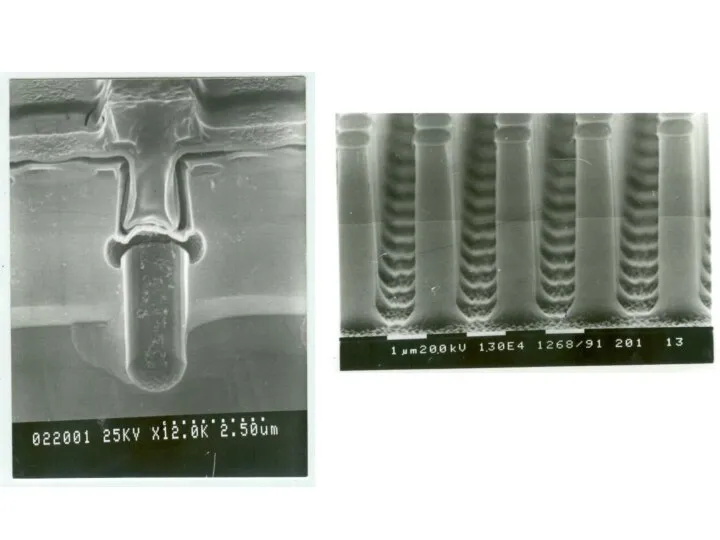


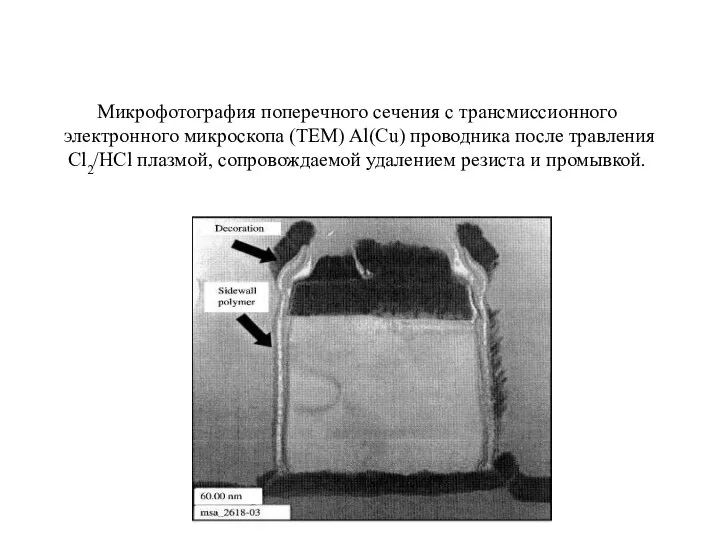
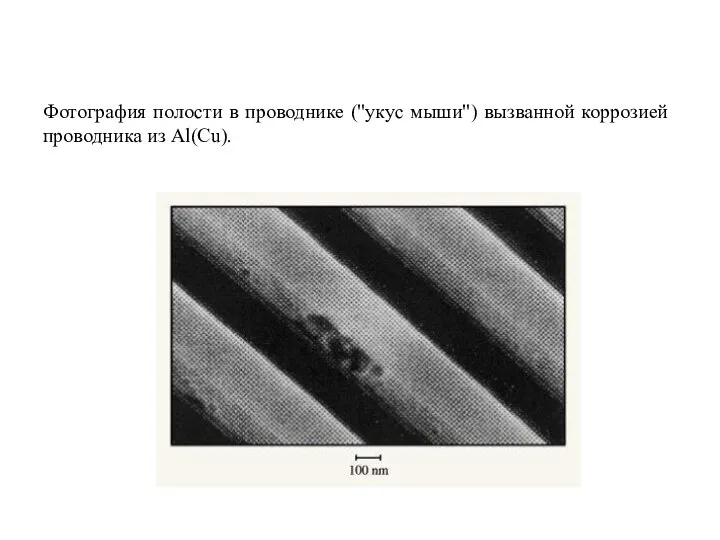

 - ФУНКЦИЈА ШКОЛСКЕ БИБЛИОТЕКЕ У МУЛТИДИСЦИПЛИНАРНОМ МЕТОДУ И МУЛТИМЕДИЈАЛНОМ ПРИСТУПУ НАСТАВИ И ВАННАСТАВНИМ АКТИВНОСТИМА - Славица Јурић, ОШ “Свети Сава” Бачка Паланка
- ФУНКЦИЈА ШКОЛСКЕ БИБЛИОТЕКЕ У МУЛТИДИСЦИПЛИНАРНОМ МЕТОДУ И МУЛТИМЕДИЈАЛНОМ ПРИСТУПУ НАСТАВИ И ВАННАСТАВНИМ АКТИВНОСТИМА - Славица Јурић, ОШ “Свети Сава” Бачка Паланка Unity скрипты
Unity скрипты Работу подготовила Кириакова Диана Учитель Маркова Юлия Викторовна
Работу подготовила Кириакова Диана Учитель Маркова Юлия Викторовна  МУФТЫ
МУФТЫ Презентация "Внешнеэкономическая деятельность предприятия" - скачать презентации по Экономике
Презентация "Внешнеэкономическая деятельность предприятия" - скачать презентации по Экономике Поисковые системы Интернет
Поисковые системы Интернет Дымковская игрушка
Дымковская игрушка Извлечение фактов из текста. Математическая лингвистика
Извлечение фактов из текста. Математическая лингвистика Экономические показатели
Экономические показатели Арабо-мусульманский тип культуры
Арабо-мусульманский тип культуры Святая Нижегородская земля. Мордовские корни. Национальные костюмы
Святая Нижегородская земля. Мордовские корни. Национальные костюмы Инвестиции
Инвестиции Мониторинг прессы по проекту "Форма для Национальной олимпийской сборной Украины" by Andre Tan
Мониторинг прессы по проекту "Форма для Национальной олимпийской сборной Украины" by Andre Tan Презентация Становление философских систем в эпоху античности
Презентация Становление философских систем в эпоху античности Политические новости Галибина Любовь Т - 114
Политические новости Галибина Любовь Т - 114  Какие русские народные праздники без хоровода
Какие русские народные праздники без хоровода Шишкин Иван Иванович
Шишкин Иван Иванович  Энергетические характеристики и разложение в ряд
Энергетические характеристики и разложение в ряд Викторина. Знаешь-ли ты этикет
Викторина. Знаешь-ли ты этикет Классный час в УКПСИЗО Учитель Афанасьева Н.Н.
Классный час в УКПСИЗО Учитель Афанасьева Н.Н. Изучение озелененных территорий общего пользования (ОТОП) Нижнего Новгорода
Изучение озелененных территорий общего пользования (ОТОП) Нижнего Новгорода Анализ затрат на производство
Анализ затрат на производство Зримая музыка. 8 класс
Зримая музыка. 8 класс Презентация на тему "Физиологическая роль оксида азота" - скачать презентации по Медицине
Презентация на тему "Физиологическая роль оксида азота" - скачать презентации по Медицине ЦРТД и Ю г. Королёв. Проект «Международный Олимпийский комитет»
ЦРТД и Ю г. Королёв. Проект «Международный Олимпийский комитет» Сущность, принципы и функции права
Сущность, принципы и функции права Содержание и организационные формы физической культуры в ВУЗах. Структурные особенности учебного процесса
Содержание и организационные формы физической культуры в ВУЗах. Структурные особенности учебного процесса Сибирские мумии. Татуировки вождя и принцессы
Сибирские мумии. Татуировки вождя и принцессы