Содержание
- 2. Создание скрытого коллекторного слоя Обработка поверхности пластины кремния p -типа Окисление Фотолитография – формирование рисунка в
- 3. Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности) Окисление с разгонкой
- 4. Создание глубокого коллектора Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности)
- 5. Создание пассивной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 6. Создание активной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 7. Создание эмиттера Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности) Окисление
- 8. Создание металлизации Фотолитография – вскрытие окон в оксиде для создания контактов к областям Напыление алюминия с
- 9. Изготовление биполярной ИС с изопланарной изоляцией транзисторов
- 10. Локальное окисление кремния
- 11. Создание скрытого коллекторного слоя Обработка поверхности пластины кремния p -типа Окисление Фотолитография – формирование рисунка в
- 12. Создание изолирующих областей Нанесение нитрида кремния химическим осаждением из газовой фазы Фотолитография – формирование рисунка в
- 13. Создание глубокого коллектора Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности)
- 14. Создание пассивной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 15. Создание активной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 16. Создание эмиттера Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности) Окисление
- 17. Создание металлизации Фотолитография – вскрытие окон в оксиде для создания контактов к областям Напыление алюминия с
- 18. Изготовление биполярной ИС с щелевой изоляцией транзисторов
- 20. Создание скрытого коллекторного слоя Обработка поверхности пластины кремния p -типа Загонка мышьяка (диффузия из источника неограниченной
- 21. Создание изолирующих областей Фотолитография – формирование рисунка в оксиде Ионное травление канавок до глубины средней канавки
- 22. Создание глубокого коллектора Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности)
- 23. Создание пассивной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 24. Создание активной базы Фотолитография – формирование рисунка в оксиде Загонка бора (диффузия из источника неограниченной мощности)
- 25. Создание эмиттера Фотолитография – формирование рисунка в оксиде Загонка фосфора (диффузия из источника неограниченной мощности) Окисление
- 27. Скачать презентацию



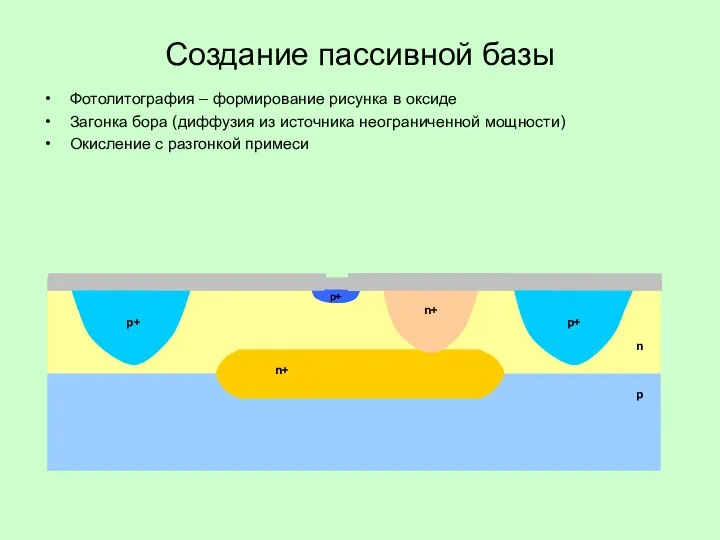

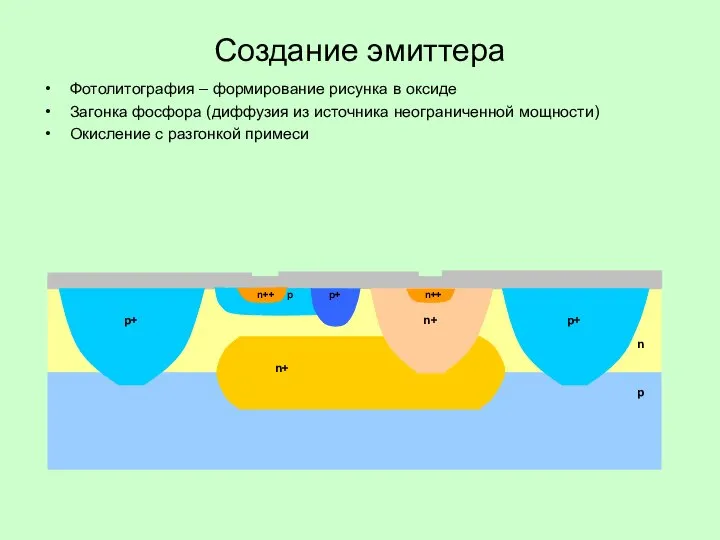
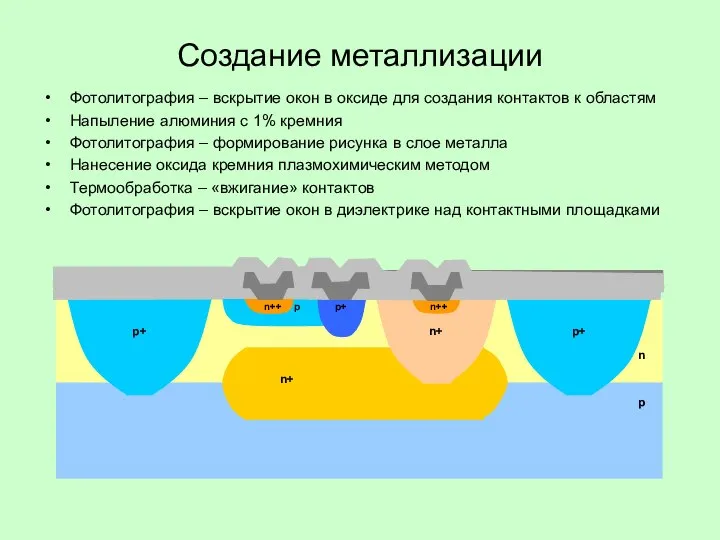

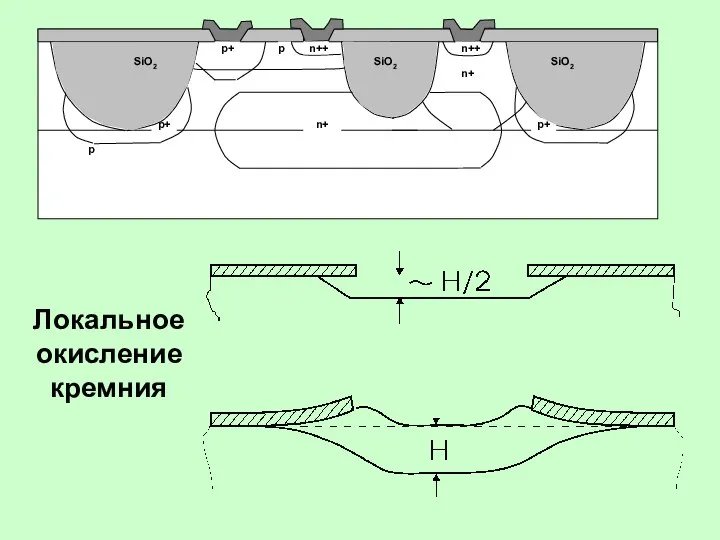

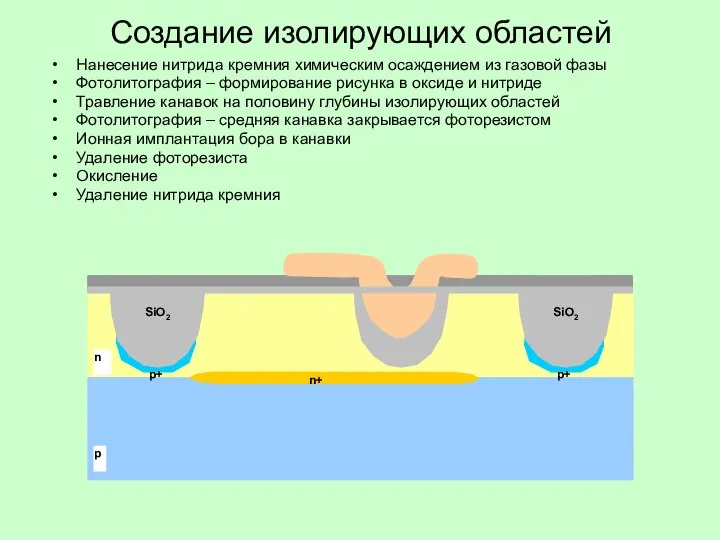













 Презентация на тему "Здоровьесбережение в учебном процессе" - скачать презентации по Педагогике
Презентация на тему "Здоровьесбережение в учебном процессе" - скачать презентации по Педагогике Монументально-декоративное искусство Японии
Монументально-декоративное искусство Японии Языки программирования высокого уровня
Языки программирования высокого уровня Потоки произвольного вида
Потоки произвольного вида ЛИЧНОСТНО-ОРИЕНТИРОВАННЫЙ ПОДХОД В ВОСПИТАНИИ ДЕТЕЙ С ОГРАНИЧЕННЫМИ ВОЗМОЖНОСТЯМИ ЗДОРОВЬЯ Подготовила воспитатель ГКОУ сп
ЛИЧНОСТНО-ОРИЕНТИРОВАННЫЙ ПОДХОД В ВОСПИТАНИИ ДЕТЕЙ С ОГРАНИЧЕННЫМИ ВОЗМОЖНОСТЯМИ ЗДОРОВЬЯ Подготовила воспитатель ГКОУ сп Лоббизм как объект корпоративного управления
Лоббизм как объект корпоративного управления The olympics games
The olympics games ОКРУЖАЮЩИЙ МИР Семён Иванович Дежнёв
ОКРУЖАЮЩИЙ МИР Семён Иванович Дежнёв  АКТУАЛЬНЫЕ ВОПРОСЫ В ОБЛАСТИ МЕТРОЛОГИИ
АКТУАЛЬНЫЕ ВОПРОСЫ В ОБЛАСТИ МЕТРОЛОГИИ РОССИЯ И ГЕРМАНИЯ: РАЗМЕЖЕВАВШИЕСЯ ПАРТНЁРЫ Нечаева Анастасия, Юрлова Виктория, ДС.02
РОССИЯ И ГЕРМАНИЯ: РАЗМЕЖЕВАВШИЕСЯ ПАРТНЁРЫ Нечаева Анастасия, Юрлова Виктория, ДС.02 Базовые основы системной инженерии
Базовые основы системной инженерии Логические задания!
Логические задания! Товарная номенклатура внешнеэкономической деятельности Общая характеристика и порядок применения ТН ВЭД
Товарная номенклатура внешнеэкономической деятельности Общая характеристика и порядок применения ТН ВЭД евпрм
евпрм  Презентация Политическая система общества
Презентация Политическая система общества Гемостаз и гемореалогия
Гемостаз и гемореалогия Електромагнітні явища. Потік вектора магнітної індукції. (Лекція 14)
Електромагнітні явища. Потік вектора магнітної індукції. (Лекція 14) Системы счисления Введение Двоичная система Восьмеричная система Шестнадцатеричная система Другие системы счисления
Системы счисления Введение Двоичная система Восьмеричная система Шестнадцатеричная система Другие системы счисления  Образы и темы в народном искусстве Руси
Образы и темы в народном искусстве Руси Terroryzm międzynarodowy
Terroryzm międzynarodowy Cartoon constructor similar
Cartoon constructor similar Презентация на тему "ПРОФИЛАКТИКА ЗАБОЛЕВАНИЙ ПАРОДОНТА У ДЕТЕЙ" - скачать презентации по Медицине
Презентация на тему "ПРОФИЛАКТИКА ЗАБОЛЕВАНИЙ ПАРОДОНТА У ДЕТЕЙ" - скачать презентации по Медицине День героя 9 декабря
День героя 9 декабря Русский язык
Русский язык Презентация "Всемирный банк в Казахстане" - скачать презентации по Экономике
Презентация "Всемирный банк в Казахстане" - скачать презентации по Экономике Веселая мышка
Веселая мышка Противоположные числа Какие числа называют противоположными? Как на координатной прямой располагаются точки, соответствующи
Противоположные числа Какие числа называют противоположными? Как на координатной прямой располагаются точки, соответствующи Проектирование летательного аппарата с разработкой регулятора подачи окислителя в КС
Проектирование летательного аппарата с разработкой регулятора подачи окислителя в КС