Содержание
- 7. Основы технологии наноэлектроники Схема установки MBE для получения легированных тройных соединений. Вся установка размещается в камере
- 8. Основы технологии одноэлектроники Элементарные процессы в зоне роста: 1.Адсорбция атомов из зоны смешивания на поверхности, 2.
- 9. Основы технологии одноэлектроники Схема горизонтального реактора открытого типа с охлаждаемыми стенками для MOCVD: 1. Кварцевый корпус,
- 14. Одним из определяющих технологических процессов в микроэлектронике в течение более 40 лет продолжает оставаться литография. Литография
- 15. 10 ступеней литографического процесса. 1. Подготовка поверхности (промывка и сушка) 2. Нанесение резиста (тонкая пленка полимера
- 16. 6. Стабилизирующий отжиг (удаление остатков растворителя) 7. Контроль и исправление дефектов. 8. Травление (Непосредственный перенос рисунка
- 17. ПРИМЕНЕНИЕ ОПТИЧЕСКОЙ ЛИТОГРАФИИ ДЛЯ ПОЛУЧЕНИЯ СТРУКТУР НАНОРАЗМЕРНОГО МАСШТАБА. Минимальный размер рисунка, который может быть разрешен с
- 18. Конструкция туннельного резонансного транзистора и структура с набором квантовых точек.
- 19. Определение аспектного отношения. Aspect ratio>>1
- 20. Фазосдвигающее маски. а) Шаблон без сдвига фазы. б) Шаблон с фазовым сдвигом.
- 21. Многослойные резисты. Применение двухслойного резиста с антиотражающим покрытием (АОП).
- 22. Литография с двухслойным резистом различной полярности.
- 23. «Lift-off» процесс.
- 24. Иммерсионная литография
- 26. Double patterning
- 28. АЛЬТЕРНАТИВНЫЕ ИСТОЧНИКИ ЭКСПОНИРОВАНИЯ. Для получения структур с разрешением ниже 100 нм становится обоснованным использование принципиально новых
- 29. ЛИТОГРАФИЯ С ЭКСТРЕМАЛЬНЫМ УЛЬТРАФИОЛЕТОМ. EUVL является обычной оптической литографией, но с использованием излучения с длиной волны
- 30. Схема EUV литографии.
- 31. Схема маски для EUV литографии.
- 32. ПРОЕКЦИОННАЯ ЭЛЕКТРОННО-ЛУЧЕВАЯ ЛИТОГРАФИЯ. ОГРАНИЧЕНИЯ ПРОЕКЦИОННОЙ ЭЛЛ: 1.Термический нагрев маски. 2. Большие числовые апертуры. Понимание ограничений адсорбционной
- 33. Принцип работы системы SCALPEL:
- 34. Электроны проходящие через мембраны рассеиваются на малые углы, тогда как рисунок рассеивает электроны на большие углы.
- 38. Травление микроструктур
- 39. Физическое травление Плазменное травление Катод (-) Подложкодержатель снагревателем Si SiO2 Anod (+)
- 41. Катодное распыление + +
- 42. Катодное распыление Еi >Eth; Eth- пороговая энергия распыления. Eth слабозависит от атомной массы ионов и мишени
- 43. Катодное распыление Угловое распределение распыленных атомов при энергии ионов 1-10 keV косинусному закону Nα = N0cosα
- 44. Катодное распыление Коэффициент распыления Y = Na/Ni Y зависит от атомного номера мишени. Теория Зигмунда Для
- 45. Схема реактивного ионного травления Ионизация Химическая реакция Продукты реакции удаляются Вакуумной системой
- 46. Реактивное ионное травление (RIE)
- 47. Цилиндрические реакторы
- 48. ТРАВЛЕНИЕ НАНОСТРУКТУР
- 49. Типовая установка (Oxford instruments) RIE technology top electrode with shower head gas inlet substrate electrode with
- 50. typical process pressure: 5 - 150 mtorr plasma density: ca 1 - 5 x 109 /
- 51. ТРАВЛЕНИЕ НАНОСТРУКТУР
- 54. ЧУВСТВИТЕЛЬНОСТЬ ОПТИКА λ = 1060 nm 1 mJ/sm2 λ = 560 nm 0,5 mJ/sm2 λ =
- 55. Линии ванадиево-оксидного резиста на кремнии.
- 56. Definition of ALD ALD is a method of applying thin films to various substrates with atomic
- 57. Brief History of ALD Introduced in 1974 by Dr. Tuomo Suntola and co-workers in Finland to
- 58. ALD Process and Equipments Releases sequential precursor gas pulses to deposit a film one layer at
- 59. ALD Process and Equipments Example: ALD cycle for Al2O3 deposition (Step 1a) Releases sequential precursor gas
- 60. Releases sequential precursor gas pulses to deposit a film one layer at a time. A first
- 61. ALD Process and Equipments Example: ALD cycle for Al2O3 deposition (Step 1c) Releases sequential precursor gas
- 62. ALD Process and Equipments Example: ALD cycle for Al2O3 deposition (Step 2a) Releases sequential precursor gas
- 63. ALD Process and Equipments Example: ALD cycle for Al2O3 deposition (Step 2b) Releases sequential precursor gas
- 64. ALD Process and Equipments Example: ALD cycle for Al2O3 deposition (Step 2c) Releases sequential precursor gas
- 65. ALD Process and Equipments Example: ALD cycle for Al2O3 deposition (after 3 cycles) Releases sequential precursor
- 66. ALD Process and Equipments Releases sequential precursor gas pulses to deposit a film one layer at
- 67. ALD Process and Equipments Four main types of ALD reactors Closed system chambers Open system chambers
- 68. ALD Process and Equipments Four main types of ALD reactors Closed system chambers (most common) Open
- 69. ALD Process and Equipments Four main types of ALD reactors Closed system chambers (most common) The
- 70. ALD Process and Equipments Process Temperature [1] [1] [1] 1 "Technology Backgrounder: Atomic Layer Deposition," IC
- 71. ALD Process and Equipments One cycle Process Temperature [1] [1] [1] Acceptable temperature range for deposition.
- 72. ALD Applications High-K dielectrics for CMOS Semiconductor memory (DRAM) Cu interconnect barrier Deposition in porous structures
- 73. Элементы электронных систем.
- 74. Физические основы наноэлектроники
- 75. Квантовые основы наноэлектроники квантовое размерное ограничение интерференция туннелирование через потенциальные барьеры.
- 76. Квантовое размерное ограничение
- 77. Уравнение Шредингера
- 78. Решения уравнения Шредингера в непериодическом потенциале Решениe уравнения Шредингера для U(x) = const U2 U1 E
- 79. Квантовое размерное ограничение. ΔЕ = 0.02эВ для а=50нм и m=10-27г Δ Е = 0.2эВ для а=5нм
- 80. Квантовое размерное ограничение. ΔЕ = 0.02эВ для а=50нм и m=10-27г Δ Е = 0.2эВ для а=5нм
- 81. Двумерный электронный газ Энергетические зоны на границе двух полупроводников.Есi и Еvi – границы зон проводимости и
- 82. Квантовые ямы Одномерный электронный газ Квантовая яма сформированная в слое полупроводника с узкой запрещенной зоной, заключенном
- 83. Квантовые нити. Одномерный электронный газ Полупроводниковые гетероструктуры с квантовыми нитями, полученные с помощью субмикронной литографии за
- 84. Квантовые точки. Нульмерный электронный газ В квантовой точке движение ограничено в трех направлениях и энергетический спектр
- 85. Интерференция. Эффект Ааронова-Бома.
- 86. Туннелирование Квантовое ограничение, проявляясь в наноразмерных структурах, накладывает специфический отпечаток и на туннелирование. Так, квантование энергетических
- 87. Туннельный резонансный транзистор Схема работы и вольт-амперная характеристика резонансного прибора. а – напряжение равно 0; б
- 88. Туннельный резонансный транзистор
- 89. Одноэлектроника. Одно из самых перспективных направлений увеличения степени интеграции микросхем основано на развитии приборов, в которых
- 90. Одноэлектроника. -е/2 Кулоновская блокада — это явление отсутствия тока при приложении напряжения к туннельному переходу из-за
- 91. Одноэлектроника. Одноэлектронное туннелирование в условиях кулоновской блокады VКБ= е/2С, е=I*t f=I/e, Кулоновская лестница при 4.2 К
- 92. Одноэлектроника.
- 97. Одноэлектроника.
- 100. Скачать презентацию

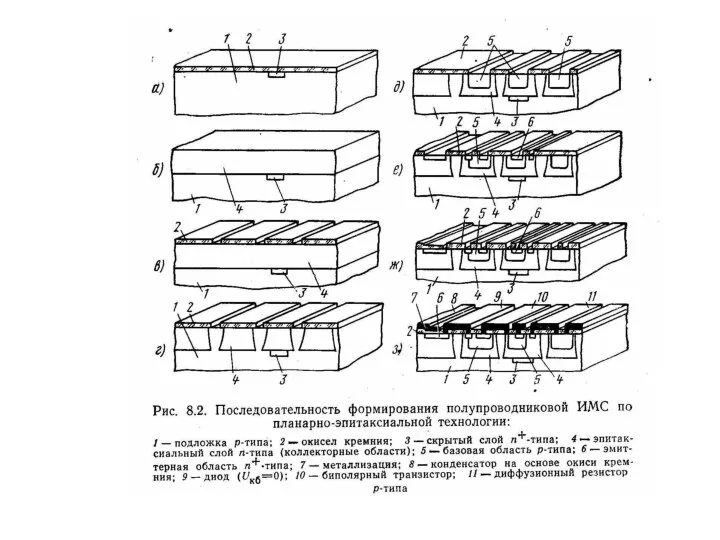

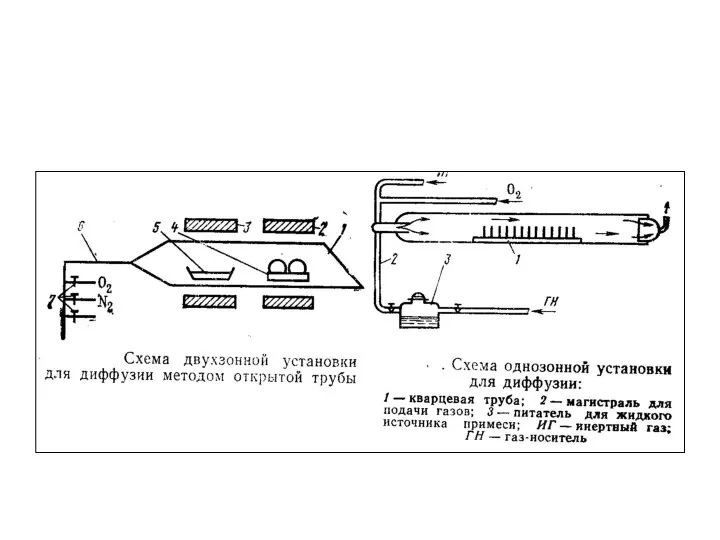
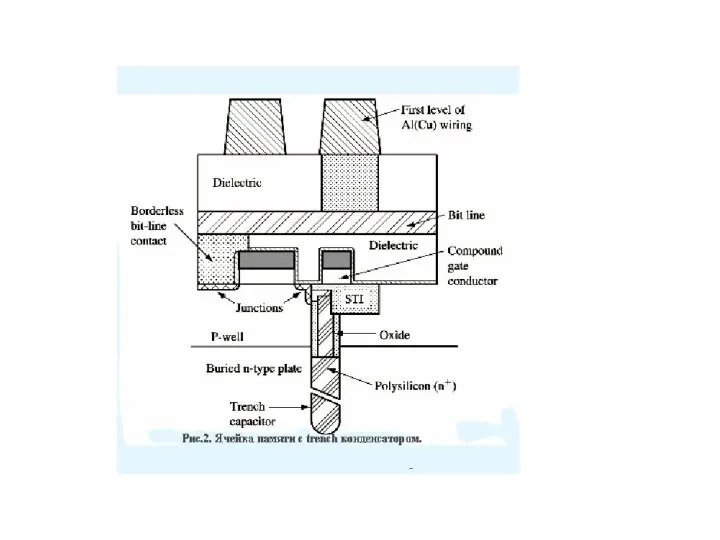








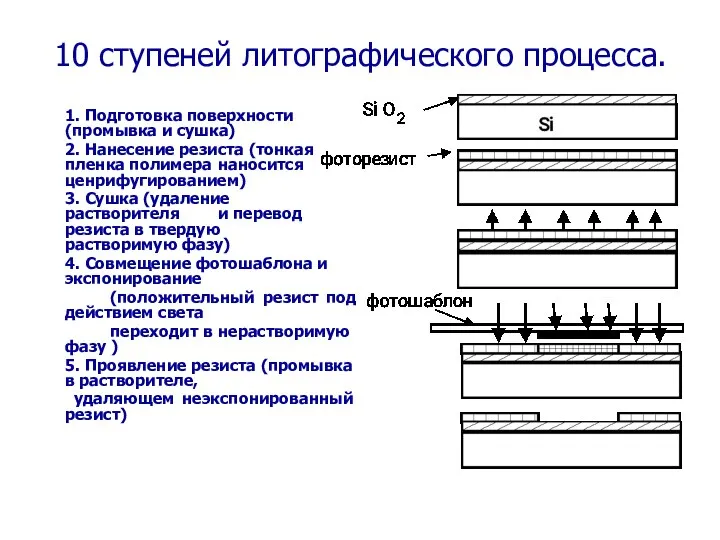



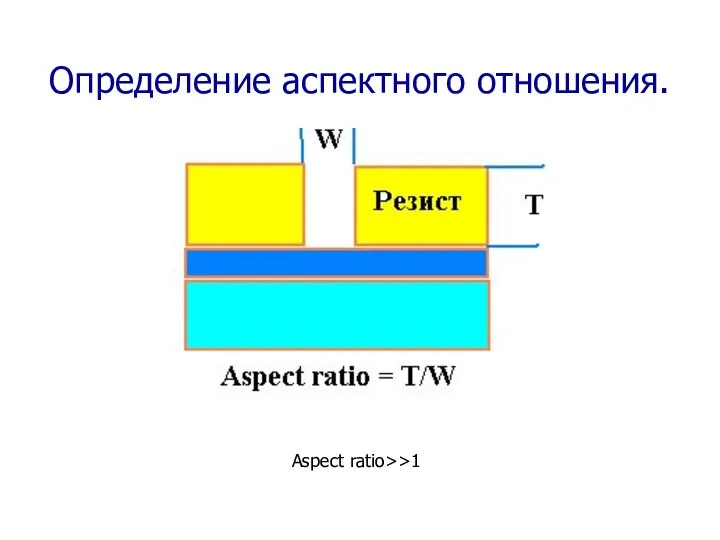
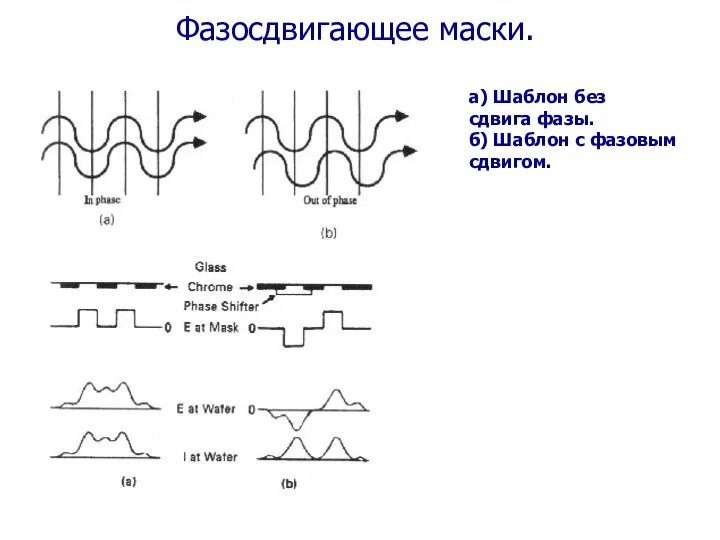
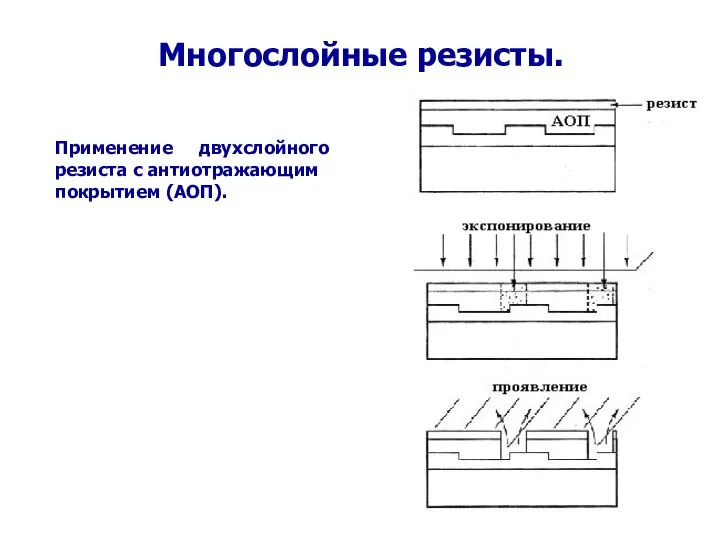


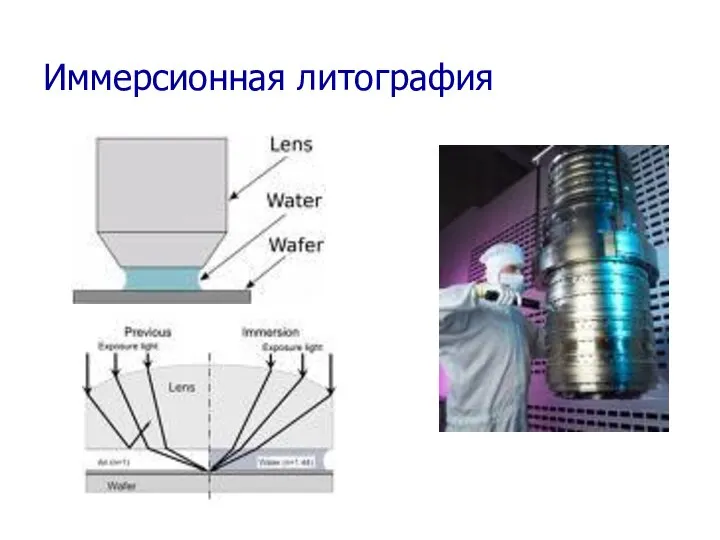
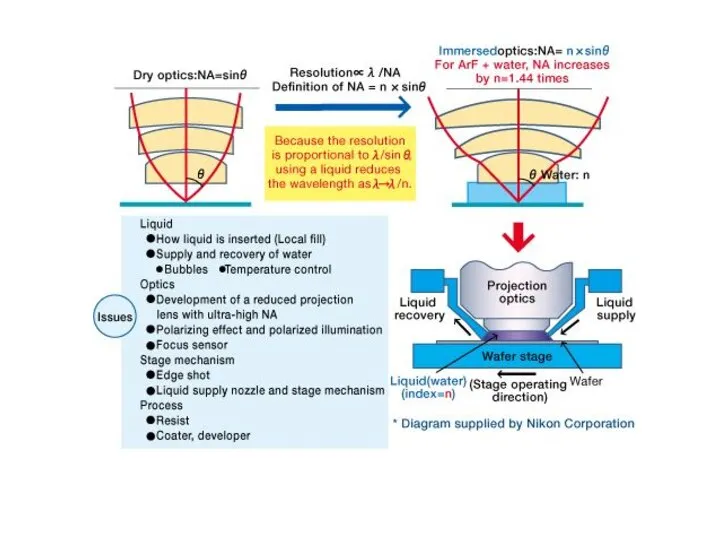
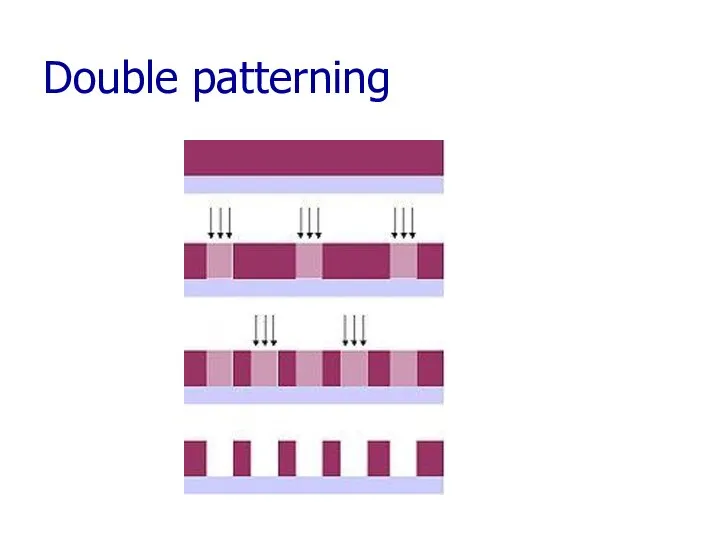



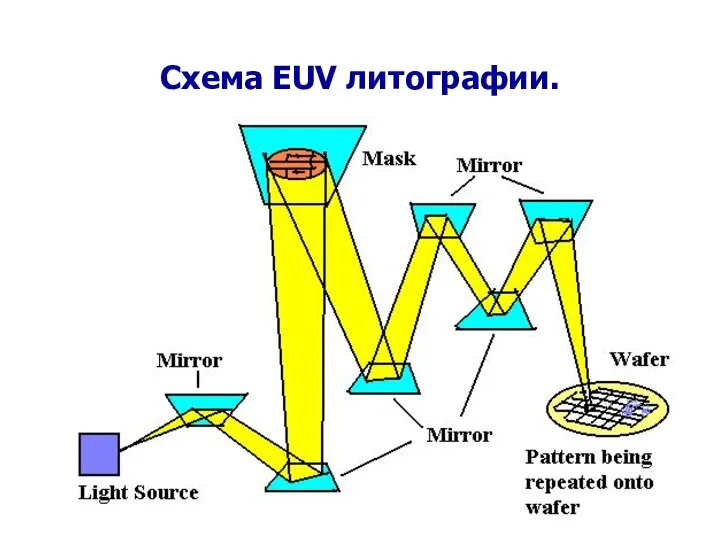
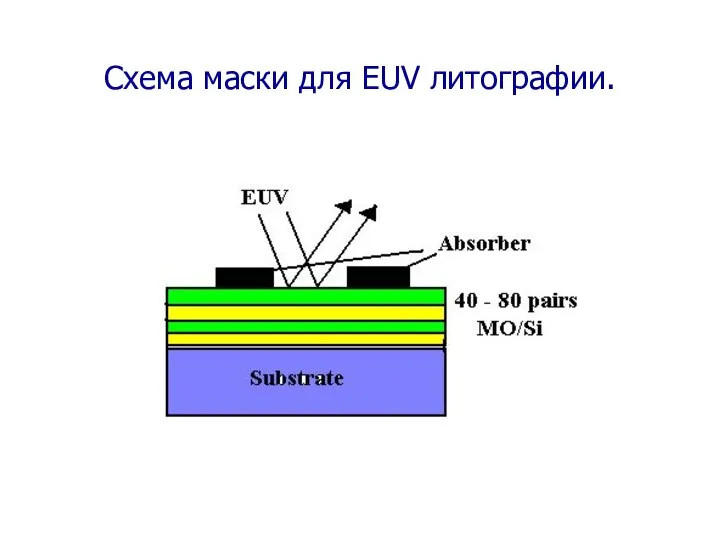

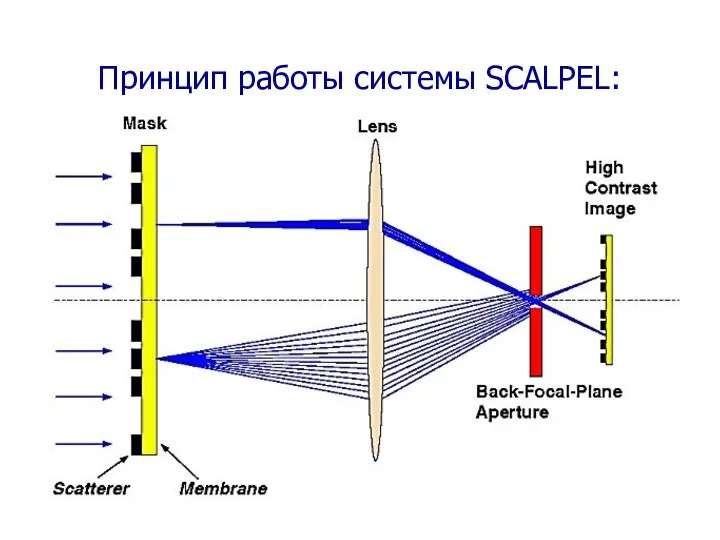

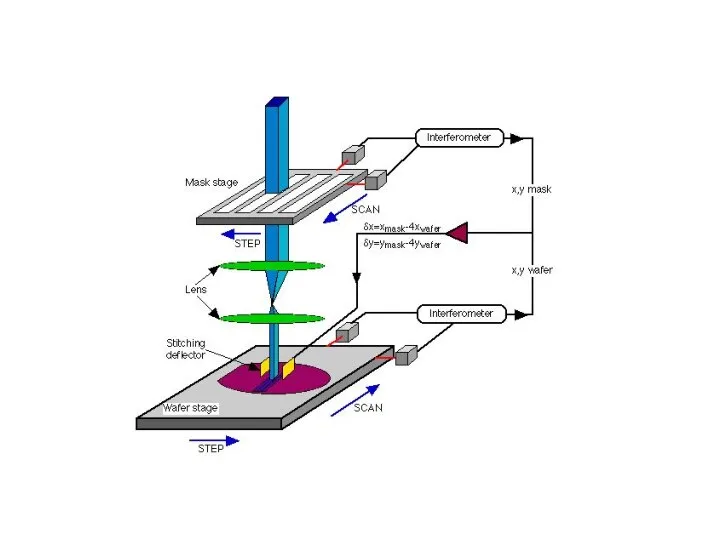
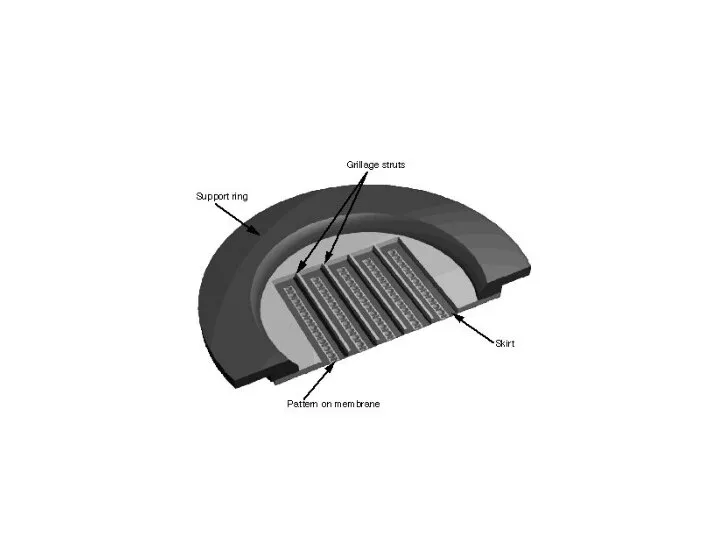
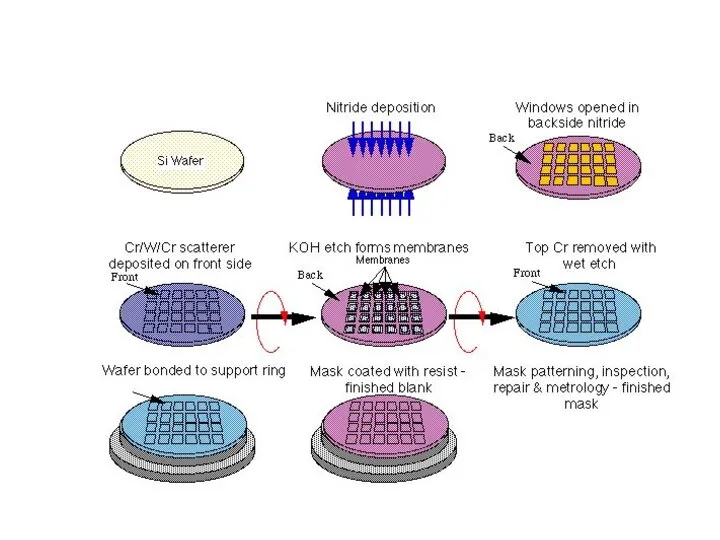

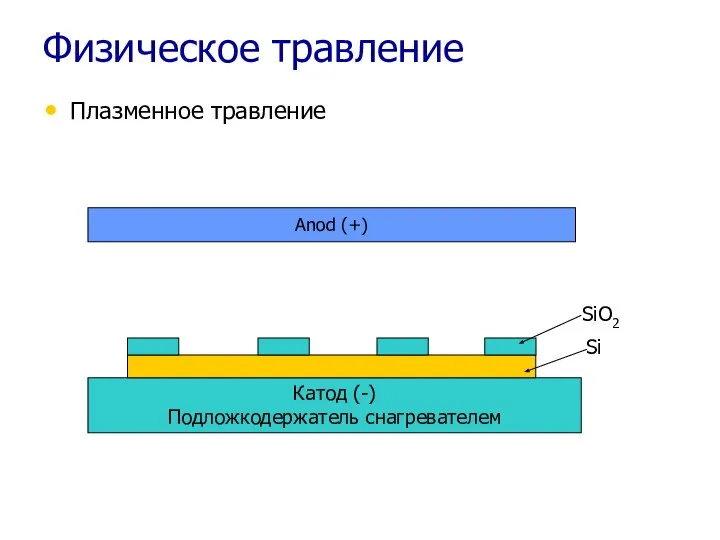
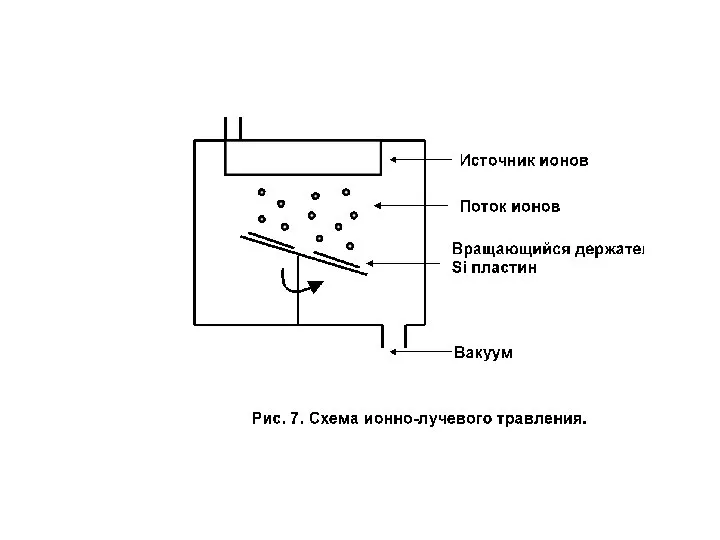
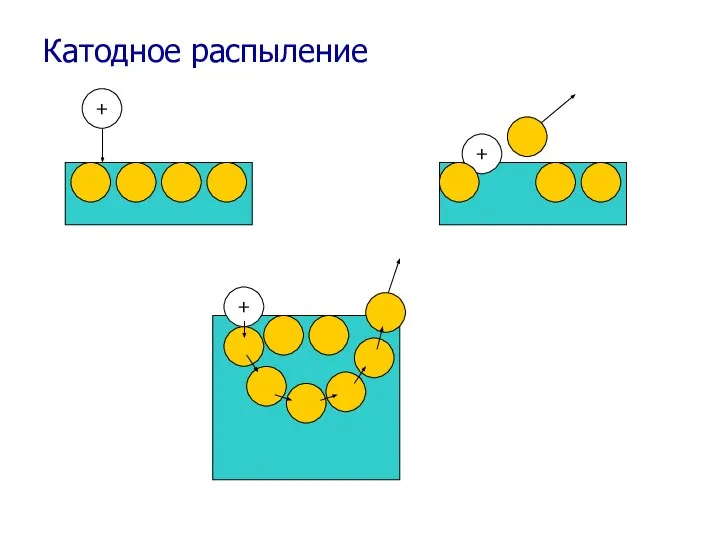



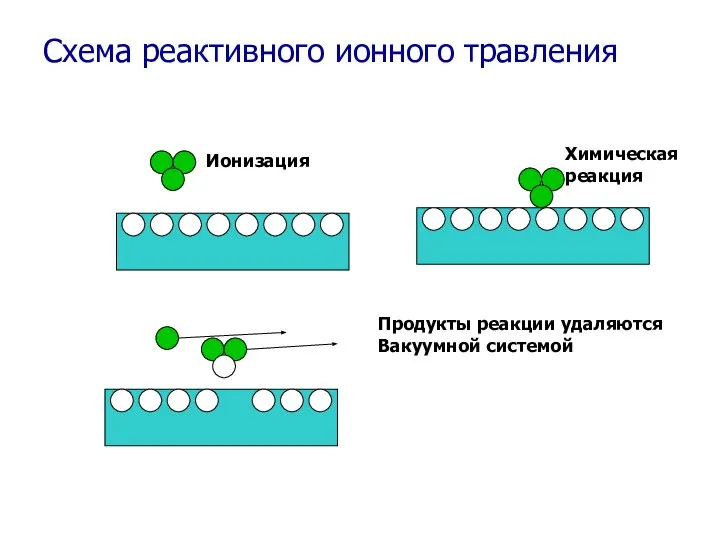

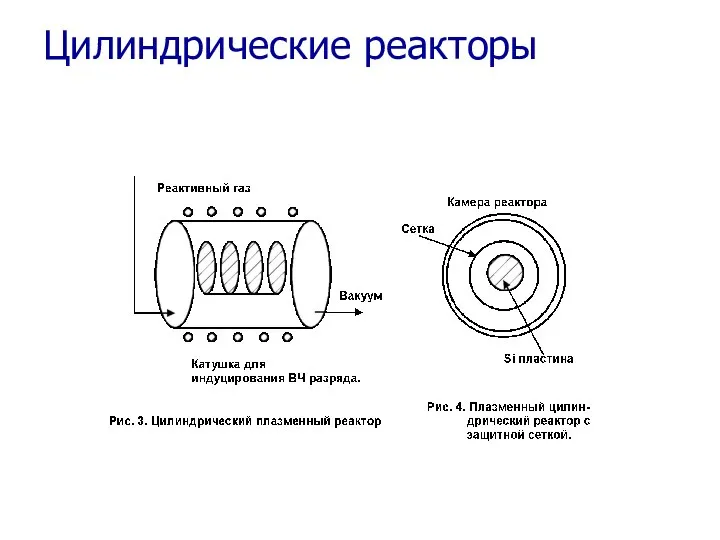
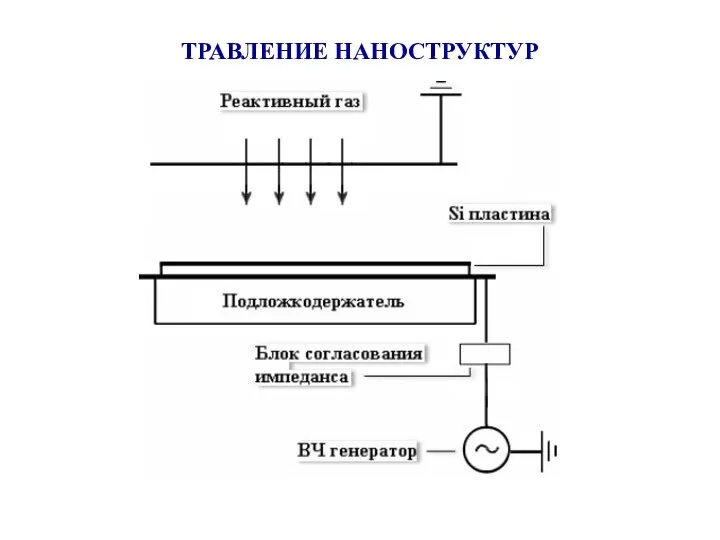
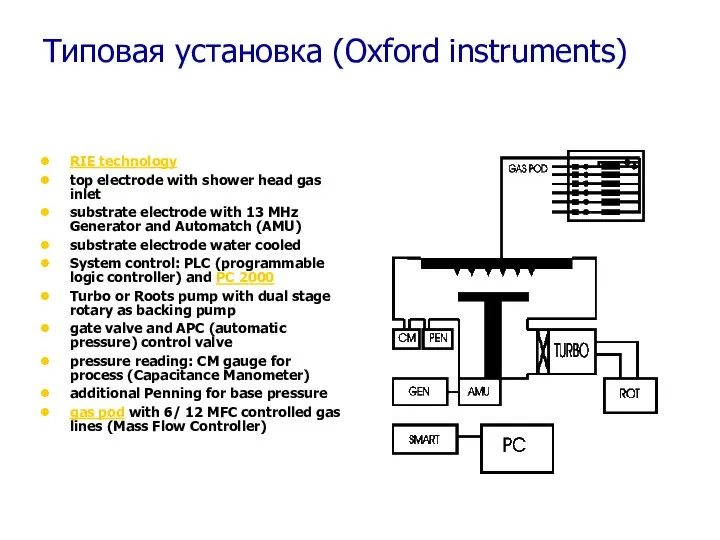



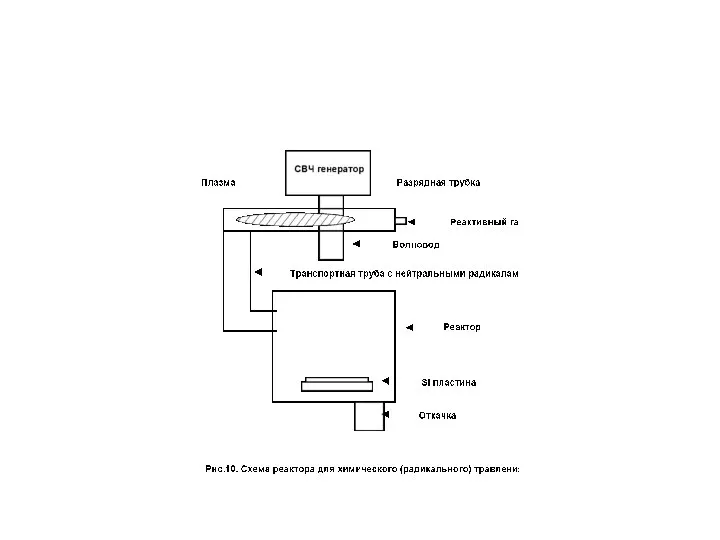




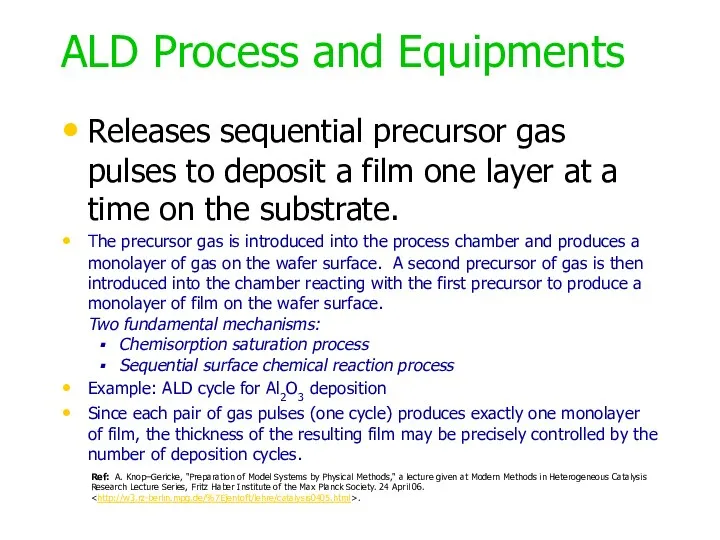
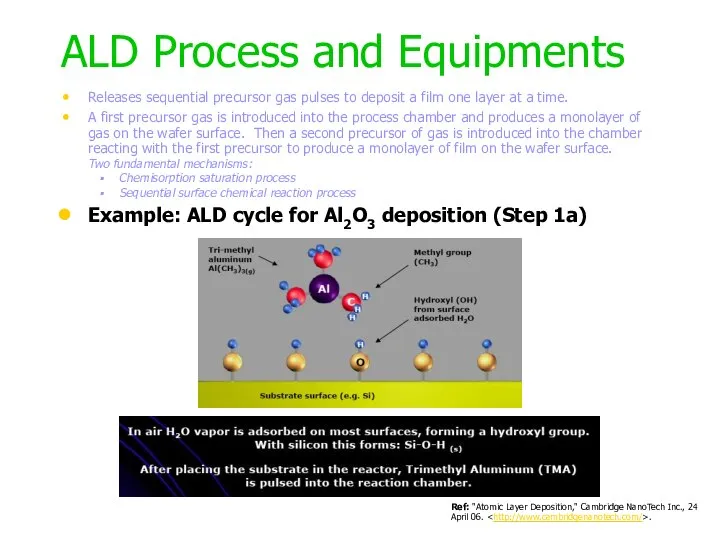
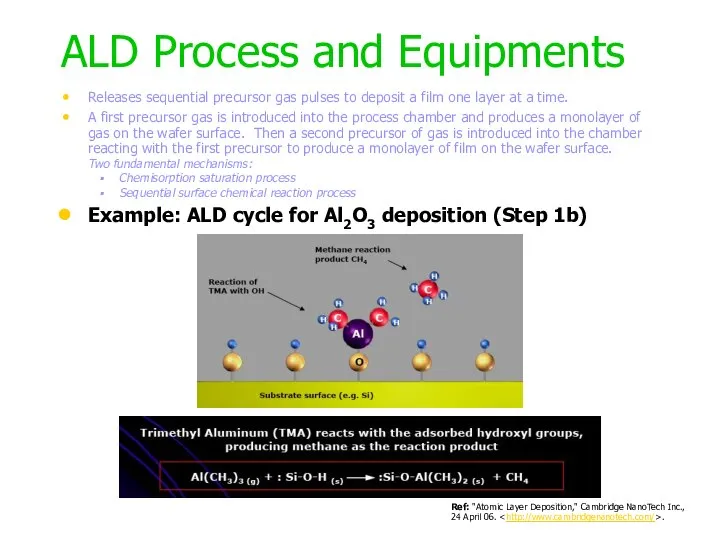
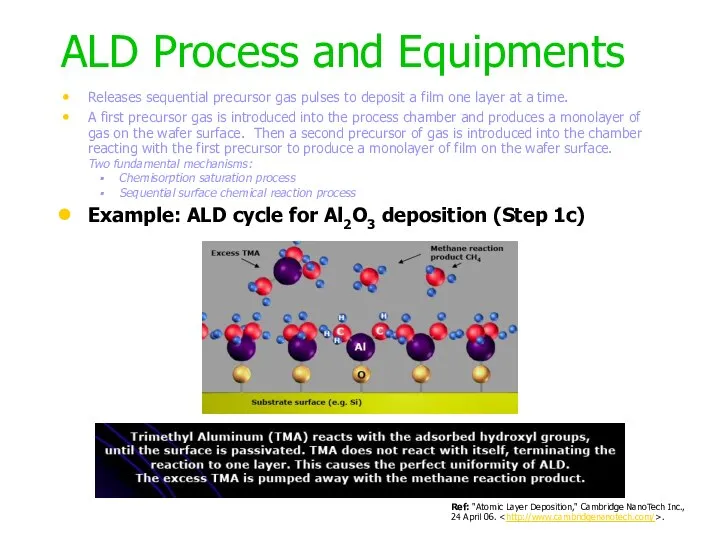
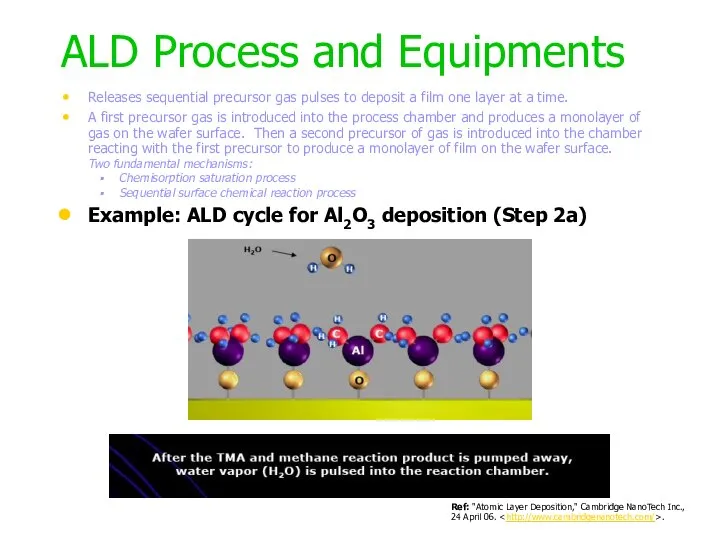
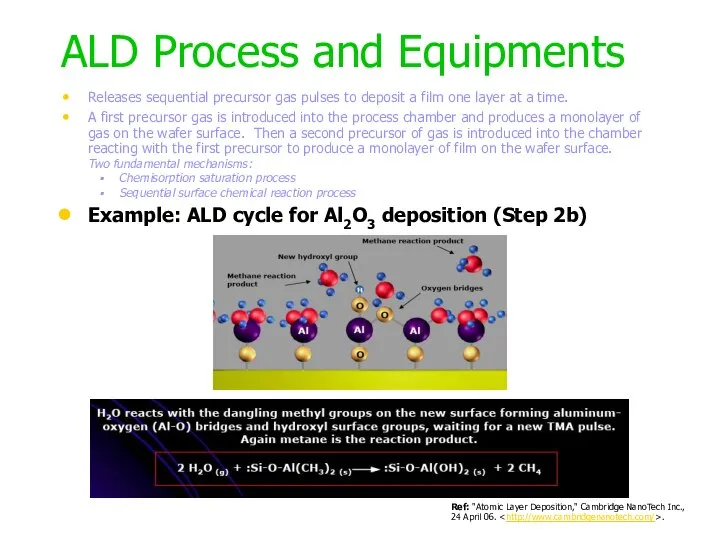
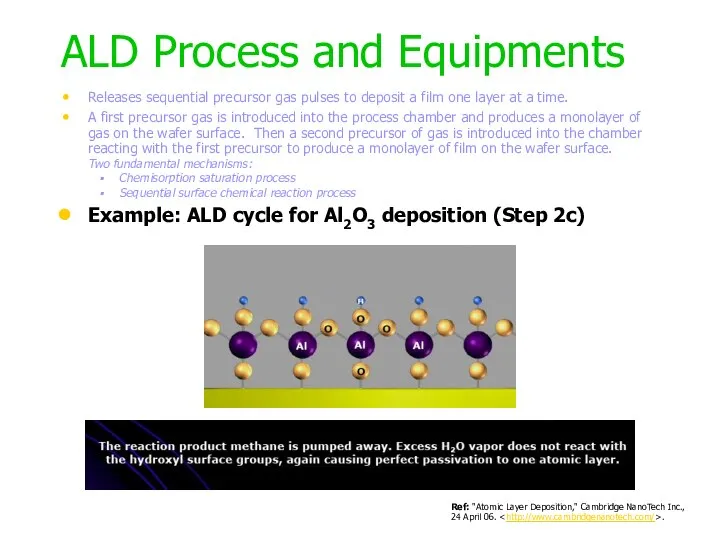
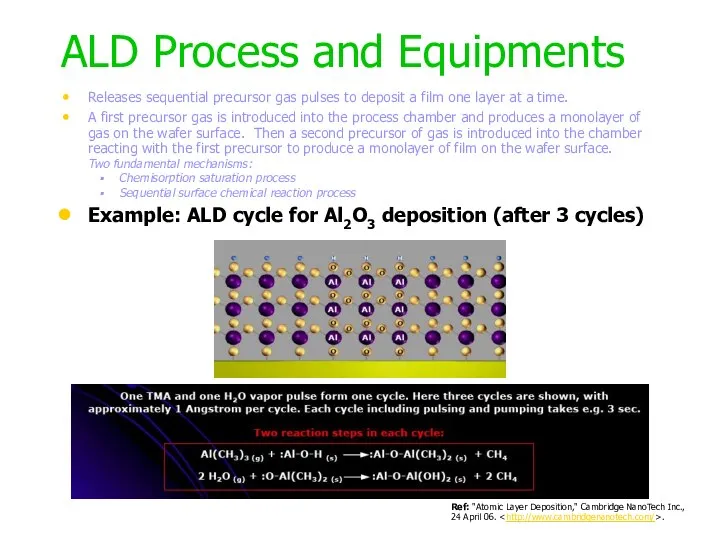
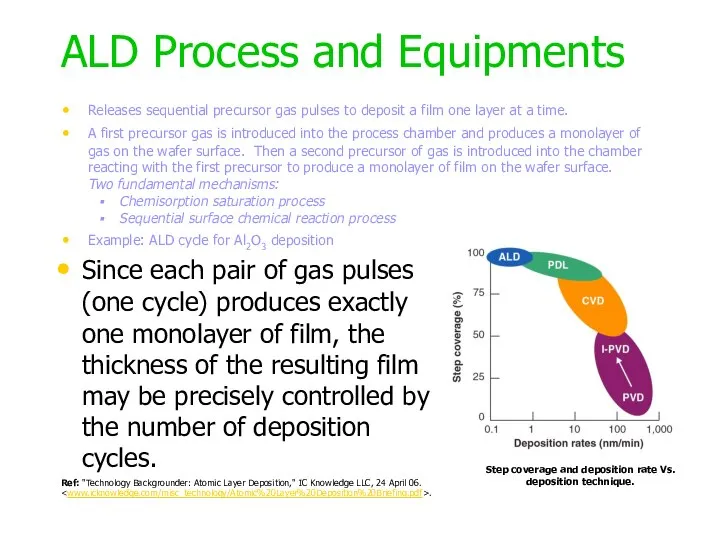



![ALD Process and Equipments Process Temperature [1] [1] [1] 1 "Technology](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1491351/slide-69.jpg)
![ALD Process and Equipments One cycle Process Temperature [1] [1] [1]](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1491351/slide-70.jpg)
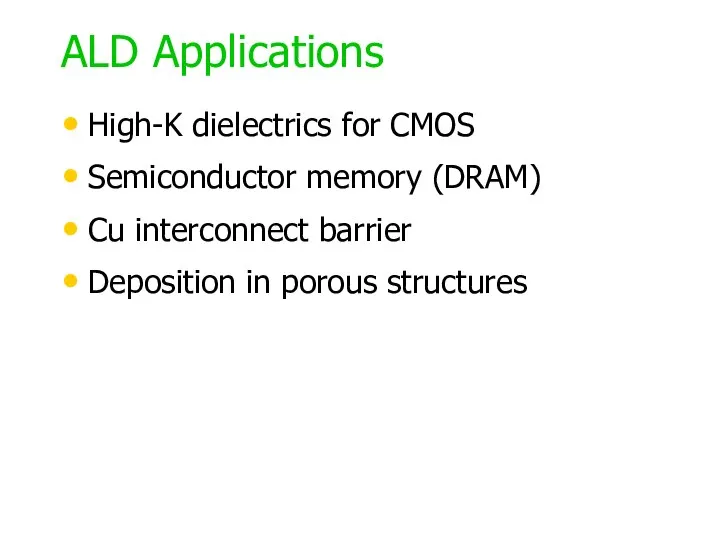





















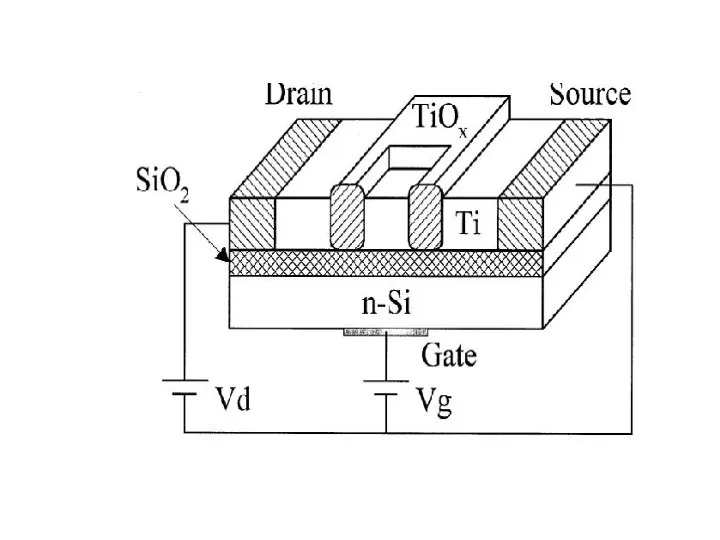
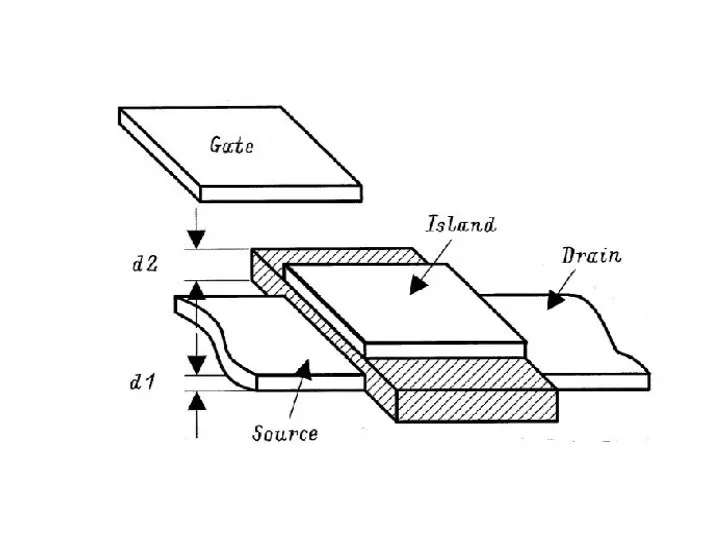
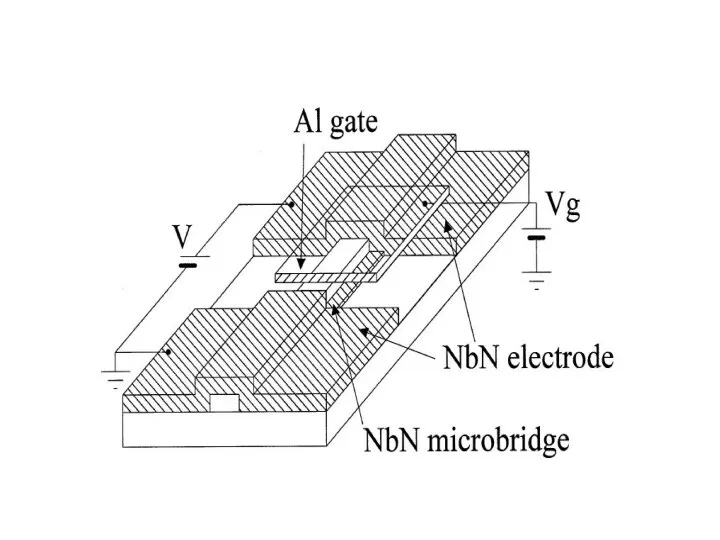
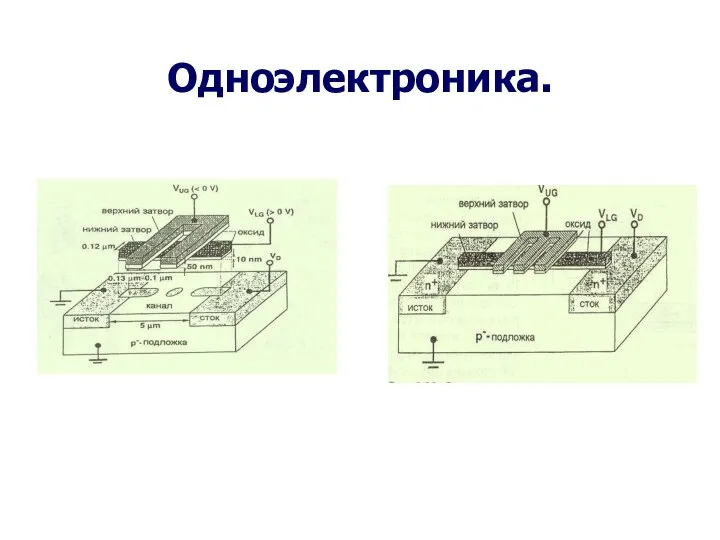
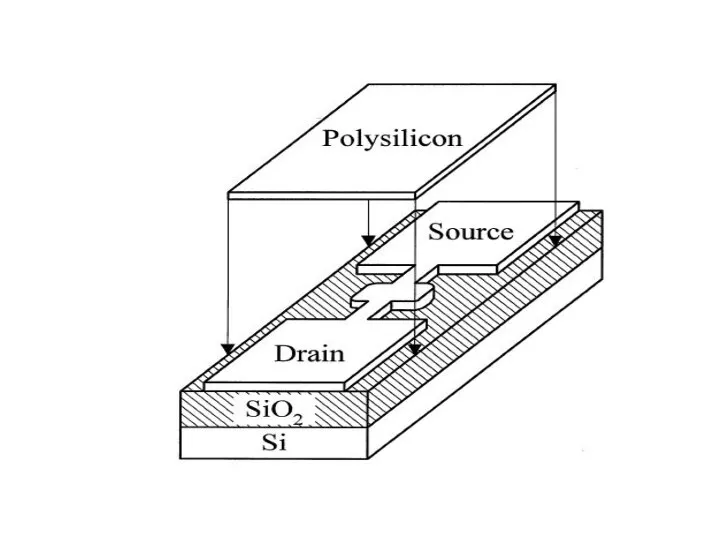
 Разметка документов
Разметка документов ПСИХОЛОГИЯ ПОДРОСТКОВ
ПСИХОЛОГИЯ ПОДРОСТКОВ  ЛЕКЦИОННЫЕ МАТЕРИАЛЫ К КУРСУ “МЕЖДУНАРОДНЫЙ БУХГАЛТЕРСКИЙ УЧЕТ” (бакалавры) О.В.Соловьева к.э.н., доцент кафедра Учета, анализа и аудита экономический ф-т МГУ им. М.В.ломоносова
ЛЕКЦИОННЫЕ МАТЕРИАЛЫ К КУРСУ “МЕЖДУНАРОДНЫЙ БУХГАЛТЕРСКИЙ УЧЕТ” (бакалавры) О.В.Соловьева к.э.н., доцент кафедра Учета, анализа и аудита экономический ф-т МГУ им. М.В.ломоносова  Персональный маркетинг профессионального спортсмена
Персональный маркетинг профессионального спортсмена Задача 1. Банковский мультипликатор (Бм) равен 40, В результате выдачи центральным банком кредитов коммерческим банкам денежная мас
Задача 1. Банковский мультипликатор (Бм) равен 40, В результате выдачи центральным банком кредитов коммерческим банкам денежная мас Закаливание детей в детском саду
Закаливание детей в детском саду Slice Method
Slice Method  Механизмы метасоматоза
Механизмы метасоматоза  Жан Батист Ламарк
Жан Батист Ламарк Материалы к заседанию Комиссии при Президенте Российской Федерации по модернизации и технологическому развитию экономики Рос
Материалы к заседанию Комиссии при Президенте Российской Федерации по модернизации и технологическому развитию экономики Рос Опытное определение параметров схемы замещения трансформатора. Упрощенная схема замещения
Опытное определение параметров схемы замещения трансформатора. Упрощенная схема замещения Современные автомобили и двигатели
Современные автомобили и двигатели Шеңбердің теңдеуі
Шеңбердің теңдеуі Инфляция создает риски для исполнения бюджета РФ на 2012-2014 годы Поповой Натальи Т-093
Инфляция создает риски для исполнения бюджета РФ на 2012-2014 годы Поповой Натальи Т-093 Нұрсұлтан Әбішұлы Назарбаев
Нұрсұлтан Әбішұлы Назарбаев Презентация на тему Творческий проект. Фартук.
Презентация на тему Творческий проект. Фартук.  Бизнес план строительство
Бизнес план строительство Памятники книге
Памятники книге Лестницы
Лестницы Геометрическая прогрессия - презентация по Алгебре
Геометрическая прогрессия - презентация по Алгебре ЭТНОКАЛЕНДАРЬ Санкт-Петербург 2009: Методические рекомендации по работе с комплектом плакатов для воспитателей до
ЭТНОКАЛЕНДАРЬ Санкт-Петербург 2009: Методические рекомендации по работе с комплектом плакатов для воспитателей до Заболевания сосудов
Заболевания сосудов Иосиф прекрасный праотец
Иосиф прекрасный праотец Государственная политика в религиозной сфере
Государственная политика в религиозной сфере Удмурты. Народы Поволжья
Удмурты. Народы Поволжья Архитектура и функциональные возможности Visual Studio Team Foundation Server
Архитектура и функциональные возможности Visual Studio Team Foundation Server Российский университет дружбы народов Кафедра хирургических болезней Презентацию подготовила: Кузнецова Анастасия студен
Российский университет дружбы народов Кафедра хирургических болезней Презентацию подготовила: Кузнецова Анастасия студен Электричество в быту
Электричество в быту