Содержание
- 2. Работа создания дислокации Creation work of dislocation Энергия дислокации равна работе, затраченной на ее создание -
- 3. Сила, действующая на дислокацию вблизи поверхности Force acting on a dislocation near surface Энергия дислокации вблизи
- 4. Упругая энергия напряженной тонкой пленки Elastic energy of stressed thin film Энергия на единицу площади Elastic
- 5. Работа по созданию дислокации в напряженной пленке Creation work for a dislocation in stressed film Поверхность
- 6. Критическая толщина для формирования дислокаций в напряженной пленке: Critical thickness Representative graphs of Wd(η)=μfb2 and Wm(η)=μfb2
- 7. Критическая толщина для формирования дислокаций в напряженной пленке Matthews-Blakeslee critical thickness for dislocation formation in a
- 8. Критическая толщина. Теория Critical thickness with different dislocation cores Normalized critical thickness ln(hcr/b) versus mismatch strain
- 9. Критическая толщина. Эксперимент Critical thickness. Experiment Experimentally observed critical thickness versus mismatch strain for the SiGe/Si(100)
- 10. Зависимость критической толщины от кристаллографической ориентации Critical thickness for different crystallographic orientations Разным ориентациям отвечают разные
- 11. Дислокации несоответствия на гетерогранице Si/SiGe A plan-view, bright-feld transmission electron microscopy (TEM) image of misfit dislocations
- 12. Критическая толщина для GeSi/Si (001) Critical thickness for GeSi/Si (001) Кристаллография: вектор Бюргерса, плоскости скольжения; Силы,
- 13. Дислокации несоответствия на гетерогранице GaAs/CdTe Misfit dislocations at GaAs/CdTe interface Atomic resolution transmission electron micrograph of
- 14. Механизмы формирования дислокаций несоответствия в гетероэпитаксиальных системах Mechanisms of formation of misfit dislocations Зарождение дислокаций на
- 15. Зарождение дислокаций на поверхности и скольжение к интефейсу Dislocations gliding to the interface
- 16. Зарождение дислокаций непосредственно на интерфейсе на начальных стадиях роста Dislocations in quantum dots Bright-field cross-sectional TEM
- 17. Дислокации на гетероэпитаксиальном интерфейсе GaN(0001)/GaAs(111) Cross-sectional bright-field TEM micrographs of a GaAs/GaN hetrostructure. Vertical black arrows
- 18. Изгиб прорастающих дислокаций Bending of threading dislocations Сила, действующая на дислокацию в напряженной пленке
- 19. Плотность дислокаций несоответствия Density of misfit dislocations Энергия системы: Приближение среднего поля. Mean field approximation Одновременное
- 20. Методы понижения плотности дислокаций в структурах Reduction of dislocation density in heterostructures Блокирование движения дислокаций Blocking
- 21. Сверхрешетка как средство борьбы с прорастающими дислокациями Supelattice as a tool to block dislocations (a) Сверхрешетка
- 22. Lateral epitaxial overgrowth technique GaN sapphire GaN buffer SiN SiN Advantage: Reduced density of threading dislocations
- 23. Заключение Conclusion Дислокации могут быть равновесными в напряженных гетероструктурах. Dislocations can be equilibrium defects in heterostructures.
- 25. Скачать презентацию




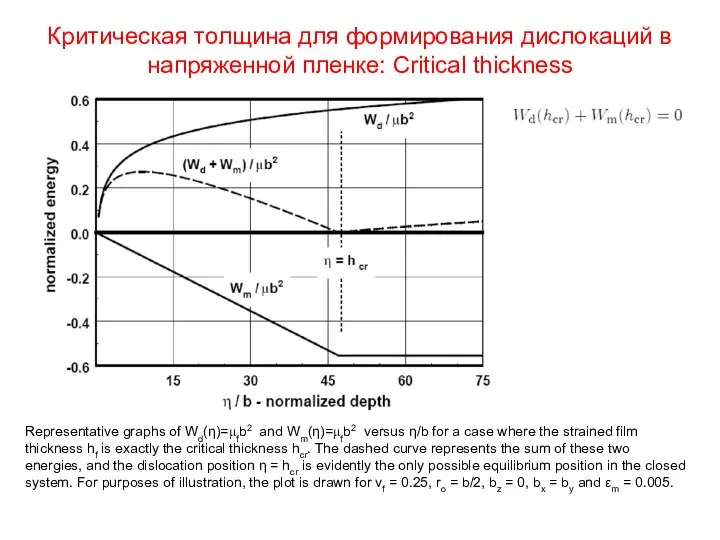



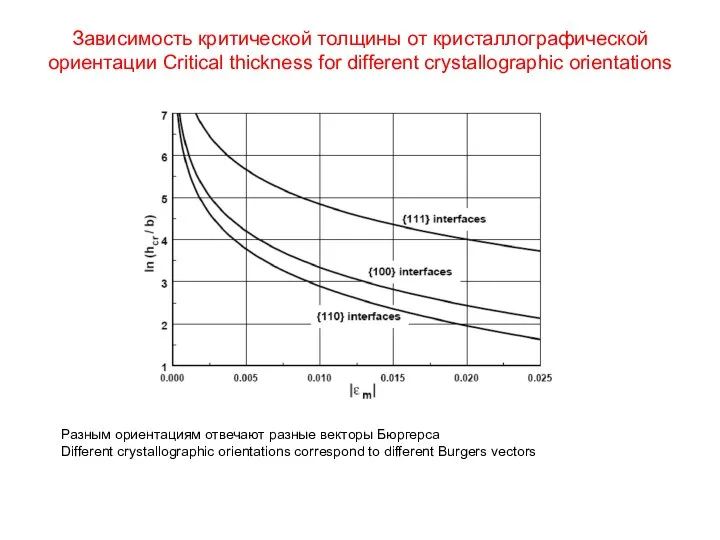


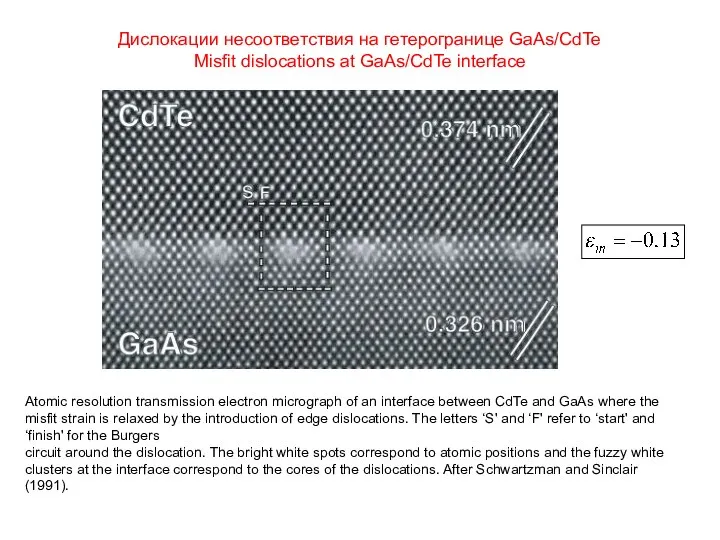


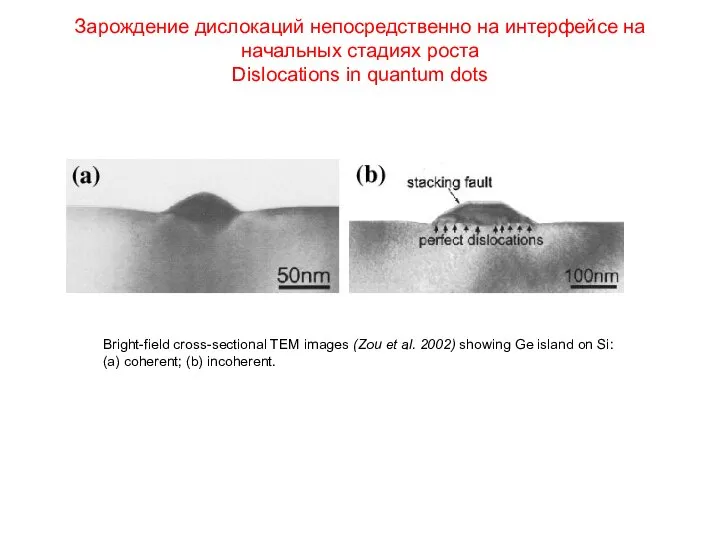
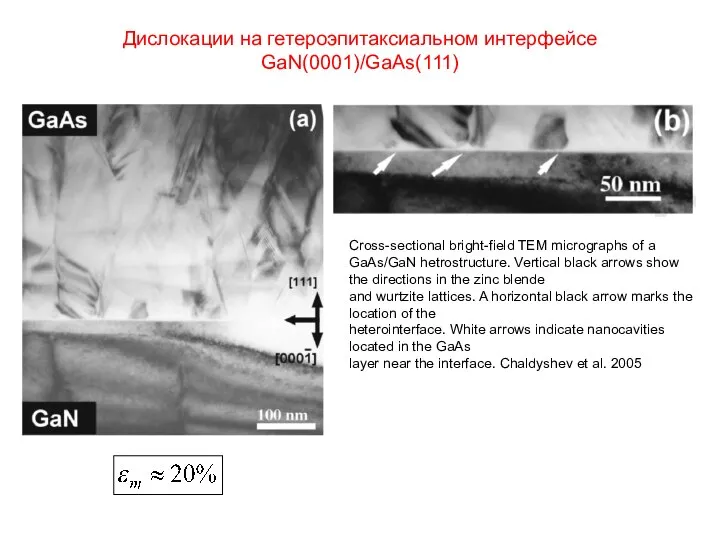



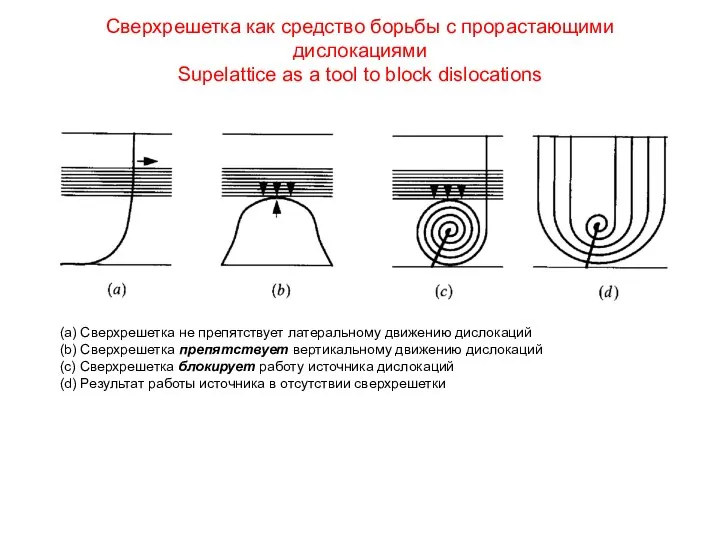
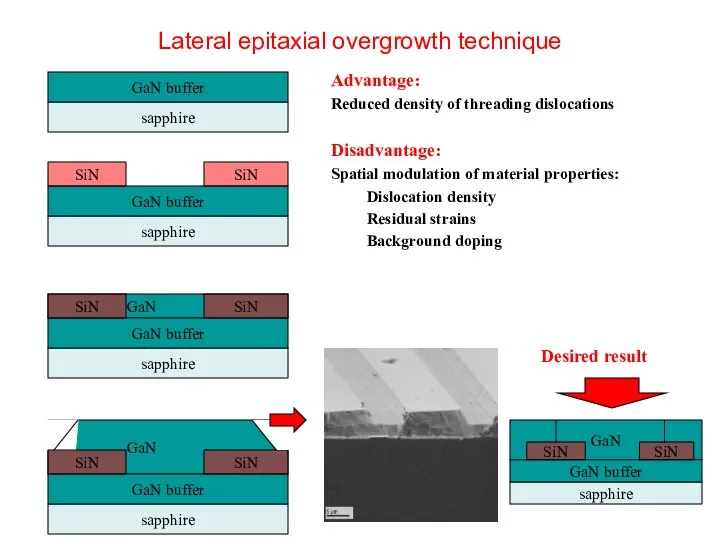

 Свет и его источники
Свет и его источники Двигатель внутреннего сгорания
Двигатель внутреннего сгорания Законы отражения и преломления света
Законы отражения и преломления света Факторы возникновения световой волны. Фотометрические величины и единицы их измерения
Факторы возникновения световой волны. Фотометрические величины и единицы их измерения Устройство машинной иглы. Неполадки
Устройство машинной иглы. Неполадки Магниторазведка. Вопросы госэкзамена. Лекция 2
Магниторазведка. Вопросы госэкзамена. Лекция 2 Теория линейных электрических цепей
Теория линейных электрических цепей Электрические явления. Обобщающий урок
Электрические явления. Обобщающий урок Магнитное поле
Магнитное поле Работа и энергия. Механическая работа. Мощность
Работа и энергия. Механическая работа. Мощность Общетехнический курс
Общетехнический курс Технологический процесс обработки детали Вал ротора
Технологический процесс обработки детали Вал ротора Понятие о равновесии фаз
Понятие о равновесии фаз Презентация урока-лекции по теме «Электрическое поле точечного заряда. Закон Кулона» для профильного 10-го класса Подготовил
Презентация урока-лекции по теме «Электрическое поле точечного заряда. Закон Кулона» для профильного 10-го класса Подготовил Методические рекомендации при проведении эксперимента для подготовки к ОГЭ по физике
Методические рекомендации при проведении эксперимента для подготовки к ОГЭ по физике Лабораторные работы по физике 8 класс
Лабораторные работы по физике 8 класс Единицы напряжения
Единицы напряжения Открытие дисперсии и дифракции (оптика второй половины xvii века)
Открытие дисперсии и дифракции (оптика второй половины xvii века) Альберт Эйнштейн Я был третируем моими профессорами, которые не любили меня из-за моей независимости и закрыли мне путь в науку…
Альберт Эйнштейн Я был третируем моими профессорами, которые не любили меня из-за моей независимости и закрыли мне путь в науку… Трение качения
Трение качения Презентация по физике "Урок путешествие" - скачать
Презентация по физике "Урок путешествие" - скачать  Трение. Силы трения
Трение. Силы трения Энергия топлива. Удельная теплота сгорания топлива
Энергия топлива. Удельная теплота сгорания топлива Волновые процессы
Волновые процессы Дифракция света
Дифракция света Физика в быту
Физика в быту Клепка, пайка, притирка и доводка
Клепка, пайка, притирка и доводка Потенциальная энергия
Потенциальная энергия