Содержание
- 2. Анізотропія електропровідності шаруватих кристалів Анізотропія електропровідності шаруватих кристалів визначається параметром Λ = σ|| /σ⊥, який температурно
- 3. Рис. 2. Модель перенесення носіїв заряду поперек шарів. Просторовий та енергетичний розподіл електронних станів зображено горизонтальними
- 4. По аналогії з аморфними напівпровідниками, феноменологічний опис властивостей переносу в шаруватих кристалах можна здійснити, увівши край
- 5. Рис. 6. Діаграма густини станів для аморфних і склоподібних напівпровідників. а – реальна заборонена зона, яка
- 6. Температурна залежність електропровідності на постійному струмі Халькогенідні стекла є напівпровідниками, однією з характерних ознак яких є
- 7. де Со = (Nеф – ефективна густина станів на рівні Ес і Еv). У випадку електронної
- 8. Стрибковий механізм провідності Якщо теплової енергії носія заряду недостатньо, щоб піднятися із проміжного положення у зону
- 9. Якщо густина станів на рівні Фермі ЕF скінчена, то провідність одержує вклад від носіїв заряду з
- 10. де - радіус локалізації, ν ≈ 1012 – частота фононів. N(Е) вважається сталою в інтервалі ~
- 11. Загальний вигляд залежності провідності у координатах lnσ від Т–1 з врахуванням усіх перерахованих механізмів переносу наведений
- 12. Рис. 5. Т-залежність електропровідності ХСН. GeS2 SiO2
- 13. Вплив домішок на електропровідність ХСН Рис. 7. а) температурна залежність σ стекол (GeS3)100–xBix: 1– x =
- 14. Вплив домішок на електропровідність ХСН Рис. 8. а) залежність σ (Т) для стекол (Ge2S3)100–xCu(Ag)x: 1– x
- 15. Електропровідність суперіонних ХСН Таблиця. Основні параметри іонної провідності кристалів і стекол M2S(x)AS2 (1–x) (M = Li,
- 16. Li2S Li2SiS3 кристал скло Рис. 9. Проекції кристалічних структур. α-SiS2
- 17. Рис. 10. Проекції кристалічних структур. Na2S Na2GeS3 –Na1 β-фаза GeS2 –Ge –S –Na2
- 18. в) г) д) Рис. 11. Розподіл валентної густини в α-SiS2 (а, б), Li2SiS3 (в, г) та
- 19. Рис. 12. Температурні залежності провідності кристалічних фаз Li2SiS3 (а) та стекол Li2S(x)SiS2(1–x) (б) одержаних швидким загартуванням
- 20. Рис. 13. Концентраційні залежності: а) log σ25°C (крива1) і енергії активації (крива 2); б) предекспоненціального коефіцієнта
- 21. Рис. 14. Температурна залежність провідності стекол: а – Na2S(x)GeS2(1–x)(а): 1 – Na2S(0.33)GeS2(0.66); 2 – Na2S(0.42)GeS2(0.58); 3
- 22. AL Current Collector Cu Current Collector Електроліт LiMO2 Графіт Lithium-Ion Battery Зарядка
- 24. Скачать презентацию










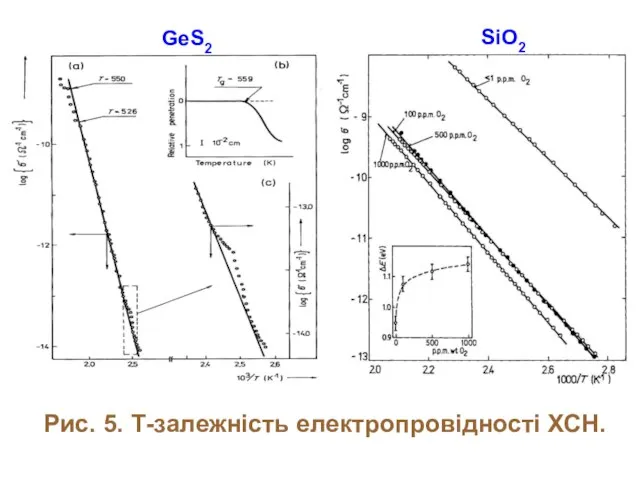


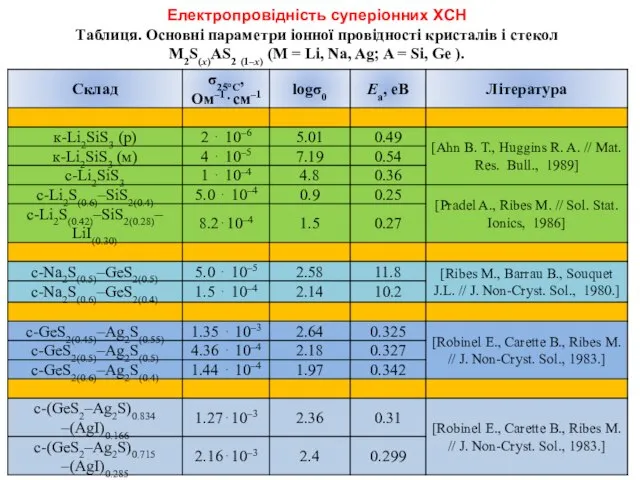



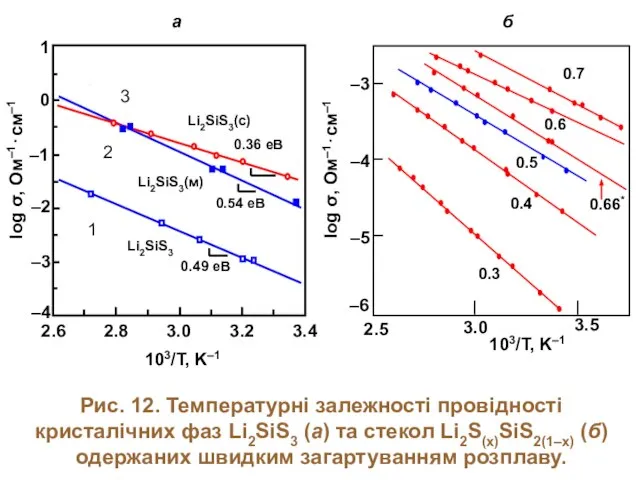
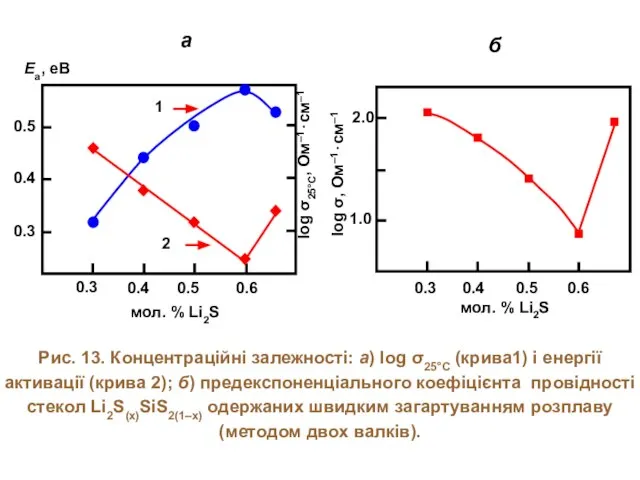
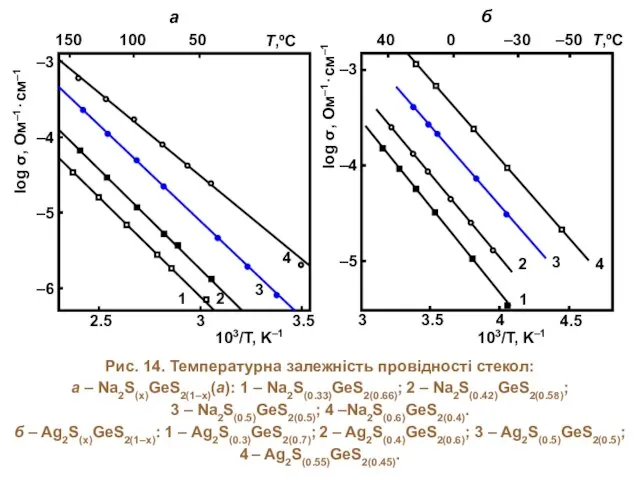
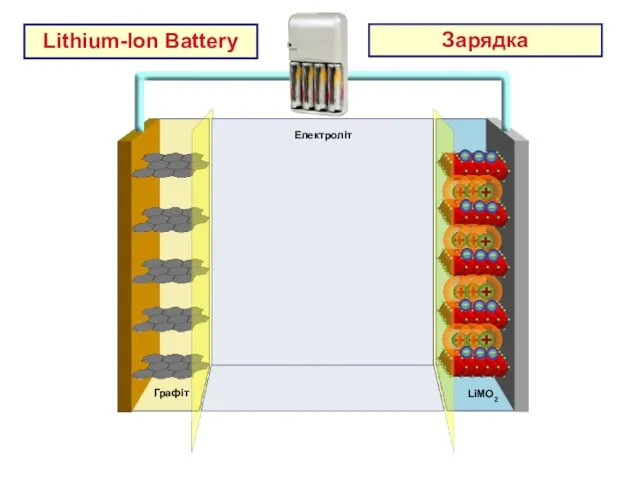
 План трассы. Вписывание круговых кривых с переходными кривыми
План трассы. Вписывание круговых кривых с переходными кривыми Презентация по физике "Системы цветопередачи" - скачать
Презентация по физике "Системы цветопередачи" - скачать  Внесок українських вчених у розвиток науки. Історія фізики
Внесок українських вчених у розвиток науки. Історія фізики Молекуляроно-кинетическая теория
Молекуляроно-кинетическая теория Делимость электрического заряда. Электрон
Делимость электрического заряда. Электрон Оборудование АЭС
Оборудование АЭС Кроссворды по физике
Кроссворды по физике Магнитооптика ферромагнитных металлов
Магнитооптика ферромагнитных металлов Презентация по физике Молекулярная физика и термодинамика
Презентация по физике Молекулярная физика и термодинамика  Последовательное соединение проводников
Последовательное соединение проводников Кривошипно-шатунный механизм. Назначение
Кривошипно-шатунный механизм. Назначение ПЕРВОЕ НАЧАЛО ТЕРМОДИНАМИКИ. ВНУТРЕННЯЯ ЭНЕРГИЯ. РАБОТА И ТЕПЛОТА 1. Внутренняя энергия. Работа и теплота 2. Теплоёмкость идеал
ПЕРВОЕ НАЧАЛО ТЕРМОДИНАМИКИ. ВНУТРЕННЯЯ ЭНЕРГИЯ. РАБОТА И ТЕПЛОТА 1. Внутренняя энергия. Работа и теплота 2. Теплоёмкость идеал Идеальный газ в молекулярно-кинетической теории. Среднее значение квадрата скорости молекул
Идеальный газ в молекулярно-кинетической теории. Среднее значение квадрата скорости молекул Sbs – silicon bidirectional switch
Sbs – silicon bidirectional switch Тест по физике Выполнил ученик 11 «А» класса Серый Константин
Тест по физике Выполнил ученик 11 «А» класса Серый Константин Тепловые электростанции
Тепловые электростанции  Сохранение импульса. Момент сил. Силы инерции. (Лекция 6)
Сохранение импульса. Момент сил. Силы инерции. (Лекция 6) Сила пружності. Закон Гука
Сила пружності. Закон Гука Математические модели и методы оптимизации процессов пространственного маневрирования морских подвижных объектов
Математические модели и методы оптимизации процессов пространственного маневрирования морских подвижных объектов Урок технологии 5 класс раздел: Элементы машиноведения
Урок технологии 5 класс раздел: Элементы машиноведения Лекция 2. Моделирование технологических процессов. Аналитические аппроксимации распределения ионов
Лекция 2. Моделирование технологических процессов. Аналитические аппроксимации распределения ионов Соединения деталей машин Соединения деталей машин Сварные соединения Классификация и разновидности сварных соединений (швов) С
Соединения деталей машин Соединения деталей машин Сварные соединения Классификация и разновидности сварных соединений (швов) С Строение и свойства кристаллических тел
Строение и свойства кристаллических тел Физика колебаний
Физика колебаний Соединение проводников
Соединение проводников Применение первого закона термодинамики к различным процессам
Применение первого закона термодинамики к различным процессам Изучение конструкции и исследование цилиндрическими редуктора зубчатыми колесами
Изучение конструкции и исследование цилиндрическими редуктора зубчатыми колесами Физика в мультфильмах
Физика в мультфильмах