Содержание
- 2. Деформация сплошной среды Deformation of continuum Конечное или деформированное состояние Transformation of an object dR =
- 3. Тензор малой деформации Infinitesimal strain tensor тензор дисторсии - deformation gradient тензор деформации - strain tensor
- 4. Тензор вращений Rotation tensor Физический смысл – вращение вокруг мгновенной оси
- 5. Тензор напряжений Коши Cauchy stress tensor
- 6. Закон Гука (Hooke’s law) тензор упругих констант (stiffness tensor) кубическая симметрия – 3 независимых константы: c44≠(c11-c12)/2
- 7. Тензор упругих констант изотропного материала (stiffness tensor for isotropic material) Модуль Юнга (Young modulus) Модуль сдвига
- 8. Полная система уравнений статической теории упругости Full system of equations in static elasticity (3) (6) (6)
- 9. Эпитаксия (Epitaxy) Гомоэпитаксия Гетероэпитаксия Рассогласование параметров решетки Lattice mismatch
- 10. Запрещенная зона и параметры решетки полупроводников Adapted from V. Keramidas and R. Nahory. Lucent Technologies, Murray
- 11. Правило Вегарда (Vegard’s rule) Параметр решетки бинарного твердого раствора (сплава) двух материалов с одинаковой стуктурой решетки
- 12. Cube-on-Cube (001) CdZnTe/ZnTe/GaAs/Si (001) Hex-on-Hex (0001) GaN/Sapphire (0001) ZnTe a = 0.610 nm CdZnTe a =
- 13. Причины рассогласование параметров решетки пленки и подложки
- 14. Просвечивающая электронная микроскопия высокого разрешения A HRTEM [110] cross-sectional view of a coherent interface that develops
- 15. Собственные и упругие деформации Eigenstrain and elastic strain Граничные условия u(R)|S = uo(R) Boundary conditions n
- 16. Собственные напряжения Eigenstrain Film and substrate separated, but with distributed force f acting on the film
- 17. Пленка на недеформируемой подложке Film on a rigid substrate Материалы с кубической решеткой и ориентацией (001)
- 18. Изотропный материал Isotropic material Mf=Ef / (1-ν)
- 19. Критерий недеформируемости подложки Criterion for the rigid substrate assumption
- 20. Рентгеновская дифракция на упруго-напряженных пленках X-ray diffraction in strained films Материалы с кубической решеткой и ориентацией
- 21. Пленка и подложка с кубической симметрией с ориентацией {001}
- 22. Наряженная пленка на деформируемой подложке Stressed film on a deformable substrate In the upper diagram, the
- 23. Деформации в пленке и подложке Strain in a film/substrate sandwich Если деформации зависят только от z:
- 24. Формула Стони (Stoney formula) Граничные условия на поверхности σkz=0 и условия равенства нулю равнодействующей силы и
- 25. Multi-beam optical stress sensor
- 26. Упругие деформации в пленке и подложке The distribution of normalized strain εrr=εm versus normalized distance z/hs
- 27. Точность формулы Стони Accuracy of Stoney formula
- 28. Экспериментальное определение кривизны структур Experimental study of curvature Лазерное сканирование поверхности (Laser scanning) Многолучевое оптическое отражение
- 29. Scanning laser method 2θ Используется для in-situ мониторинга деформаций при наращивании пленок, например, при MBE и
- 30. Grid reflection method
- 31. Coherent gradient sensor method По изменению интерференции измеряются изменения кривизны
- 32. Многослойные структуры Multilayer structures To 1-rst order in the small parameters hi/hs, the total curvature is
- 33. Влияние анизотропии на деформации Anisotropy in curvature
- 34. Область геометрически-нелинейных деформаций Geometrically nonlinear deformations Вращения, вызванные изгибом с вертикальным смещением w(r), могут быть не
- 35. Изменение кривизны по площади Variation of curvature Experimentally observed and numerically estimated variation of curvature as
- 36. Bifurcation in equilibrium shape Example: graphite-polyimide laminate R – radius of the wafer Требование минимума упругой
- 37. Экспериментальное определение упругих деформаций в пленках Experimental determination of strain in films Измерения параметра решетки пленок
- 38. Микро-Рамановская спектроскопия Micro-Raman scattering Lateral mapping Confocal measurements Olympus microscope Lateral shift across SiN mask (μm)
- 39. Просвечивающая электронная микроскопия Transmission electron microscopy Strain mapping into a uniaxial 45 nm strained channel pinched
- 40. Изменение энергий электронных состояний Change in energy of electronic states
- 42. Скачать презентацию












![Просвечивающая электронная микроскопия высокого разрешения A HRTEM [110] cross-sectional view of](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/1470365/slide-13.jpg)














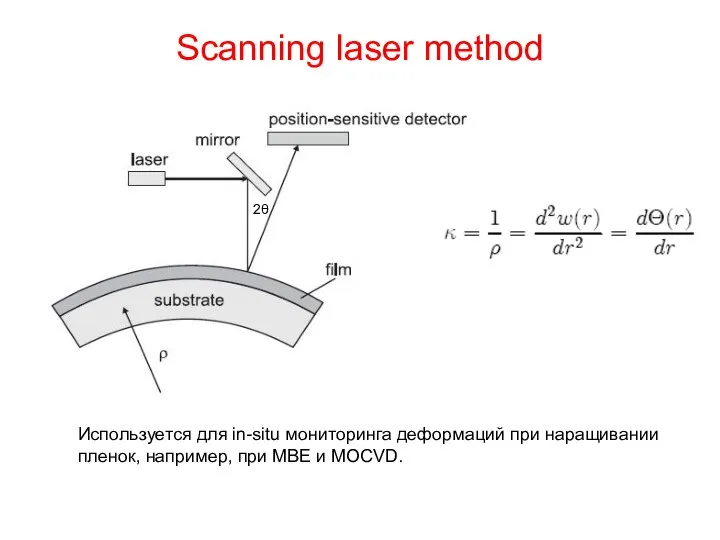

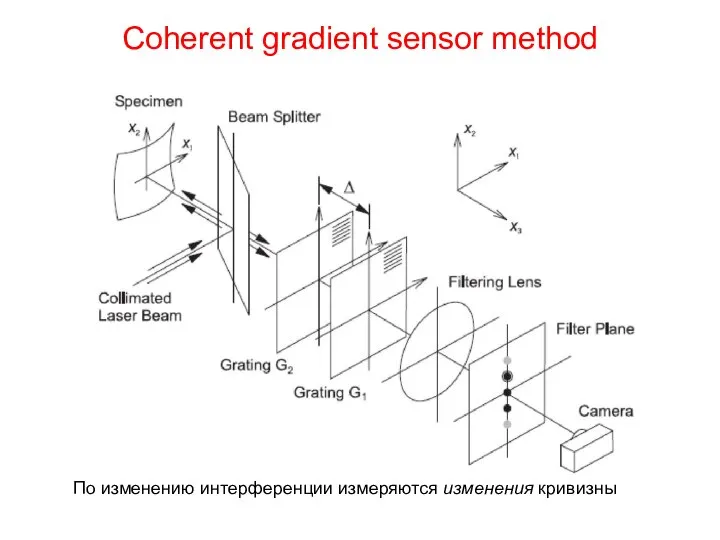









 Презентация Голография
Презентация Голография  Механика. Работа и энергия
Механика. Работа и энергия Условия работы проводников и аппаратов
Условия работы проводников и аппаратов Магнітостатичні хвилі в дотично намагніченому феромагнітному шарі
Магнітостатичні хвилі в дотично намагніченому феромагнітному шарі Презентация Конденсаторы
Презентация Конденсаторы  Телескопы
Телескопы Контрольная работа по теме Законы постоянного тока
Контрольная работа по теме Законы постоянного тока Основные понятия механики
Основные понятия механики Расчет сопротивления проводника. Удельное сопротивление
Расчет сопротивления проводника. Удельное сопротивление Устройство надводного корабля
Устройство надводного корабля Физические явления
Физические явления История создания швейной машины, их виды
История создания швейной машины, их виды Предпусковой подогрев
Предпусковой подогрев Агрегатные состояния веществ. Переходные процессы
Агрегатные состояния веществ. Переходные процессы Пожарная опасность выхода горючих веществ из поврежденного технологического оборудования. (Тема 5)
Пожарная опасность выхода горючих веществ из поврежденного технологического оборудования. (Тема 5) Постановка задачи оптимизации
Постановка задачи оптимизации Уравнения предельного равновесия для сыпучих и связных грунтов
Уравнения предельного равновесия для сыпучих и связных грунтов Закон Ампера. Сила взаимодействия параллельных токов
Закон Ампера. Сила взаимодействия параллельных токов Коэффициент полезного действия
Коэффициент полезного действия Спектрально-люминесцентные методы исследования
Спектрально-люминесцентные методы исследования Дальність дії радіолокатора
Дальність дії радіолокатора Увлекательный мир физики
Увлекательный мир физики Альбом электрических схем для сдачи экзаменов по программе «Машинист электропоезда»
Альбом электрических схем для сдачи экзаменов по программе «Машинист электропоезда» Нитяной монорельс
Нитяной монорельс Методы формирования и исследования квазиодномерных проводников
Методы формирования и исследования квазиодномерных проводников Свойства металлов. Учебная практика (занятие 1)
Свойства металлов. Учебная практика (занятие 1) конвекция 8 класс
конвекция 8 класс Плазма
Плазма