Содержание
- 2. Деформации и изгиб в пленке и подложке Strain and bending in a film/substrate sandwich Если деформации
- 3. Упругие деформации в пленке и подложке Strain in film and substrate The distribution of normalized strain
- 4. Точность формулы Стони Accuracy of Stoney formula
- 5. Экспериментальное определение кривизны структур Experimental study of curvature Лазерное сканирование поверхности (Laser scanning) Многолучевое оптическое отражение
- 6. Scanning laser method 2θ Используется для in-situ мониторинга деформаций при наращивании пленок, например, при MBE и
- 7. Многослойные структуры Multilayer structures To 1-rst order in the small parameters hi/hs, the total curvature is
- 8. Влияние анизотропии на деформации Anisotropy in curvature
- 9. Область геометрически-нелинейных деформаций Geometrically nonlinear deformations Вращения, вызванные изгибом с вертикальным смещением w(r), могут быть не
- 10. Изменение кривизны по площади Variation of curvature Experimentally observed and numerically estimated variation of curvature as
- 11. Bifurcation in equilibrium shape Example: graphite-polyimide laminate R is radius of the wafer Требование минимума упругой
- 12. Экспериментальное определение упругих деформаций в пленках Experimental determination of strain in films Измерения параметра решетки пленок
- 13. Микро-Рамановская спектроскопия Micro-Raman scattering Lateral mapping Confocal measurements Olympus microscope Lateral shift across SiN mask (μm)
- 14. Просвечивающая электронная микроскопия Transmission electron microscopy Strain mapping into a uniaxial 45 nm strained channel pinched
- 15. Изменение энергий электронных состояний Change in energy of electronic states
- 16. Should a surface of a stressed solid be flat? Does a flat surface provide the lowest
- 17. Нестабильность механически напряженной пленки Instability of mechanically stressed films Механизм развития нестабильности - поверхностная диффузия Mechanism
- 18. Малые периодические изменения толщины Small periodic variation of thickness ω=2π/λ
- 19. Малые периодические изменения толщины Small periodic variation of thickness
- 20. Плотность энергии и химический потенциал Energy and chemical potential Увеличение площади поверхности квадратично по a /
- 21. Критическая длина стабильности Critical length of stability Пусть a зависит от времени Изменение свободной энергии, усредненное
- 22. Нестабильность напряженной пленки Asaro-Tiller--Grinfeld instability ν = 0.3 G = 0.67 1011 Pa γ = 1
- 23. Нестабильность пленки GeSi на Si Asaro-Tiller--Grinfeld instability of GeSi on Si Transmission electron microscopy cross-sectional image
- 24. Возмущения второго порядка Second order disturbation
- 25. Применимость приближения малых флуктуаций Applicability of small perturbation approach The dependence of change in surface energy
- 27. Скачать презентацию




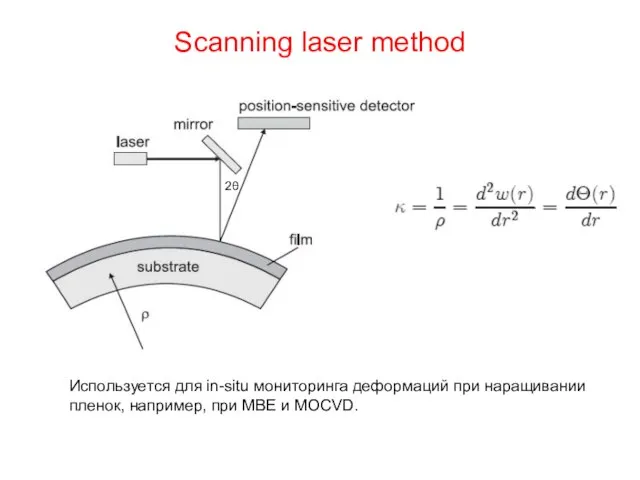



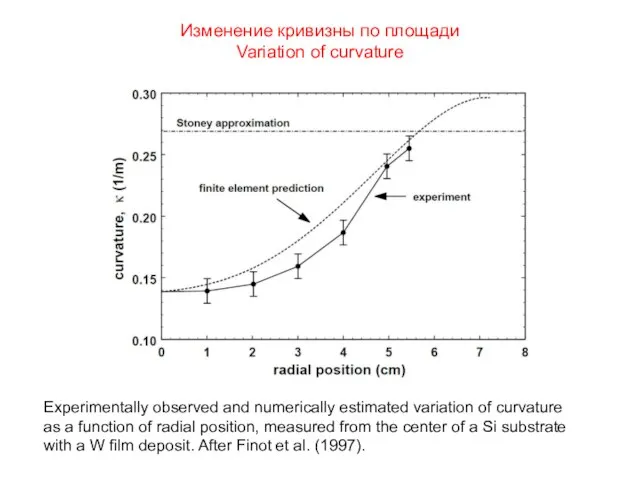















 Томас Алва Эдисон
Томас Алва Эдисон Элементарные частицы. Квантовая хромодинамика
Элементарные частицы. Квантовая хромодинамика Сили в механіці. Сила пружності
Сили в механіці. Сила пружності Блоки. Похила площина. підготувала
Блоки. Похила площина. підготувала  Азбука Морзе та електричний телеграф
Азбука Морзе та електричний телеграф Магнитное поле
Магнитное поле Электрические явления
Электрические явления Деформації. Сили пружності
Деформації. Сили пружності Электромагнитные волны. Длина волны. График электромагнитной волны (11 класс)
Электромагнитные волны. Длина волны. График электромагнитной волны (11 класс) Строение вещества
Строение вещества Система оценки учебных достижений по физике в стандартах второго поколения
Система оценки учебных достижений по физике в стандартах второго поколения Методы зондирования окружающей среды. Рассеяние электромагнитных волн атмосферными образованиями
Методы зондирования окружающей среды. Рассеяние электромагнитных волн атмосферными образованиями Звуковые колебания и волны
Звуковые колебания и волны Электрооборудование автомобилей. Катушки зажигания. (Урок 6)
Электрооборудование автомобилей. Катушки зажигания. (Урок 6) Тема урока: «Влажность воздуха. Насыщенный пар» Тип урока: закрепление и совершенствование знаний
Тема урока: «Влажность воздуха. Насыщенный пар» Тип урока: закрепление и совершенствование знаний Сравнение автомобильных двигателей
Сравнение автомобильных двигателей Механические волны. Звук, ультразвук. (Лекция 3)
Механические волны. Звук, ультразвук. (Лекция 3) Процесс намагничивания ферромагнетиков. Основные магнитные свойства ферромагнетиков. Природа коэрцитивной силы
Процесс намагничивания ферромагнетиков. Основные магнитные свойства ферромагнетиков. Природа коэрцитивной силы Способы изменения внутренней энергии . Выполнила: учитель физики и информатики Девяткина Т.К. 2011г.
Способы изменения внутренней энергии . Выполнила: учитель физики и информатики Девяткина Т.К. 2011г. Прогноз температуры и влажности воздуха
Прогноз температуры и влажности воздуха Презентация по физике "Сила тока 8 класс" - скачать
Презентация по физике "Сила тока 8 класс" - скачать  Электрические цепи в dcaclab
Электрические цепи в dcaclab Машиноведение. История, устройство и использование швейных машин
Машиноведение. История, устройство и использование швейных машин Лекция 42. Строение атома
Лекция 42. Строение атома Ядерный реактор
Ядерный реактор Учитель биологии МБОУ СОШ №19 Куликова И.В. Волгоградская область, г. Волжский
Учитель биологии МБОУ СОШ №19 Куликова И.В. Волгоградская область, г. Волжский  Кратность циркуляции. Напоры воды в опускных трубах
Кратность циркуляции. Напоры воды в опускных трубах Коливальний рух у природі і техніці
Коливальний рух у природі і техніці