Cross-section sample preparation using focused ion beam system (FIB) for transmission electron microscopy (TEM)
Содержание
- 2. What is TEM? TEM Hitachi HT 7700 What can be observed by TEM: Thin films and
- 3. Supporting grid for TEM specimens TEM specimen holder
- 4. Examples Ni nanoparticles (catalysts) and carbon nanotubes Ni-Ti thin foil Neonothopanus nambi (lat.) biological specimen Co-Al2O3
- 5. What is “cross-section”? cross-section is basic method of observation multi layers structures cross-section method allows to
- 6. Classic method of cross-section sample preparation Four pieces of specimens on the silicon substrate are glued
- 7. 3 sawing disc of 100 um thickness 4 Thinning the disk up to 10 microns by
- 8. 5 Thinning the disk up to 10 nm by Precision Ion Polishing System (PIPS)
- 9. Modern method of cross-section sample preparation Focused Ion Beam System (FIB) Hitachi FB 2100
- 10. Basic steps of cross-section sample preparation by FIB 1. Deposition of protective tungsten coating on the
- 11. 2. Cutting half-finished (lamella)
- 12. 2. Cutting lamella (continuation)
- 13. 3. Fixing microprobe
- 14. 4. Cutting left side and removing lamella
- 15. 5. Fixing lamella on the toothed semicircle
- 16. 6. Cutting and removing microprobe
- 17. 7. Thinning specimen to 50-100 nm
- 18. Finish result Область просмотра в ПЭМ Disadvantages of FIB method Damaging top layer during deposition tungsten
- 19. Some features sample preparation with thin layers (thickness less than 300 nm)
- 22. Pre-sputtering of Ge protective layer
- 23. substrate (Si) Ge (protection layer) Mn (epitaxial layers) Examples
- 24. substrate (Si) Ge (protection layer) Co Pt
- 25. comparison of the two methods Classic method FIB method
- 27. Скачать презентацию

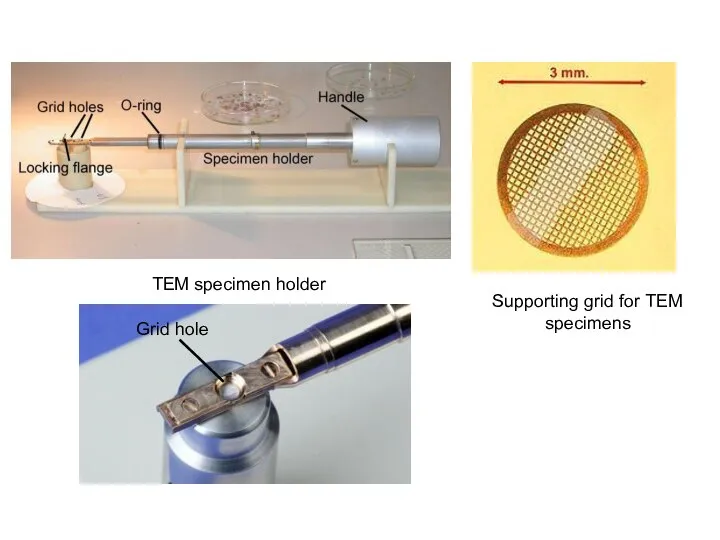
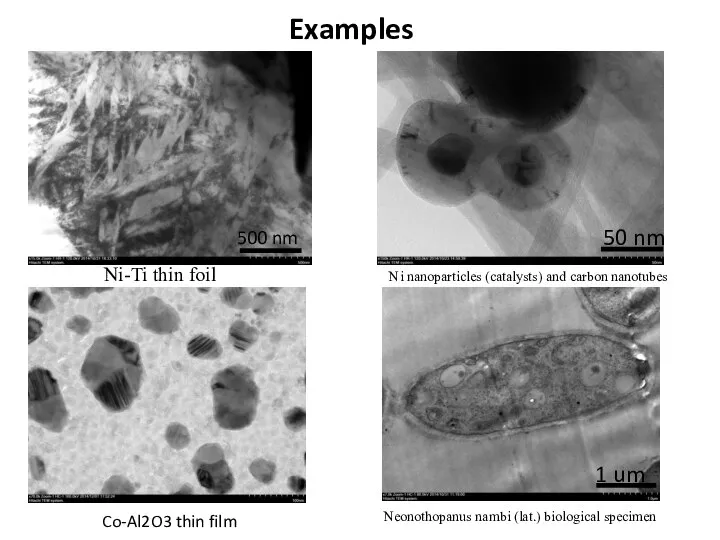
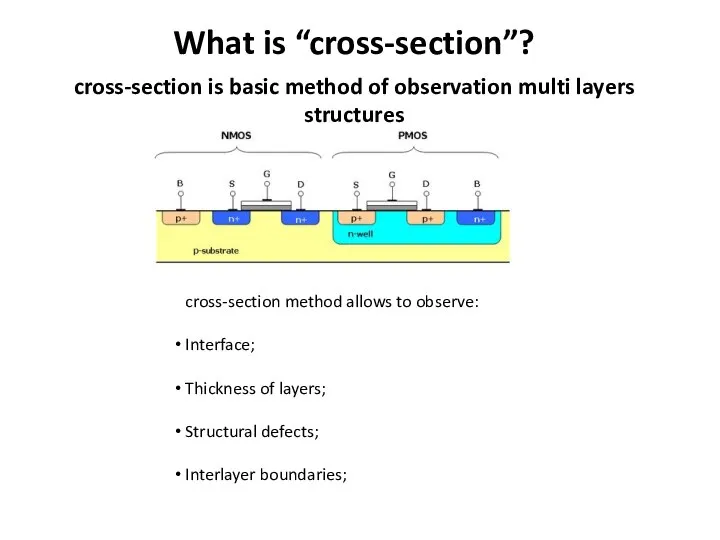
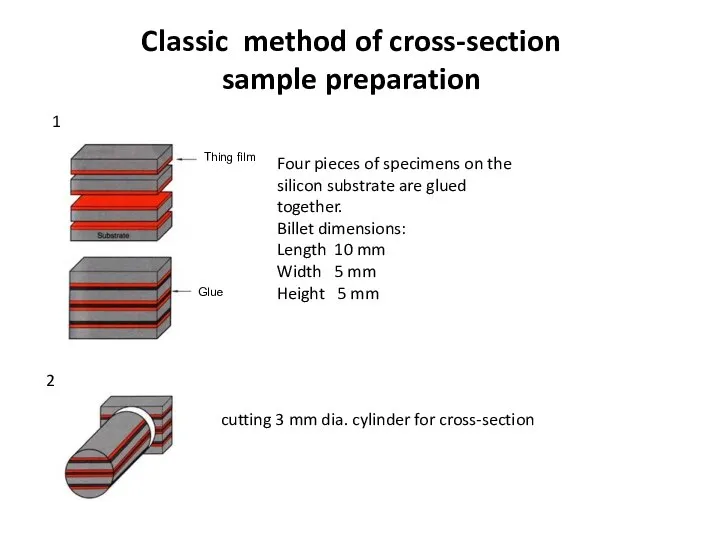
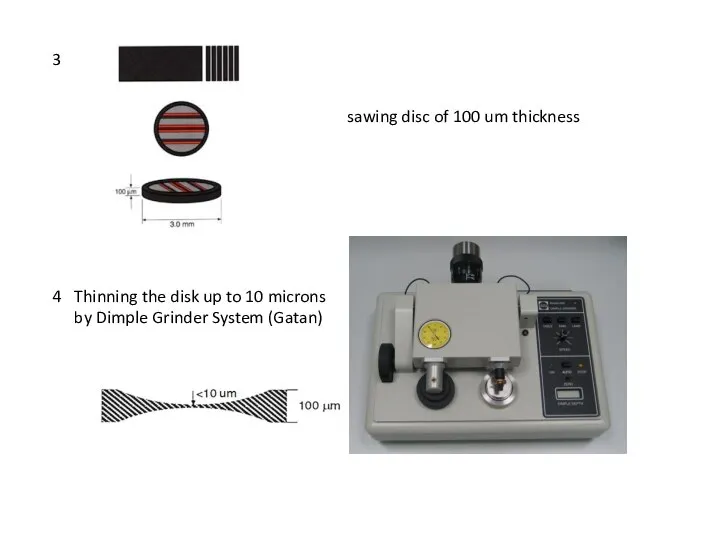
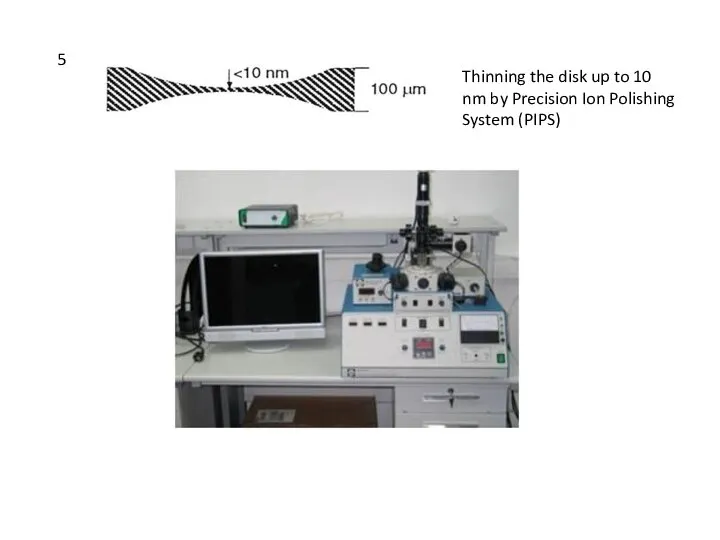
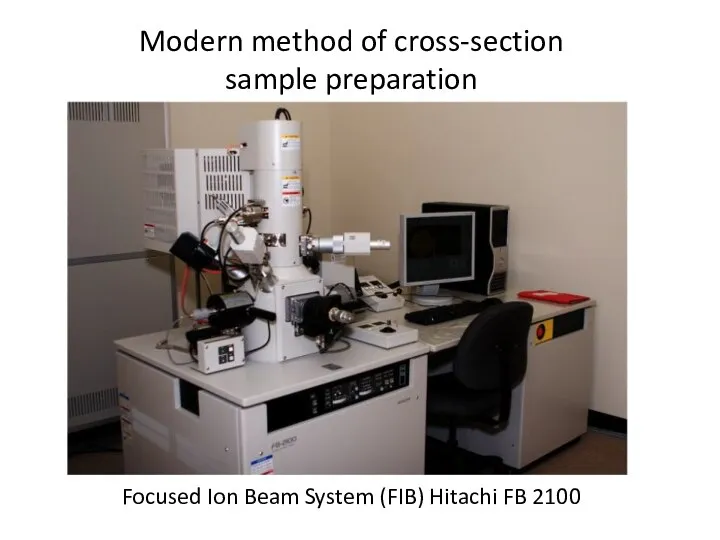

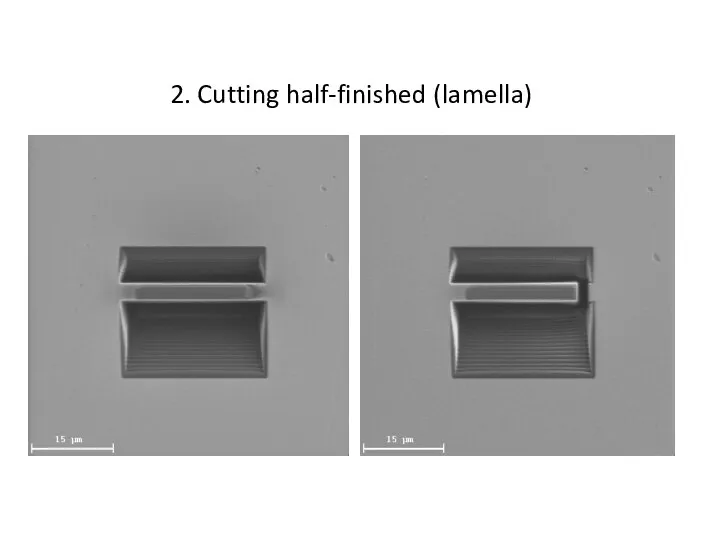



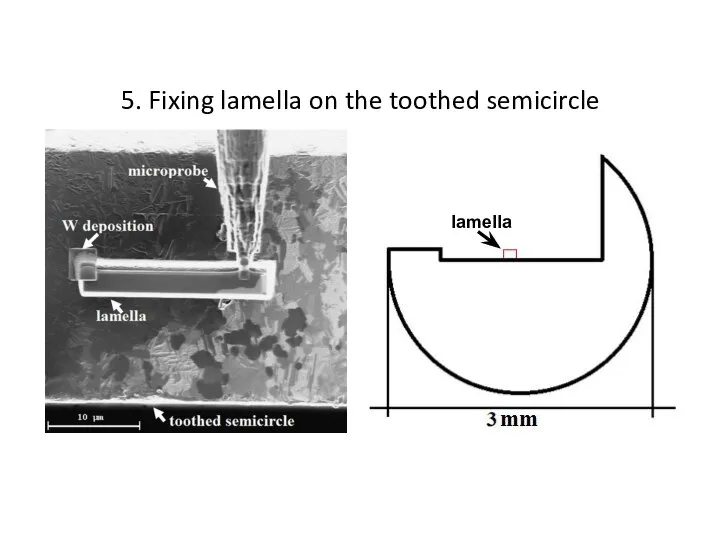






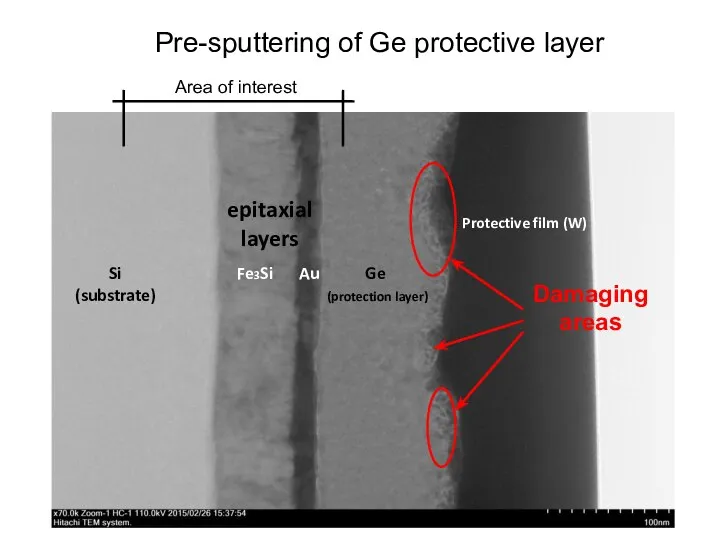



 Обзор основных методов исследования супрамолекулярных объектов
Обзор основных методов исследования супрамолекулярных объектов Презентация по Химии "Многоатомные спирты" - скачать смотреть
Презентация по Химии "Многоатомные спирты" - скачать смотреть  Родючість ґрунтів , можливості її регулювання. Учень 9-Г класу Юрчак Владислав Керівник Садовська Т.Я.
Родючість ґрунтів , можливості її регулювання. Учень 9-Г класу Юрчак Владислав Керівник Садовська Т.Я. Симметрия в химии. Кристаллы
Симметрия в химии. Кристаллы Количественное определение лекарственных средств
Количественное определение лекарственных средств Электронные конфигурации атомов
Электронные конфигурации атомов Презентація З хімії На тему : ” Майбутнє альтернативного палива” Виконала учениця 11-А класу Твердохліб Анжеліка
Презентація З хімії На тему : ” Майбутнє альтернативного палива” Виконала учениця 11-А класу Твердохліб Анжеліка  Кислоты органические и неорганические.
Кислоты органические и неорганические. Синтетические моющие средства.(СМС) Подготовила Живулько Елена.
Синтетические моющие средства.(СМС) Подготовила Живулько Елена.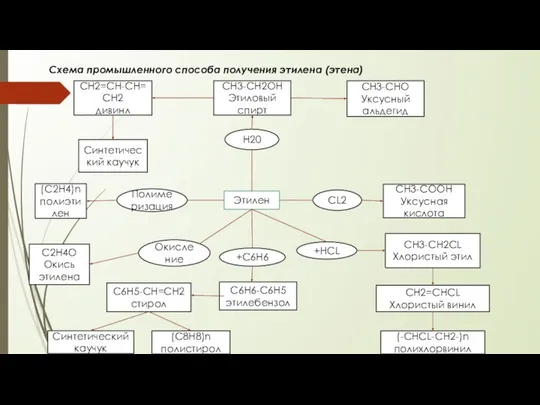 Промышленній способ получения этилена (этена)
Промышленній способ получения этилена (этена) Сложные эфиры
Сложные эфиры Растворы. Способы выражения концентрации растворенного вещества
Растворы. Способы выражения концентрации растворенного вещества Титани органічної хімії
Титани органічної хімії Энергетика химических процессов
Энергетика химических процессов Презентация по химии Химические уравнения Реакции обмена
Презентация по химии Химические уравнения Реакции обмена  Выращивание кристаллов в домашних условиях
Выращивание кристаллов в домашних условиях Неметаллы. Обобщение. Открытый урок
Неметаллы. Обобщение. Открытый урок Окислительно-восстановительные реакции
Окислительно-восстановительные реакции Биогеохимия Оренбургской области
Биогеохимия Оренбургской области Химия элементов VIA группы. Сера
Химия элементов VIA группы. Сера Кремнийорганическая гипотеза
Кремнийорганическая гипотеза Неметаллы. Положение неметаллов в ПСХЭ
Неметаллы. Положение неметаллов в ПСХЭ Полифункциональды (гетерофункциональды) биоорганикалық қосылыстар: оксиқышқылдар, альдегидо- және кетоқышқылдар
Полифункциональды (гетерофункциональды) биоорганикалық қосылыстар: оксиқышқылдар, альдегидо- және кетоқышқылдар - Это оружие массового поражения, действие которого основано на токсических свойствах химических веществ. - Это оружие массового
- Это оружие массового поражения, действие которого основано на токсических свойствах химических веществ. - Это оружие массового  Задачи по теме Энергетический обмен
Задачи по теме Энергетический обмен Горение паро-газо-воздушного облака
Горение паро-газо-воздушного облака Ковалентная полярная связь
Ковалентная полярная связь Нітратна кислота. Нітрати Підготувала:Рибальчук Вікторія
Нітратна кислота. Нітрати Підготувала:Рибальчук Вікторія