Содержание
- 2. Дифракционные методы - совокупность методов исследования атомного строения вещества, использующих дифракцию пучка фотонов, электронов или нейтронов,
- 3. Рентгеноструктурный анализ - один из дифракционных методов исследования структуры вещества. Основа: явление дифракции рентгеновских лучей на
- 4. РИ (X-Rays) – электромагнитное излучение с длиной волны 5*10-2 - 102 A. (E = 250 кэВ
- 5. Энергия связи электронов на низшей (К) оболочке атомов: H: 13.6 эВ, Be: 115.6 эВ, Cu: 8.983
- 6. Источники РИ Рентгеновская трубка (Cu - анод) Источники РИ: рентгеновская трубка, синхротрон, изотопы, ...
- 7. Дифракция РИ на поликристаллической пробе
- 8. Дифракция РИ на поликристаллической пробе Порошковая рентгенограмма Дифракционный угол 20; Интенсивность (имп., имп./сек, отн.ед. и пр.
- 9. Рентгенография Взаимодействие рентгеновских лучей с кристаллами, частицами металлов, молекулами ведет к их рассеиванию. Из начального пучка
- 10. Рентгенография наноструктурных материалов позволяет по уширению рентгеновских пиков достаточно надежно определить размеры зерен при величинах 2-
- 11. Порошковая рентгенограмма Интенсивность пика: - кристаллическая структура - количественный анализ Ширина пика: микроструктура (размер ОКР) Положение
- 12. Размер областей когерентного рассеяния (ОКР) можно рассчитать с помощью уравнения Debye-Scherrer по формуле: D ср =
- 13. Дифракционная картина LaMnO3, полученного золь-гель технологией, прокаленного при Т= 900°С.
- 14. D ср = k ·λ / (β*cos θ ), Границы применимости уравнения Debye-Scherrer: неприменима для кристаллов,
- 15. Рентгенограммы материалов диоксида титана, полученных осаждением (1, 2) и золь-гель метом (3, 4), прокаленных при 500
- 16. Наночастицы платины на углеродном носителе, размер – 4,2 нм
- 17. Вопрос: на рентгенограмме нет пиков – что это значит?
- 18. Вопрос: на рентгенограмме нет пиков – что это значит? общий термин “рентгеноаморфный образец” Две возможности: 1)
- 19. Рентгенография тонких пленок Особенности пленок • Не «бесконечно поглощающие слои» • Значительное текстурирование (эпитаксиальные пленки) •
- 20. Рентгенография тонких пленок
- 21. Рентгенография тонких пленок Особенности пленок: текстурирование Рентгенограммы порошка нитрида титана TiN (а) и пленок TiN, полученных
- 22. Рентгенография тонких пленок
- 23. Дифракционные методы исследований 1. Дифракционные методы применимы к исследованию практически любых объектов в конденсированном состоянии. 2.
- 24. Нейтронография Нейтрон - частица, подходящая по своим свойствам для анализа различных материалов. Ядерные реакторы дают тепловые
- 26. Скачать презентацию


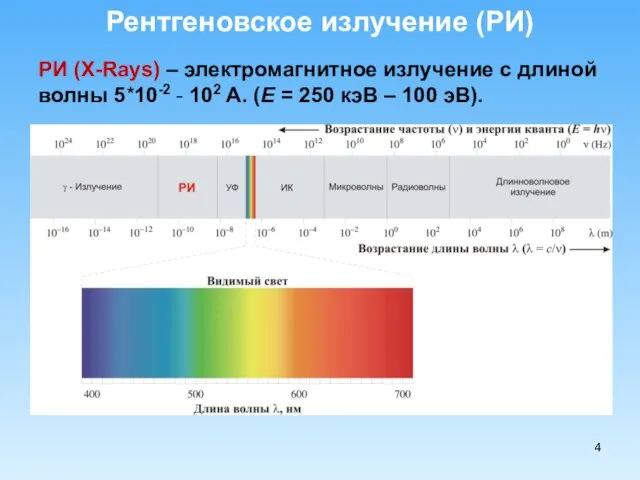

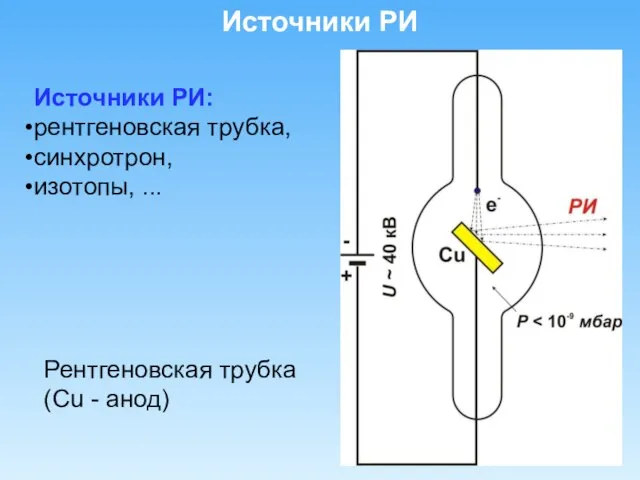
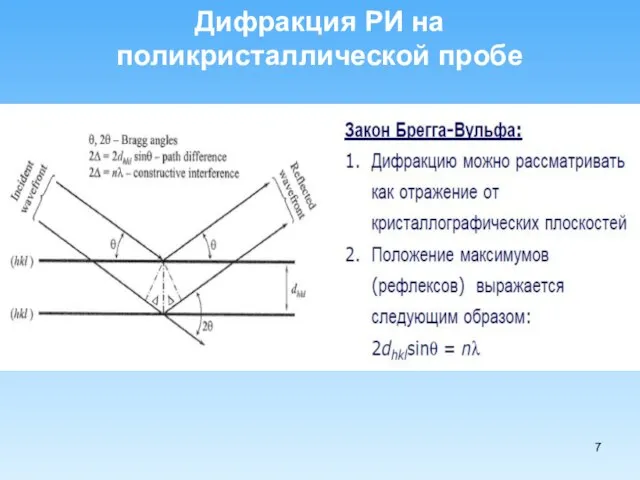







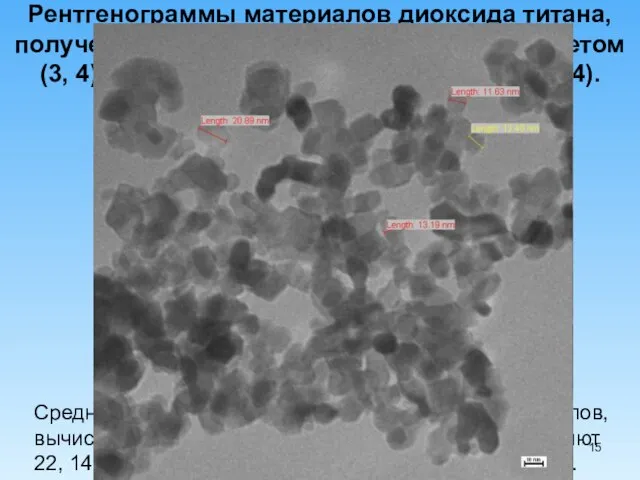



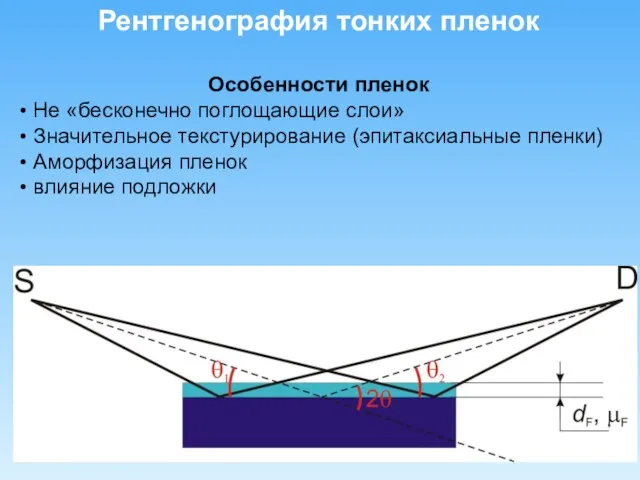





 Биохимияның зерттеу әдістері
Биохимияның зерттеу әдістері Комплексные соединения
Комплексные соединения Квантовая химия
Квантовая химия Химический брейн-ринг
Химический брейн-ринг Основания. Определение. Номенклатура
Основания. Определение. Номенклатура Бензофураны и бензотиофены. Общие методы синтеза
Бензофураны и бензотиофены. Общие методы синтеза История изучения структуры белка Лайнус Полинг считается первым учёным, который смог успешно предсказать вторичную структуру
История изучения структуры белка Лайнус Полинг считается первым учёным, который смог успешно предсказать вторичную структуру Фосфор. Элемент жизни и мысли
Фосфор. Элемент жизни и мысли Азот
Азот The role of chemistry in the solution of the food problem
The role of chemistry in the solution of the food problem Химические свойства металлов. (9 класс)
Химические свойства металлов. (9 класс) Аттестационная работа. Методическая разработка фрагмента урока химии с элементами исследовательской деятельности
Аттестационная работа. Методическая разработка фрагмента урока химии с элементами исследовательской деятельности Презентация по Химии "Химия табачного дыма" - скачать смотреть
Презентация по Химии "Химия табачного дыма" - скачать смотреть  Растворы
Растворы Афферентные средства. (Лекция 6)
Афферентные средства. (Лекция 6) Предельные углеводороды
Предельные углеводороды Композиційні матеріали на основі функціоналізованих олігодієнів, вінілових мономерів і наповнювачів різної природи
Композиційні матеріали на основі функціоналізованих олігодієнів, вінілових мономерів і наповнювачів різної природи Презентация по Химии "Простые вещества-неметаллы" - скачать смотреть
Презентация по Химии "Простые вещества-неметаллы" - скачать смотреть  Интоксикация пестицидами
Интоксикация пестицидами Химические свойства кислорода. Применение кислорода
Химические свойства кислорода. Применение кислорода Биологические мембраны
Биологические мембраны 6-я группа элементов. 9 класс
6-я группа элементов. 9 класс Химия элементов IVA группы
Химия элементов IVA группы Классификация основных пород
Классификация основных пород Таблица Периодическая система Д.И.Менделеева
Таблица Периодическая система Д.И.Менделеева Шоколад. Плюсы и минусы
Шоколад. Плюсы и минусы Чудеса своїми руками
Чудеса своїми руками  Химия и пища
Химия и пища