Содержание
- 2. Цель работы: Расчет химического состава Ar/N2/Al плазмы газового разряда. Задачи: Провести литературный обзор по нитриду алюминия.
- 3. Актуальность изолирующий слой в полупроводниковых приборах; пассирующий слой в полупроводниковых приборах; устройства на поверхностно-акустических волнах (ПАВ);
- 4. В качестве ключевых элементов химической модели смеси аргон (Ar), азот (N), алюминий (Al) в плазме газового
- 5. ТАБЛИЦА 1 - Основные константы скорости для плазмы Al/Ar/N2.
- 6. ТАБЛИЦА 2 - Уравнения баланса частиц для плазмы Al/Ar/N2.
- 7. Рис.1 – Степень диссоциации азота в зависимости от давления и мощности, [N2]/[Ar]=1/10. 1- 1500Вт, 2-1250Вт, 3-1000Вт,
- 8. Рис.2 - Плотности частиц смеси Ar/N2 в зависимости от давления при мощности разряда 1 кВт.
- 10. Рис.3 - Фракция потока ионов Al в зависимости от концентрации электронов.
- 11. Выводы. Заключение.
- 12. Список использованной литературы. [1] A. E. Wickenden, L. J. Currano, T. Takacs, J. Pulskamp, M. Dubey,
- 13. Спасибо за внимание!
- 14. [11] J. J. Hantzpergue, Y. Pauleau, and H. C. Remy, //Thin Solid Films (1981), p 75,
- 16. Скачать презентацию
Цель работы:
Расчет химического состава Ar/N2/Al плазмы газового разряда.
Задачи:
Провести литературный
Цель работы:
Расчет химического состава Ar/N2/Al плазмы газового разряда.
Задачи:
Провести литературный
Составление балансных уравнений химической кинетики.
Расчет химического состава на основе модели процессов, протекающих в плазме смеси аргон (Ar), азот (N), алюминий (Al)
Актуальность
изолирующий слой в полупроводниковых приборах;
пассирующий слой в полупроводниковых приборах;
устройства
Актуальность
изолирующий слой в полупроводниковых приборах;
пассирующий слой в полупроводниковых приборах;
устройства
микро- и нано-электромеханические системы (MEMS, NEMS);
объемные акустические волны (ОАВ) для резонаторов и фильтров c высокочастотными элементами связи.
В качестве ключевых элементов химической модели смеси аргон (Ar), азот (N),
В качестве ключевых элементов химической модели смеси аргон (Ar), азот (N),
(1) плотности частиц усреднены по объему.
(2) для упрощения рассматривается одно эквивалентное возбужденное состояние N2 в плазме. Генерация N2* определяется из общего сечения электронного возбуждения для N2.
(3) из-за низкой вероятности реакции при интересующих давлениях столкновения трех тел не включены в модель (10–40 мТорр).
(4) предполагается, что нейтральная и ионная температуры равны температуре газа N2.
(5) электронная диссоциация иона азота N2+ не учтена, поскольку молекулярная плотность ионов относительно мала по сравнению с плотностью N2.
(6) распыленные атомы Al полностью термализуются при столкновении с газовой смесью Ar/N2.
(7) из-за отсутствия данных о сечении ионизации возбужденного состояния Al (Al* + e- → Al+ + 2e-) предполагается, что Al+ генерируется только одноступенчатым энергетическим процессом электронного удара Al+e- → Al++ 2e- и пеннинговской ионизацией Al+Ar* → Al++Ar+e-.
(8) нитрид алюминия образуется на подложке.
Поэтому реакциями Algas+Ngas →AlNgas в газовой фазе можно пренебречь [22].
Основные положения модели:
ТАБЛИЦА 1 - Основные константы скорости для плазмы Al/Ar/N2.
ТАБЛИЦА 1 - Основные константы скорости для плазмы Al/Ar/N2.
ТАБЛИЦА 2 - Уравнения баланса частиц для плазмы Al/Ar/N2.
ТАБЛИЦА 2 - Уравнения баланса частиц для плазмы Al/Ar/N2.
Рис.1 – Степень диссоциации азота в зависимости от давления и мощности,
Рис.1 – Степень диссоциации азота в зависимости от давления и мощности,
Рис.2 - Плотности частиц смеси Ar/N2 в зависимости от давления при
Рис.2 - Плотности частиц смеси Ar/N2 в зависимости от давления при
Рис.3 - Фракция потока ионов Al в зависимости от концентрации электронов.
Рис.3 - Фракция потока ионов Al в зависимости от концентрации электронов.
Выводы. Заключение.
Выводы. Заключение.
Список использованной литературы.
[1] A. E. Wickenden, L. J. Currano, T. Takacs,
Список использованной литературы.
[1] A. E. Wickenden, L. J. Currano, T. Takacs,
[2] W. J. Liu, S. J. Wu, C. M. Chen, Y. C. Lai, C. H. Chuang, J. Cryst. Control of in-plane and out-of-plane texture in shear mode piezoelectric ZnO films by ion-beam irradiation. // Growth, p 276, p 525, (2005).
[3] R. C. Turner, P. A. Fuierer, R. E. Newnham, T. R. Shrout, T. R. Appl. Ceramic Materials and Multilayer Electronic Devices. //Acoust. 41299 (1994).
[4] M. Akiyama, T. Kamohara, K. Nishikubo, N. Ueno, H. Nagai, T. Okutani. AlN texturing and piezoelectricity on flexible substrates for sensor applications. //Appl. Phys. Lett. (2005), p 86, p 022, p 106.
[5] D. Yin, Y. Li, Y. Shao, X. Zhao, S. Yang, L. Fan, J. Fluorine Chem. Advanced Polyimide Materials: Synthesis, Characterization, and Applications. (2005), p 126, p 819.
[6] M. Akiyama, C. N. Xu, K. Nonaka, K. Shobu, T. Watanabe. Characteristics of AIN thin films deposited by electron cyclotron resonance dual-ion-beam sputtering and their application to GHz-band surface acoustic wave devices. //Thin Solid Films (1998), p 315, p 62.
[7] Сартаков А. В., Худайбергенов Г. Ж. Моделирование кинетики электронного газа азот – алюминиевой плазмы тлеющего разряда. //Вестник ОмГУ №4,Т.54, 2009, с.80-81.
[8] Белянин А. Ф., Выращивание плазменными методами пленок алмаза и родственных материалов (алмазоподобных, нитрида алюминия, оксида цинка) и применение многослойных структур на основе этих пленок в микро- и акустоэлектронике.) //Диссертация (2002).
[9] M. Morita, S. Isogai, N. Shimizu, K. Tsubochi, and N. Mikoshiba, Considerations in Further Development of Aluminum Nitride as a Material for Device Applications. //Jpn. App. Phys. 20, (1981), p 173.
[10] S. Mirsch and H. Reimer, Impact of the silicon substrate resistivity and growth condition on the deep levels in Ni-Au/AlN/Si MIS Capacitors. //Phys. Status Solidi 11, (1972), p 631.
Спасибо за внимание!
Спасибо за внимание!
[11] J. J. Hantzpergue, Y. Pauleau, and H. C. Remy, //Thin
[11] J. J. Hantzpergue, Y. Pauleau, and H. C. Remy, //Thin
[12] T. Shiosaki, T. Yamamoto, T. Oda, and A. Kawabata, Composite substrate material for surface acoustic-wave oscillator //App. Phys. Lett. (1980), p 36, p 643.
[13] E. V. Gerova, N. A. Inanov, and K. I. Kirov K. J. Deposition of AIN thin films by magnetron reactive sputtering. //Thin Solid Films p 81, p 201 (1981).
[14] Пащенко П. В., Магнетронные методы выращивания пленок AIN для устройств электронной техники. Диссертация 1998г.
[15] Лесунова, Р.П. О влиянии кислорода и влаги на электрохимические свойства нитрида алюминия / Р.П. Лесунова, С.Ф. Пальгуев, Е.И. Бурмаки // Неорганические материалы. – 1998. – Т. 1, № 34. – С. 47–51.
[16] Самсонов, Г.В. Технология получения нитрида алюминия и возможности его промышленного использования / Г.В. Самсонов, Т.В. Дубовик // Цветные металлы. – 1962. – № 3. – С. 56–61.
[17] Самсонов, Г.В. Получение и методы анализа нитридов / Г.В. Самсонов, О.П. Кулик, В.С. Полищук. – К.: Наукова думка, 1978г. с 132.
[18] Самсонов, Г.В. Азотирование порошка алюминия под давлением / Г.В. Самсонов, Ю.Д. Репкин Ю.Д. // Порошковая металлургия. – 1965. – № 2. – С. 1–3.
[19] Lan Y.C. et al. Low-temperature synthesis and photoluminescence of AlN // Journal of Crystal Growth. (1999). № 207. С. 247–250.
[20] Самсонов, Г.В. Получение и методы анализа нитридов / Г.В. Самсонов, О.П. Кулик, В.С. Полищук. – К.: Наукова думка, 1978г. с 132.




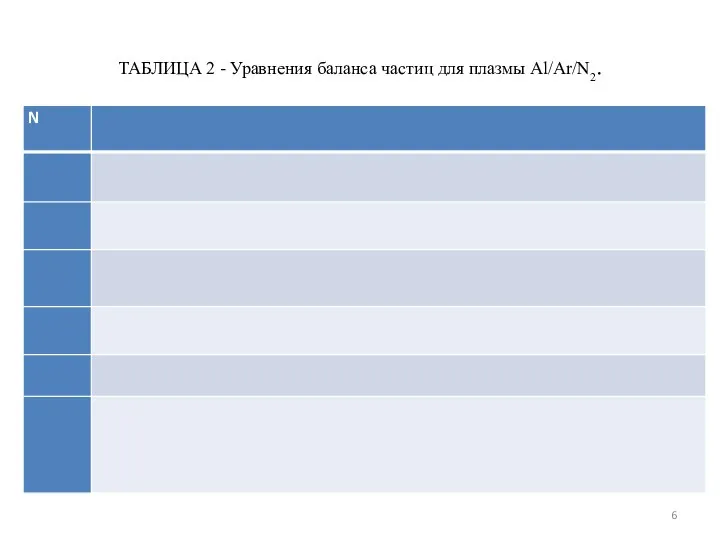
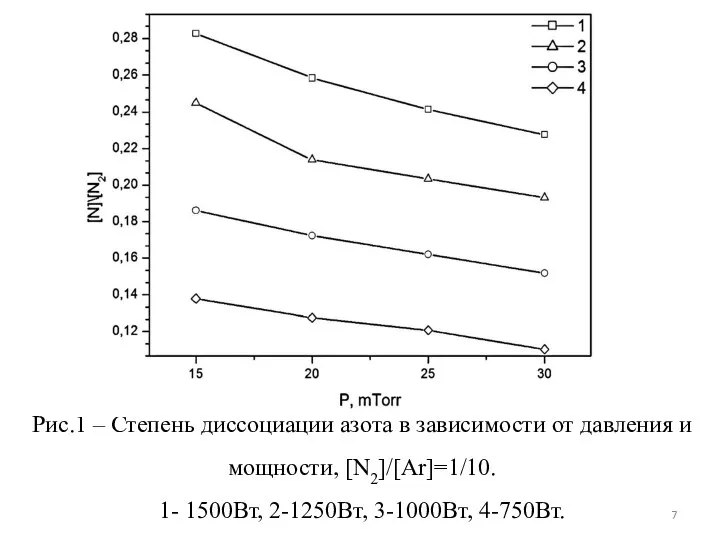
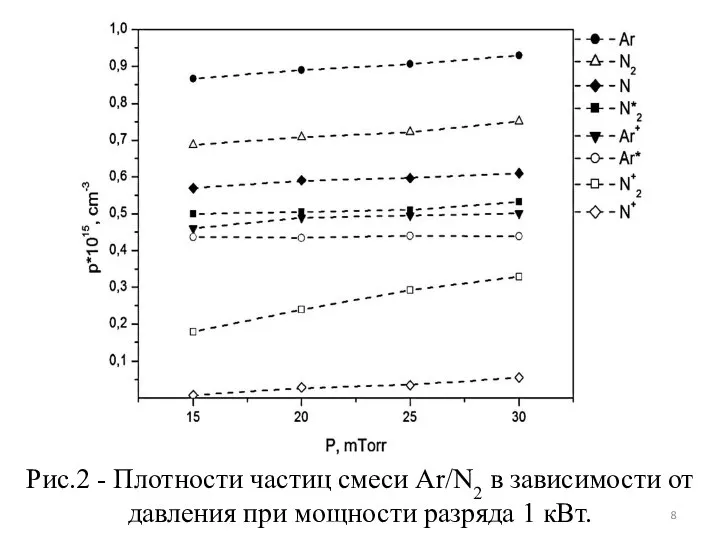



![Список использованной литературы. [1] A. E. Wickenden, L. J. Currano, T.](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/626751/slide-11.jpg)

![[11] J. J. Hantzpergue, Y. Pauleau, and H. C. Remy, //Thin](/_ipx/f_webp&q_80&fit_contain&s_1440x1080/imagesDir/jpg/626751/slide-13.jpg)
 Презентация по Химии "Основания, их классификация" - скачать смотреть
Презентация по Химии "Основания, их классификация" - скачать смотреть  Презентация по Химии "Малахіт" - скачать смотреть
Презентация по Химии "Малахіт" - скачать смотреть  Гидролиз. Методы его получения и применения
Гидролиз. Методы его получения и применения Місце хімії серед інших наук про природу, її значення для розуміння наукової картини світу Виконали : Ткаченко Олена і Сардаков
Місце хімії серед інших наук про природу, її значення для розуміння наукової картини світу Виконали : Ткаченко Олена і Сардаков Закономерности адсорбции ионов и адагуляции коллоидных частиц. Самосборка на поверхности. (Лекция 9)
Закономерности адсорбции ионов и адагуляции коллоидных частиц. Самосборка на поверхности. (Лекция 9) Витамины молока и молочных продуктов. Жирорастворимые витамины
Витамины молока и молочных продуктов. Жирорастворимые витамины Презентация по Химии "Мышьяк – As" - скачать смотреть
Презентация по Химии "Мышьяк – As" - скачать смотреть  Углерод. Химические свойства
Углерод. Химические свойства Презентация по Химии "Химические средства гигиены и косметики" - скачать смотреть
Презентация по Химии "Химические средства гигиены и косметики" - скачать смотреть  Ацетилсаліцилова кислота(аспірин) Підготувала: Коваленко Альона
Ацетилсаліцилова кислота(аспірин) Підготувала: Коваленко Альона  Реакции, применяемые в синтезах гетероциклов
Реакции, применяемые в синтезах гетероциклов Майда еритін витаминдер. А,D,E,K витаминдері
Майда еритін витаминдер. А,D,E,K витаминдері Өндірістік улар
Өндірістік улар Кислород. Горение сложных веществ на воздухе или в кислороде
Кислород. Горение сложных веществ на воздухе или в кислороде Адиабатическое приближение в твердом теле
Адиабатическое приближение в твердом теле Сплавы серебра
Сплавы серебра Парфюмерия. Основные химические элементы, производство
Парфюмерия. Основные химические элементы, производство Тест «Природный газ»
Тест «Природный газ» Сахара и липиды
Сахара и липиды Влияние химической завивки на волосы Муниципальное образовательное учреждение среднеобразовательная школа №1 работа Рожковой
Влияние химической завивки на волосы Муниципальное образовательное учреждение среднеобразовательная школа №1 работа Рожковой  Ағзаның барлық жасушасындағы белок алмасу. Аминқышқылдарының дезаминденуі, пурин және пиримидиндердің ыдырауынан
Ағзаның барлық жасушасындағы белок алмасу. Аминқышқылдарының дезаминденуі, пурин және пиримидиндердің ыдырауынан Полимеры
Полимеры  Биосинтез пиримидиновых нуклеотидов
Биосинтез пиримидиновых нуклеотидов «Сухая вода» помогла измерить поляризацию ковалентных связей
«Сухая вода» помогла измерить поляризацию ковалентных связей Кислоты Начальные сведения
Кислоты Начальные сведения Підгрупа карбону
Підгрупа карбону Свойства неорганических веществ. (Задание 37. ЕГЭ по химии)
Свойства неорганических веществ. (Задание 37. ЕГЭ по химии) Номенклатура алканов
Номенклатура алканов