Содержание
- 2. Нанометрологические средства исследования объектов: Прямые микроскопические: Электронная микроскопия Сканирующая зондовая микроскопия Косвенные: Дифракционный анализ Спектральные методы:
- 3. Задачи: Определение химического состава отдельных фаз, зерен, структурных составляющих Определение атомно-молекулярной структуры Определение морфологии и микроструктуры
- 4. Просвечивающий электронный микроскоп это устройство, в котором изображение от ультратонкого образца (толщиной порядка 0,1 мкм) формируется
- 5. Растровая электронная микроскопия Тонкий электронный зонд генерируется электронной пушкой, которая играет роль источника электронов, и фокусируется
- 6. Электроны зонда (пучка) взаимодействуют с материалом образца и генерируют различные типы сигналов: вторичные электроны, обратноотраженные электроны,
- 7. Сканирующая зондовая микроскопия Сканирующие зондовые микроскопы — класс микроскопов для получения изображения поверхности и её локальных
- 8. Основные типы сканирующих зондовых микроскопов Сканирующий туннельный микроскоп — для получения изображения используется туннельный ток между
- 9. Сканирующий туннельный микроскоп Применяется для исследования электропроводящих образцов: металлов, сплавов, сверхпроводников и полупроводников. При подаче напряжения
- 10. Атомно-силовой микроскоп Принцип работы атомно-силового микроскопа основан на регистрации силового взаимодействия между поверхностью исследуемого образца и
- 11. Сканирующий зондовый микроскоп Кантилевер атомно-силового микроскопа
- 12. Сканирующий ближнепольный микроскоп в качестве зонда используется миниатюрная диафрагма с отверстием в несколько нанометров - апертура.
- 13. В настоящее время сканирующий зондовые микроскопы нашли применение практически во всех областях науки. В физике, химии,
- 14. Рентгеновский дифракционный анализ Когда рентгеновское излучение проходит через материал, радиация взаимодействует с электронами в атоме, что
- 15. Рентгеновский дифракционный анализ Это приводит к дифракции, где рентгеновское излучение связано с расстояниями между атомами, организованными
- 17. Скачать презентацию








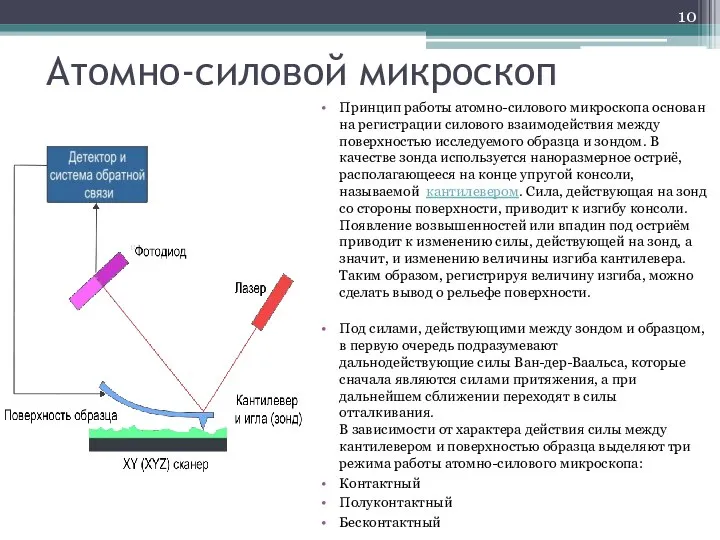





 Биохимияның зерттеу әдістері
Биохимияның зерттеу әдістері Комплексные соединения
Комплексные соединения Квантовая химия
Квантовая химия Химический брейн-ринг
Химический брейн-ринг Основания. Определение. Номенклатура
Основания. Определение. Номенклатура Бензофураны и бензотиофены. Общие методы синтеза
Бензофураны и бензотиофены. Общие методы синтеза История изучения структуры белка Лайнус Полинг считается первым учёным, который смог успешно предсказать вторичную структуру
История изучения структуры белка Лайнус Полинг считается первым учёным, который смог успешно предсказать вторичную структуру Фосфор. Элемент жизни и мысли
Фосфор. Элемент жизни и мысли Азот
Азот The role of chemistry in the solution of the food problem
The role of chemistry in the solution of the food problem Химические свойства металлов. (9 класс)
Химические свойства металлов. (9 класс) Аттестационная работа. Методическая разработка фрагмента урока химии с элементами исследовательской деятельности
Аттестационная работа. Методическая разработка фрагмента урока химии с элементами исследовательской деятельности Презентация по Химии "Химия табачного дыма" - скачать смотреть
Презентация по Химии "Химия табачного дыма" - скачать смотреть  Растворы
Растворы Афферентные средства. (Лекция 6)
Афферентные средства. (Лекция 6) Предельные углеводороды
Предельные углеводороды Композиційні матеріали на основі функціоналізованих олігодієнів, вінілових мономерів і наповнювачів різної природи
Композиційні матеріали на основі функціоналізованих олігодієнів, вінілових мономерів і наповнювачів різної природи Презентация по Химии "Простые вещества-неметаллы" - скачать смотреть
Презентация по Химии "Простые вещества-неметаллы" - скачать смотреть  Интоксикация пестицидами
Интоксикация пестицидами Химические свойства кислорода. Применение кислорода
Химические свойства кислорода. Применение кислорода Биологические мембраны
Биологические мембраны 6-я группа элементов. 9 класс
6-я группа элементов. 9 класс Химия элементов IVA группы
Химия элементов IVA группы Классификация основных пород
Классификация основных пород Таблица Периодическая система Д.И.Менделеева
Таблица Периодическая система Д.И.Менделеева Шоколад. Плюсы и минусы
Шоколад. Плюсы и минусы Чудеса своїми руками
Чудеса своїми руками  Химия и пища
Химия и пища