Содержание
- 2. В базовых технологических маршрутах оптической нанолитографии можно выделить два микромаршрута: создание защитной маски (фоторезистивной или из
- 3. Классификация процессов размерного травления материалов
- 4. Плазмой называют квазинейтральный газ заряженных и нейтральных частиц, концентрация которых достаточна для того, чтобы создаваемый ими
- 5. Низкотемпературная газоразрядная плазма (НГП). НГП – это слабо ионизированный газ при давлении 13·10-2 - 13·102 Па
- 6. В зависимости от вида плазмообразующего газа и природы поверхности твёрдого тела в каждом из трёх случаев
- 8. По физико-химическому механизму взаимодействия частиц НГП с поверхностью обрабатываемого материала (образца) процессы травления можно разделить на
- 9. ПТ и РИПТ происходят в плазме химически активных газов, и в них поверхность обрабатываемого материала подвергается
- 10. Процессы травления должны обеспечивать: воспроизводимость, скорость, селективность, степень анизотропии, равномерность и высокую производительность. Указанные характеристики зависят
- 11. Основные выходные параметры процесса травления: Скорость травления Селективность травления Анизотропия травления Профиль травления Уровень внесенных радиационных
- 12. В системах вакуумного плазменного травления (ВПТ) диапазон давлений рабочего газа определяется условиями существования рабочих разрядов. В
- 15. Sisolid + 4F SiF4gas
- 16. Транспорт частиц в микроструктуре
- 18. Номенклатура специальных газов
- 22. Скорость травления поликристаллического кремния для газовых смесей, основанных на HBr- и Cl2,- от расхода смеси
- 23. Зависимость скорости травления слоев проводника от соотношения газовых потоков в смеси.
- 27. Несмотря на большое разнообразие все процессы вакуумного газоплазменного травления (ВГПТ) по механизму взаимодействия с обрабатываемым материалом
- 28. Классификация процессов вакуумного газо-плазменного травления (ВГПТ) по механизму взаимодействия с обрабатываемым материалом спонтанное химическое травление физическое
- 29. Спонтанное химическое травление материалов. В процессах спонтанного химического травления (spontaneous chemical etching - SC etching) основной
- 30. Из-за отсутствия данных по температурам испарения многих соединений, летучесть продуктов реакций, образующихся в процессах спонтанного химического
- 31. Если материал ФС не образует летучих двухкомпонентных соединений с ХАЧ (атомами и радикалами), то необходимо рассмотреть
- 32. Характеристики процесса спонтанного травления во фторуглеродных газах существенно зависят от относительного содержания фтора и углерода. В
- 33. Добавка кислорода в диапазоне (20 – 40) % при спонтанном травлении материалов в плазме фторуглеродных газов
- 34. В механизме спонтанного химического гетерогенного травления можно выделить следующие основные стадии: - доставка химически активных частиц
- 35. Скорость спонтанного травления материала ФС в результате химической реакции (spontaneous chemical etching - SC etching) в
- 36. По своему механизму процессы спонтанного химического травления материалов потоками атомов и радикалов должны быть изотропными, также
- 37. . Ионное травление материалов физическим распылением В процессах ионного травления физическим распылением (ion etching by physical
- 38. Процесс физического распыления материалов количественно характеризуется коэффициентом распыления (КР) (sputtering yield), который определяется как число атомов,
- 39. Значение КР материалов ионами инертных газов зависит от следующих факторов: 1. Массы бомбардирующих ионов mi. КР
- 40. 3. От атомного номера распыляемого материала za. Наблюдается сложная периодическая зависимость КР от атомного номера распыляемого
- 41. Эволюция профиля ионного травления подложки через защитную маску: a – профиль маски и подложки до проведения
- 42. Влияние эффекта переосаждения распыленного материала (sputtered material) подложки (substrate) на профиль ионного травления структуры через фоторезистивную
- 43. Влияние на профиль получаемой при ионном травлении структуры (etched film) эффекта отражения ионов от боковых стенок
- 44. Применительно к процессам травления материалов физическим распылением, следует отметить два важных аспекта: 1. Существующие теории физического
- 45. Ионное травление химически модифицированным физическим распылением материалов. При ионном травлении химически модифицированным физическим распылением (ion etching
- 46. Скорость травления химически модифицированных поверхностных слоев материала за счет физического распыления может быть как больше, так
- 47. Радиационно-стимулированное химическое травление материалов. При радиационно-стимулированном химическом травлении (radiation assisted chemical etching - RAC etching) спонтанные
- 48. Скорость радиационно-стимулированного химического травления (radiation assisted chemical etching - RAC etching) материала определяется выражением: Где -
- 49. Сравнивая выражение для радиационно-стимулированного химического травления с формулой для спонтанного травления, его можно представить в виде:
- 50. Типичный профиль ионно-стимулированного газового или радикального травления Coburn J.W., Winters H.F. Plasma etching - a discussion
- 51. Соотношение между плотностью потока молекул, атомов или радикалов рабочего газа и плотностью тока пучка ионов инертного
- 52. Радиационно-возбуждаемое химическое травление материалов. При радиационно-возбуждаемом химическом травлении (radiation excited chemical etching - REC etching) спонтанные
- 53. В этом случае радиационное воздействие (РВ) само возбуждает химические реакции, и его параметры (вид, энергия, интенсивность,
- 54. В процессах ионно-возбуждаемого газового и радикального травления (ИВГТ и ИВРТ), когда возбуждение химической реакции травления материала
- 55. Типичные зависимости скорости травления материалов для спонтанного химического травления vSCet, радиационно-стимулированного химического травления vRACet и радиационно-возбуждаемого
- 56. При проведении процессов травления в условиях плазмы (низкотемпературной неравновесной газоразрядной плазмы - ННГП) процессы взаимодействия различных
- 57. Повышение концентрации электронов, например, за счет увеличения мощности, вкладываемой в плазму, автоматически изменит концентрацию и энергию
- 58. Сравнительные технологические характеристики процессов вакуумного газоплазменного травления
- 60. Состав и параметры оборудования вакуумного газоплазменного травления функциональных слоев. Оборудование вакуумного газоплазменного травления (ВГПТ) материалов функциональных
- 61. 5. Системы термостатирования электродов, стенок камеры, подложкодержателей, испарителей жидких реагентов, участков газовых каналов и откачных магистралей,
- 62. Состав оборудования ВГПТ материалов ФС определяет перечень операционных (целенаправленно выставляемых режимных) параметров, к которым относятся: 1.
- 63. Способ крепления пластины к охлаждаемому подложкодержателю и обеспечения ее хорошего теплового контакта в оборудовании вакуумного газоплазменного
- 64. Изображение ICP системы для травления. Электростатический экран между катушкой и диэлектрическим окном (кварцевая труба) обеспечивает индуктивное
- 65. Схема форвакуумного насоса
- 66. Диффузионный насос
- 67. Турбомолекулярный насос
- 68. Схема криогенного насоса
- 71. а – эмиссионный спектр ВЧ-разряда на смеси 92% CF4 – 8% O2; б – эмиссионный спектр
- 73. Основные системы размерного вакуумного газоплазменного травления функциональных слоев ИС первого поколения: a - цилиндрический реактор (barrel
- 75. Основные системы размерного вакуумного газоплазменного травления функциональных слоев ИС второго поколения: a - планарная система магнитно-стимулированного
- 76. Основные системы размерного вакуумного газоплазменного травления функциональных слоев ИС третьего поколения: a - система с индукционно-связанной
- 84. Для большинства применений плазменных процессов в микро- и наноэлектронике важно знать как распределено падение потенциала в
- 88. 1) первая катодная темная область; 2) первое катодное свечение; 3) вторая катодная темная область; 4) второе
- 91. Схема РИТ
- 93. Основные факторы при травлении в плазме элементов с малыми размерами и высоким аспектным соотношением: зарядка диэлектрических
- 94. Четыре основных механизма снижения анизотропии и задержки РИТ Ионное затенение. Рассеивание и зарядовый обмен в ОПЗ
- 95. а- «идеальный» профиль, b - осаждение полимера на боковые стенки формируемой структуры, с - проявляется химическая
- 96. На рисунке а) показан профиль травления, который во многих случаях можно считать «идеальным». В этом случае
- 97. На рисунке е) показан профиль, который формируется, если боковые стенки профиля окна маски имеют наклон. В
- 98. В силу своей природы плазма содержит заряженные частицы – положительно зараженные ионы и отрицательно заряженные электроны.
- 109. Transmission electron microscopy cross-sections of nanowire structure. (Reprinted from Yang, F.-L., Lee, D.-H., Chen, H.-Y., Chang,
- 111. Микрофотография профиля щелевой структуры с осажденными тонкими слоями TaN/Ta/Cu.
- 112. Возможные поврежденияструктур, присущие плазменным процессам.
- 116. Поперечное сечение нижней части канавки с подтравом, вызванным переотражением ионов от заряженных стенок.
- 123. Селективное плазменное травление нитрида для формирования нитридного спейсера.
- 124. Микрофотография самосовмещенного контакта, вытравленного в системе высокоплотной плазмы, иллюстрирующая низкую селективность на углах структуры при понижении
- 125. Микроснимок поперечного сечения щелей различной ширины, протравленных в DRM системе в течение восьми минут. Наблюдается снижение
- 127. Схематичное изображение щелевого конденсатора, используемого в 256 Мгб ДОЗУ.
- 128. Вариации формы канавки для различных поколений ДОЗУ, приводящие к 10% изменениям площади конденсатора, вызываемым отклонением параметров
- 129. SF6/O2 крио процесс с использованием наноимпринт литографии. Суб-20 нм область.
- 130. 26 нм элемент поликремния, протравленный с высокой селективностью по отношению к подзатворному окислу. 3 стадии травления:
- 131. 27 нм линии в кремнии глубиной 450 нм.
- 132. 1 мкм переходные контактные отверстия в окисле кремния
- 133. 110 нм линии хрома.
- 134. 100 нм линии. Аспектное отношение 10:1.
- 135. 50 мкм элемент кремния.
- 136. 50 мкм травление кремния с использованием Bosch Process при изготовлении микромеханических устройств
- 137. Травление кремния по РИТ технологии в анизотропно-изотропном процессе для формирования кантиливеров АСМ
- 138. 75 мкм травление кремния
- 139. 400 мкм отверстие в кремнии, полученное по технологии криогенного РИТ
- 140. Микрофотография поперечного сечения с трансмиссионного электронного микроскопа (TEM) Al(Cu) проводника после травления Cl2/HCl плазмой, сопровождаемой удалением
- 141. Фотография полости в проводнике ("укус мыши") вызванной коррозией проводника из Al(Cu).
- 142. Микрофотографии изотропных профилей травления Si*: а) - W = 90 Вт, P = 45 Па, QSF6
- 143. Микрофотографии нанопроволочной кремниевой структуры (а) и чувствительного виброрезонансного наноэлемента для атомных весов (б).
- 144. Зависимости скоростей травления Si*, SiO2 и Si3N4 от операционных параметров процесса: а) - от ВЧ-мощности; б)
- 145. Зависимости селективностей травления Si*/SiO2 и Si*/Si3N4 от операционных параметров процесса: а) от ВЧ-мощности; б) – от
- 150. Линии шириной 22 нм протравленные в кремнии через электронно-лучевой резист. Аспектное отношение 7:1
- 153. Темы для рефератов: Физико-химические свойства низкотемпературной плазмы. Методы диагностики. Физико-химическое воздействие НГП на обрабатываемую поверхность. Методы
- 155. Скачать презентацию












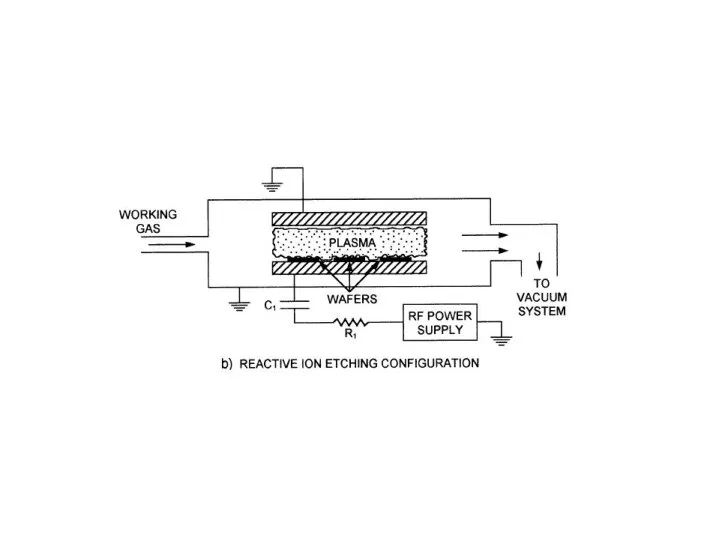
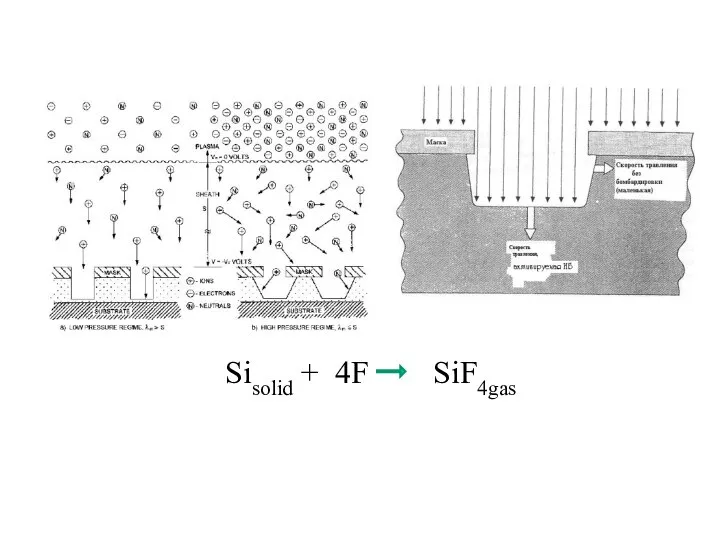








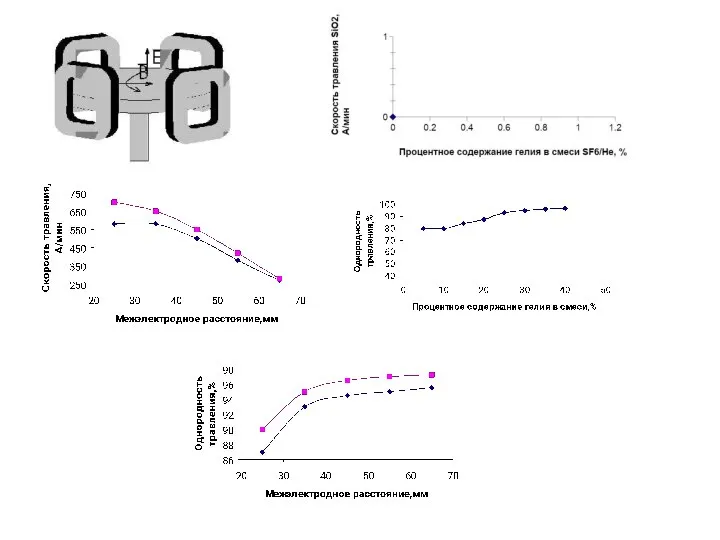
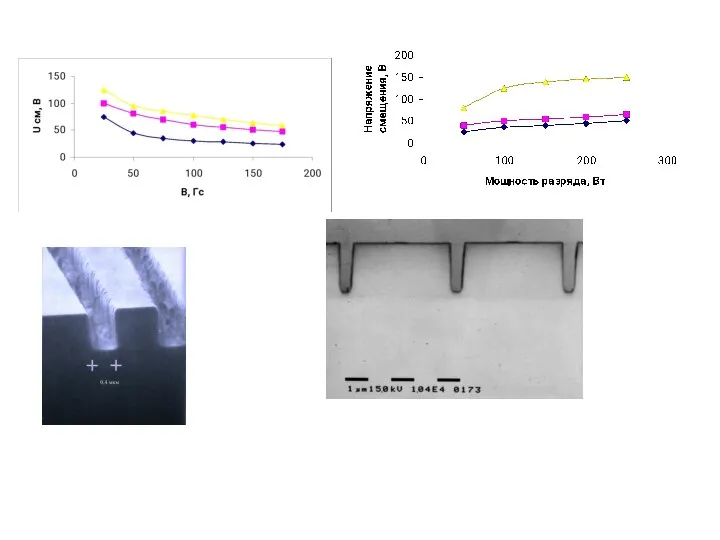















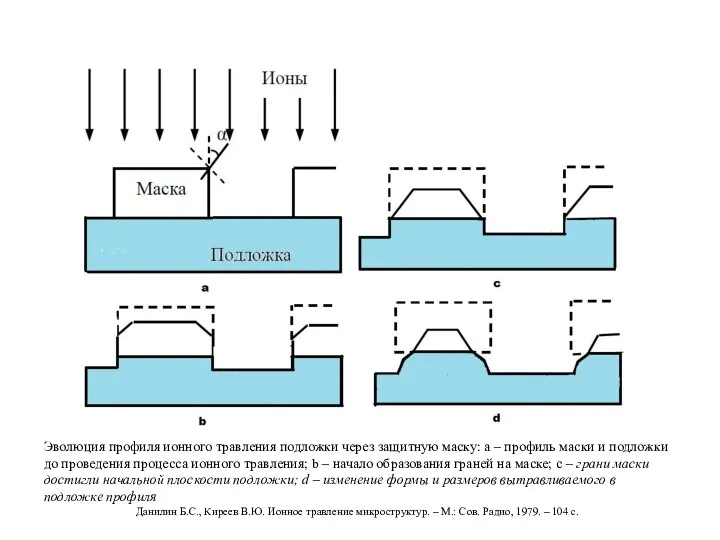
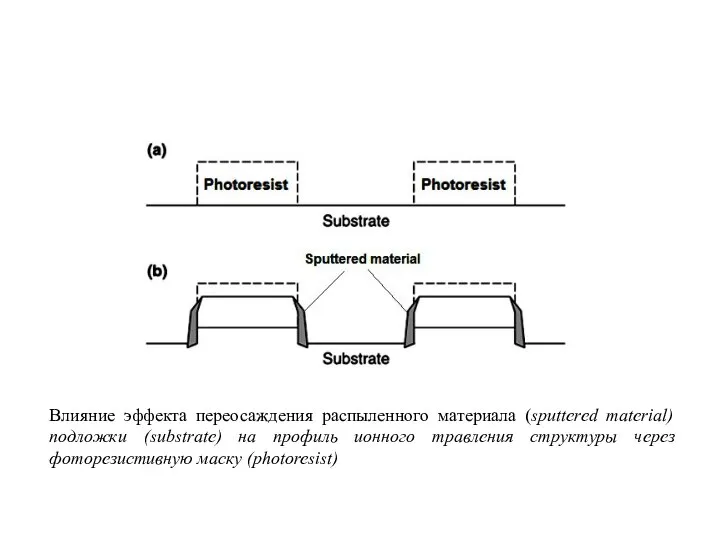
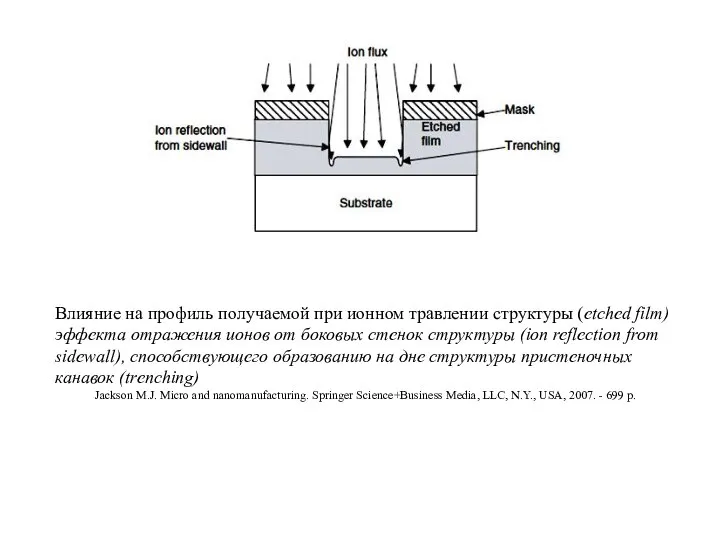






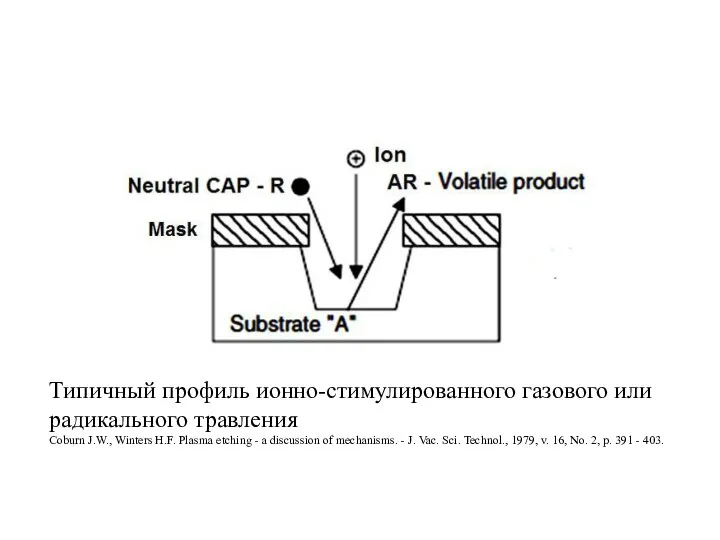












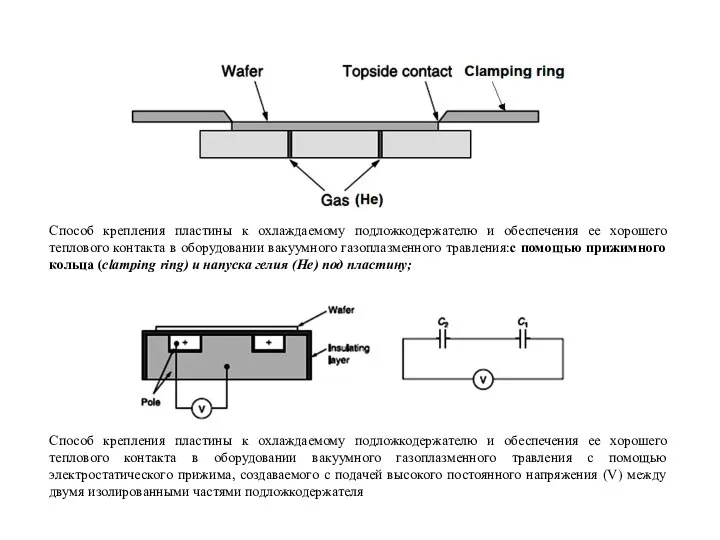
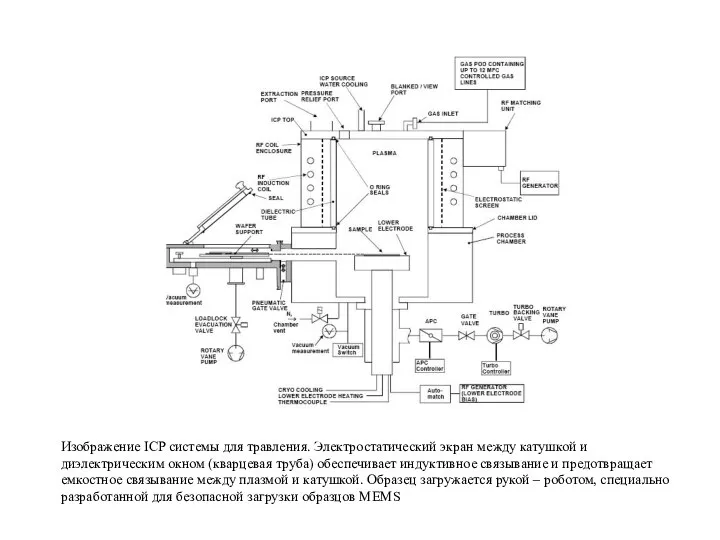




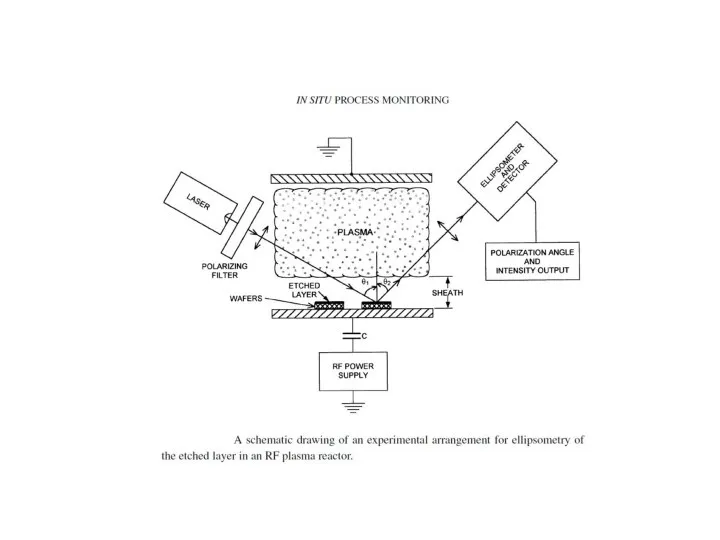
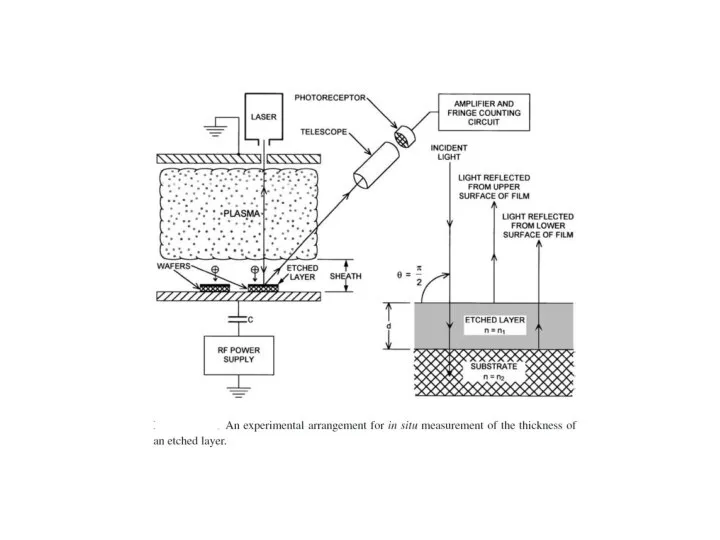


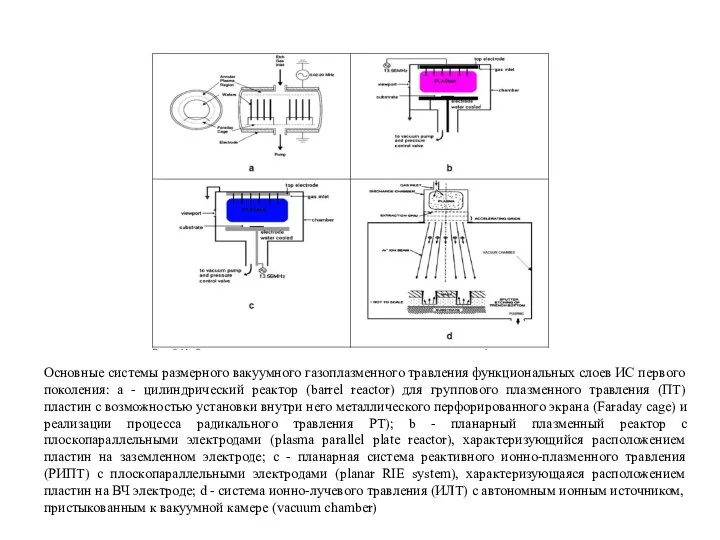
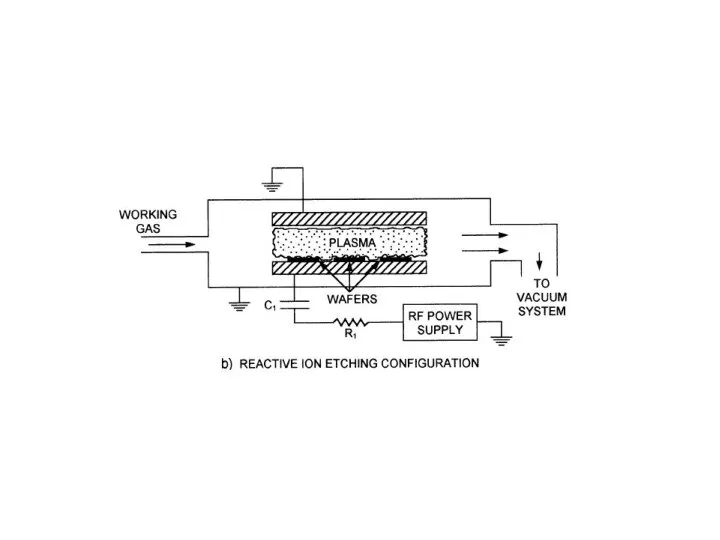
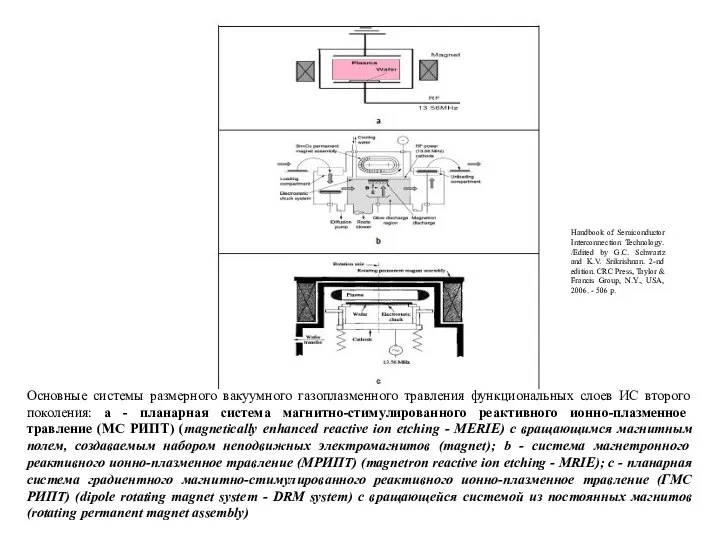
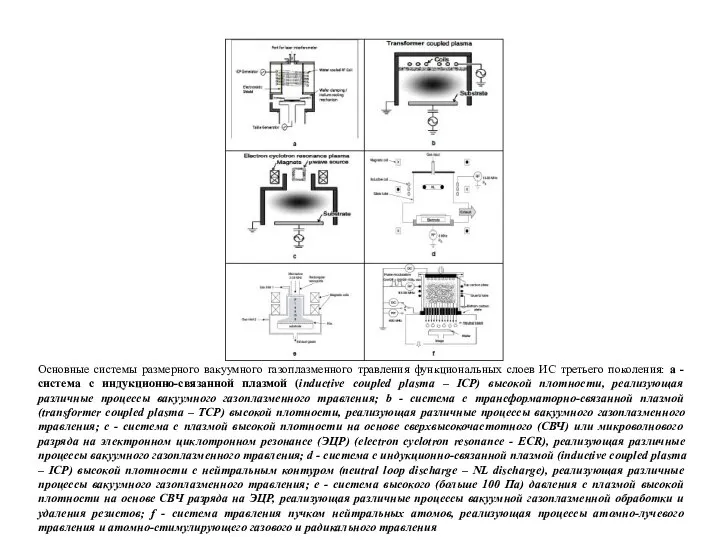

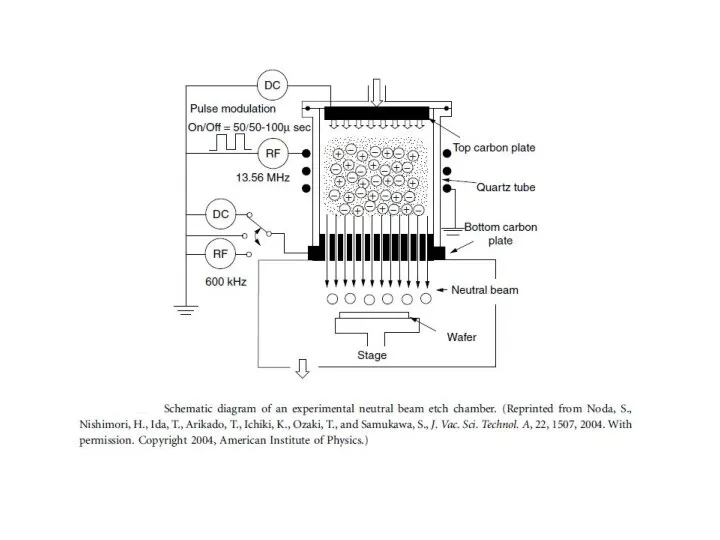
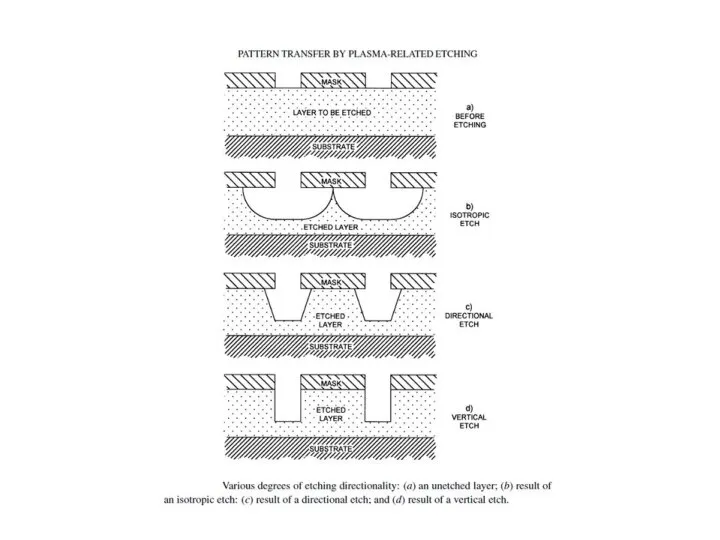


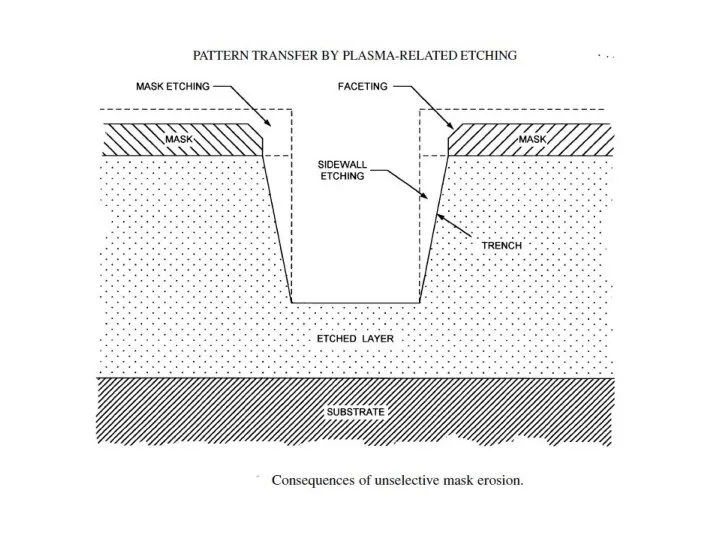
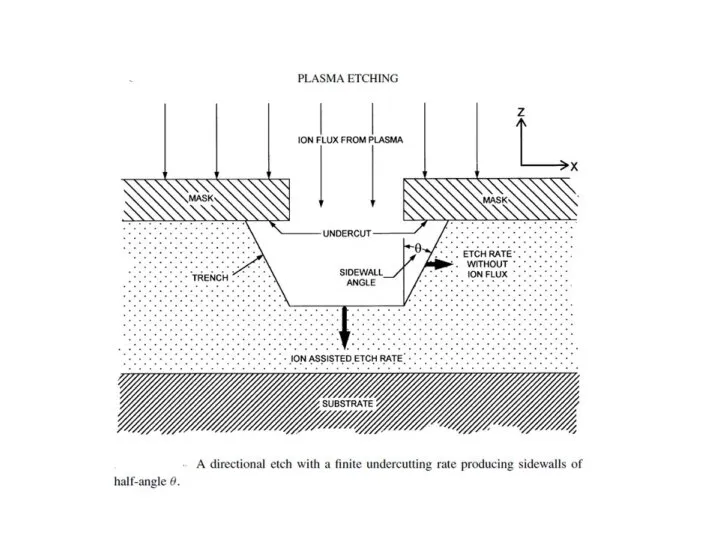

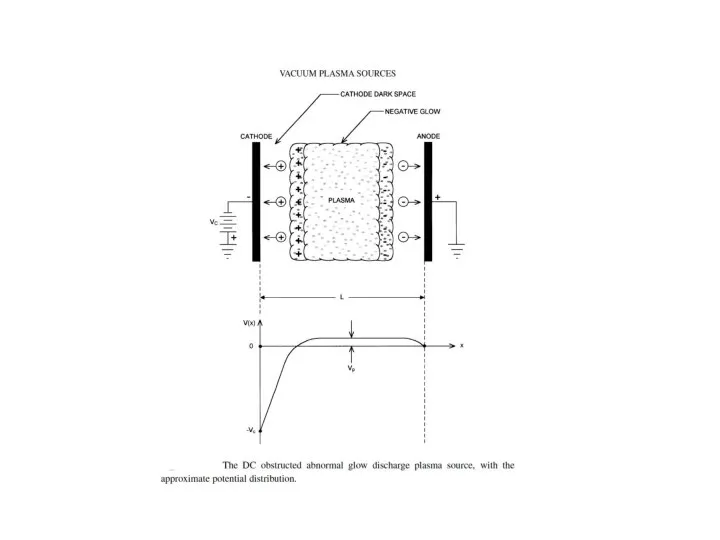
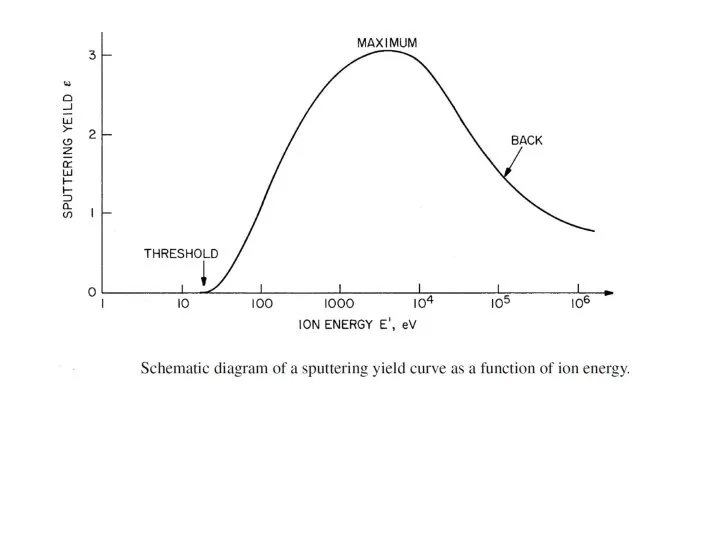
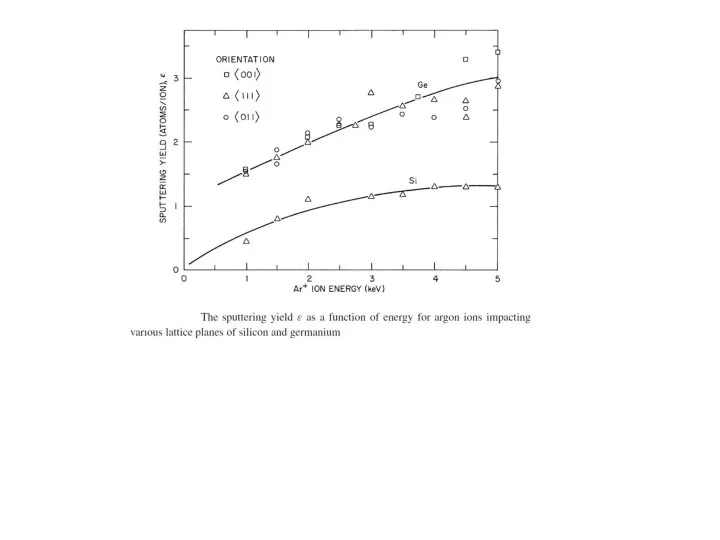


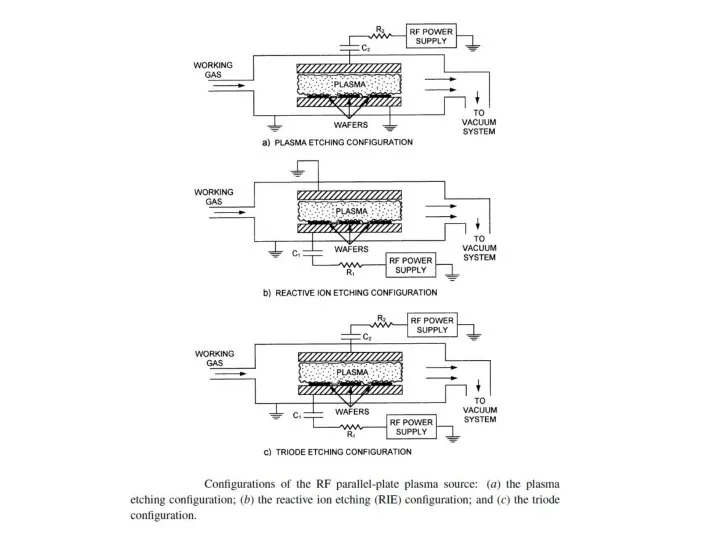
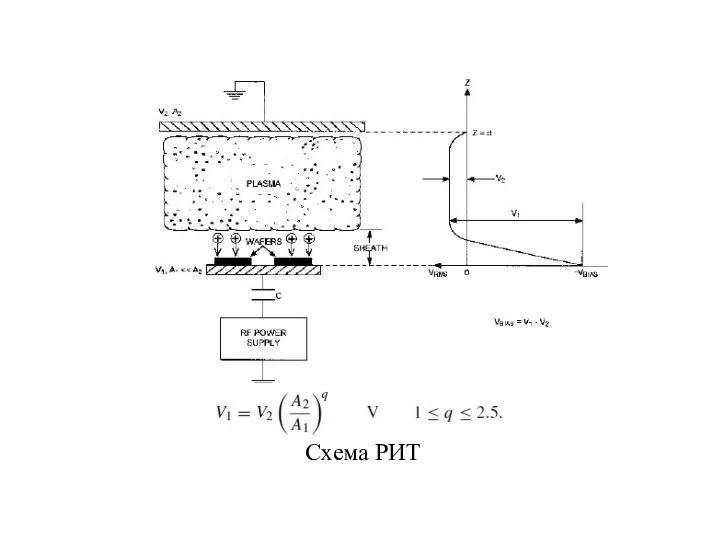



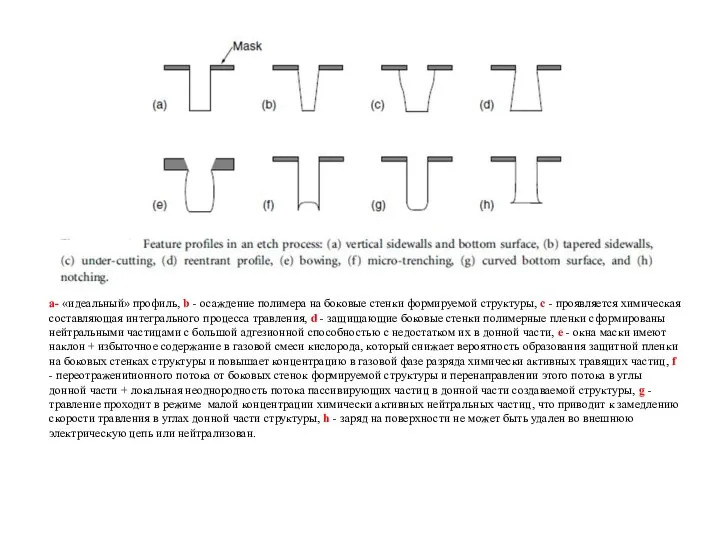




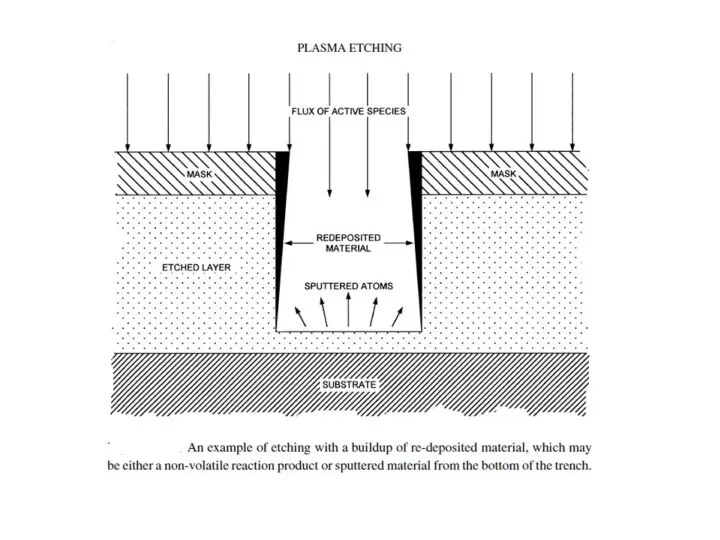

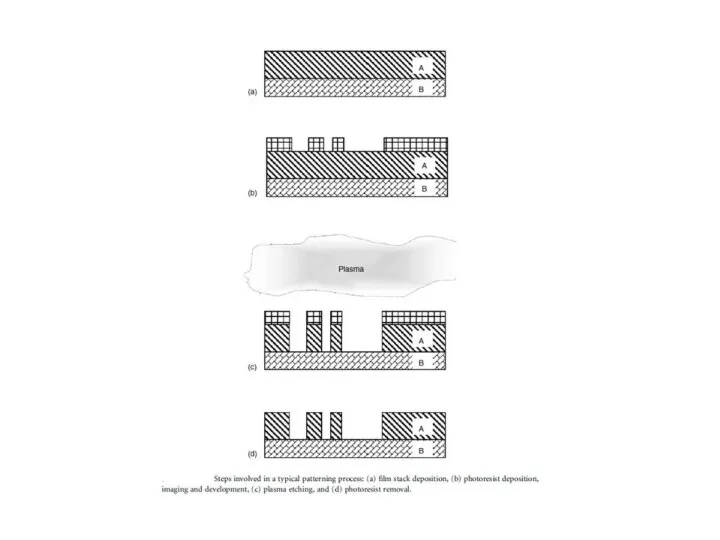
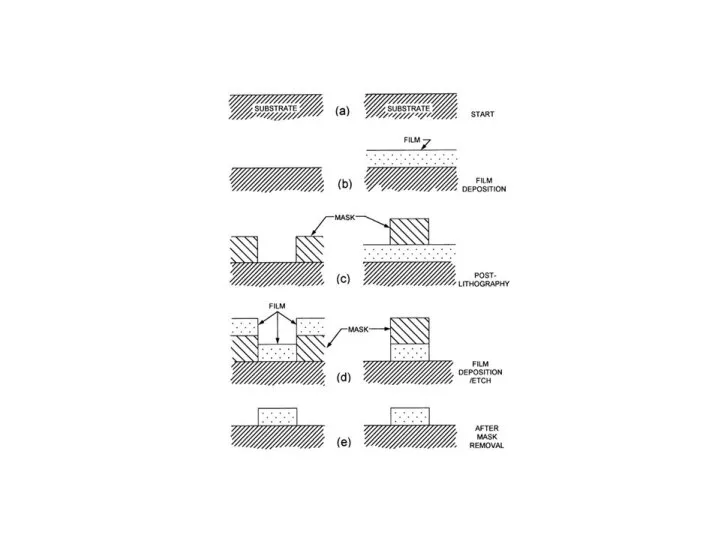

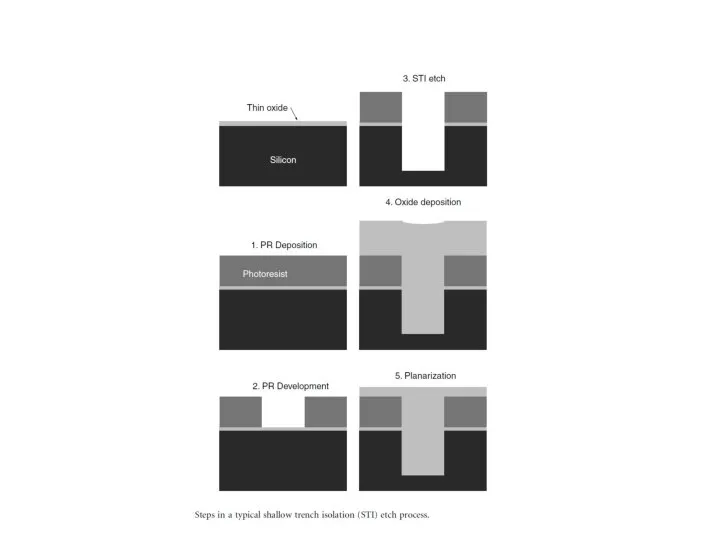
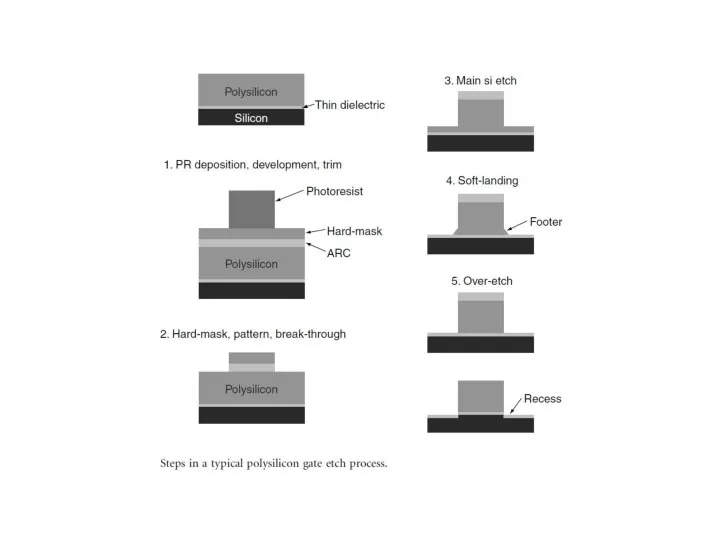
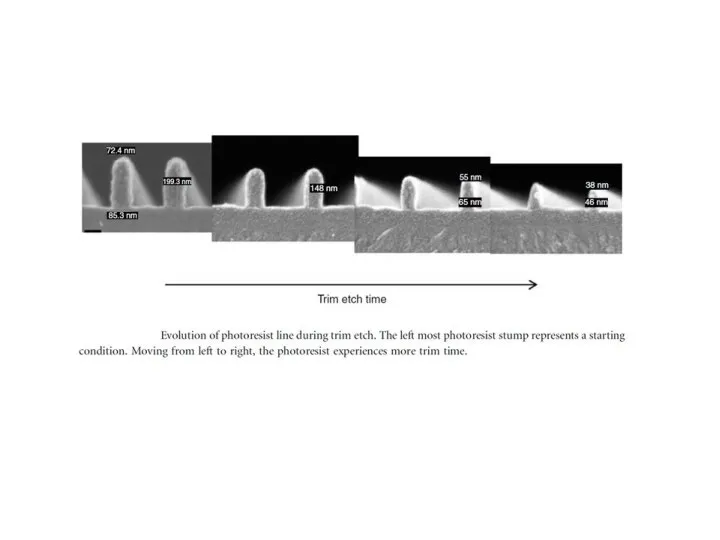

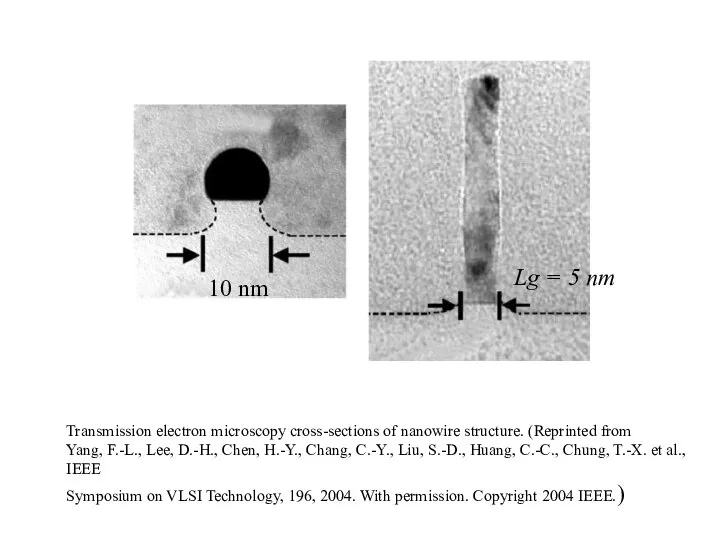








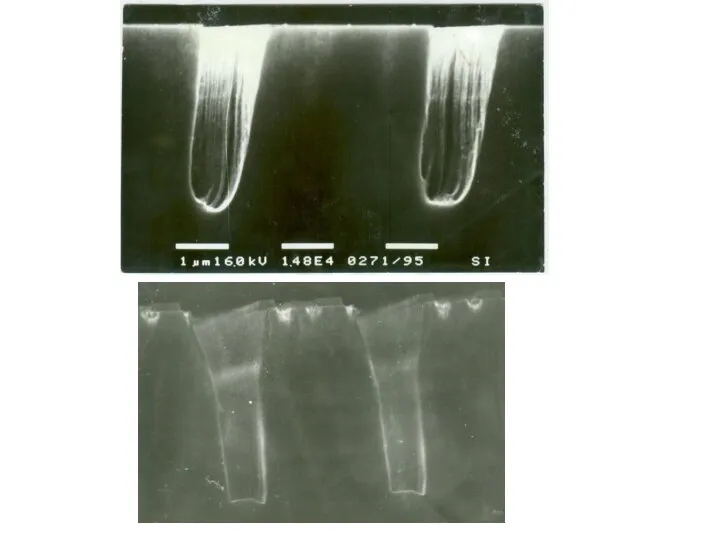


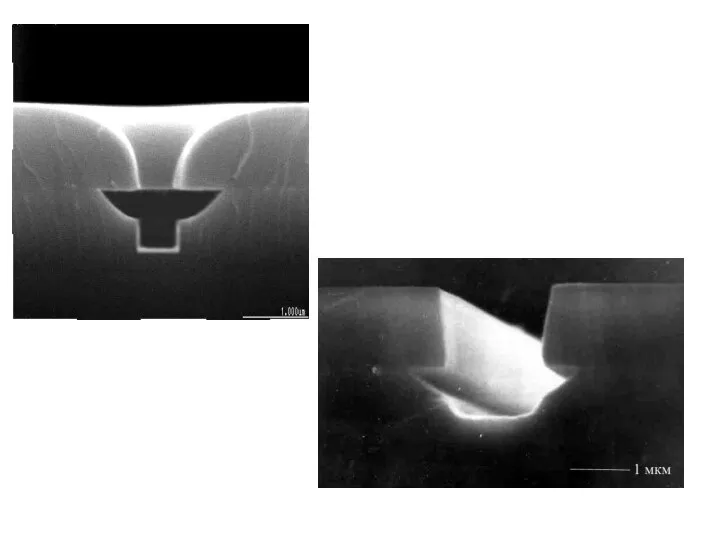



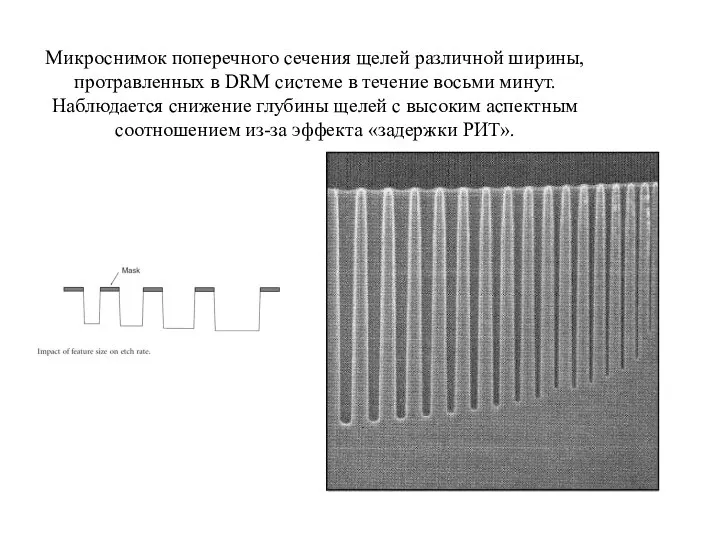
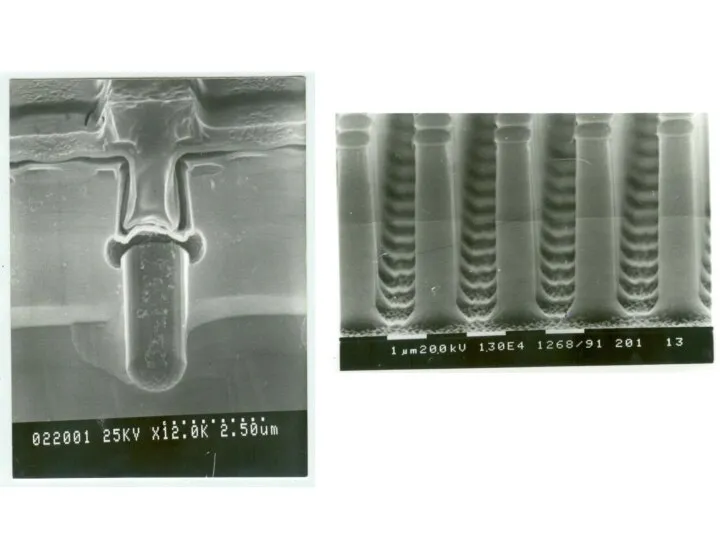





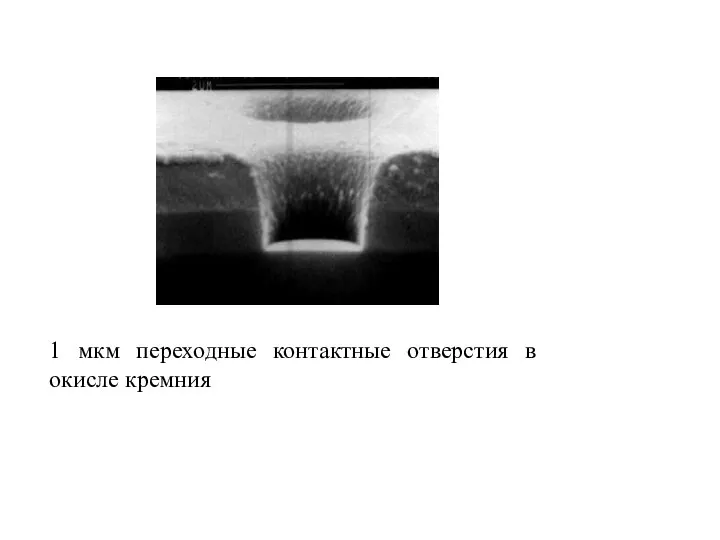
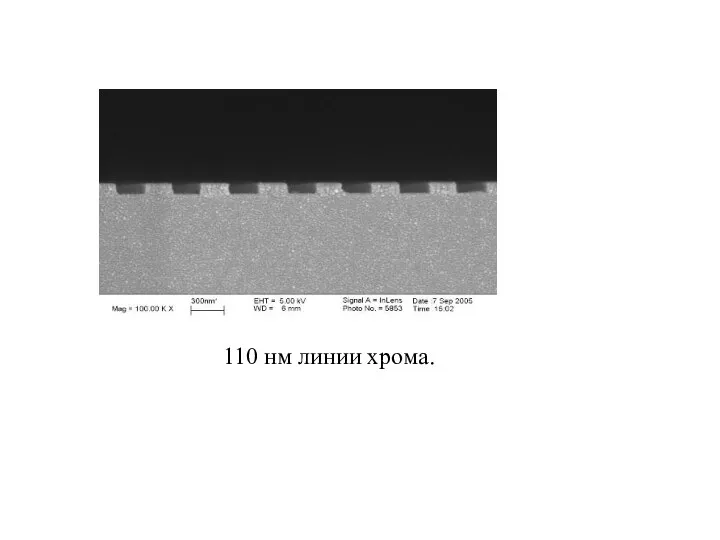


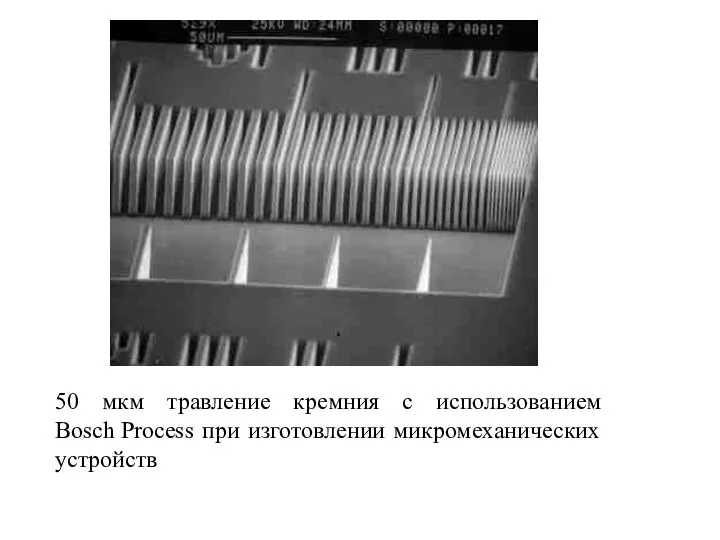
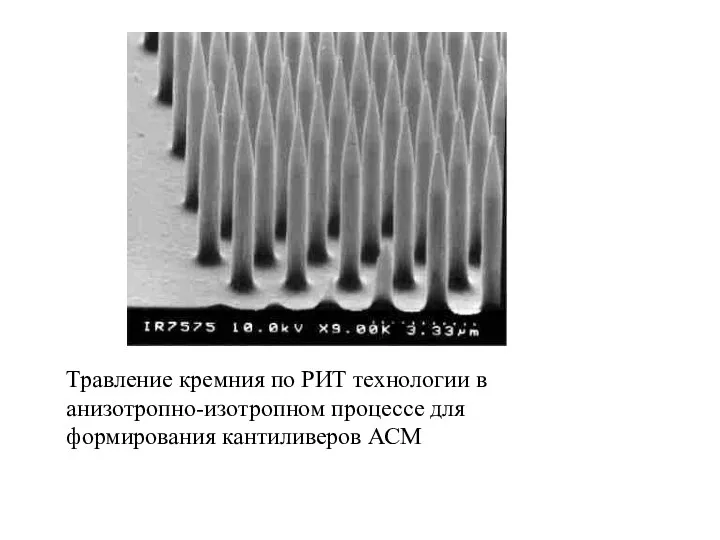


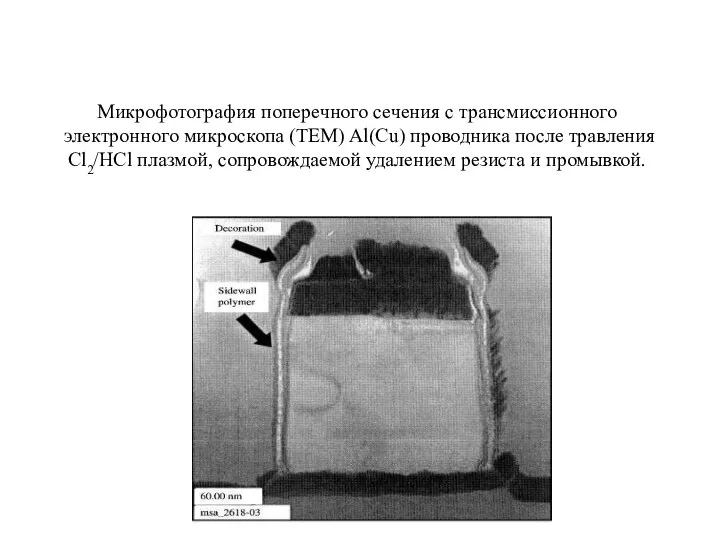
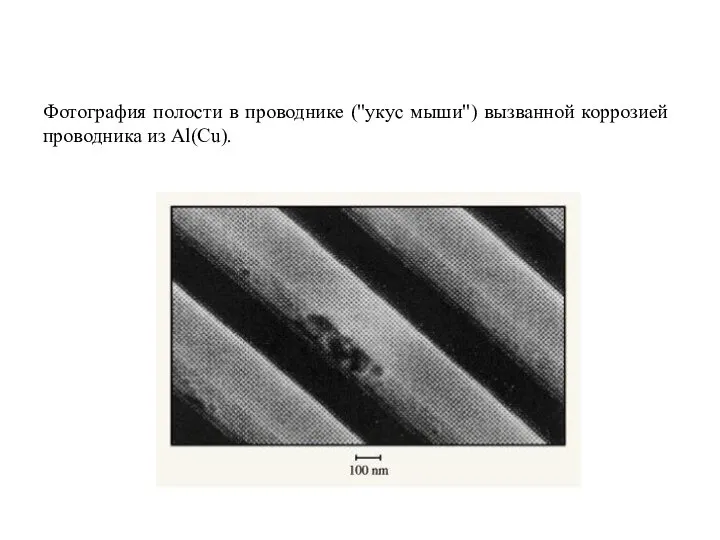
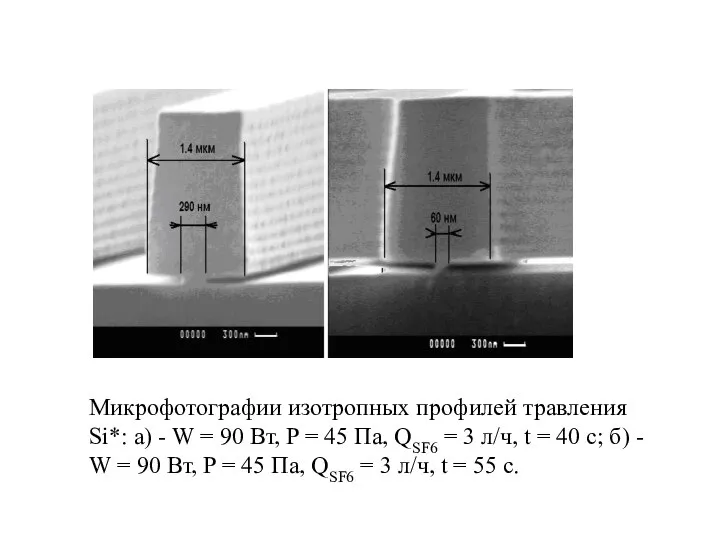
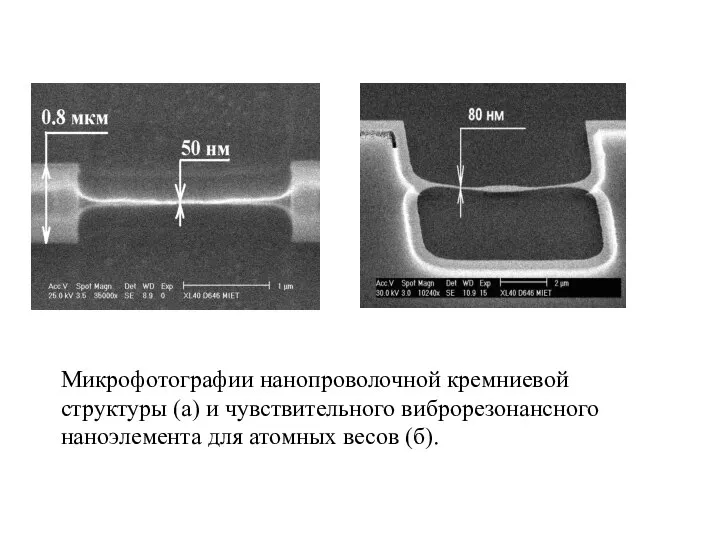






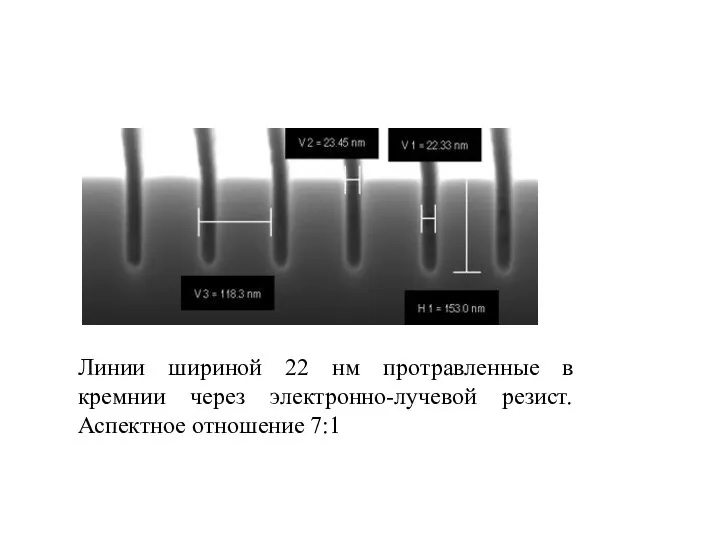

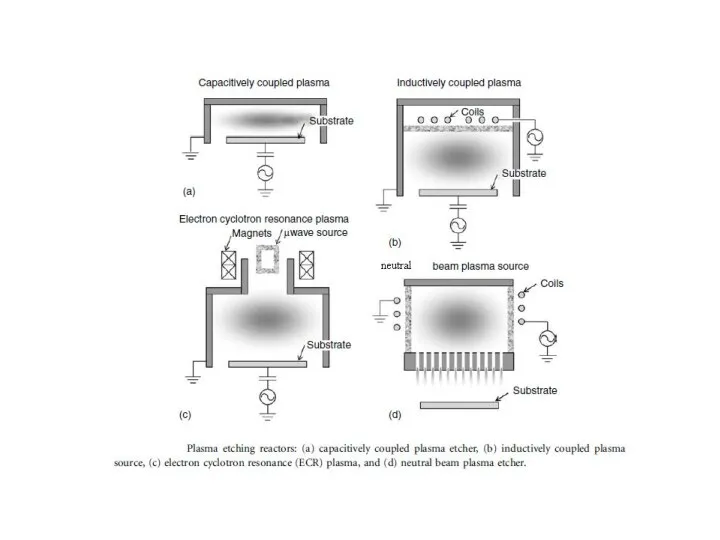

 The particularity of cosplayers identity with different motivation
The particularity of cosplayers identity with different motivation Презентация на тему "Как научить детей сотрудничать?" - скачать презентации по Педагогике
Презентация на тему "Как научить детей сотрудничать?" - скачать презентации по Педагогике Обеспечение безопасной эксплуатации жилых зданий Фрунзенского района Санкт-Петербурга
Обеспечение безопасной эксплуатации жилых зданий Фрунзенского района Санкт-Петербурга Гражданско-правовая ответственность медицинских работников
Гражданско-правовая ответственность медицинских работников Презентация на тему "Социальный комикс" - скачать презентации по Педагогике
Презентация на тему "Социальный комикс" - скачать презентации по Педагогике Аттестационная работа. Традиционная культура кубанских казаков
Аттестационная работа. Традиционная культура кубанских казаков 4_5877587462389236442
4_5877587462389236442 Федеральное собрание
Федеральное собрание  Организация питания в походе
Организация питания в походе Рабочие чертежи (с актуализированными изменениями 2015 года)
Рабочие чертежи (с актуализированными изменениями 2015 года) Джорджо Моранди
Джорджо Моранди  Кратчайшие пути
Кратчайшие пути Функциональная организация головного мозга
Функциональная организация головного мозга Самураи
Самураи Современные подходы к целеполаганию
Современные подходы к целеполаганию Особенности современного этапа развития мирового хозяйства Выполнил: студент 1-го курса очной формы обучения факультета тамо
Особенности современного этапа развития мирового хозяйства Выполнил: студент 1-го курса очной формы обучения факультета тамо Проект-РСО
Проект-РСО Технология сборки и сварки корпуса и днища резервуара РВС 2000 куб.м
Технология сборки и сварки корпуса и днища резервуара РВС 2000 куб.м Опыт использования бизнес-моделей в процессе обучения предпринимательству в магистратуре Екатерина Бузулукова к.э.н., ст.преп
Опыт использования бизнес-моделей в процессе обучения предпринимательству в магистратуре Екатерина Бузулукова к.э.н., ст.преп Гостиница “Метрополь”
Гостиница “Метрополь”  Задача Диофанта
Задача Диофанта Matka Boska Pajęczańska
Matka Boska Pajęczańska Царство Животные
Царство Животные  Вычисление линейной скорости и ускорения
Вычисление линейной скорости и ускорения РЕЧЕВОЕ ПОВЕДЕНИЕ СПОРЯЩИХ
РЕЧЕВОЕ ПОВЕДЕНИЕ СПОРЯЩИХ  ПСИХОЛОГИЧЕСКОЕ ОБЕСПЕЧЕНИЕ ПРОФЕССИОНАЛЬНОГО ЗДОРОВЬЯ ПЕДАГОГОВ САНКТ-ПЕТЕРБУРГ 2010
ПСИХОЛОГИЧЕСКОЕ ОБЕСПЕЧЕНИЕ ПРОФЕССИОНАЛЬНОГО ЗДОРОВЬЯ ПЕДАГОГОВ САНКТ-ПЕТЕРБУРГ 2010 С масленицей
С масленицей Шувалова Н. С., заместитель директора по УВР МУ СОШ № 66 г. Иваново
Шувалова Н. С., заместитель директора по УВР МУ СОШ № 66 г. Иваново