Содержание
- 2. 2.Сенсоры. Классификация сенсоров. Классификация сенсоров: назначение, вид преобразования, условия эксплуатации. Характеристики сенсоров: диапазон измерения, чувствительность, точность,
- 3. 2.Сенсоры. Классификация сенсоров. Микромеханические сенсоры. Механические конструкции: объемные, мембранные, балочные, струнные. Виды преобразователей. Датчики на основе
- 4. Механические конструкции объемные мембранные балочные струнные.
- 5. Виды преобразователей. Пьезоэлектрические преобразователи. Пьезоэлектрики являются прямыми преобразователями механической энергии в электрическую. Величина заряда, генерируемого на
- 6. Тензорезистивные преобразователи Виды преобразователей. Относительное изменение сопротивления проводника является линейной функцией от деформации е Se –
- 7. Виды преобразователей. емкость C изменяется прямо пропорционально площади электродов Sy и обратно пропорционально расстоянию между ними
- 8. Датчики на основе микромеханических преобразователей Датчики давления Тензорезистивные
- 9. МИКРОМЕХАНИЧЕСКИЕ ДАТЧИКИ ДАВЛЕНИЯ Датчик промышленного стандарта Защитный гель Пластиковый корпус Автомобильный датчик
- 10. Автомобиль МИКРОМЕХАНИЧЕСКИЕ ДАТЧИКИ ДАВЛЕНИЯ
- 11. Датчики давления Датчики на основе микромеханических преобразователей Пьезоэлектрические
- 12. Датчики на основе микромеханических преобразователей Датчики силы Тензорезистивные АСМ – атомно силовой микроскоп
- 13. Микротехнологии Микроэлектроника Параллельное (“групповое”) изготовление большего количества одинаковых устройств Снижение сроков разработки и стоимости производства Однотипное
- 14. A Microfabricated Inertial Sensor MEMSIC (Andover, Mass.) Two-axis thermal-bubble accelerometer Technology: standard CMOS electronics with post
- 17. Технологии поверхностной микромеханики Si-пластина Жертвенный слой -ФСС Защитный слой-нитрид кремния ФЛГ –окна для якорей Нанесение Si-пк
- 18. Технологии поверхностной микромеханики
- 19. Технологии объемной микромеханики
- 21. Технологии объемной микромеханики
- 22. Технологии объемной микромеханики
- 24. Скачать презентацию


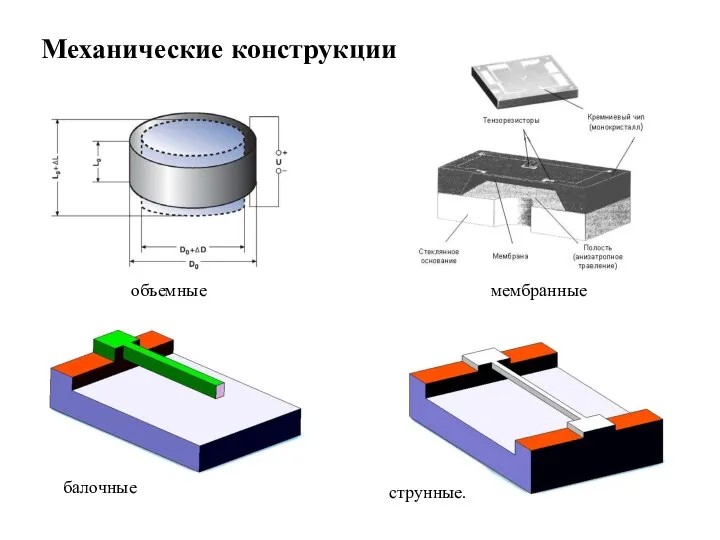
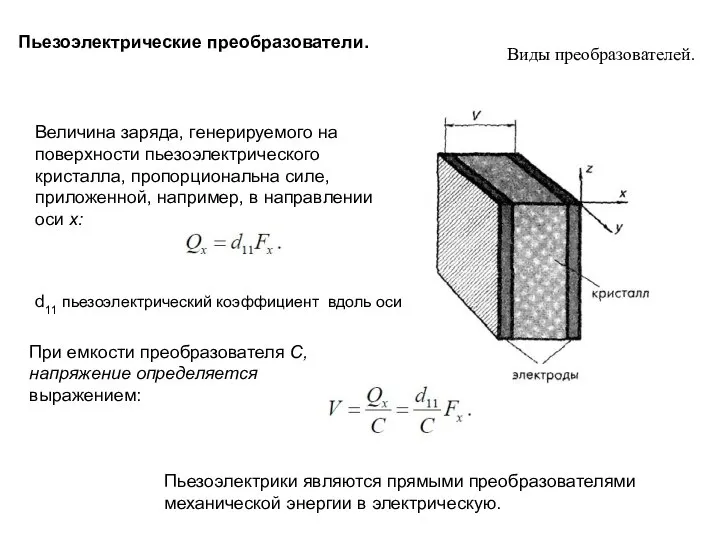
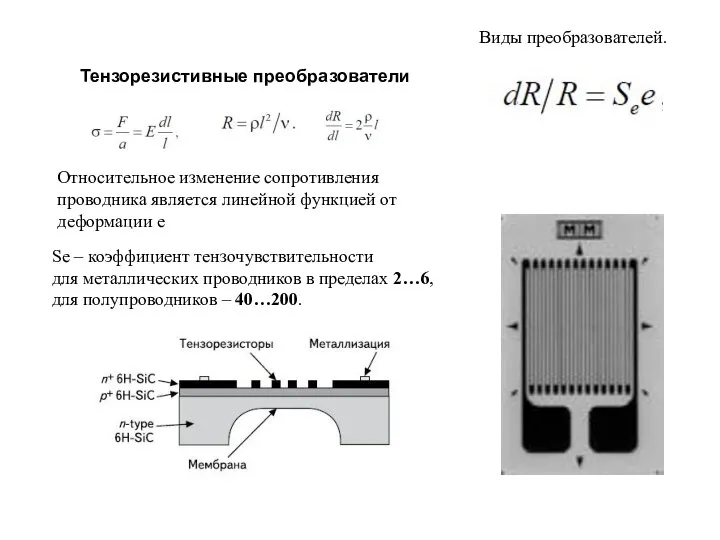

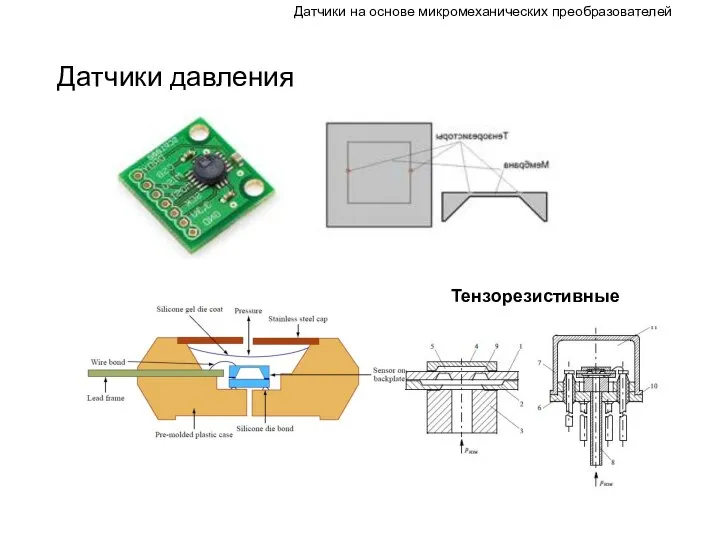



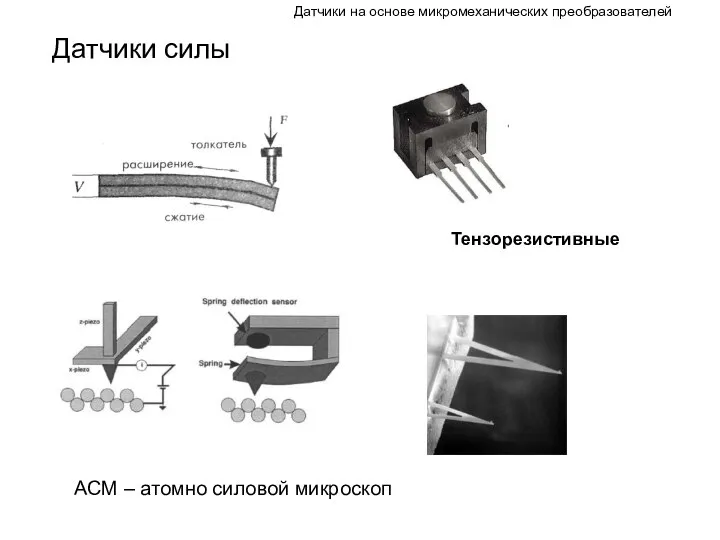

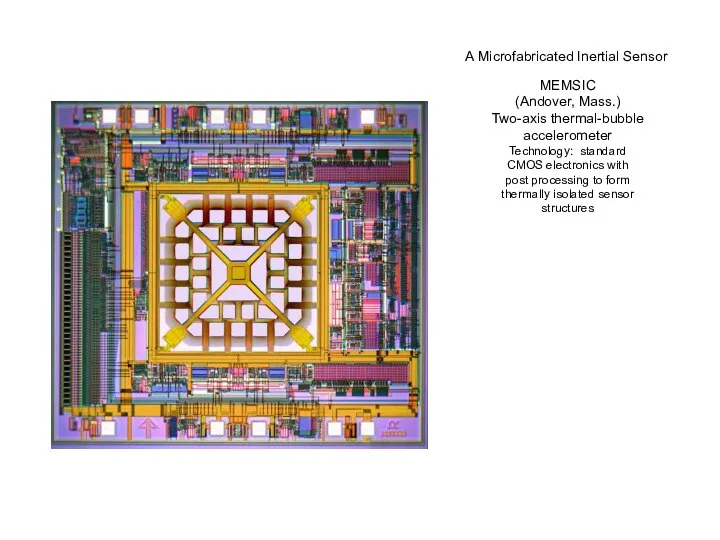
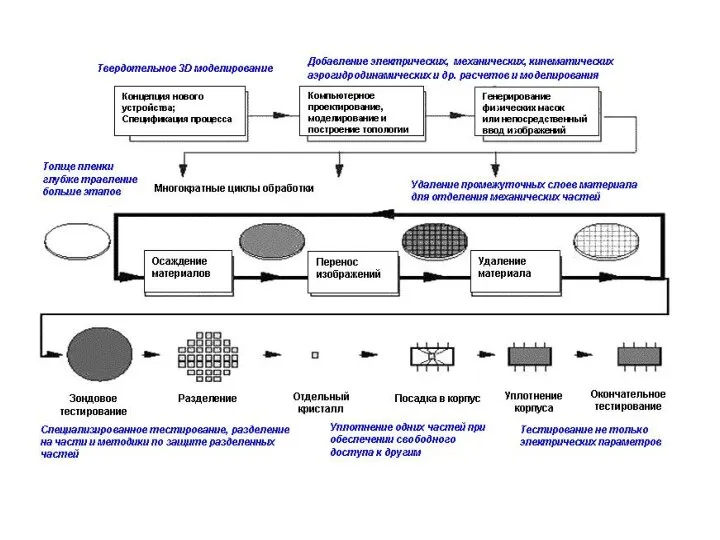

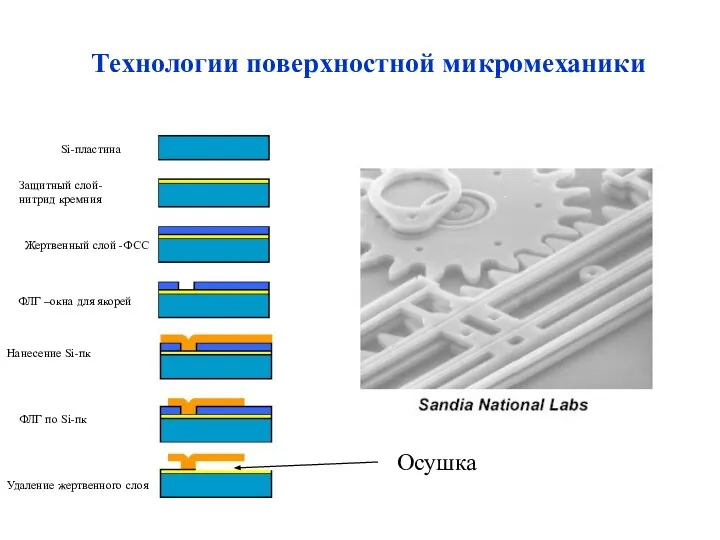
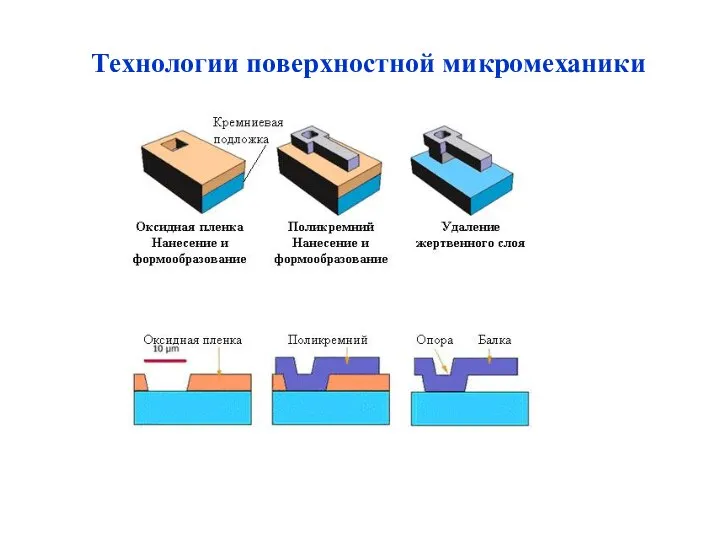

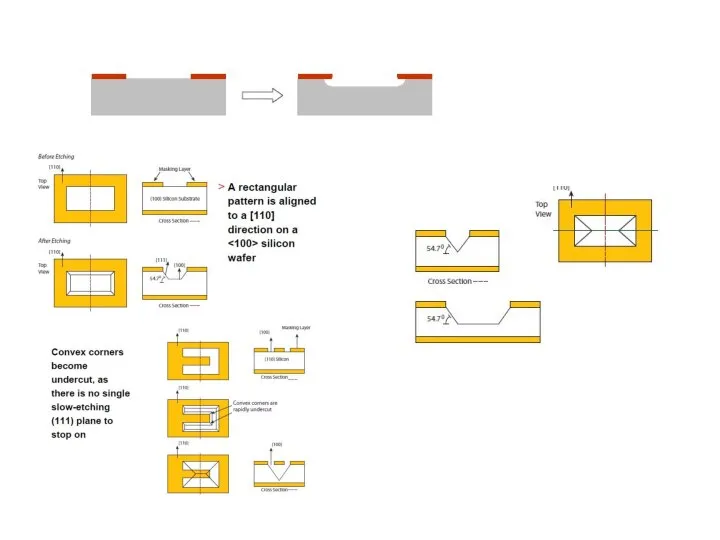
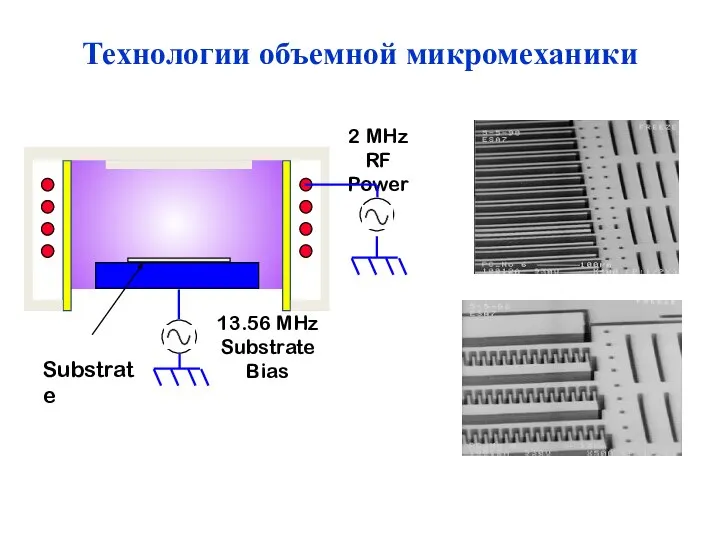
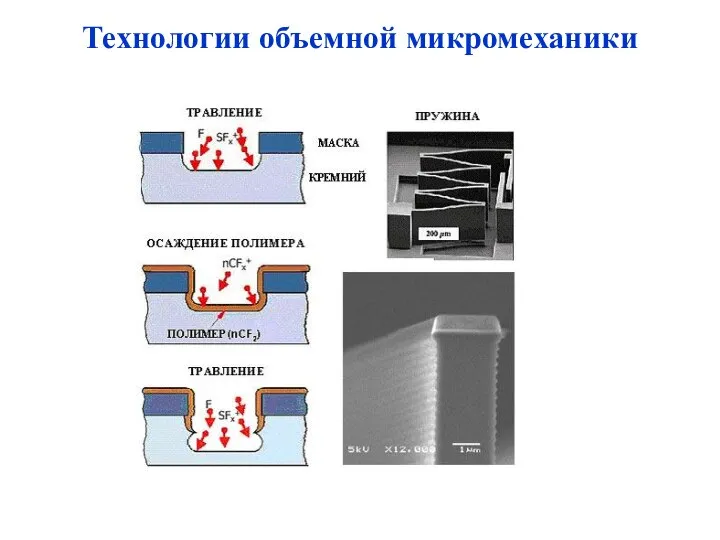
 Понятие функции хэширования, дайджест сообщения, свойства необратимости, рассеивания и чувствительности к изменениям
Понятие функции хэширования, дайджест сообщения, свойства необратимости, рассеивания и чувствительности к изменениям Физкультура в радость
Физкультура в радость Орта Азия мен Иранның мәдениеті
Орта Азия мен Иранның мәдениеті Имитационное моделирование в среде Arena 3.0
Имитационное моделирование в среде Arena 3.0 Введение в историю Древней Греции
Введение в историю Древней Греции  Каждое утро жизнь возобновляется. Вечное чудо
Каждое утро жизнь возобновляется. Вечное чудо Заимствованная лексика. Англицизм в русском языке
Заимствованная лексика. Англицизм в русском языке Золотые травы Хохломы.
Золотые травы Хохломы. Планирование эксперимента в области оптимума
Планирование эксперимента в области оптимума  Игровой бренд PlayStation
Игровой бренд PlayStation История развития косметических средств
История развития косметических средств Формирование Федерального бюджета РФ
Формирование Федерального бюджета РФ А.Барто - презентация для начальной школы
А.Барто - презентация для начальной школы Презентация Способы нарезки овощей урок технологии
Презентация Способы нарезки овощей урок технологии Nuduri japoneze
Nuduri japoneze Отчёт по учебной практике. Выполнение работ по профессии машинист холодильных установок
Отчёт по учебной практике. Выполнение работ по профессии машинист холодильных установок How to become an Italian: 12 Tips for beginners
How to become an Italian: 12 Tips for beginners Гимнастика - это один из наиболее популярных видов спорта
Гимнастика - это один из наиболее популярных видов спорта Социально-психологические особенности взаимопонимания тренеров со спортсменами
Социально-психологические особенности взаимопонимания тренеров со спортсменами Предмет и задачи антропологии. Антропогенез. Этническая антропология
Предмет и задачи антропологии. Антропогенез. Этническая антропология Известное и неизвестное. О самых знаменитых открытиях и изобретениях немецких ученых, конструкторов, инженеров
Известное и неизвестное. О самых знаменитых открытиях и изобретениях немецких ученых, конструкторов, инженеров Налоговая система РФ
Налоговая система РФ Трибодиагностика и диагностика на основе анализа продуктов износа в продуктах сгорания
Трибодиагностика и диагностика на основе анализа продуктов износа в продуктах сгорания Представители круглых червей
Представители круглых червей  Промышленные здания
Промышленные здания Презентация ШКОЛА ЧЕЛОВЕЧЕСКИХ ОТНОШЕНИЙ а
Презентация ШКОЛА ЧЕЛОВЕЧЕСКИХ ОТНОШЕНИЙ а Общие закономерности кристализации магмы
Общие закономерности кристализации магмы Детский фитнес
Детский фитнес