Содержание
- 2. Статичні характеристики. Вольт-амперні характеристики Умовне позначення і назви елементів біполярного транзистора. а) p-n-p- транзистор; б) n-p-n–
- 3. Вольт-амперні характеристики Статичні характеристики транзистора можна безпосередньо отримати із теорії p-n переходу. Вважаємо, що ВАХ емітерного
- 4. Вольт-амперні характеристики Із рівняння неперервності і рівняння для густини струмів визначаються рівноважні характеристики. Для нейтральної області
- 5. Вольт-амперні характеристики Залежність повного колекторного струму від прикладеної напруги: Струм бази:
- 6. Нерівномірний розподіл домішки в базі. Транзистор з подібним розподілом домішки- дрейфовий транзистор, оскільки в його базу
- 7. Типова характеристика базового струму. Можна виділити чотири ділянки: 1) область малих струмів, де базовий струм змінюється
- 8. Коефіцієнт підсилення струму Коефіцієнт підсилення струму в схемі зі спільною базою α0 . (в гібридній системі
- 9. α0- близький до 1. β0- значно більший одиниці. При нормальній роботі p-n-p транзистора VEB>0 і VCB
- 10. Залежність коефіцієнту підсилення транзистора (на частоті 5 ГГц) від дози домішки імплантованої в базу. Якщо αТ
- 11. hFE Коефіцієнт підсилення по струму в загальному випадку залежить від струму колектора. При дуже малих струмах
- 12. hFE При подальшому збільшенні колекторного струму густина неосновних носіїв інжектованих в базу наближається до вихідної густини
- 13. Ефект звуження ширини забороненої зони Звуження ширини забороненої зони в кремнії. Звуження ширини забороненої зони в
- 14. Ефект оже-рекомбінації Залежність коефіцієнта підсилення транзистора від струму колектора. а- врахування лише генерації ШХР; б- врахування
- 15. При збільшенні концентрації носіїв оже-рекомбінація стає домінуючою і визиває зменшення часу життя неосновних носіїв в емітері.
- 16. Ефект Кірка В сучасних біполярних транзисторах зі слабо легованим епітаксійним колектором на коефіцієнт підсилення впливає зміщення
- 17. Вихідні характеристики Основні співвідношення в транзисторі можна сформулювати наступним чином. 1. Прикладені напруги задають густини струмів
- 18. Вихідні характеристики Вихідні характеристики транзистора. а- в схемі зі спільною базою; б- в схемі зі спільним
- 19. В схемі зі спільним емітером зі збільшенням VCE ширина бази W зменшується і спостерігається збільшення β0.
- 20. НВЧ-транзистори Транзистор зі смужковою геометрією електродів. Задача зменшення двох критичних параметрів дискретних транзисторів: - ширини емітерної
- 21. Дифузійні трубки (а) і дифузійні виступи (б) в базі вздовж дислокацій. Задачі: Мінімізувати (а) дефекти упаковки
- 22. Частота відсічки Частота відсічки fT є найбільш важливим показником якості НВЧ-транзистора. Визначається як частота, на якій
- 23. Частота відсічки Друга складова часу затримки являє собою час прольоту через шар бази і дорівнює: де
- 24. Частота відсічки Четверта компонента затримки обумовлена часом, протягом якого заряджається збіднена ємність колектора: де rc- послідовний
- 25. Частота відсічки Час руху носіїв від емітера до колектора в залежності від густини колекторного струму. Зі
- 26. де VC0 -контактний потенціал колектора, VCB - напруга прикладена між базою і колектором. Струми, що перевищують
- 28. Скачать презентацию








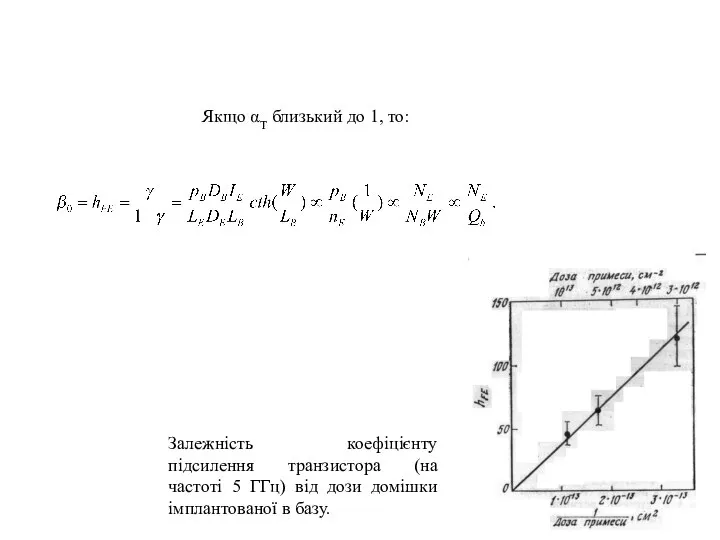





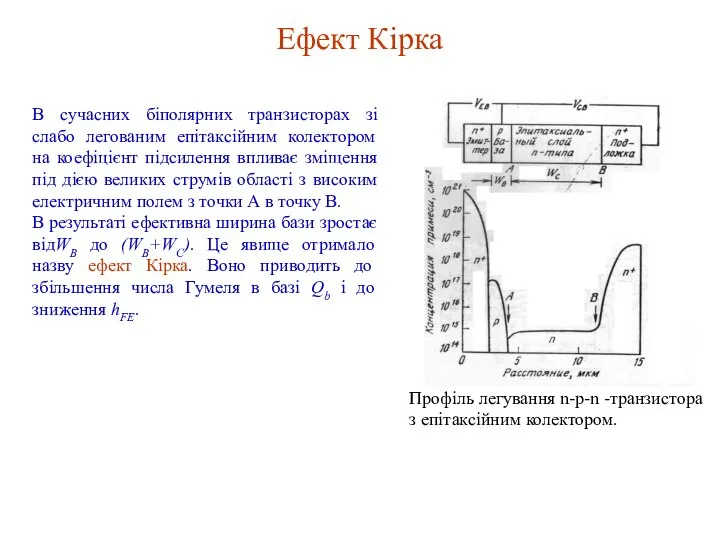




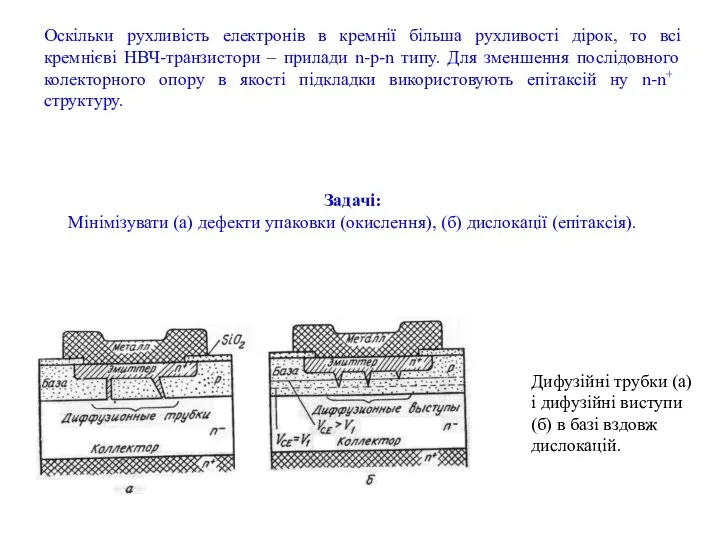





 Душа, як правило, передається через вираз очей, через погляд, спрямований на глядача… Відділ мистецтв пропонує! З циклу онлайн презентацій “Креатив” ОЧІ ЕПОХ III Західна
Душа, як правило, передається через вираз очей, через погляд, спрямований на глядача… Відділ мистецтв пропонує! З циклу онлайн презентацій “Креатив” ОЧІ ЕПОХ III Західна  C#, объектно-ориентированное программирование
C#, объектно-ориентированное программирование Презентация на тему "Ошибки ставшие откытиями" - скачать презентации по Педагогике
Презентация на тему "Ошибки ставшие откытиями" - скачать презентации по Педагогике Рестлинг. История рестлинга
Рестлинг. История рестлинга Составление разветвляющихся алгоритмов
Составление разветвляющихся алгоритмов Лица, перемещающие товары и транспортные средства через таможенную границу, как субъекты таможенного права. Подготовили студент
Лица, перемещающие товары и транспортные средства через таможенную границу, как субъекты таможенного права. Подготовили студент Programming paradigms
Programming paradigms Big picture. Persistence
Big picture. Persistence Утренняя зарядка. Правила её составления и выполнения
Утренняя зарядка. Правила её составления и выполнения ИНФОРМАЦИОННАЯ БЕЗОПАСНОСТЬ: ОСНОВНЫЕ АСПЕКТЫ, СОВРЕМЕННОЕ СОСТОЯНИЕ
ИНФОРМАЦИОННАЯ БЕЗОПАСНОСТЬ: ОСНОВНЫЕ АСПЕКТЫ, СОВРЕМЕННОЕ СОСТОЯНИЕ Федеральная Служба Охраны РФ
Федеральная Служба Охраны РФ Эгейское искусство Материалы к уроку МХК В 10 классе _
Эгейское искусство Материалы к уроку МХК В 10 классе _ Начертательная геометрия. Введение
Начертательная геометрия. Введение Рефлекторный принцип деятельности ЦНС
Рефлекторный принцип деятельности ЦНС Внешний образ современного учителя
Внешний образ современного учителя Кокки. cтом
Кокки. cтом Сравнительное правоведение. Чиркин Вениамин Евгеньевич
Сравнительное правоведение. Чиркин Вениамин Евгеньевич Презентация на тему "подготовка к ЕНТ" - скачать презентации по Педагогике
Презентация на тему "подготовка к ЕНТ" - скачать презентации по Педагогике Конструкторская документация. Чертежи деталей и изделий из древесины
Конструкторская документация. Чертежи деталей и изделий из древесины Астродиетология. Обозначения знаков зодиака, планет и аспектов
Астродиетология. Обозначения знаков зодиака, планет и аспектов рисуем мальчика - презентация для начальной школы
рисуем мальчика - презентация для начальной школы Презентация "ГРАФФИТИ" - скачать презентации по МХК
Презентация "ГРАФФИТИ" - скачать презентации по МХК Первый шаг к «эффективному тестировщику»: профориентация Юлия Нечаева, NIX Solutions, Харьков, Украина
Первый шаг к «эффективному тестировщику»: профориентация Юлия Нечаева, NIX Solutions, Харьков, Украина  Симплекс метод розв’язання задачі лінійного програмування
Симплекс метод розв’язання задачі лінійного програмування Военно-специальная подготовка
Военно-специальная подготовка БИОХИМИЯ МИОКАРДА-МОЗГА
БИОХИМИЯ МИОКАРДА-МОЗГА  Синхронные машины
Синхронные машины Презентация на тему "Дружная семья" - скачать презентации по Педагогике
Презентация на тему "Дружная семья" - скачать презентации по Педагогике