Содержание
- 2. Ідеальна МДН структура Структура метал-діелектрик-напівпровідник (МДН-структура). Зонні діаграми ідеальних МДН структур при V=0. а- напівпровідник n–типу;
- 3. де ϕm - робота виходу металу; χ- спорідненість до електрону напівпровідника, Eg- ширина забороненої зони, ψB
- 4. Зонні діаграми МДН-структури при V≠0. а- режим акумуляції: б- режим збіднення; в- режим інверсії. 1) Якщо
- 5. 2) Якщо до МДН структури прикладена не дуже велика додатна напруга (V>0), зони вигинаються в оберненому
- 6. Приповерхнева область просторового заряду Зонна діаграма приповерхневої області напівпровідника p-типу. Потенціал ψ визначений по відношенню до
- 7. Характерні інтервали зміни поверхневого потенціалу ψs: ψs ψs=0 – стан плоских зон; ψB>ψs>0 – режим збіднення
- 8. В результаті рівняння Пуасона перепишеться як Інтегрування рівняння Дає співвідношення, яке зв’язує електричне поле (E≡-dψ/dx) і
- 9. Тоді електричне поле При цьому знак + потрібно використовувати при ψ>0 , а знак – при
- 10. Залежність густини об’ємного заряду (на одиницю площі границі розділу) від поверхневого потенціалу ψs для кремнію p
- 11. В стані плоских зон, тобто при ψs=0, CD можна легко визначити, розклавши в ряд відповідні експоненти.
- 12. Характеристики ідеальної МДН структури Зонна діаграма ідеальної МДН структури (а) і розподіл зарядів (в умовах інверсії)
- 13. Повна ємність структури що відповідає послідовному з’єднанню ємності напівпровідника CD і ємності діелектрика Ci=εi/d. Остання визначається
- 14. Залежність ємності ідеальної МДН структури від напруги при від’ємних значеннях останньої відповідає акумуляції дірок біля границі
- 15. Крива (в) на рисунку відповідає вольт-фарадній характеристиці ідеальної МДН структури в умовах глибокого збіднення (імпульсна напруга
- 16. Характерні значення поверхневого потенціалу: В ідеальній МДН структурі стан плоских зон ψs=0 реалізується при нульовому зміщенні
- 17. Важливою величиною є так звана напруга включення (порогова напруга) VT, при якій починається сильна інверсія. де
- 18. C-V криві ідеальних МДН-структур. Суцільними лініями показані низькочастотні характеристики, а штриховими – високочастотні. В структурах з
- 19. Si-SiO2-МДН-структури Заряди в МДН структурі Класифікація зарядів присутніх в термічно окисленому кремнії. Qi Ni=Qi/q 1.Заряд захоплений
- 20. Заряд захоплений поверхневими пастками Основна причина виникнення поверхневих станів в забороненій зоні напівпровідника полягає в тому,
- 21. Заповнення поверхневих станів, так як і об’ємних, визначається розподілом Фермі для донорних поверхневих пасток і для
- 22. Витягування C-V кривих за рахунок поверхневих станів. При високих частотах (ωτ>>1) заряд на поверхневих станах не
- 23. Густина поверхневих станів в термічно окисленому кремнії. Поблизу середини забороненої зони Dit змінюється відносно слабо, але
- 24. Фіксований заряд Зсув C-V кривих вздовж осі напруг, обумовлений позитивним чи нагативним фіксованим зарядом окисла. a-
- 25. Вплив фіксованого заряду окисла на властивості МДН-структур. Для повної електронейтральності структури необхідно, щоб кожен від’ємний заряд
- 26. Заряд рухливих іонів Розподіл концентрації іонів натрію по товщині плівок двоокису кремнію і нітриду кремнію при
- 27. Щоб запобігти проникнення рухливого іонного заряду в окисел в процесі робочого циклу приладів, можна використовувати непроникні
- 28. МДН-структура з фіксованим і захопленим в окислі зарядами. а- зонна діаграма; б- розподіл заряду; в- електричне
- 29. Результуючий зсув напруги плоских зон ΔVFB, обумовлений всіма компонентами заряду в окислі, є cума відповідних ефективних
- 30. Різниця робіт виходу В ідеальній МДН структурі різниця робіт виходу електрона з металу і напівпровідника рівна
- 31. Зонна діаграма (а) структури Al-SiO2-Si з товщиною окисла 50 нм і NA=1016 см-3 і залежність (б)
- 32. Залежність фотовідгуку МОН структури з різними металічними електродами від енергії фотонів. На вставці наведені відповідні C-V
- 33. Спостерігається спів падіння значень qϕm визначених вольт-фарадним і фотоемісійним методами. Проте спостерігається помітна відмінність цих значень
- 34. Вплив температури, світла, іонізуючих випромінень, лавинної інжекції Вплив температури Заряд інверсійного шару в МОН структурах зв’язаний
- 35. Температурна залежність провідності. Еквівалентна схема МОН структури в режимі інверсії наведена на Рис.1. Температурні залежності повної
- 36. В цьому температурному діапазоні значення енергії активації 0,56 еВ практично співпадає з очікуваною величиною Eg/2. При
- 37. Вплив світла При опроміненні МОН структури світлом збільшується високочастотна ємність структури на ділянці C-V кривої, що
- 38. Вплив іонізуючих випромінювань Основний процес, що обумовлює зміну характеристик МОН структур під дією іонізуючих випромінювань таких
- 39. Вплив лавинної інжекції Лавинна інжекція в окисел може відбуватися в МОН структурах при їх роботі в
- 40. Залежність напруги пробою МДН-структури в умовах глибокого збіднення від концентрації домішки в підкладці. На вставці показано
- 41. Залежність ємності і провідності МДН-структури від напруги до та після лавинної інжекції електронів в окисел. Відмітимо,
- 42. Слід відмітити, що лавинна інжекція або інжекція гарячих носіїв має безпосереднє відношення до вибору робочих режимів
- 44. Скачать презентацию














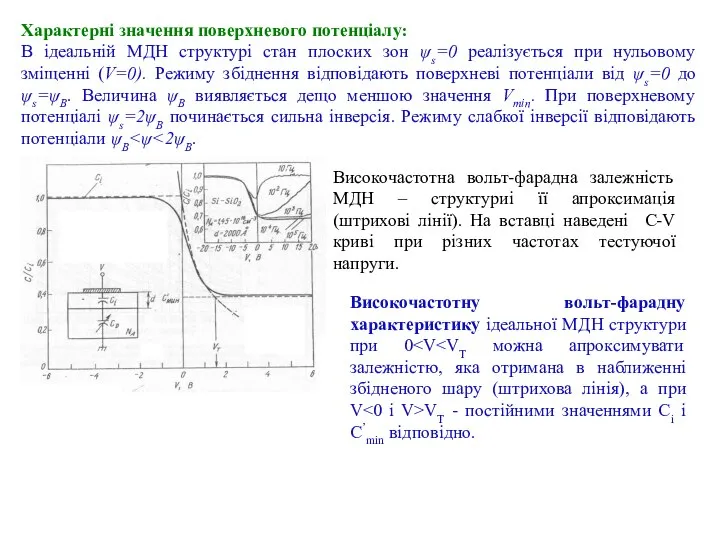















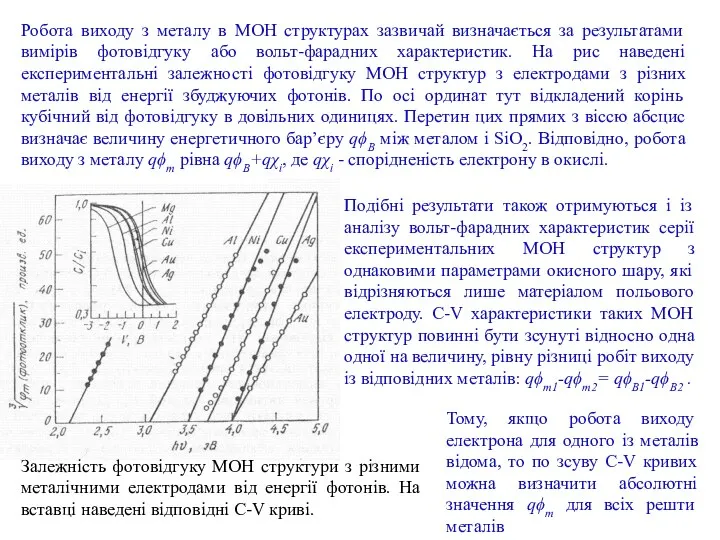


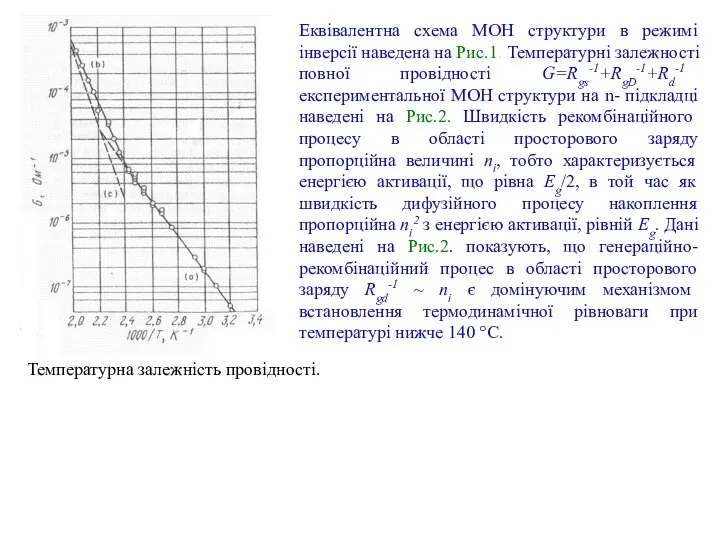





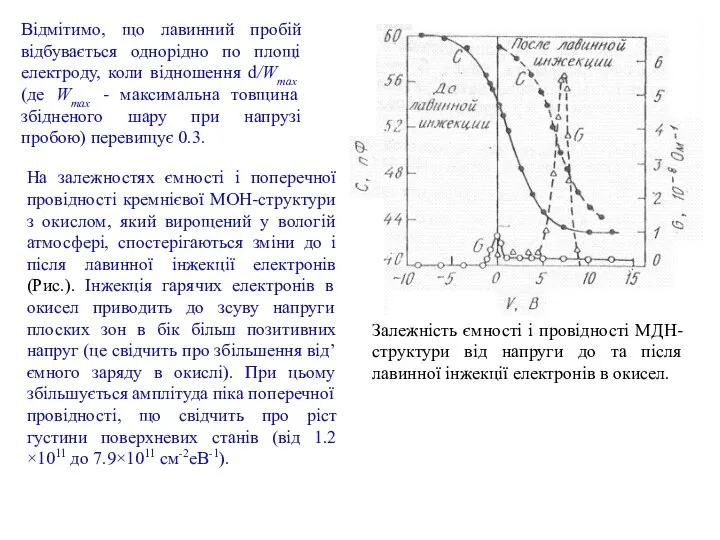

 огневая подготовка
огневая подготовка ИГРА ПО ИСТОРИИ РУССКОЙ ЖИВОПИСИ ДЛЯ УЧАЩИХСЯ 5-6 КЛАССОВ Разработка Марченковой И.М.
ИГРА ПО ИСТОРИИ РУССКОЙ ЖИВОПИСИ ДЛЯ УЧАЩИХСЯ 5-6 КЛАССОВ Разработка Марченковой И.М. Родительское собрание № 1
Родительское собрание № 1 Условия включения в реестр владельцев склада временного хранения Подготовила студентка группы 1403 Хорькова Юлия
Условия включения в реестр владельцев склада временного хранения Подготовила студентка группы 1403 Хорькова Юлия  Устранение и предупреждение аварий и неполадок электрооборудования
Устранение и предупреждение аварий и неполадок электрооборудования Sygnał
Sygnał Строительная компания "Крепость". Предложение работы социально-незащищенным группам населения
Строительная компания "Крепость". Предложение работы социально-незащищенным группам населения Алгоритм расчета (назначения) допусков размеров, массы и припусков на отливку по ГОСТ Р-53464-2009
Алгоритм расчета (назначения) допусков размеров, массы и припусков на отливку по ГОСТ Р-53464-2009 МУНИЦИПАЛЬНОЕ БЮДЖЕТНОЕ ОБЩЕОБРАЗОВАТЕЛЬНОЕ УЧРЕЖДЕНИЕ СРЕДНЯЯ ОБЩЕОБРАЗОВАТЕЛЬНАЯ ШКОЛА № 4 Г. АЛЕКСАНДРОВ
МУНИЦИПАЛЬНОЕ БЮДЖЕТНОЕ ОБЩЕОБРАЗОВАТЕЛЬНОЕ УЧРЕЖДЕНИЕ СРЕДНЯЯ ОБЩЕОБРАЗОВАТЕЛЬНАЯ ШКОЛА № 4 Г. АЛЕКСАНДРОВ Физиология форменных элементов крови
Физиология форменных элементов крови Основные понятия в тестировании. Тестовые артефакты
Основные понятия в тестировании. Тестовые артефакты Газ как моторное топливо
Газ как моторное топливо Политические партии и движения
Политические партии и движения Разнообразие домашних животных - презентация для начальной школы_
Разнообразие домашних животных - презентация для начальной школы_ Опцион (оption) - контракт, заключенный между двумя лицами, в соответствии с которым одно лицо предоставляет другому лицу право купить
Опцион (оption) - контракт, заключенный между двумя лицами, в соответствии с которым одно лицо предоставляет другому лицу право купить Технология изготовления и организация производства двутавровой балки
Технология изготовления и организация производства двутавровой балки Вимірювання обертального моменту валу електродвигуна на основі тензорезистора
Вимірювання обертального моменту валу електродвигуна на основі тензорезистора Концепции международных отношений после окончания холодной войны
Концепции международных отношений после окончания холодной войны Разработка информационно- моделирующей системы газодинамического режима доменной плавки и системы мониторинга в корпоративн
Разработка информационно- моделирующей системы газодинамического режима доменной плавки и системы мониторинга в корпоративн Здоровая нация - это ГТО
Здоровая нация - это ГТО ПОРЯДОК ПРОВЕДЕНИЯ ЛЕСНОЙ СЕРТИФИКАЦИИ
ПОРЯДОК ПРОВЕДЕНИЯ ЛЕСНОЙ СЕРТИФИКАЦИИ Виды проецирования. Центральное проецирование
Виды проецирования. Центральное проецирование 21 января 2018 года Всемирный День снега (World Snow Day). Международный день зимних видов спорта
21 января 2018 года Всемирный День снега (World Snow Day). Международный день зимних видов спорта Департамент образования Ярославской области Государственное образовательное учреждение среднего профессионального образовани
Департамент образования Ярославской области Государственное образовательное учреждение среднего профессионального образовани Программа Б.М.Неменского Изобразительное искусство и художественный труд 4 класс (1- 4)3 четверть. Искусство народов гор и степей И
Программа Б.М.Неменского Изобразительное искусство и художественный труд 4 класс (1- 4)3 четверть. Искусство народов гор и степей И ИНСТИТУЦИОНАЛЬНАЯ ЭКОНОМИКА (ВЗАИМОДЕЙСТВИЕ ГОСУДАРСТВА И БИЗНЕСА)
ИНСТИТУЦИОНАЛЬНАЯ ЭКОНОМИКА (ВЗАИМОДЕЙСТВИЕ ГОСУДАРСТВА И БИЗНЕСА)  Роботы-спортсмены
Роботы-спортсмены Призначення, технічна характеристика, загальна будова системи живлення двигуна УТД-20С1 паливом
Призначення, технічна характеристика, загальна будова системи живлення двигуна УТД-20С1 паливом