Содержание
- 2. В последние десятилетия основной фактор повышения степени интеграции -масштабирование (уменьшение размеров элементов)
- 3. Затвор из проводящего поликремния отделен от канала транзистора тончайшим (толщиной всего 1,2 нм или 5 атомов!)
- 4. С ростом степени интеграции СБИС и систем на кристалле увеличивается доля чипов, содержащих аналоговые блоки, которые
- 6. Требования к такому материалу весьма серьезны: высокая химическая и механическая (на атомарном уровне) совместимость с кремнием,
- 9. Столь малая толщина диэлектрика необходима для получения не только малых габаритов транзистора в целом, но и
- 10. слабая зависимость порогового напряжения от напряжения на стоке слабая зависимость порогового напряжения от длины и ширины
- 11. Масштабирование МОПТ Сравнительная таблица технологий XXI века:
- 12. Физические ограничения масштабирования МОПТ
- 13. Проблемы масштабирования МОПТ и пути их решения
- 14. Методы улучшения характеристик МОПТ I. Создание мелкозалегающих слаболегированных областей стока/истока (Lightly Doped Drain, LDD-области) Концентрация примеси
- 15. II. Создание ореола (halo) вокруг LDD-областей истока/стока Проникновение области обеднения стока в канал является основной причиной
- 16. II. Создание ореола (halo) вокруг LDD-областей истока/стока Проникновение области обеднения стока в канал является основной причиной
- 17. Методы улучшения характеристик МОПТ III . Крутое ретроградное распределение примеси в кармане (Super Steep Retrograde Well,
- 18. Методы улучшения характеристик МОПТ IV . Использование «напряженного кремния» Суть технологии лежит в изменении расстояния между
- 19. Масштабирование подзатворного диэлектрика Прогноз масштабирования толщины подзатворного SiO2 Кванто-механический эффект По прогнозу SIA масштабирование толщины SiO2
- 20. Использование High-K материалов в качестве подзатворного диэлектрика Hidh-K материалы позволяют использовать более толстые диэлектрические слои для
- 21. Проблемы при миниатюризации межсоединений Роль задержки в линиях разводки неуклонно растет: 1) до 90-х гг. доминировали
- 22. Перспективные разработки для дальнейшего масштабирования МОПТ I. Транзистор с двойным затворм Такой подход позволяет эффективно управлять
- 24. Наиболее распространнной конструкцией МОП- транзистора является LDD (Lightly Doped Drain) структура. Конструктивной особенностью является наличие мелких
- 26. Транзистор Tri-Gate, 22-нм
- 27. Результатом такого конструкторского решения является снижение сопротивления транзистора в открытом состоянии, увеличение сопротивления в закрытом и
- 28. тенденции в изменении разрешающей способности литографического процесса полушаг – это минимальный размер литографических параметров на кристалле.
- 29. Technology 0.18 um 0.25 um 0.35 um 0.50 um Supply Voltage (V) 1.8 2.5 3.3 3.3*2
- 30. Физические и механические свойства германия, кремния и арсенида галлия
- 31. Схематическое представление кристаллической решетки кремня
- 32. Схематическое представление плоскостей с различными индексами Миллера в кубической решетке
- 35. Процесс Чохральского для выращивания кристаллов кремния
- 39. 1 - Держатель 2 - Обмотка нагревателя 3 - Монокристаллический кремний 4 - Затравочный монокристалл 5
- 45. Скачать презентацию






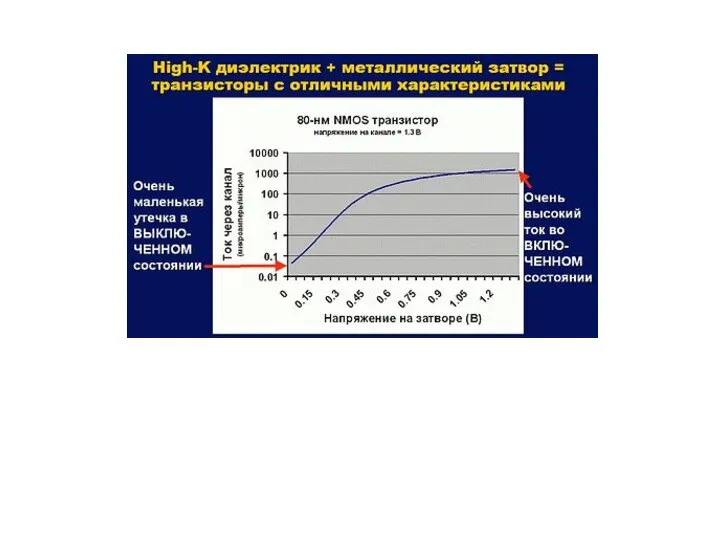








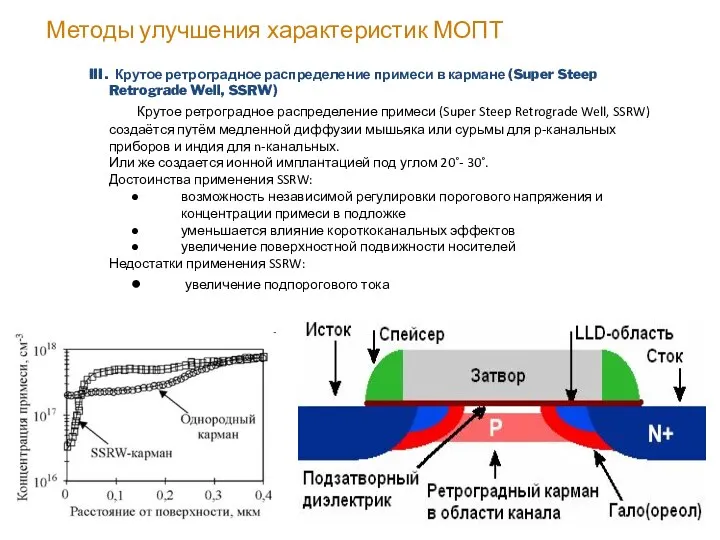
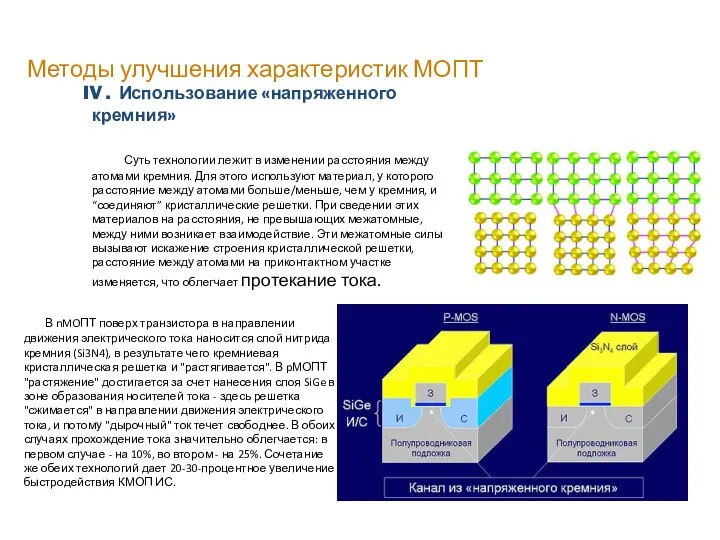
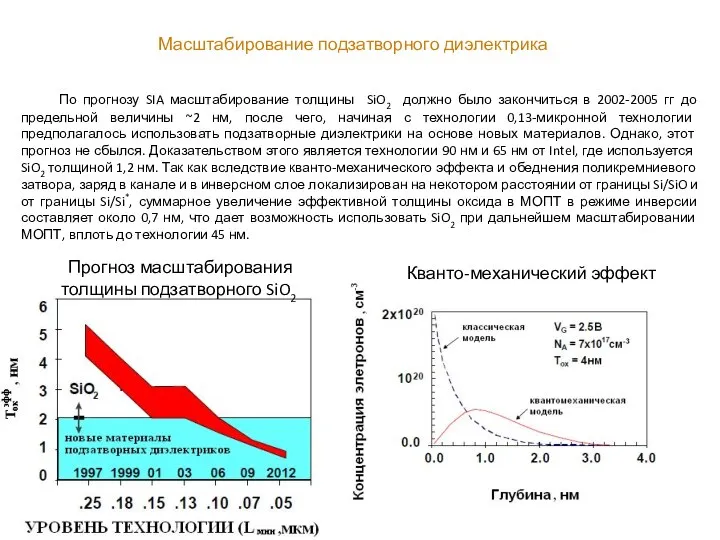



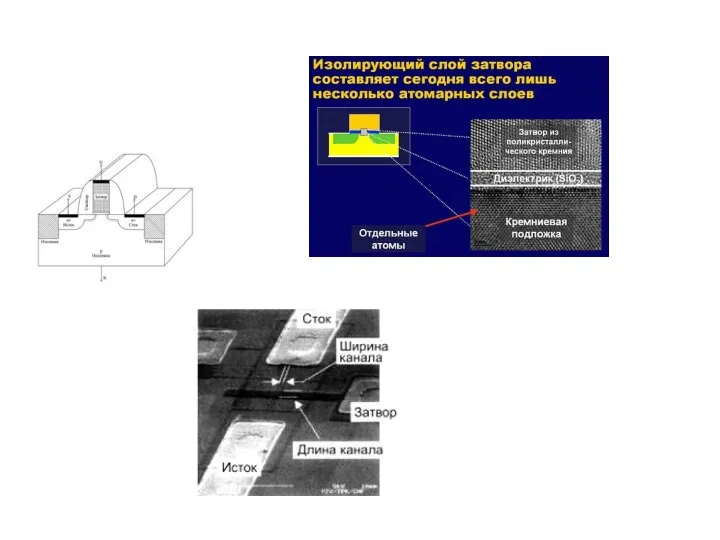

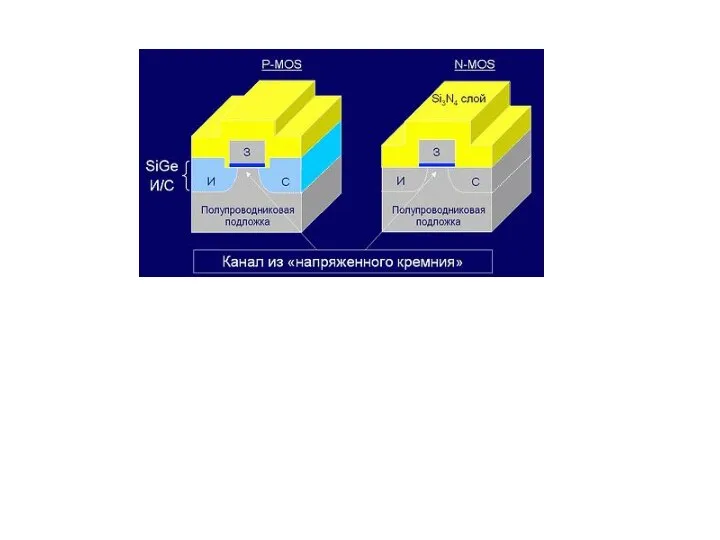
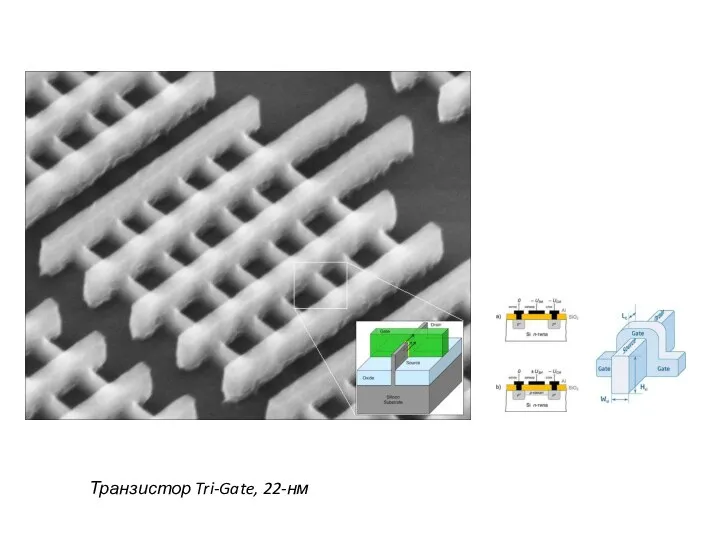
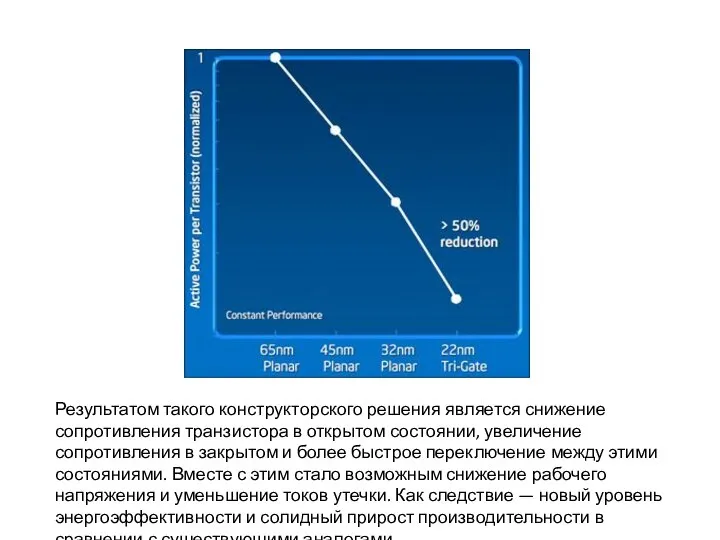




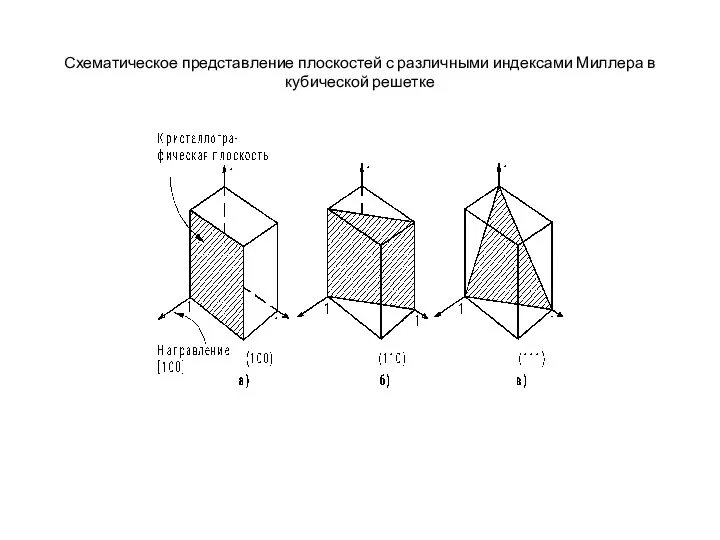







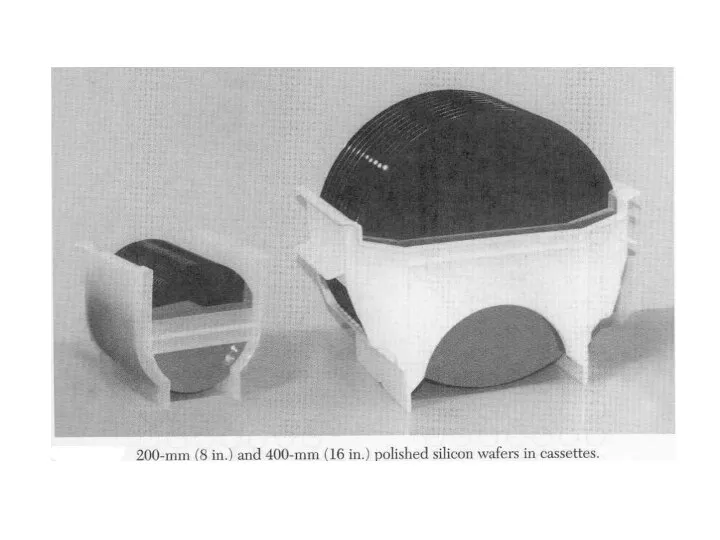
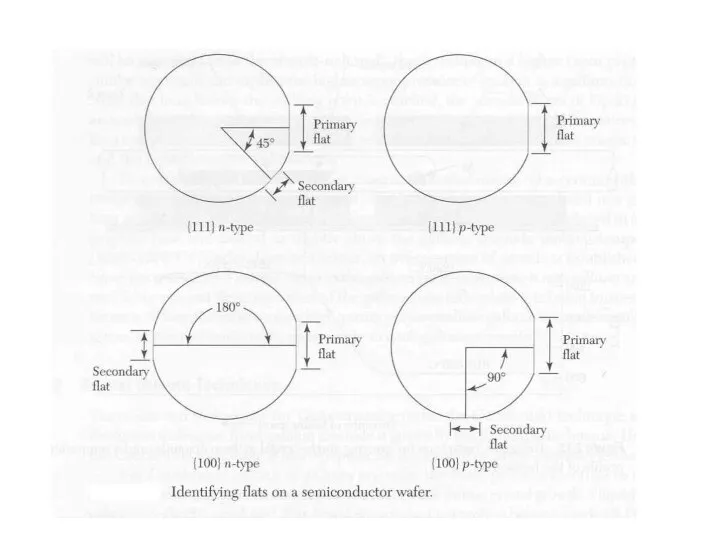


 Матрешка - символ России
Матрешка - символ России Коммуникативная грамотность менеджмента: must have или бонус? Доносим, убеждаем, воспитываем, вовлекаем
Коммуникативная грамотность менеджмента: must have или бонус? Доносим, убеждаем, воспитываем, вовлекаем  Гигиена труда при работе c неионизирующими излучениями
Гигиена труда при работе c неионизирующими излучениями Попович Наталія Іванівна
Попович Наталія Іванівна Прими силу примирения. Коринфянам 5:15-20
Прими силу примирения. Коринфянам 5:15-20 Спидометр
Спидометр Расторжение трудового договора по инициативе работодателя
Расторжение трудового договора по инициативе работодателя Литература как искусства слова.
Литература как искусства слова. Анализ данных ежедневных атмосферных осадков г. Нур-Султан (Астана)
Анализ данных ежедневных атмосферных осадков г. Нур-Султан (Астана) Математичний калькулятор
Математичний калькулятор Презентация Понятие, функции и система международного права
Презентация Понятие, функции и система международного права  Прохождение государственной службы Подготовила студентка Ю124Б Тужилова Луиза
Прохождение государственной службы Подготовила студентка Ю124Б Тужилова Луиза Всероссийский физкультурно-спортивный комплекс «Готов к труду и обороне»
Всероссийский физкультурно-спортивный комплекс «Готов к труду и обороне» ВКР: Исследование судовых нагревательных, отопительных и холодильных установок
ВКР: Исследование судовых нагревательных, отопительных и холодильных установок Ісус в світ прийшов. Х. Габрієль
Ісус в світ прийшов. Х. Габрієль Исторические мемы
Исторические мемы Культура 1 половины 19 века. Контроль знаний
Культура 1 половины 19 века. Контроль знаний Циклические алгоритмы
Циклические алгоритмы Комплексный эколого-краеведческий проект «Создание пеше-водного маршрута «Вниз по речке Василевке в сказку озера Сапшо»
Комплексный эколого-краеведческий проект «Создание пеше-водного маршрута «Вниз по речке Василевке в сказку озера Сапшо» Секция Активные технологии обучения Школа профессионального мастерства
Секция Активные технологии обучения Школа профессионального мастерства Гормональная контрацепция : возможные риски, преимущества
Гормональная контрацепция : возможные риски, преимущества  лекция развитие ребенка ЭЭриксон119 — копия
лекция развитие ребенка ЭЭриксон119 — копия 5 секретных маркетинговых технологий привлечения посетителей в Вашу аптеку. Максим Мясников, зам. Директора по маркетингу ООО «Д
5 секретных маркетинговых технологий привлечения посетителей в Вашу аптеку. Максим Мясников, зам. Директора по маркетингу ООО «Д WORLDSKILLS. Компетенция ИТрешения для бизнеса на 1С. Примеры решений нестандартных задач
WORLDSKILLS. Компетенция ИТрешения для бизнеса на 1С. Примеры решений нестандартных задач Учитель I категории Бухарова Ирина Георгиевна
Учитель I категории Бухарова Ирина Георгиевна Чтение слогов и слов с буквами Я,я
Чтение слогов и слов с буквами Я,я  Виды деформации. Методы определения твердости
Виды деформации. Методы определения твердости Организационно-правовые формы некоммерческих организаций здравоохранения
Организационно-правовые формы некоммерческих организаций здравоохранения