Содержание
- 10. Принцип работы биосенсора с использованием полевых транзисторных структур на кремниевых нанопроволоках (Si-NW FET)
- 11. Формирование кремниевой нанопроволочной структуры 1-ый этап 2-ой этап Исходная КНИ структура Осаждение слоев SiO2,Si3N4 Операция фотолитографии
- 12. Результаты экспериментов Операционные параметры оптимизированного процесса изотропного плазменного травления Si - ВЧ-мощность - 90 Вт, -
- 16. Особенности плазменного травления с использованием периодических наноразмерных алюмооксидных масок Применение ПАОА (пористый анодный оксид алюминия) в
- 17. Массив нанометровых пор в кремнии, сформированных плазменным травлением через маску пористого оксида
- 18. Ипользуют кремниевые пластины, на которые с помощью магнетронного распыления были нанесят послойно пленки титана и алюминия
- 19. Полученные структуры подвергают обработке в установке ионного травления в среде аргона. В процессе травления рабочее давление
- 20. Изображение поверхности твердой маски пористого оксида алюминия после ионного травления структуры (а) и РЭМ-микрофотография поперечного скола
- 21. АСМ изображение структуры (а) и ее схематичное поперечное сечение (б) после анодирования и «сухого» травления.
- 22. АСМ - изображение поверхности кремниевой подложки после удаления твердой оксидной маски площадью 15×8 мкм
- 23. АСМ - изображение поверхности кремниевой подложки после селективного удаления с нее твердой оксидной маски ( а)
- 24. Для расширения диапазона глубины травления кремния после первоначальной обработки структуры в установке ионного травления в среде
- 25. АСМ-изображение поверхности кремния (а) и РЭМ микрофотография поперечного сечения кремниевой подложки (б), содержащей слой оксида алюминия,
- 27. Скачать презентацию

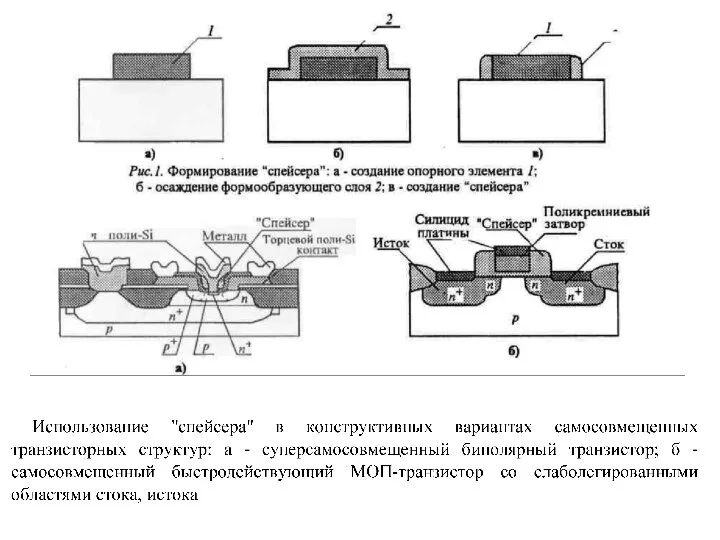
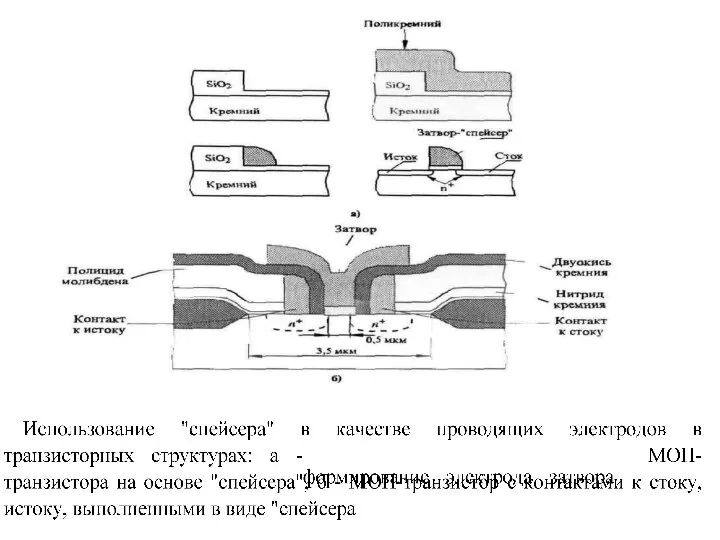


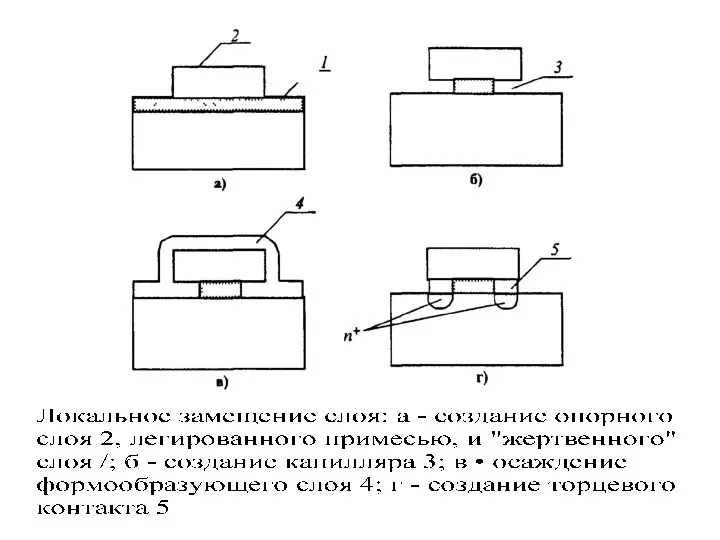

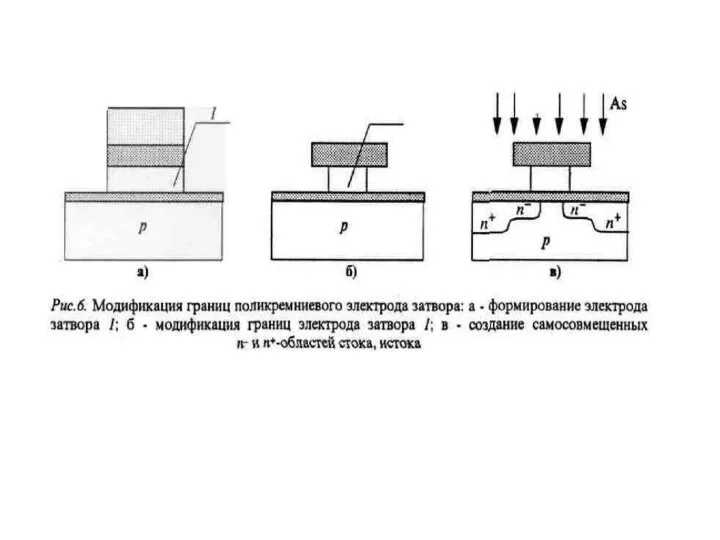

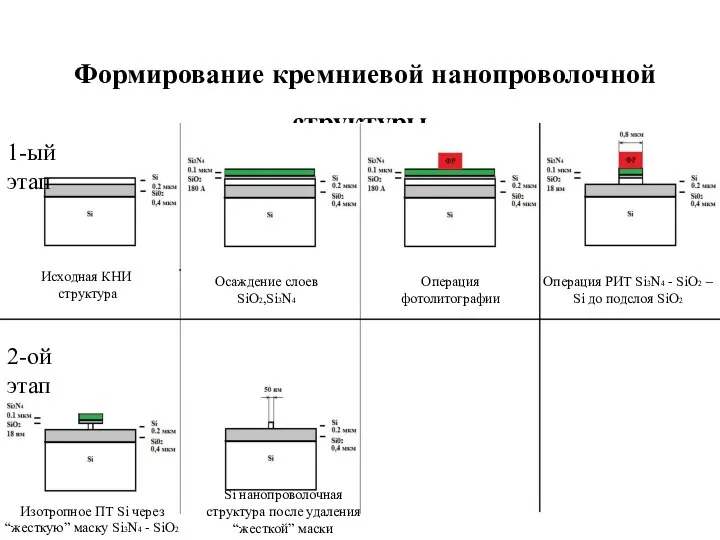


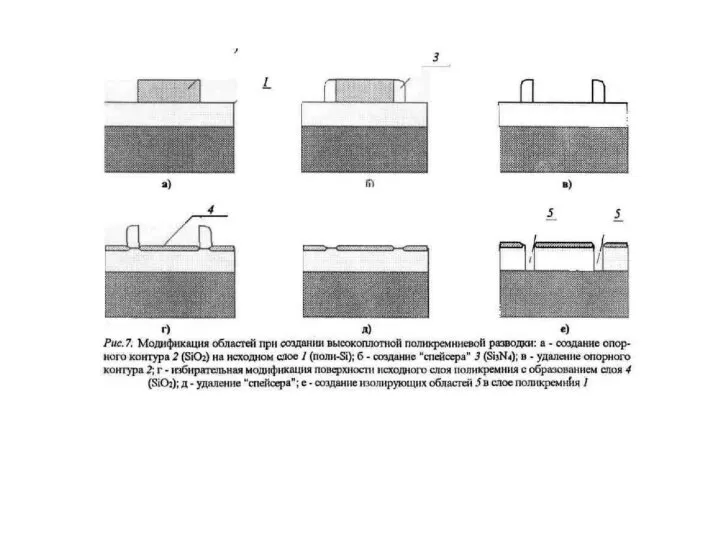






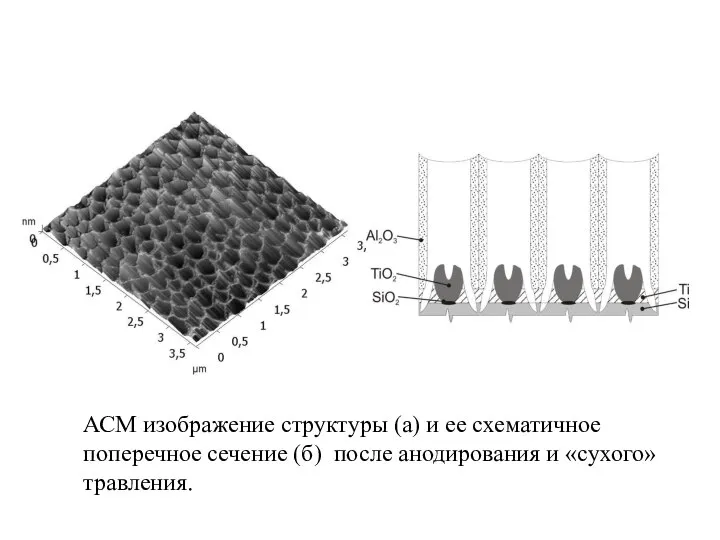



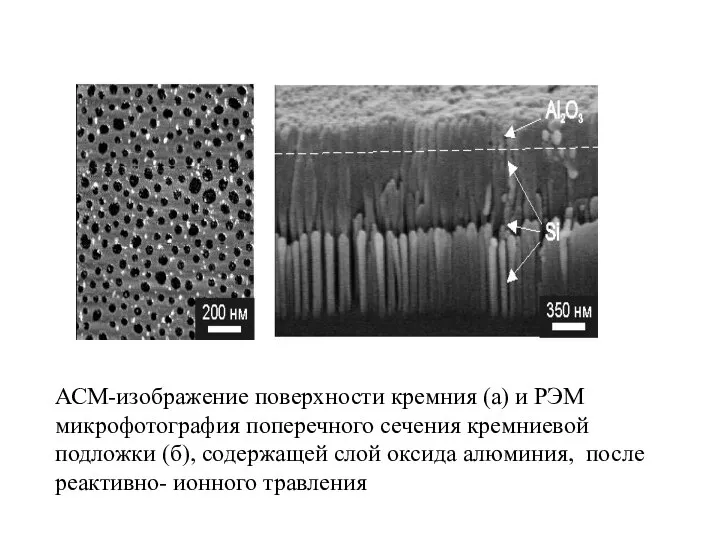
 НАТО (Организация Североатлантического Договора)
НАТО (Организация Североатлантического Договора) Родительское собрание Круглый стол: родители и дети
Родительское собрание Круглый стол: родители и дети Презентация "Андрей Рублёв (10 класс)" - скачать презентации по МХК
Презентация "Андрей Рублёв (10 класс)" - скачать презентации по МХК Система и принципы физической культуры в РФ
Система и принципы физической культуры в РФ Дәріхана ұйымын жүйлелендірудегі экономикалық көрсеткіштер
Дәріхана ұйымын жүйлелендірудегі экономикалық көрсеткіштер The block diagram of ticket purchase via the web interface
The block diagram of ticket purchase via the web interface Культура Київської Русi
Культура Київської Русi Презентация "Греческая керамика" - скачать презентации по МХК_
Презентация "Греческая керамика" - скачать презентации по МХК_ Технічне обслуговування електрообладнання автомобілів та системи запалювання карбюраторних двигунів (6)
Технічне обслуговування електрообладнання автомобілів та системи запалювання карбюраторних двигунів (6) Легализация (отмывание) денежных средств. Современное состояние и предупреждение
Легализация (отмывание) денежных средств. Современное состояние и предупреждение Из истории портрета
Из истории портрета Объектно-реляционные базы данных
Объектно-реляционные базы данных Магнитные цепи и электромагнитные устройства. Трансформатор (продолжение)
Магнитные цепи и электромагнитные устройства. Трансформатор (продолжение) Пропагандистські війни
Пропагандистські війни Презентация "ВИДЫ И СПОСОБЫ ТОРГОВЛИ" - скачать презентации по Экономике_
Презентация "ВИДЫ И СПОСОБЫ ТОРГОВЛИ" - скачать презентации по Экономике_ Стратегическое управление. Лекция 3
Стратегическое управление. Лекция 3 Презентация "Треченто в живописи." - скачать презентации по МХК
Презентация "Треченто в живописи." - скачать презентации по МХК Познание духовной природы мужчины и женщины - путь к гармонии
Познание духовной природы мужчины и женщины - путь к гармонии Момбекова
Момбекова А1. Существует несколько значений понятия «экономика». Какая позиция иллюстрирует экономику как хозяйство? А1. Существует несколь
А1. Существует несколько значений понятия «экономика». Какая позиция иллюстрирует экономику как хозяйство? А1. Существует несколь Rocket Hostel
Rocket Hostel Великобритания (Политическая система, образование, культура и традиции)
Великобритания (Политическая система, образование, культура и традиции) ElleGirl.ru Ломакина Екатерина Андреевна ИД-401
ElleGirl.ru Ломакина Екатерина Андреевна ИД-401 Устами младенца - презентация для начальной школы_
Устами младенца - презентация для начальной школы_ Готика в средневековой Западной Европе
Готика в средневековой Западной Европе Сфера духовной жизни
Сфера духовной жизни Федеральная таможенная служба Российской Федерации. Федеральная служба охраны Российской Федерации. Лекция № 5
Федеральная таможенная служба Российской Федерации. Федеральная служба охраны Российской Федерации. Лекция № 5 ЛР и руководство пользователя
ЛР и руководство пользователя