Содержание
- 2. План доклада Введение Принцип S-FIL литографии Описание технологии и последние достижения в производстве штампов Imprio I-250,
- 3. EUVL: В конце 1980-х EPL: Началась около 1990 MBDW: Началась в 1980-х 193 Immersion: Создание началась
- 4. Продолжение введения. В ХХ веке широкое распостранение получило печатание грампластинок В 1994 году Стив Чу продемонстрировал
- 5. Примеры импринт литографии 1. PDMS печать с тиолом 2. Привод в контакт 3. Молекулы переходят 4.
- 6. Примеры импринт литографии John A. Rogers, University of Illinois, Urbana-Champaing, http://rogers.mse.uiuc.edu/files%5C2006%5Cieeenano.pdf Печатание с помощью штампа сделанного
- 7. Inkjet Imprint fluid dispenser Planarization layer Substrate Low viscosity fluid (Si-containing for S-FIL, Organic for S-FIL/R)
- 8. Динамика и однородность напечатанного слоя 15 nm - 2 nm Набор линий разных размеров в данных
- 9. Шаг 1: Удаление остаточного слоя Шаг 2: Удаление планаризационного слоя Шаг 2: Нанесение кремнесодер-жащего планаризационного слоя
- 10. Гибкая печать на сапфире, 100 мм 3 сек
- 11. Гибкая печать на сапфире, 100 мм
- 12. S-FIL Импринт Литография 65 x 65 mm штамп для поля 26 мм x 33 мм Успешное
- 13. Производство нано-штампа. Стардатный процесс. Resist applied to 15 nm of Cr Expose/develop e-beam resist, descum Etch
- 14. Развитие процесса с использованием положительного резиста ZEP520 Ширина линий в зависимости от дозы экспозиции при различных
- 15. ZEP520A: Bias = -18nm, Штамп 32nm 28nm Dense Lines Metal 1
- 16. Отпечатки: -18nm Bias, 28 – 40 nm HP 28 nm 32 nm 36 nm 40 nm
- 17. Профиль отпечатков: Bias = -18 nm 28 nm 32 nm 36 nm 40 nm
- 18. 28 and 32 nm HP: малая чуствительность к изменению полученной дозы Dose = 309 μC/cm2 Dose
- 19. 36 nm Half Pitch: No Bias – Очень чуствительна к изменению дозы Bias: 0 nm Exposure
- 20. DNP нано-штамп написанный с помощью Гауссова пучка X-section Top down *Sasaki et al., Bacus 2006 *
- 21. Hoya нано-штамп для памяти с 30 нм Fins Template Imprint
- 22. Производство нано-штампа. Путь к меньшим размерам. Стандартный подход Resist applied to 15 nm of Cr Expose/develop
- 23. Штамп: 25 нм полупериод
- 24. Штампы: полупериоды 19 нм и 21 нм
- 25. Полученные отпечатки со штампами 23 нм and 21 нм (полупериод) 23nm HP 21nm HP
- 26. Штамп после удаления хрома, Cr (Lift-off): Полупериоды 17 нм и 15 нм 17nm Half Pitch 15nm
- 27. Негативный резист HSQ: Штамп с полупериодом 15 нм HSQ 15 nm half pitch
- 28. Негативный резист HSQ: Штамп с полупериодом 12.5 нм HSQ 12.5 nm half pitch
- 29. Достигнутое пространственное разрешение уже достаточно для проведения исследований Разрешение является важным фактором, но не достаточным Необходимо
- 30. Инспектирование и ремонт нано-штампа 1x template inspection/repair builds on wafer inspection technology Two technologies being used
- 31. Время написания нано-штампа является важным фактором Время написания фото-масок существенно увеличилось! Для фото-маски с 65 нм
- 32. Сравнение исходного штампа и его реплики Отпечаток с исходного штампа Отпечаток с реплики
- 33. Требования к установкам импринт литографии для CMOS приложений Высокая точность совмещения рисунка с предыдущим слоем Малый
- 34. Imprio - 250 Установка предназначена для CMOS приложений На ней можно получать структуры менее 20 нм
- 35. Точность совмещения слоев (Overlay) Требуемая точность 20-25% от минимального размера. К примеру для полупериода 22 nm
- 36. Совмещение рисунка во время печати Совмещение измеряется с помощью растровых решеток (moiré) как на штампе, так
- 37. Растровые решетки муара 25nm L/S подложка штамп две растровые решетки муара совмещены растровая решетка
- 38. Результаты по точности совмещения слоев Точность совмещения была продемонстрирована с двумя типами 193 нм сканерами Точность
- 39. Последовательное уменьшение количества дефектов Данные включают все типы дефектов Наблюдается постепенное улучшение – приблизительно один порядок
- 40. Зависимость количества S-FIL дефектов от размеров Дополнительное количество дефектов было обнаружено на установке eS32, которая обладает
- 41. Устойчивость процесса к посторонним частицам. Самоочистка при последующем печатании. Штампы удивительно устойчивы к механическому воздействию частиц
- 42. Производительность Imprio-250 Сравнительно малая стоимость печатных головок позволяет установить несколько таких головок для увеличения производительности.
- 43. Сравнение планов для интегальных микросхем (ITRS) и для хранения информации (Information Storage) ITRS Roadmap for DRAM
- 44. Research Litho Process Dev Process Integration Production План развития на ближайшие годы Производство структур с полупериодом
- 45. Приложения в CMOS индустрии Примером служит совместная работа с IBM над сверхплотной элементом памяти с размерами
- 46. IBM Almaden Research Center 30 нм “Storage-Class” сверхплотная постоянная память MNAB - Micro to Nano Addressing
- 47. Базовый рисунок с 4-Fin MNAB, углубленный в кварц 30 нм линии / 120 нм период 80
- 48. Продемонстрирована 27 нм FinFET литография с прекрасным контролем за размерами линий, вертикальностью стенок и малой шероховатостью
- 49. Потенциал для 3-х мерной печати Нанести диэлектрический слой Нарисовать и протравить контакты Нарисовать и протравить каналы
- 50. Потенциал для 3-х мерной печати Micron scale 3-tier T-gate 3-х уровневый затвор Микро-линзы
- 51. Применение к фотонным кристаллам 90nm Holes 160nm Pitch 90nm Holes 150nm Pitch 120nm Holes 268nm Pitch
- 52. Позволяет уже сегодня достичь уровня литографии менее 32 нм с маленькой шероховатостью линий (LER) Совместима с
- 53. У технологии существуют многочисленные приложения и возможности нахождения большого рынка сбыта Flat Panel Displays Future Applications
- 54. В 2006 году обе технологии EUV и S-FIL импринт начали продажи установок для CMOS! 25nm L/S
- 56. Скачать презентацию


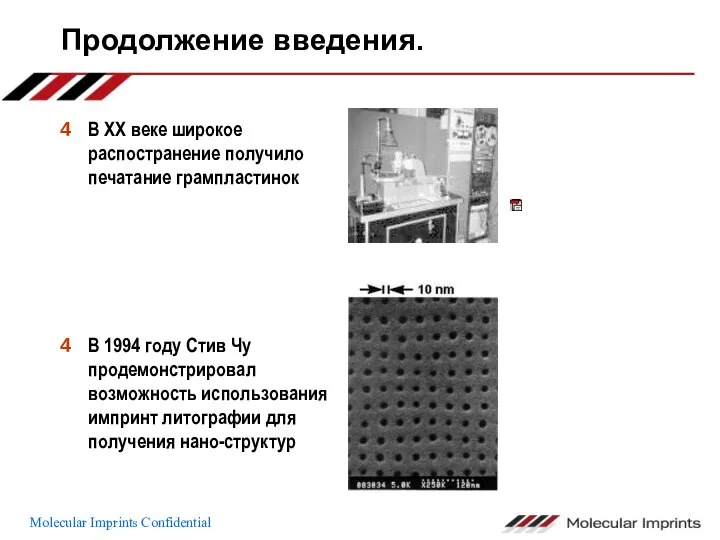
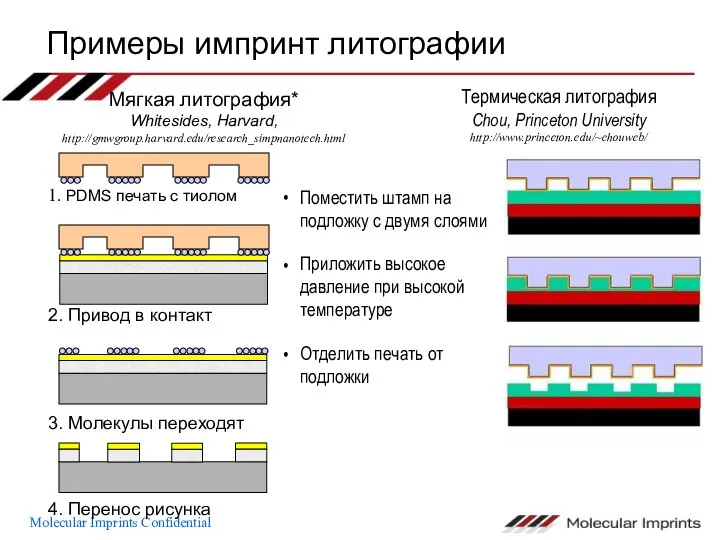

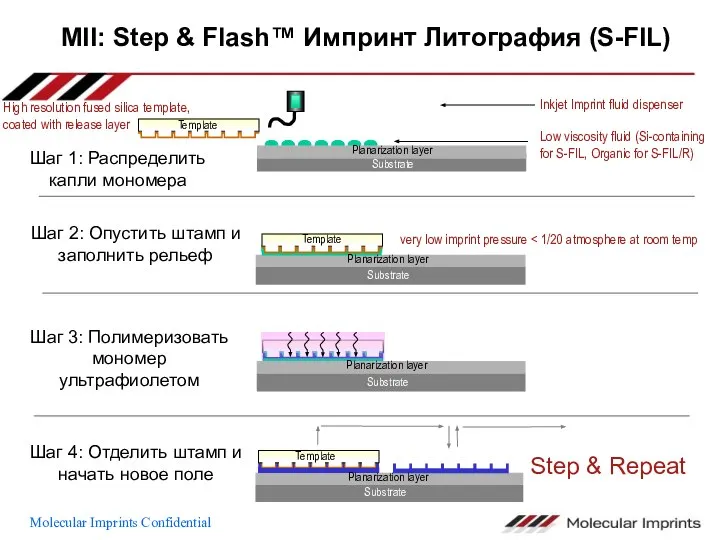
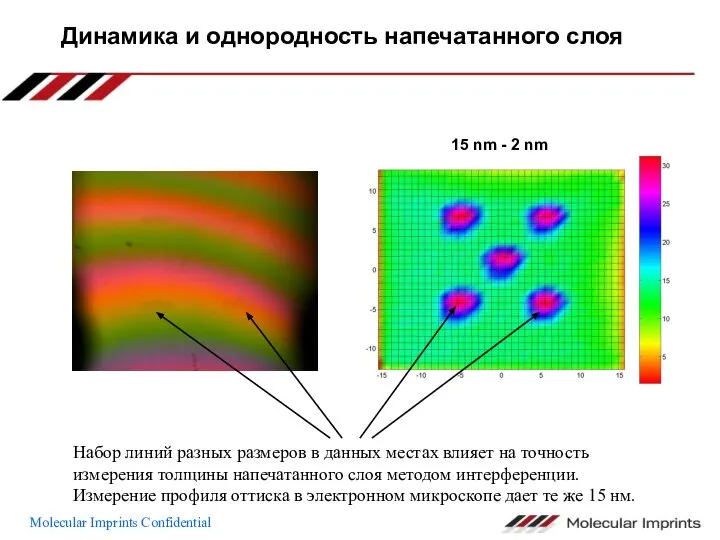
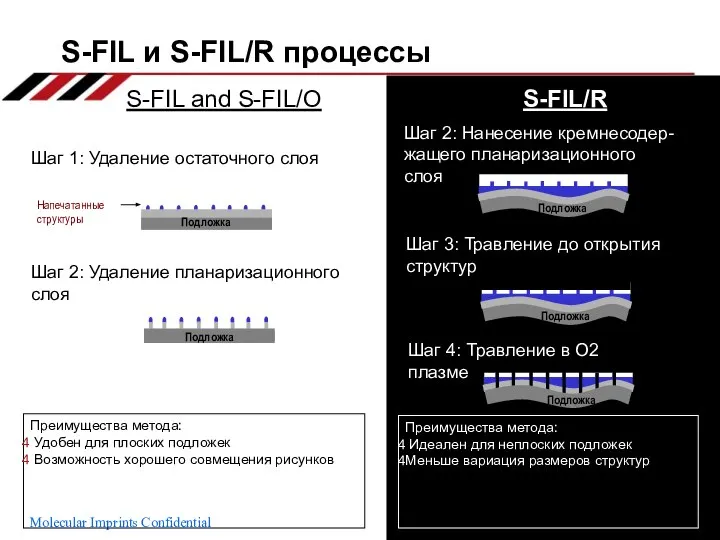
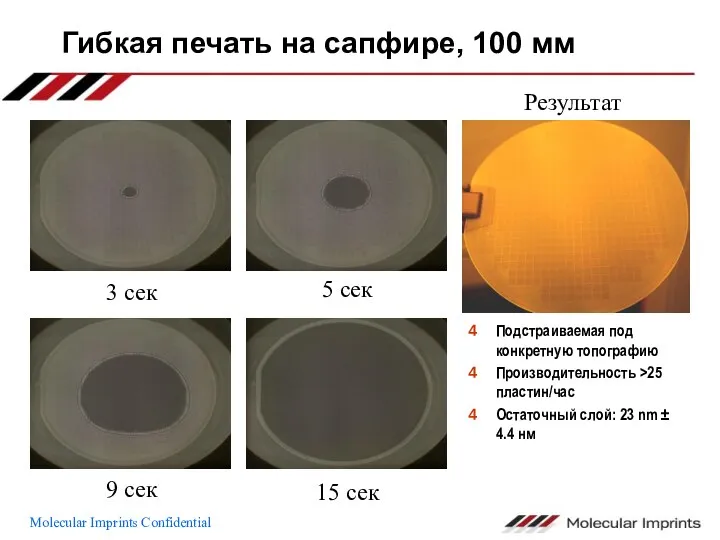


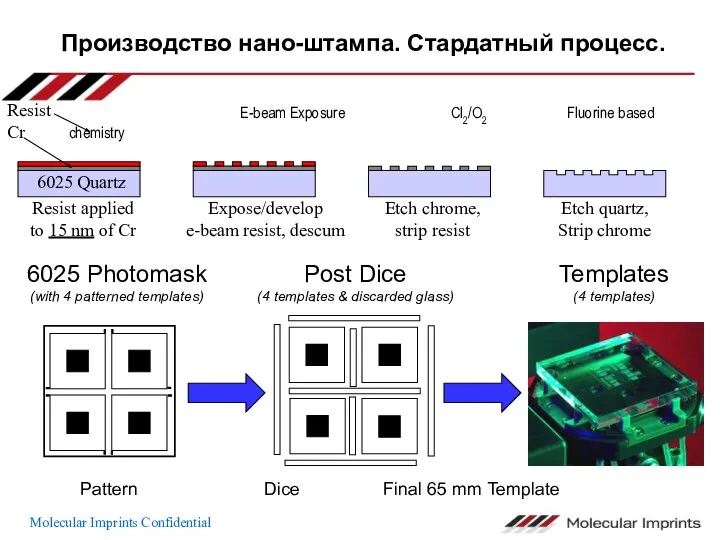

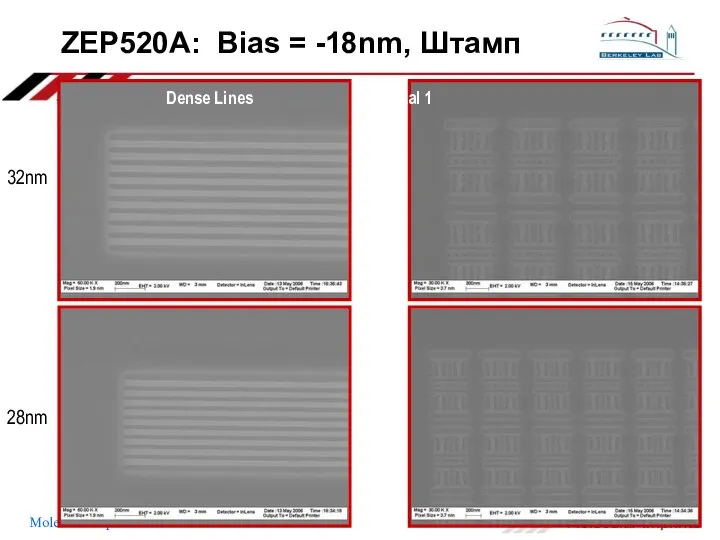
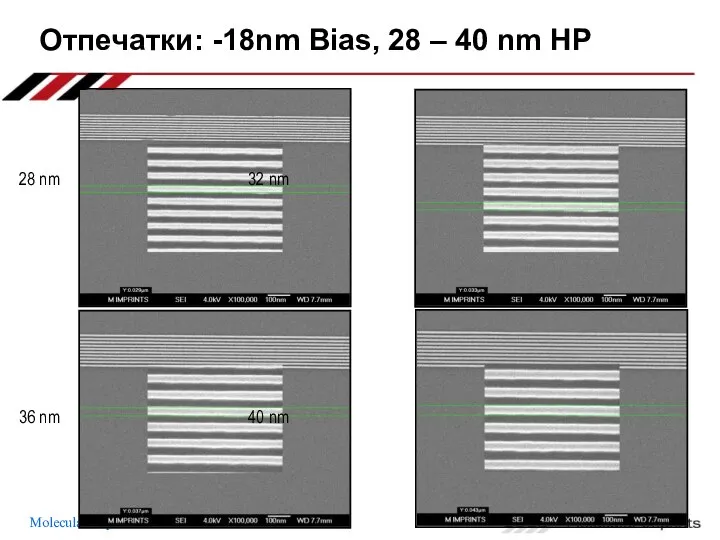
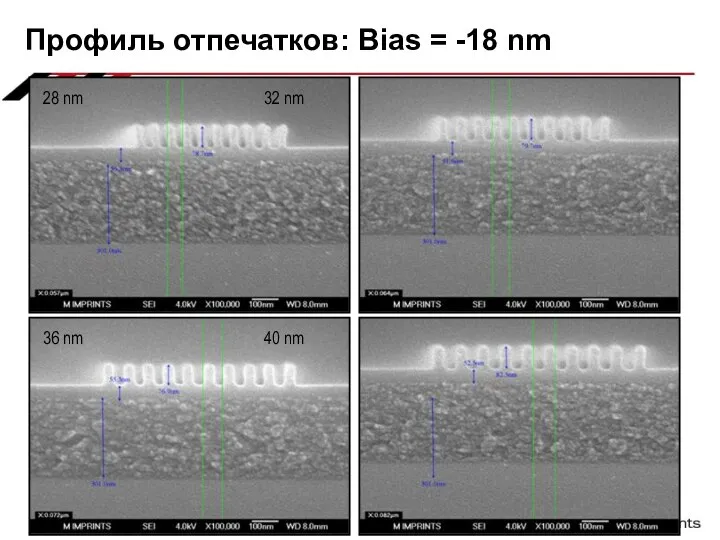
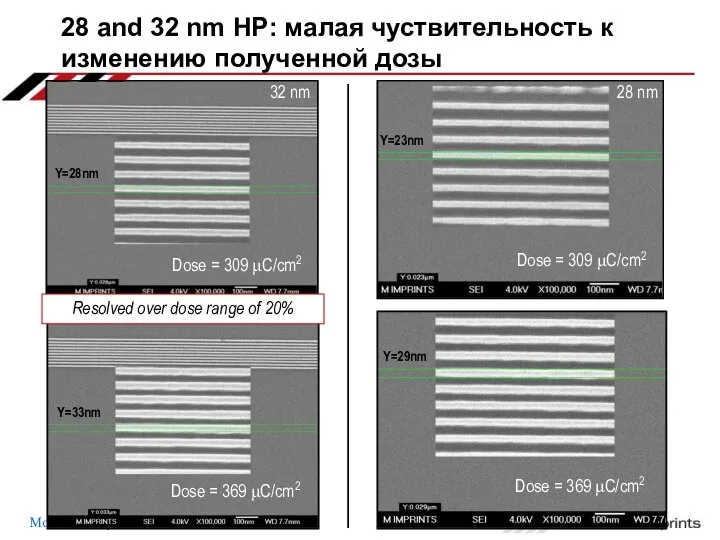

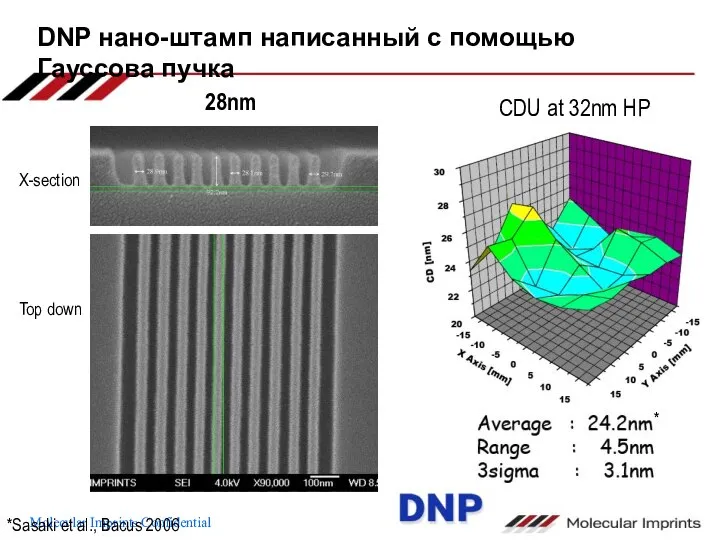
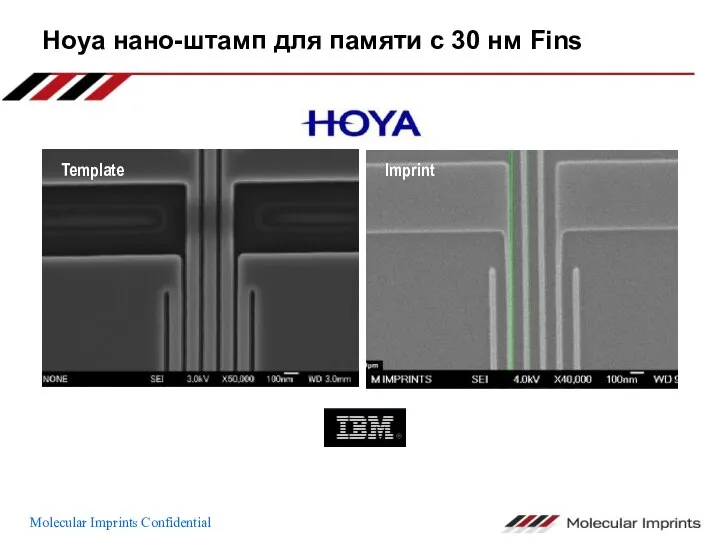
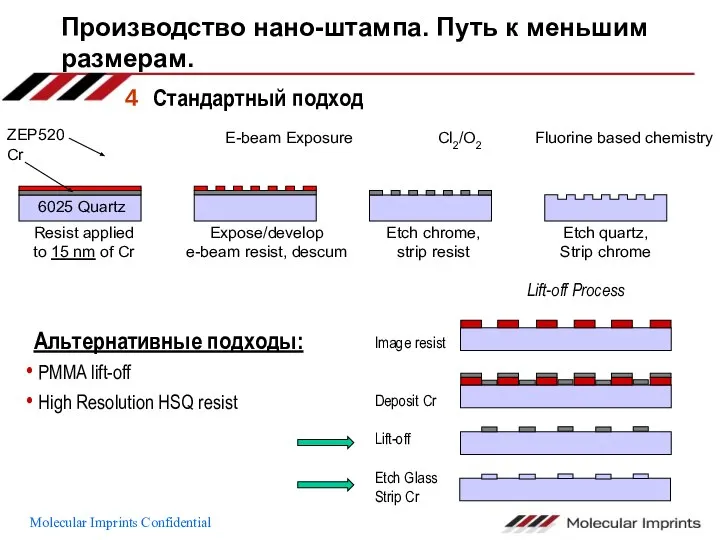



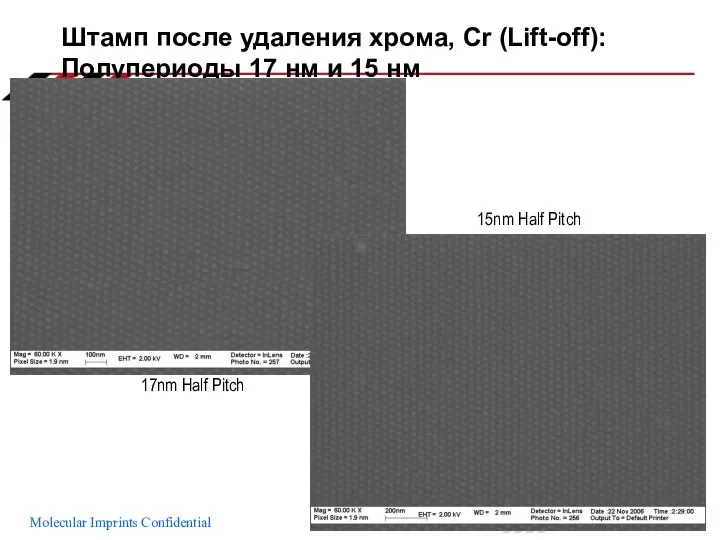


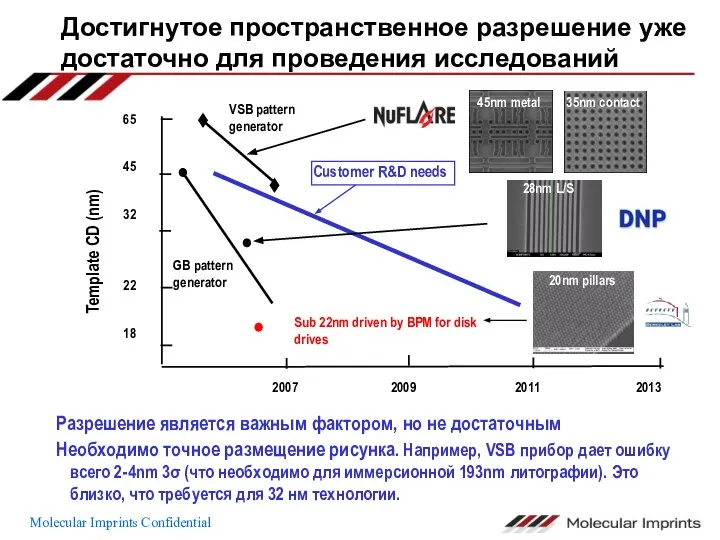

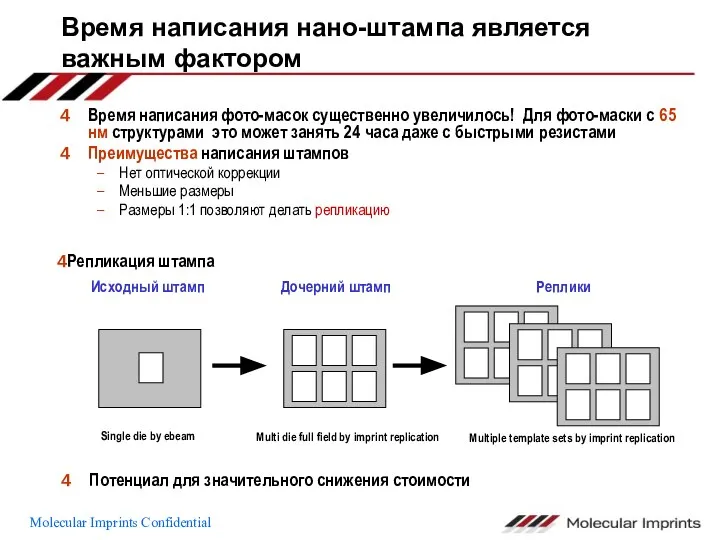
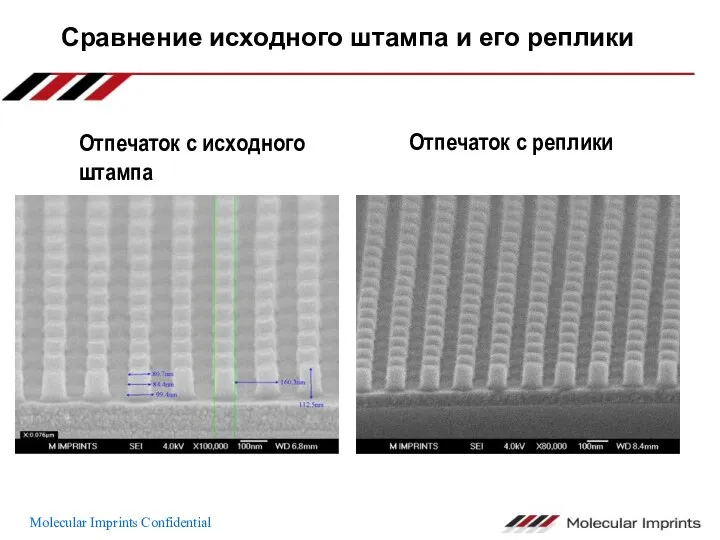












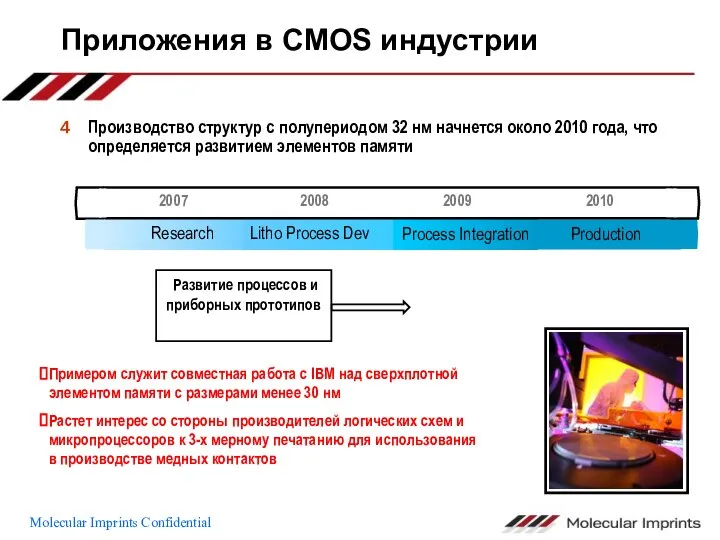
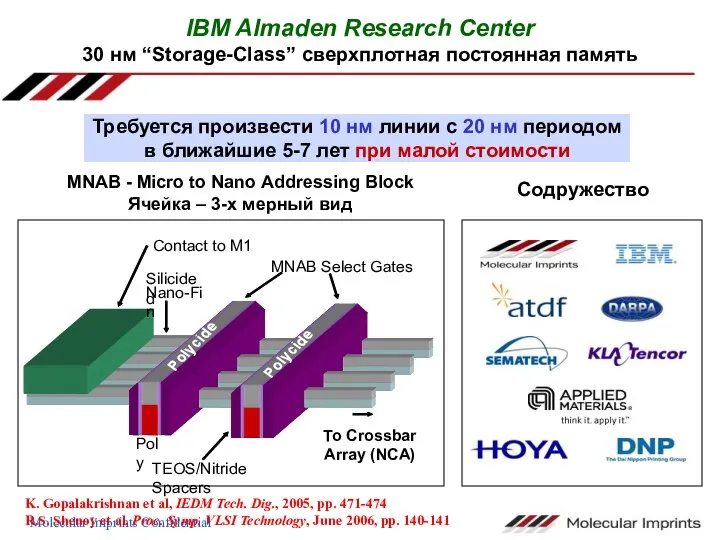
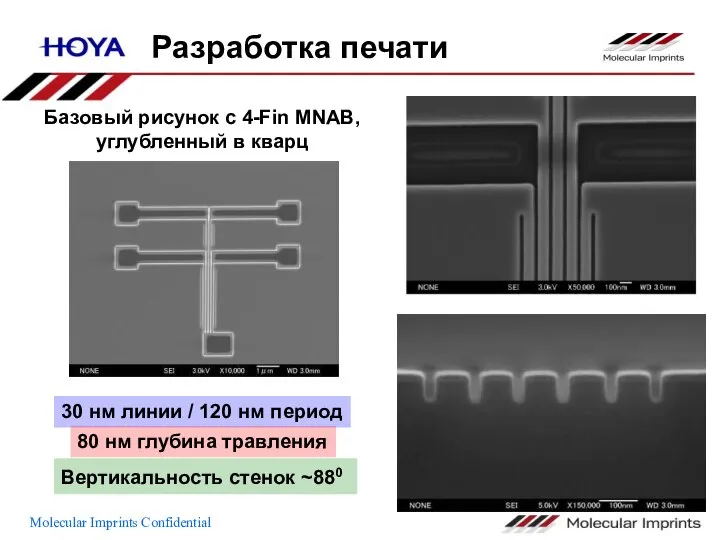

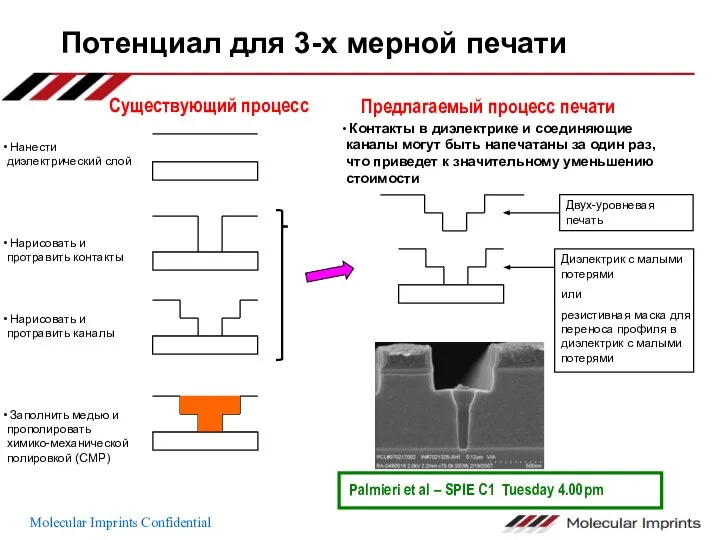
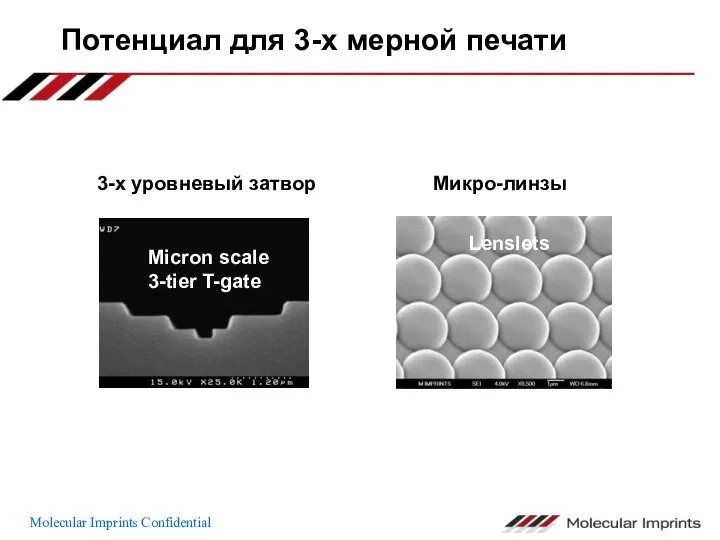




 Структура центров ГСЭН. Организационно-методическая работа областного и районного центров ГСЭН
Структура центров ГСЭН. Организационно-методическая работа областного и районного центров ГСЭН Қожа Ахмет Иассауи
Қожа Ахмет Иассауи ТАРГЕТНАЯ ТЕРАПИЯ У ОНКОЛОГИЧЕСКИХ БОЛЬНЫХ
ТАРГЕТНАЯ ТЕРАПИЯ У ОНКОЛОГИЧЕСКИХ БОЛЬНЫХ Зимняя сказка
Зимняя сказка Использование 3D принтера во внеурочной деятельности учащихся
Использование 3D принтера во внеурочной деятельности учащихся Основы экологии и энергосбережения
Основы экологии и энергосбережения Виды реактивных двигателей
Виды реактивных двигателей Графические приложения
Графические приложения Thanksgiving Day
Thanksgiving Day Основная документация педагога-психолога ДОУ
Основная документация педагога-психолога ДОУ Виктор Петрович Астафьев
Виктор Петрович Астафьев Теория и организация адаптивной физической культуры
Теория и организация адаптивной физической культуры Элементы структуры цены. Рентабельность. Выполнила: студентка 4-гог курса ФТД ДС- 05 Бреус Я.Ю.
Элементы структуры цены. Рентабельность. Выполнила: студентка 4-гог курса ФТД ДС- 05 Бреус Я.Ю.  Типы данных
Типы данных Гидросхемы
Гидросхемы  Олимпийские игры в древности
Олимпийские игры в древности Политическое сознание
Политическое сознание Прилади для вимірювання міцності бетону
Прилади для вимірювання міцності бетону Бразилия и Индия. Нужно ли выходить Micromax на рынок Бразилии?
Бразилия и Индия. Нужно ли выходить Micromax на рынок Бразилии? Конструктивные системы зданий и сооружений. Основные конструктивные схемы зданий
Конструктивные системы зданий и сооружений. Основные конструктивные схемы зданий Презентация Социальные организации
Презентация Социальные организации Особенности оценки дебиторской задолженности
Особенности оценки дебиторской задолженности Изобразительное искусство XX века
Изобразительное искусство XX века Эссе
Эссе Алгоритмы на графах Графы. Основные определения
Алгоритмы на графах Графы. Основные определения Дидактические игры
Дидактические игры  Женский костюм стиль «Второе Рококо»
Женский костюм стиль «Второе Рококо» Правовой статус несовершеннолетних . Необходимость получения правовых знаний и навыков их применения для реализации прав и ответ
Правовой статус несовершеннолетних . Необходимость получения правовых знаний и навыков их применения для реализации прав и ответ