Содержание
- 2. Лекция 1 Тенденции развития конструктивно-технологических решений при создании СБИС
- 4. Два колеса Человечества
- 5. Эдисон и его лампа (1879 год)
- 6. Диод Флеминга (1906 год)
- 7. Триод Ли де Фореста (1907 год)
- 8. Принцип работы электронной вакуумной лампы
- 9. Электронная вакуумная лампа
- 10. Миниатюрные «пальчиковые» лампы
- 11. Радиоприемник на электронных лампах
- 12. ENIAC – первый цифровой ламповый компьютер (1944год) 18000 ламп
- 13. Нереализованный «полевой транзистор» Лилиенфельда. Патент США 1 745 175 на «метод и устройство управления электрическими токами»
- 14. Принцип работы полевого транзистора
- 15. Точечный диод Шоттки (1940 год)
- 16. Патент В.Шокли на МДП- транзистор (1943 год)
- 17. Почему не работал МДП-транзистор Управляющий электрод Полупроводник Соотношение между поверхностными ловушками (оборванные связи) и количеством индуцированных
- 18. Открытие транзисторного эффекта (1947 год) В.Шокли, Д.Бардин, В.Браттейн
- 19. Биологический микроманипулятор на котором был открыт транзисторный эффект
- 20. Открытие транзисторного эффекта (1947 год) В.Шокли, Д.Бардин, В.Браттейн
- 21. Запись Д.Бардина с описанием транзисторного эффекта (1947 год)
- 22. Первый точечный биполярный транзистор (1947 год)
- 23. Празднование Нобелевской премии за изобретение транзистора( 1956 г )
- 24. Роль наших ученых В 1956 г. Дж. Бардин отметил в Нобелевской лекции, что они основывались на
- 25. Участок изготовления точечных транзисторов (1949 год)
- 26. Первый плоскостной биполярный транзистор (1951 год )
- 27. Первый плоскостной биполярный диффузионный транзистор (1958 год)
- 28. Участок диффузии ( 1957 год )
- 29. Изобретатели интегральной схемы – «чипа» Д.Килби и Р.Нойс
- 30. Первая интегральная схема на германии Джека Килби (1958 г) Нобелевская премия 2000 г
- 31. Первая интегральная схема на кремнии Роберта Нойса (1959 г )
- 32. Интегральная схема в корпусе
- 33. Структура интегрального биполярного транзистора
- 34. Структура МОП- транзистора
- 35. Почему не работал МДП-транзистор Управляющий электрод Полупроводник Соотношение между поверхностными ловушками (оборванные связи) и количеством индуцированных
- 36. Разработчики метода пассивации поверхности кремния оксидом М.Аталла М.Кант
- 37. Почему стал работать МОП-транзистор Эффект пассивации поверхности оксидом (1960-е гг. М. Аталла и Д. Кант )
- 38. Пороговое напряжение МОП-транзистора
- 39. Зарядовое состояние системы кремний-оксид Слон и семеро слепцов Р.Донована Адсорбированные ионы Галоидные ионы Кислородные вакансии Ловушки
- 40. Заряды в системе кремний-оксид кремния Na+ K+ Qм Qр Qп Qпс [ 2 ] Мигрирующий заряд
- 41. Первый МОП- транзистор (1960 год)
- 42. Первая МОП-интегральная схема 64 транзистора (Bell Laboratories 1962 год)
- 43. Первая отечественная МОП ИС более 60 транзисторов, (НИИМЭ. 1967 год)
- 44. КМОП - структура
- 45. Закон Мура
- 46. Влияние увеличения степени интеграции на параметры СБИС 1. Увеличение быстродействия ( производительности ) СБИС. 2. Повышение
- 47. Интегральная схема ПЗУ на всей пластине кремния диаметром 24 мм (НИИМЭ. 1969 год)
- 48. Причины снижения выхода годных СБИС Выход годных кристаллов на пластине кремния при изготовлении ИС снижается из-за
- 49. Образование случайных дефектов – паразитных отверстий в оксиде кремния Нанесение фоторезиста Жидкий Паразитные отверстия в оксиде
- 50. Классическая задача статистики ( ячеек - N, шариков –n)
- 51. Модели выхода годных Для расчета выхода годных используют различные модели распределения случайных дефектов по пластине: Модель
- 52. Биноминальное распределение Если n – число дефектов (пылинок) N – число кристаллов Pк - вероятность содержания
- 53. Распределение Пуассона При больших значениях N и n, ( что и наблюдается на практике) и если
- 54. Выход годных При k = 0
- 55. Зависимость выхода годных от площади кристалла и плотности дефектов. Если площадь кристалла - A, плотность дефектов
- 56. Зависимость выхода годных от площади кристалла и дефектности A (мм2) D1 D2 D3 20 40 60
- 57. Поражающие и не поражающие дефекты
- 58. Коэффициент поражаемости
- 59. Зависимость выхода годных от площади кристалла и коэффициента поражаемости A (мм2 ) B1 B2 B3 20
- 60. Выход годных Учет коэффициента поражаемости при определении выхода годных.
- 61. Выход годных Учет коэффициента поражаемости при определении выхода годных. Для увеличения выхода годных наиболее целесообразно уменьшать
- 62. Пример расчета коэффициента поражаемости. Технологический маршрут n Окисление кремния Диффузия Окисление кремния Осаждение алюминия п п
- 63. Параметры МОП ИС Для упрощения анализа и расчетов примем следующие модельные конструктивные параметры р-канальной МОП ИС:
- 64. Технологический маршрут Первая фотолитография – формирование окон исток-сток 4 фотолитография р р 3 фотолитография п n
- 65. Технологический маршрут Первая фотолитография – формирование окон исток-сток 4 фотолитография р р 3 фотолитография п n
- 66. Расчет коэффициента поражаемости для первой литографии Поражаемая площадь кристалла для первой фотолитографии будет определяться площадью каналов
- 67. Технологический маршрут Вторая фотолитография – вскрытие окна под тонкий окисел д1 д1 Поражающий эффект Д1 -
- 68. Технологический маршрут Вторая фотолитография – вскрытие окна под тонкий окисел д1 д1 Поражающий эффект Д1 -
- 69. Технологический маршрут Третья фотолитография – формирование контактных окон исток/ сток п п п п р р
- 70. Технологический маршрут Третья фотолитография – формирование контактных окон исток/ сток п п п п р р
- 71. Расчет коэффициента поражаемости для третьей литографии Таким образом, поражаемая площадь будет равна: Ап = ( 10
- 72. Технологический маршрут Четвертая фотолитография – формирование алюминиевой разводки n
- 73. Выход годных для МОП ИС Таким образом, суммарный коэффициент поражаемости всего маршрута будет равен 0,1 +
- 74. Закон сохранения выхода годных
- 75. Изменение степени интеграции, минимального размера и площади кристалла Сте6пень интеграции Минимальный размер , мкм Годы 100
- 76. Эволюция технологической нормы
- 77. Технологические поколения
- 78. 3D МОП- транзистор с двумя затворами
- 79. РЭМ-фотография 3D МОП-транзистора с двумя затворами Толщина подзатворного оксида – 1,7 нм Толщина электрода затвора –
- 81. Скачать презентацию













































































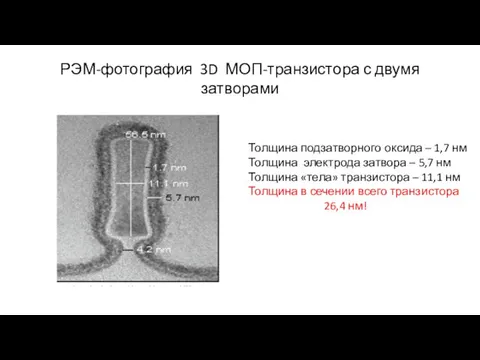
 Современные технологии развития речи детей с трудностями в обучении
Современные технологии развития речи детей с трудностями в обучении Легенды кунг-фу
Легенды кунг-фу Quest_witch
Quest_witch Заточка дереворежущих инструментов (7 класс)
Заточка дереворежущих инструментов (7 класс) Основы православной культуры
Основы православной культуры Проект Накормим птиц зимой!
Проект Накормим птиц зимой! 20131013_razvitie_zvukovogo_analiza_i_sinteza
20131013_razvitie_zvukovogo_analiza_i_sinteza Технология ручных работ
Технология ручных работ Конкурс №1 А ларчик просто открывался
Конкурс №1 А ларчик просто открывался Технология организации работ участка ТО-2 с разработкой технологии и организации
Технология организации работ участка ТО-2 с разработкой технологии и организации Системы обеспечения безопасности движения
Системы обеспечения безопасности движения Христос и его крест
Христос и его крест Строение тела человека. Звуки
Строение тела человека. Звуки Вешание одежды. Сортировка Чистая-грязная
Вешание одежды. Сортировка Чистая-грязная БабицкийМищукМоскалевич
БабицкийМищукМоскалевич Приоритетный проект Формирование комфортной городской среды
Приоритетный проект Формирование комфортной городской среды Высокотехнологичный промыслово-геофизический сервис в процессе строительства скважин и эксплуатации ПХГ
Высокотехнологичный промыслово-геофизический сервис в процессе строительства скважин и эксплуатации ПХГ РАСПРОДАЖА АКСЕССУАРОВ ДИЗАЙНЕР
РАСПРОДАЖА АКСЕССУАРОВ ДИЗАЙНЕР Территория творчества на сайт (часть)
Территория творчества на сайт (часть) Творческая мастерская художника
Творческая мастерская художника 20170529_prezentatsia_microsoft_office_powerpoint_97-2003_2
20170529_prezentatsia_microsoft_office_powerpoint_97-2003_2 Реакторные стали
Реакторные стали ПДД, Космический транспорт
ПДД, Космический транспорт Усовершенствование СВЧ печей
Усовершенствование СВЧ печей Анализ средств выразительности
Анализ средств выразительности Изучение и отработка моделей поведения в условиях вынужденной и природной аномалии
Изучение и отработка моделей поведения в условиях вынужденной и природной аномалии Музыкальный экспресс
Музыкальный экспресс 20180123_zanyatie_prezentatsiya_sergeeva
20180123_zanyatie_prezentatsiya_sergeeva