Содержание
- 2. Компетенции/подкомпетенции, формируемые в дисциплине (ПК-3): способность обосновывать принимаемые проектные решения, осуществлять постановку и выполнять эксперименты по
- 3. ОБЪЕМ ДИСЦИПЛИНЫ И ВИДЫ УЧЕБНОЙ РАБОТЫ
- 4. Учебная нагрузка по ТИМС Лекции – в ауд.4204; Лаб. работы – допуск в ауд.4201 (выполнение в
- 5. Разделы дисциплины 1. Введение в предмет курса. Организационно-технологические основы производства изделий микро- и наноэлектроники; 2. Основы
- 6. ПЕРЕЧЕНЬ УЧЕБНОЙ ЛИТЕРАТУРЫ Основная литература 1. Лабораторный практикум «Основы технологии электронной компонентной базы, под ред. Ю.А.Чаплыгина,
- 7. Структура и график контрольных мероприятий Мониторинг успеваемости студентов проводится в течение семестра трижды: - по итогам
- 8. Лекция 1 Введение в предмет курса. Организационно-технологические основы производства изделий микро- и наноэлектроники
- 9. Применение интегральных схем и микросистем в устройствах бытового назначения Мобильный телефон Домашний компьютер Телевизор КПК Коммуникатор
- 10. Проектирование и изготовление ИС и микросистем требует: 1) знание физики полупроводников и полупроводниковых приборов; 2) знание
- 11. Закон Мура Чаще всего для описания эволюции технологии КМОП применяется так называемый «закон Мура». Важно понимать
- 12. Ключ к успешному прогнозированию будущего технологий КМОП лежит в понимании факторов, влияющих на величину стоимости, на
- 13. 1-Poly and 10-Metal(9Cu + 1Al) Shallow Trench Isolation (STI) Salicide Gate Salicide Source and Drain CMP
- 14. Базовые этапы создания ИМС Окисление кремния
- 15. Фотолитография
- 16. Травление слоя
- 17. Создание легированных областей
- 18. Металлизация
- 19. Тенденции в изменении разрешающей способности литографического процесса полушаг – это минимальный размер литографических параметров на кристалле.
- 20. Technology 0.18 um 0.25 um 0.35 um 0.50 um Supply Voltage (V) 1.8 2.5 3.3 3.3*2
- 21. Физические и механические свойства германия, кремния и арсенида галлия
- 22. Схематическое представление кристаллической решетки кремня
- 23. Схематическое представление плоскостей с различными индексами Миллера в кубической решетке
- 26. Процесс Чохральского для выращивания кристаллов кремния
- 27. Процесс формирования слитка по методу Чохральского
- 28. Распределение температуры в процессе роста слитка по методу Чохральского
- 29. Установки для выращивания слитков и готовый слиток монокремния
- 30. 1 - Держатель 2 - Обмотка нагревателя 3 - Монокристаллический кремний 4 - Затравочный монокристалл 5
- 31. Ориентация пластин подложек
- 33. Список источников литературы по теме: 1. Королев М.А. Технология, конструкции и методы моделирования кремниевых интегральных микросхем:
- 34. Контрольные вопросы по первой теме: В чём заключается суть закона Гордана Мура? В чём заключается суть
- 36. Скачать презентацию













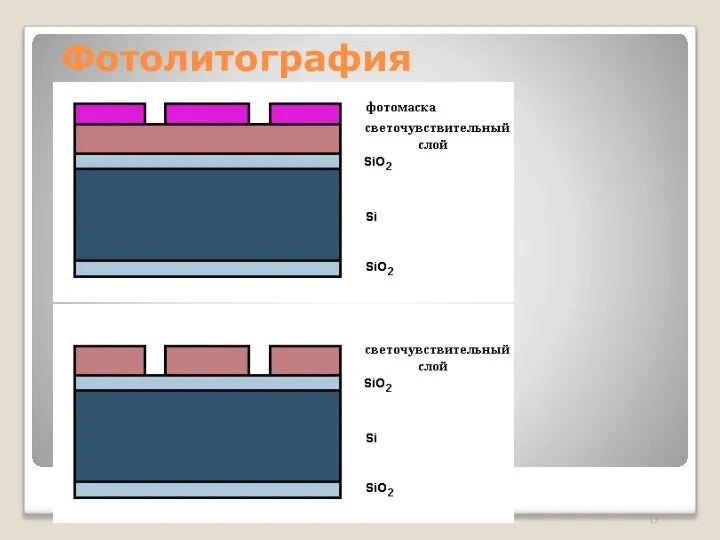

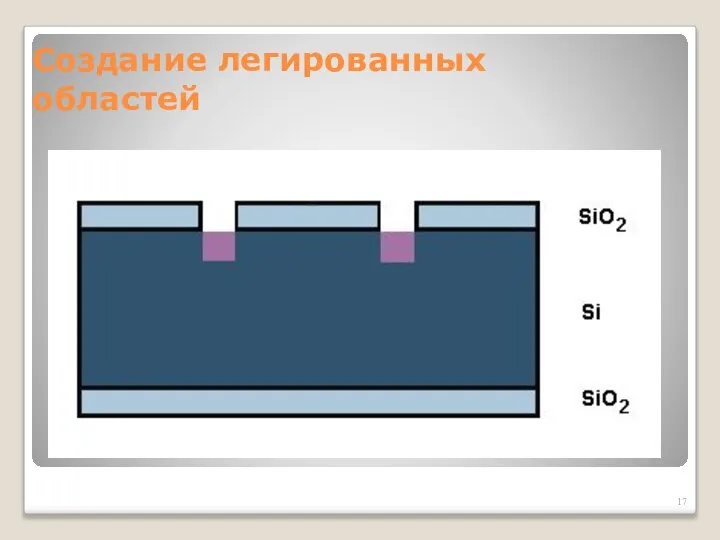
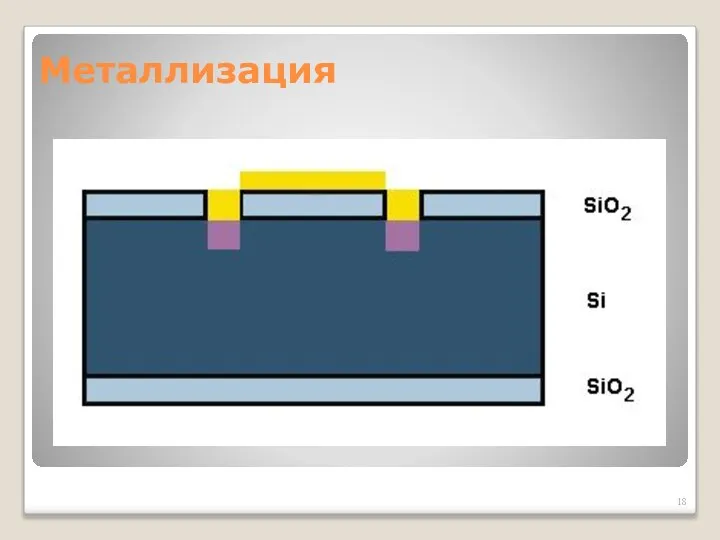

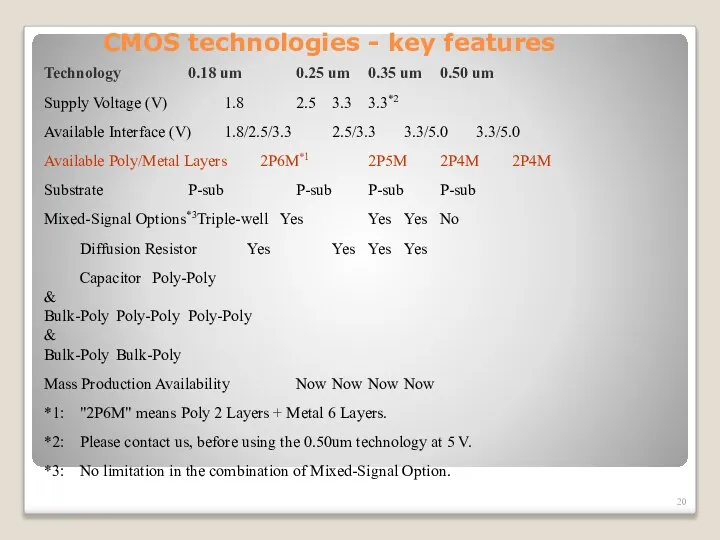














 Инструментарий веб-студии: от брифа до презентации Балахтин Кирилл Руководитель отдела по работе с клиентами Интерактивное а
Инструментарий веб-студии: от брифа до презентации Балахтин Кирилл Руководитель отдела по работе с клиентами Интерактивное а Бухгалтерский баланс ОАО «РЖД»
Бухгалтерский баланс ОАО «РЖД» Текучесть кадров кто виноват?
Текучесть кадров кто виноват?  Понятие медсестринского процесса. Функции сестринства.
Понятие медсестринского процесса. Функции сестринства.  Семья святой праведной Иулиании Лазаревской как идеал православной семьи
Семья святой праведной Иулиании Лазаревской как идеал православной семьи Конёк горбунок - презентация для начальной школы
Конёк горбунок - презентация для начальной школы Фирма «Акра». Производство и офис:
Фирма «Акра». Производство и офис: Программы постгарантийного обслуживания автомобилей Volvo
Программы постгарантийного обслуживания автомобилей Volvo Droga krzyżowa
Droga krzyżowa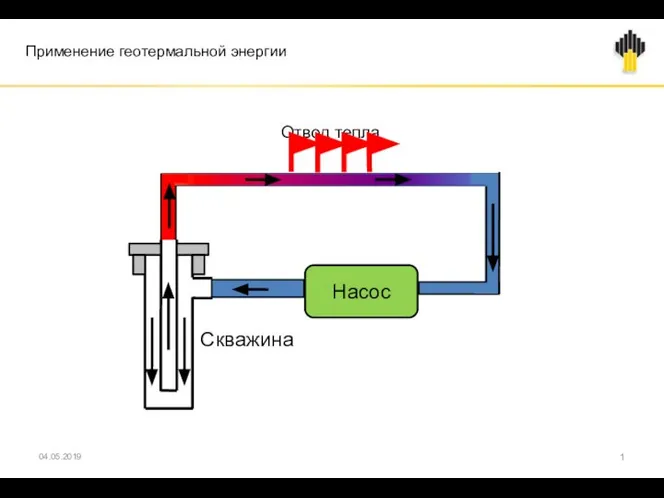 Применение геотермальной энергии
Применение геотермальной энергии Метод наименьших квадратов
Метод наименьших квадратов Religie świata
Religie świata Презентация "Акмеизм" - скачать презентации по МХК
Презентация "Акмеизм" - скачать презентации по МХК Дифракция света
Дифракция света  Алтай-Актив-Тур. Конный тур «Во владения синего волка»
Алтай-Актив-Тур. Конный тур «Во владения синего волка» Назначение и возможности языка PHP. Переменные, константы и типы данных РНР. Лекция №1
Назначение и возможности языка PHP. Переменные, константы и типы данных РНР. Лекция №1 Алексей Семёнович Губкин (1816 – 1883)
Алексей Семёнович Губкин (1816 – 1883) Logical gates. Логические ворота
Logical gates. Логические ворота SQL Server - основа информационной системы предприятия или организации.
SQL Server - основа информационной системы предприятия или организации. Роль государства в рыночной экономике Лекция 9
Роль государства в рыночной экономике Лекция 9 Сортировка-Пузырёк Выборочная QuickSort
Сортировка-Пузырёк Выборочная QuickSort Презентация учителя обществознания МОУ «Одесская СОШ №2» Бородавкиной Ирины Александровны
Презентация учителя обществознания МОУ «Одесская СОШ №2» Бородавкиной Ирины Александровны עמוד הבית
עמוד הבית Реакции гиперчувствительности
Реакции гиперчувствительности Оперативно-розыскная деятельность таможенных органов
Оперативно-розыскная деятельность таможенных органов Натуральные числа - презентация для начальной школы_
Натуральные числа - презентация для начальной школы_ Вторичная костная пластика в комплексной терапии расщелин верхней губы и неба (обзор) Одесский государственный медицинский
Вторичная костная пластика в комплексной терапии расщелин верхней губы и неба (обзор) Одесский государственный медицинский  Аудитория. Тренды. Программирование
Аудитория. Тренды. Программирование