Содержание
- 2. КМДП структура
- 3. Структура МДП транзистора Подложка – легированный кремний одного типа (для n-МОП легирование бором (p-тип примеси), для
- 4. Технология производства КМДП интегральных схем Выращивание кристалла Si Нарезка пластин Si Механическая полировка Химическая полировка Ионная
- 5. Формирование n-кармана Нанесение фоторезиста (Фоторезист – вещество, меняющее свои свойства при воздействии определенного рода излучений) Фотолитография
- 6. Фотолитография (Процесс повторяющийся перед каждым травлением или легированием)
- 7. Плазмохимическое травление Плазмохимическое травление Удаление фоторезиста
- 8. Технология производства КМДП интегральных схем (продолжение) Формирование тонкого подзатворного окисла Выращивание поликристаллического кремния Создание активных областей
- 9. Создание активных областей транзистора Легирование бором/фосфором высокой концентрации (p+/n+), прямо через поликристаллический кремний и тонкий окисел
- 10. Формирование контактов и металлизации Выращивание толстого окисла Вскрытие контактных окон (травление) Осаждение металла (магнетронное распыление)
- 11. Топология КМДП инвертора
- 12. Топологические нормы (правила проектирования топологии) λ – норма проектирования равная половине технологического размера Минимальный размер области
- 13. Топологические нормы (важные нормы для выполнения лабораторных работ) Минимальная длина затвора транзистора – 2λ Вылет (хвост)
- 15. Скачать презентацию
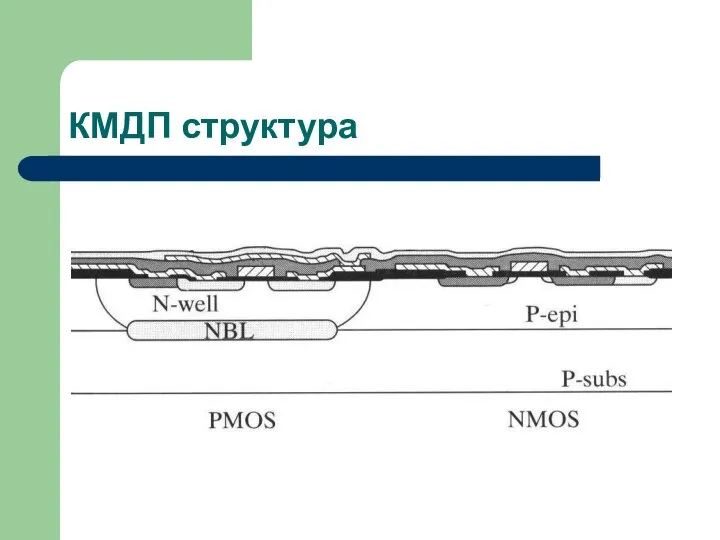






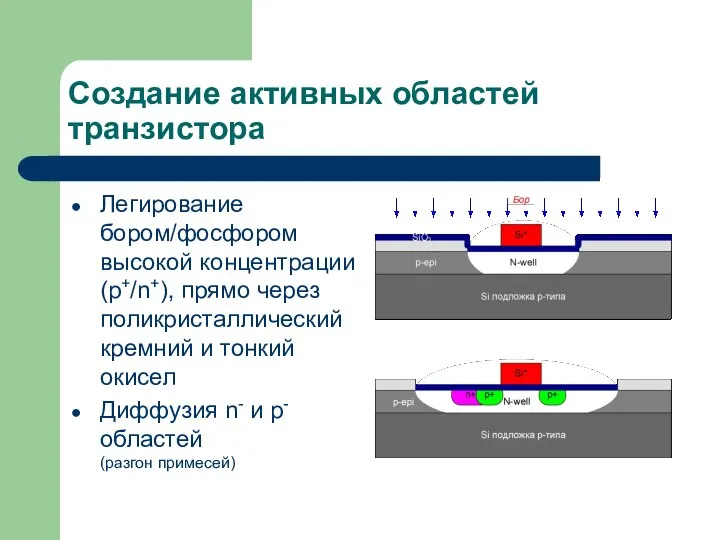
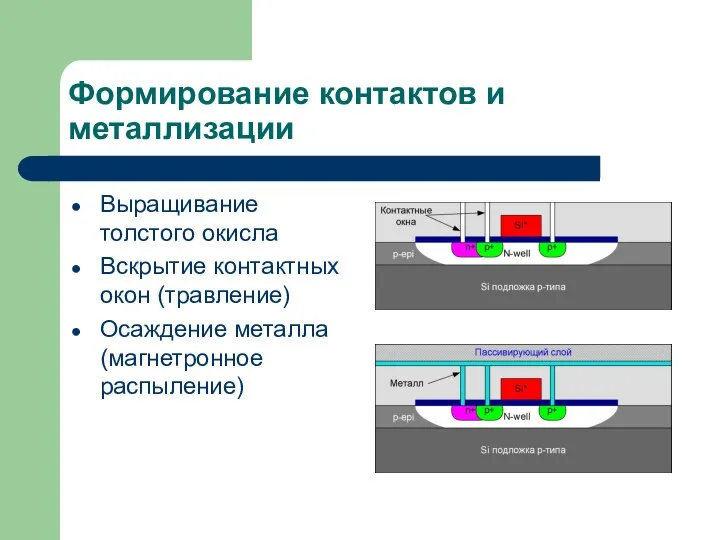
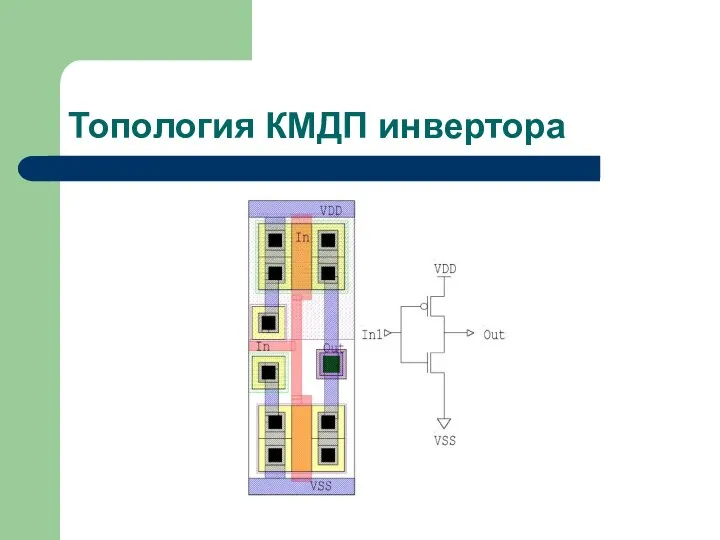


 Презентация "Андрей Матвеев" - скачать презентации по МХК
Презентация "Андрей Матвеев" - скачать презентации по МХК Die Zeit
Die Zeit . Экомониторинг
. Экомониторинг Հայկազուն-Երվանդունիների թագավորություն (6)
Հայկազուն-Երվանդունիների թագավորություն (6) German Customs and Traditions
German Customs and Traditions Ноябрь – зиме родной брат
Ноябрь – зиме родной брат Леонард Эйлер. Круги Эйлера
Леонард Эйлер. Круги Эйлера Шағын бизнес
Шағын бизнес Концепция подготовки спортивного резерва в РФ до 2025
Концепция подготовки спортивного резерва в РФ до 2025 Презентация "Государственное регулирование цен" - скачать презентации по Экономике
Презентация "Государственное регулирование цен" - скачать презентации по Экономике Mitsubishi Galant VIII - история автомобиля
Mitsubishi Galant VIII - история автомобиля Католическая церковь
Католическая церковь Презентация Дальневосточное Таможенное управление
Презентация Дальневосточное Таможенное управление Третейское разбирательство. Нотариат в Российской Федерации
Третейское разбирательство. Нотариат в Российской Федерации ТЕРМОРЕГУЛЯЦИЯ
ТЕРМОРЕГУЛЯЦИЯ Меры социальной поддержки по ЖКУ. Субсидии
Меры социальной поддержки по ЖКУ. Субсидии Этапы создания текста перевода
Этапы создания текста перевода Взаимоотношения с риелторскими службами
Взаимоотношения с риелторскими службами Оборудование плавильного участка
Оборудование плавильного участка Микробиология сальмонеллезов
Микробиология сальмонеллезов Вибрационные методы
Вибрационные методы Пампа Моняк
Пампа Моняк Культура и поведение
Культура и поведение Туристский клуб «Белки». Первый сплав по Берди - «Первооткрыватель»
Туристский клуб «Белки». Первый сплав по Берди - «Первооткрыватель» Cyber Spying in world today
Cyber Spying in world today OptoGaN Enabling bulb-like brightness for LEDs
OptoGaN Enabling bulb-like brightness for LEDs Виды отклонений от языковой нормы и их передача
Виды отклонений от языковой нормы и их передача Отделение электроники. Лидский колледж
Отделение электроники. Лидский колледж