Содержание
- 2. Список использованных и рекомендуемых источников Технология, конструкции и методы моделирования кремниевых интегральных микросхем: в 2 ч.
- 4. Уровень технологии определяется минимально возможной топологической нормой, т. е. минимальным размером элемента или зазора в периодических
- 5. Степень интеграции Ki=lgN, N – количество основных элементов, входящих в состав микросхемы Ki= ≤ 1 –
- 6. Table 1.2. Major milestones in semiconductor processing history. Year Event 1798 Lithography process invented 1855 Fick
- 7. 1-Poly and 10-Metal(9Cu + 1Al) Shallow Trench Isolation (STI) Salicide Gate Salicide Source and Drain CMP
- 9. FEOL (front-end-of-line). Означает первую часть производственного цикла изготовления ИС, в котором отдельные элементы (транзисторы, емкости, резисторы
- 13. Закон Мура: Функциональные возможности высокосовершенных дозу (объем памяти или количество ячеек памяти) и МП (количество транзисторов
- 14. Закон Гордона Мура Современные тенденции масштабирования ИС могут быть сформулированы следующим образом: - новое поколение технологии
- 15. В последние десятилетия основной фактор повышения степени интеграции -масштабирование (уменьшение размеров элементов)
- 16. Затвор из проводящего поликремния отделен от канала транзистора тончайшим (толщиной всего 1,2 нм или 5 атомов!)
- 17. С ростом степени интеграции СБИС и систем на кристалле увеличивается доля чипов, содержащих аналоговые блоки, которые
- 19. Требования к такому материалу весьма серьезны: высокая химическая и механическая (на атомарном уровне) совместимость с кремнием,
- 22. Столь малая толщина диэлектрика необходима для получения не только малых габаритов транзистора в целом, но и
- 23. слабая зависимость порогового напряжения от напряжения на стоке слабая зависимость порогового напряжения от длины и ширины
- 24. Масштабирование МОПТ Сравнительная таблица технологий XXI века:
- 25. Физические ограничения масштабирования МОПТ
- 26. Проблемы масштабирования МОПТ и пути их решения
- 27. Методы улучшения характеристик МОПТ I. Создание мелкозалегающих слаболегированных областей стока/истока (Lightly Doped Drain, LDD-области) Концентрация примеси
- 28. II. Создание ореола (halo) вокруг LDD-областей истока/стока Проникновение области обеднения стока в канал является основной причиной
- 29. II. Создание ореола (halo) вокруг LDD-областей истока/стока Проникновение области обеднения стока в канал является основной причиной
- 30. Методы улучшения характеристик МОПТ III . Крутое ретроградное распределение примеси в кармане (Super Steep Retrograde Well,
- 31. Методы улучшения характеристик МОПТ IV . Использование «напряженного кремния» Суть технологии лежит в изменении расстояния между
- 32. Масштабирование подзатворного диэлектрика Прогноз масштабирования толщины подзатворного SiO2 Кванто-механический эффект По прогнозу SIA масштабирование толщины SiO2
- 33. Использование High-K материалов в качестве подзатворного диэлектрика Hidh-K материалы позволяют использовать более толстые диэлектрические слои для
- 34. Проблемы при миниатюризации межсоединений Роль задержки в линиях разводки неуклонно растет: 1) до 90-х гг. доминировали
- 35. Перспективные разработки для дальнейшего масштабирования МОПТ I. Транзистор с двойным затворм Такой подход позволяет эффективно управлять
- 37. Наиболее распространнной конструкцией МОП- транзистора является LDD (Lightly Doped Drain) структура. Конструктивной особенностью является наличие мелких
- 39. Транзистор Tri-Gate, 22-нм
- 40. Результатом такого конструкторского решения является снижение сопротивления транзистора в открытом состоянии, увеличение сопротивления в закрытом и
- 41. тенденции в изменении разрешающей способности литографического процесса полушаг – это минимальный размер литографических параметров на кристалле.
- 42. Technology 0.18 um 0.25 um 0.35 um 0.50 um Supply Voltage (V) 1.8 2.5 3.3 3.3*2
- 43. Физические и механические свойства германия, кремния и арсенида галлия
- 44. Схематическое представление кристаллической решетки кремня
- 45. Схематическое представление плоскостей с различными индексами Миллера в кубической решетке
- 48. Процесс Чохральского для выращивания кристаллов кремния
- 52. 1 - Держатель 2 - Обмотка нагревателя 3 - Монокристаллический кремний 4 - Затравочный монокристалл 5
- 58. Скачать презентацию





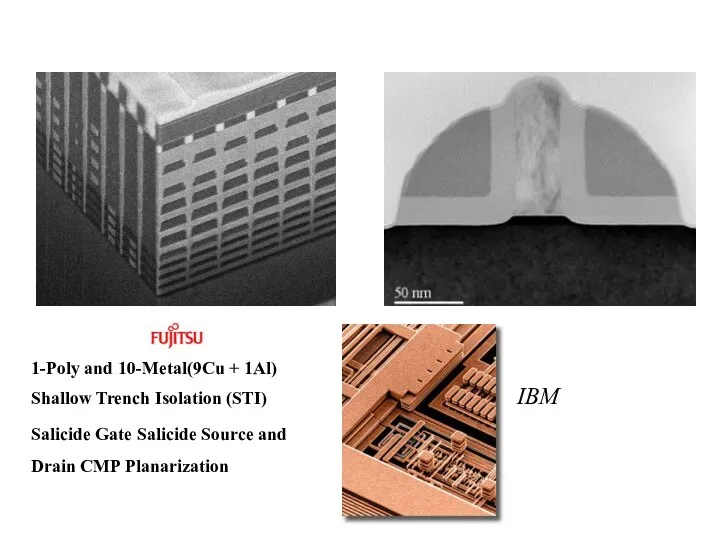



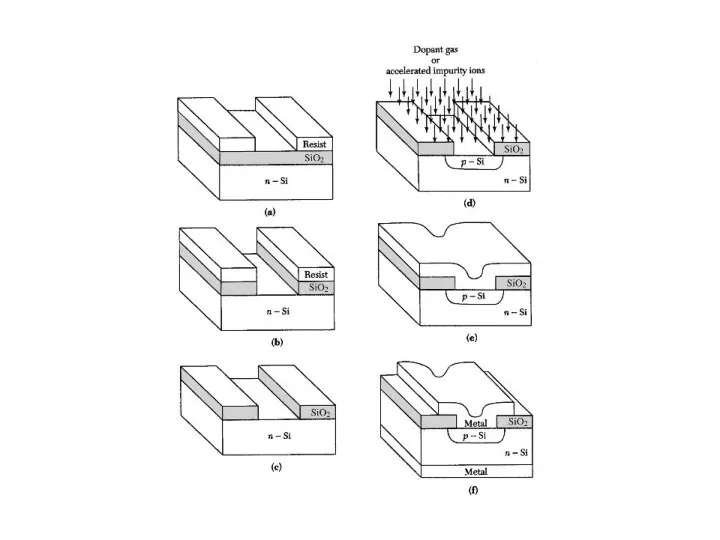
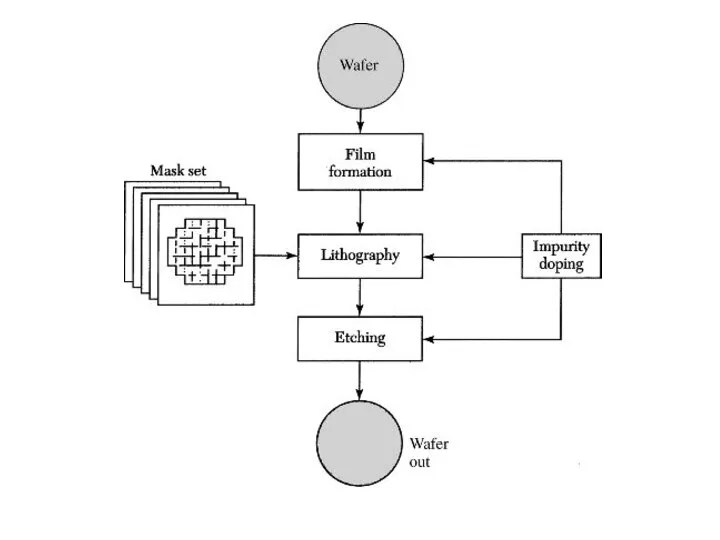

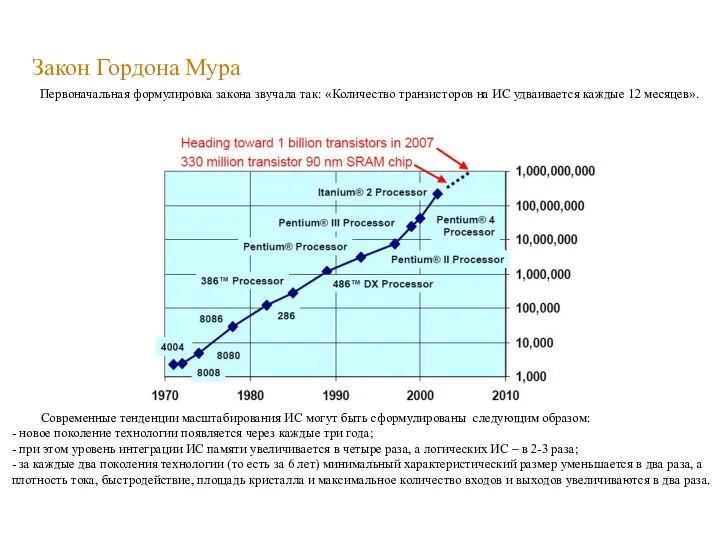






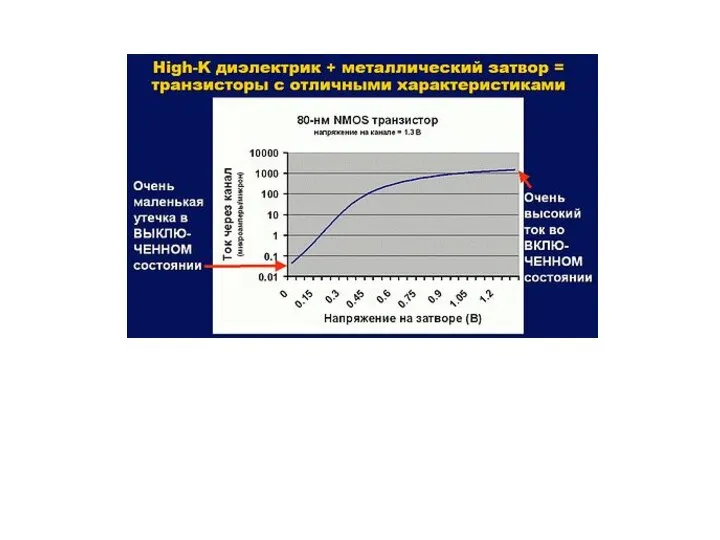






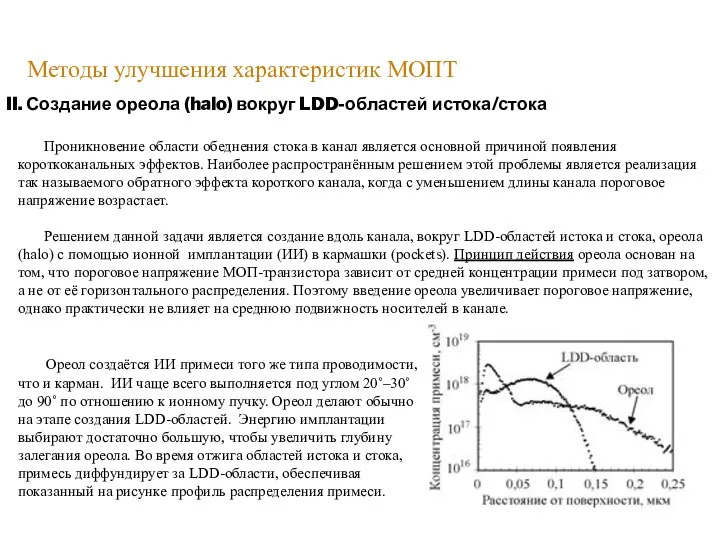
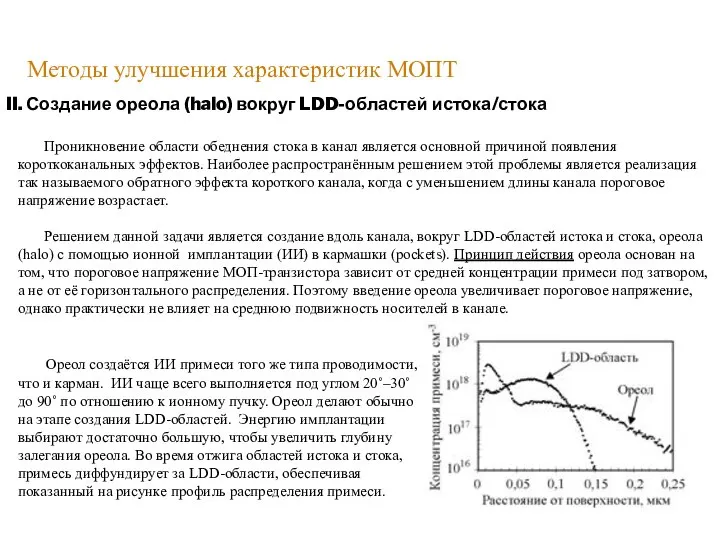
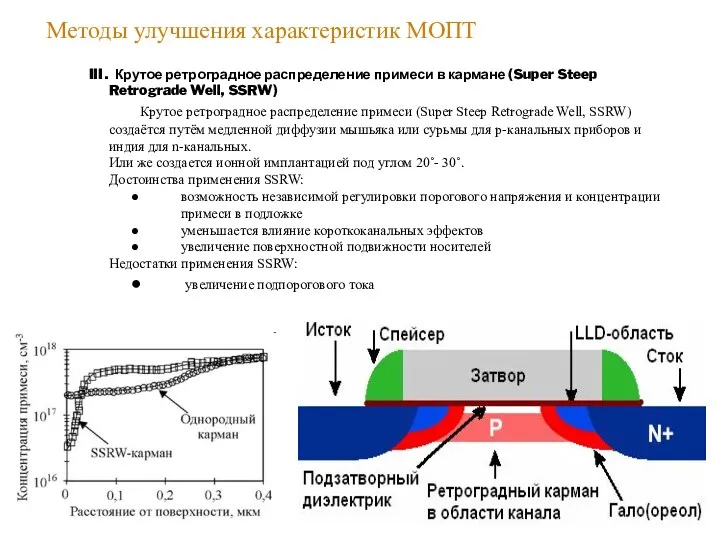
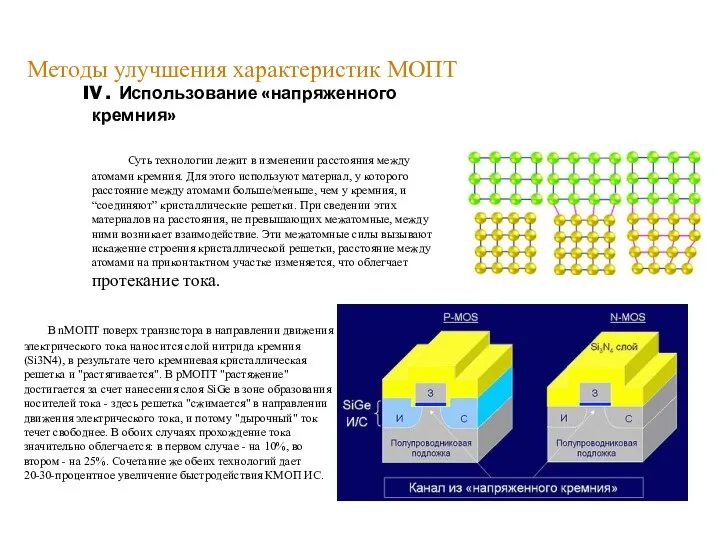
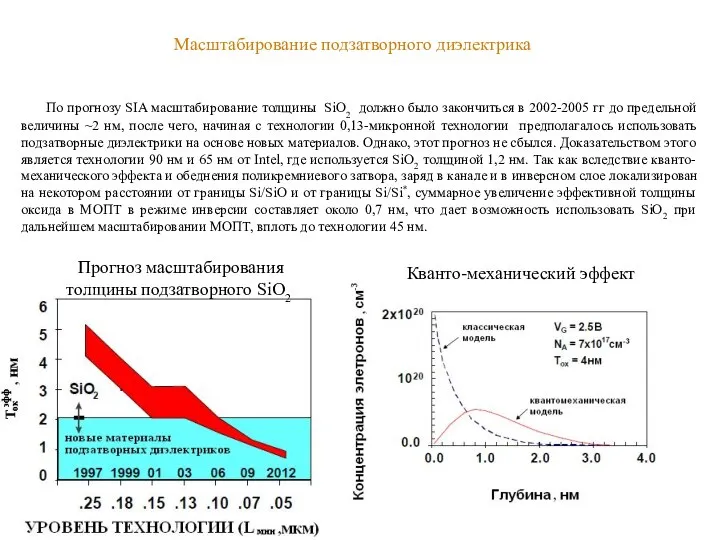



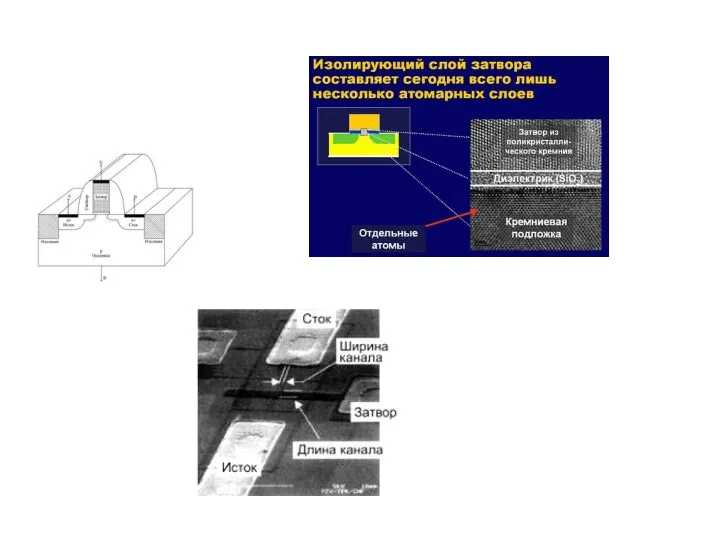

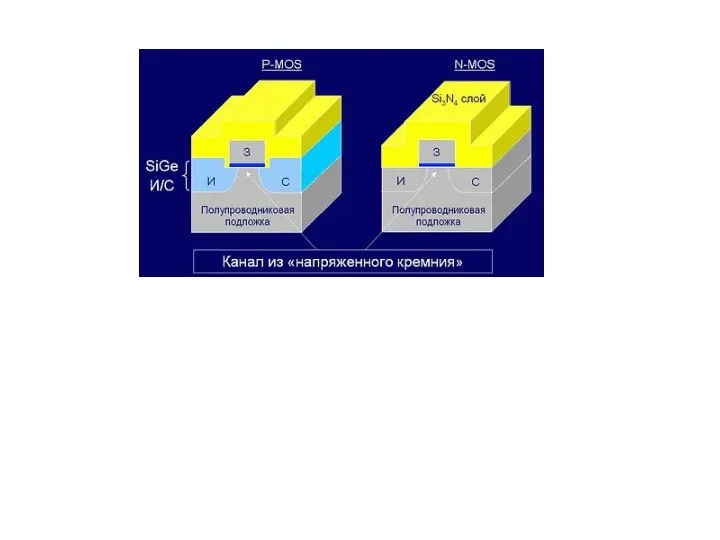
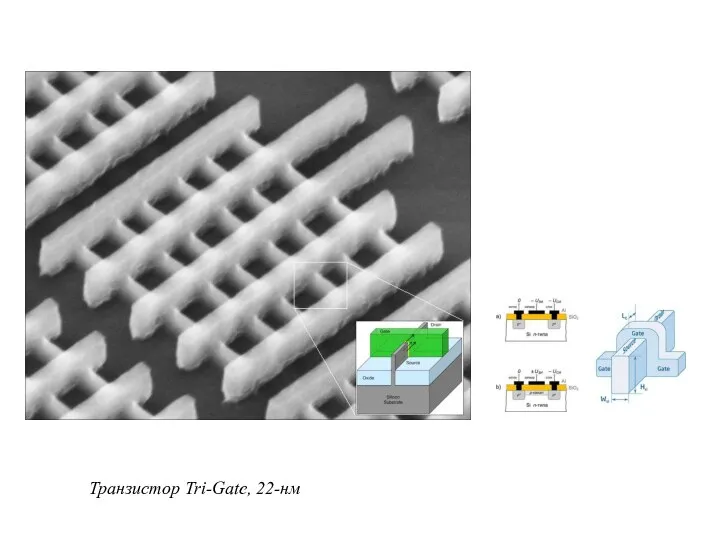
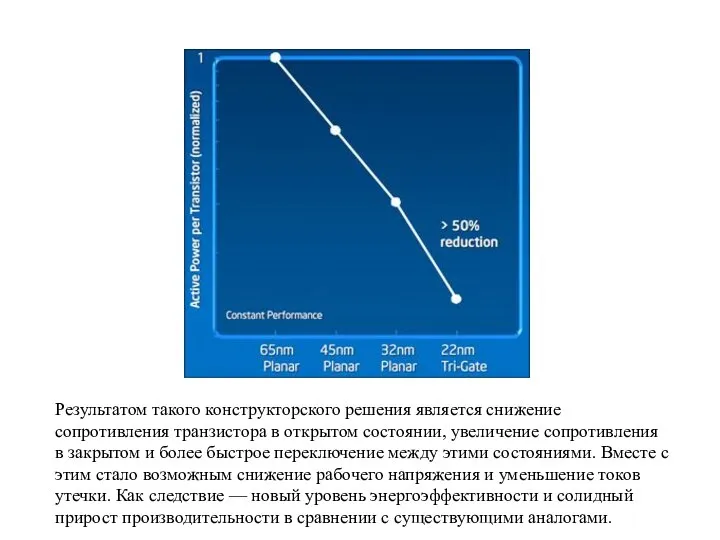




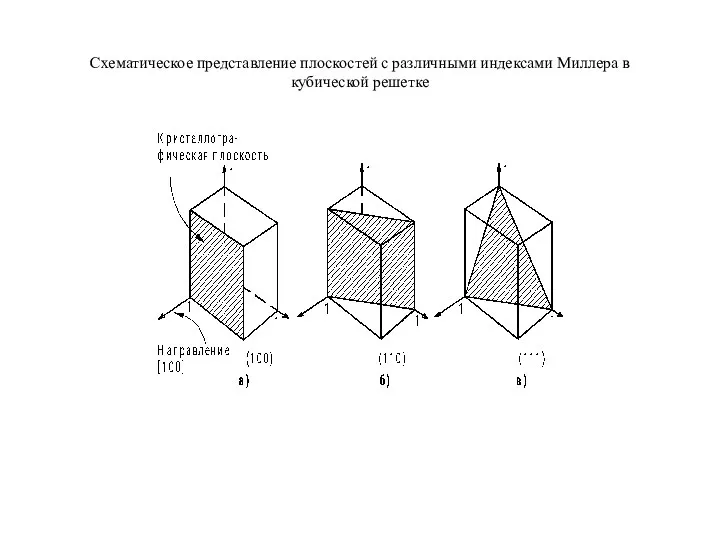


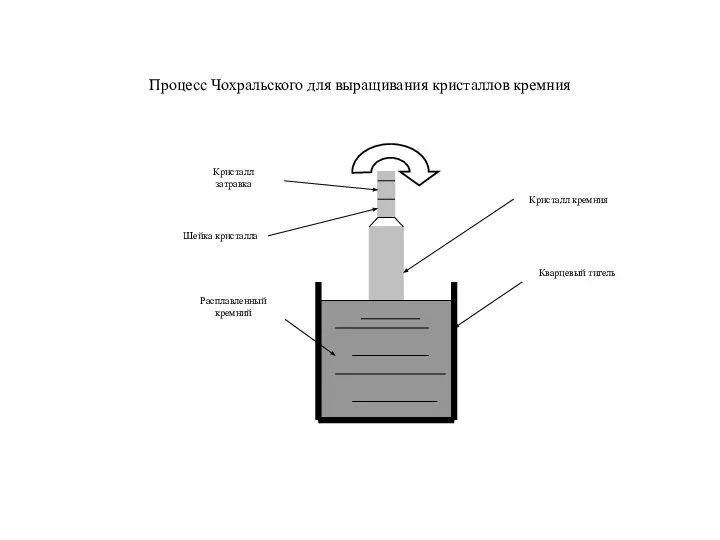




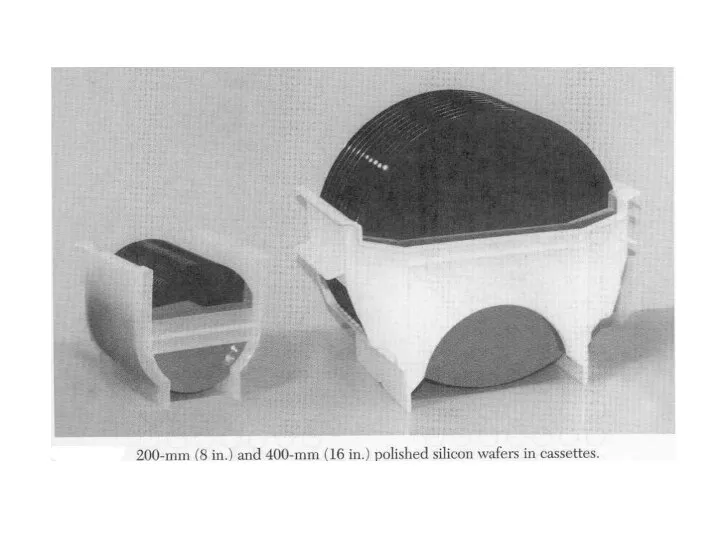
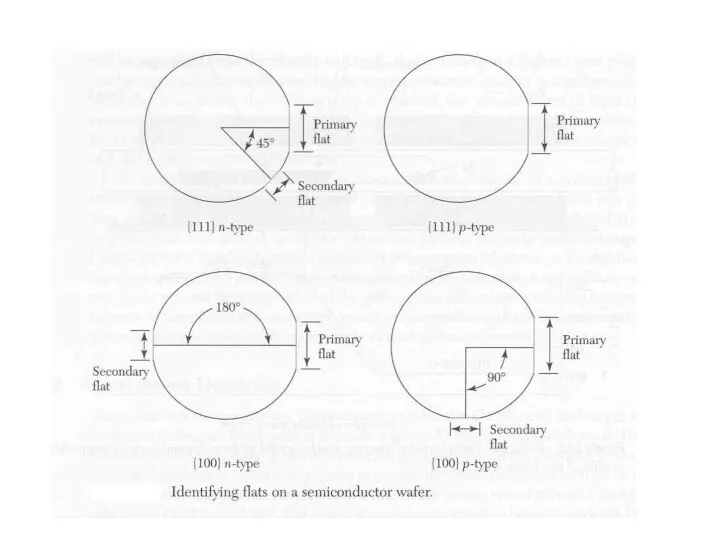


 Машины постоянного тока
Машины постоянного тока Оборудование и благоустройство дорог
Оборудование и благоустройство дорог Презентация на тему "Профілактика синдрому емоційного вигорання" - скачать презентации по Педагогике
Презентация на тему "Профілактика синдрому емоційного вигорання" - скачать презентации по Педагогике Ертетегі үнділердің діндері
Ертетегі үнділердің діндері Культурологическая концепция Н. Бердяева
Культурологическая концепция Н. Бердяева Презентация "Классификация и структура организационно - распорядительных документов" - скачать презентации по Экономике
Презентация "Классификация и структура организационно - распорядительных документов" - скачать презентации по Экономике Система водоснабжения дома
Система водоснабжения дома Массивы. Классификация данных по структуре
Массивы. Классификация данных по структуре Достопримечательности города Астана
Достопримечательности города Астана Мем - картинка с разными приписками
Мем - картинка с разными приписками Основные инструменты денежно-кредитной политики ЦБ РФ Выполнила: студентка 2 курса ФТД Т-114 Галибина Любовь
Основные инструменты денежно-кредитной политики ЦБ РФ Выполнила: студентка 2 курса ФТД Т-114 Галибина Любовь  Мегатренды 2030, их влияние на компетенции новых лидеров. Роль коучинга в компаниях будущего
Мегатренды 2030, их влияние на компетенции новых лидеров. Роль коучинга в компаниях будущего Правописание безударных окончаний имён существительных Автор: Попружная Г.П., учитель начальных классов МОУ гимназия №8 г. Дубны
Правописание безударных окончаний имён существительных Автор: Попружная Г.П., учитель начальных классов МОУ гимназия №8 г. Дубны  Реклама в современном мире
Реклама в современном мире Презентация "Бизнес под ключ" - скачать презентации по Экономике
Презентация "Бизнес под ключ" - скачать презентации по Экономике Видовые пары и противопоставление видов
Видовые пары и противопоставление видов Лек 2 проецир
Лек 2 проецир Расчет колонн. Сечения металлической колонны
Расчет колонн. Сечения металлической колонны Политика и власть
Политика и власть Модели в физике
Модели в физике Косметический ремонт актового зала
Косметический ремонт актового зала Споры, связанные с самовольной постройкой Выполнил: студент 2-го курса очной формы обучения юридического факультета Гру
Споры, связанные с самовольной постройкой Выполнил: студент 2-го курса очной формы обучения юридического факультета Гру Этникааралық шиеліністер және оларды болдырмау жолдары
Этникааралық шиеліністер және оларды болдырмау жолдары Консультация. Управленческие решения
Консультация. Управленческие решения Урок алгебры в 8 классе по учебно-методическому пособию А.Г.Мордкович Автор презентации : учитель математики МОУ «СОШ п.Целинн
Урок алгебры в 8 классе по учебно-методическому пособию А.Г.Мордкович Автор презентации : учитель математики МОУ «СОШ п.Целинн Функциональная анатомия ВНС
Функциональная анатомия ВНС Инфраструктура муниципальных образований
Инфраструктура муниципальных образований Билборды на тему электронное декларирование Выполнили студентки 2-го курса Русакова Ксения и Курчина Маргарита Группа М 111 Б
Билборды на тему электронное декларирование Выполнили студентки 2-го курса Русакова Ксения и Курчина Маргарита Группа М 111 Б